Новый SCR с высоким удерживающим напряжением со встроенной структурой рекомбинации несущих для защиты от защелкивания и надежной защиты от электростатических разрядов
Аннотация
Предложен новый КМОП-совместимый выпрямитель высокого удерживающего напряжения с кремниевым управлением (HHV-SCR) для защиты от электростатического разряда (ESD), который продемонстрирован с помощью моделирования и импульсного тестирования линии передачи (TLP). Вновь введенная область рекомбинации дырок (или электронов) H-RR (или E-RR) не только рекомбинирует неосновной носитель в базе паразитного PNP (или NPN) транзистора слоем N + (или P +), но и обеспечивает дополнительную рекомбинацию для устранения поверхностные лавинные носители за счет недавно добавленного слоя P + (или N +) в H-RR (или E-RR), что приводит к дальнейшему улучшению удерживающего напряжения ( V h ). По сравнению с измеренным V h 1,8 В низковольтного триггерного кремниевого выпрямителя (LVTSCR), напряжение V h HHV-SCR можно увеличить до 8,1 В при сохранении достаточно высокого тока отказа ( I t2 > 2,6 А). Достигнуто более чем четырехкратное улучшение показателей качества (FOM).
Введение
С развитием полупроводниковой интегрированной технологии и последовательной миниатюризацией размеров элементов полупроводникового устройства повреждение устройства, вызванное электростатическим разрядом, становится все более серьезным. Ценой большой площади кристалла было сообщено об обычных устройствах, таких как N-канальный МОП-транзистор с заземлением через диод и затвор (ggNMOS), обладающих нормальной устойчивостью к электростатическому разряду [1]. Чтобы реализовать улучшенную способность к электростатическому разряду с меньшими размерами устройства, низковольтный управляемый кремниевый выпрямитель (LVTSCR) был признан привлекательным устройством из-за его способности выдерживать большие токи на единицу площади [2]. Для низковольтных приложений благодаря встроенному низковольтному напряжению срабатывания ( В t1 ) ggNMOS, LVTSCR с превосходной устойчивостью к электростатическому разряду способен обеспечить более высокую скорость реакции на электростатический разряд, чем это достигается в обычном SCR. Однако сильная положительная обратная связь приводит к очень низкому V h (1 ~ 2 В), который отвечает за фиксацию и кратковременное ошибочное срабатывание [3]. Такие негативные эффекты можно эффективно подавить, просто увеличив V h [3,4,5,6,7,8,9,10,11]. Устройство не будет подвержено защелкиванию и кратковременному ошибочному срабатыванию, в то время как V h выше, чем напряжение источника питания (VDD). Соответственно, область N + ESD и область P + LDD были добавлены в SCR с дополнительными масками и этапами ионной имплантации для улучшения V h [3]. Однако устойчивость к электростатическому разряду может ухудшиться из-за дополнительного рассеивания мощности вместе с увеличенным V h . Кроме того, технология фиксации напряжения эмиттера для V h улучшение с приемлемым током отказа ( I t2 ) также был предложен [5]. Тем не менее, V h в вышеупомянутых подходах не регулируется, что по-прежнему создает неудобства и ограничения в универсальных приложениях.
В этом письме предлагается новый выпрямитель с кремниевым управлением с высоким удерживающим напряжением (HHV-SCR), который демонстрируется посредством моделирования TCAD и тестирования TLP. Устройство одновременно достигает высокого V h , высокий I t2 , и регулируемый V h без дополнительных масок и ступенек. TLP-тест был проведен для подтверждения того, что V h можно эффективно улучшить при сохранении достаточно высокого I t2 . Согласно результатам тестирования, HHV-SCR имеет более чем в четыре раза более высокое напряжение V . h чем в LVTSCR с незначительной деградацией в I t2 .
Метод
В этой работе исследуется новый тринистор с высоким удерживающим напряжением со встроенной структурой рекомбинации носителей. В численном моделировании используются физические модели IMPACT.I, BGN, CONMOB, FLDMOB, SRH и SRFMOB. На основе модели H-RR и E-RR оптимизированы для достижения высокого V h и высокий P M . Изготовленные HHV-SCR и LVTSCR тестируются системой TLP.
Структура и механизм
Схематический вид в разрезе предлагаемого HHV-SCR и схема расположения показаны на рис. 1a, b, соответственно. Вновь введенные H-RR и E-RR, образованные плавающими N + и P +, идентичны N + и P + в анодной и катодной областях соответственно. Плавающий N + в H-RR (или плавающий P + в E-RR) размещается рядом с областью P + на аноде (или областью N + на катоде). Более того, новый плавающий P + в H-RR (или плавающий N + в E-RR) также расположен рядом с вышеупомянутым плавающим N + в H-RR (или плавающим P + в E-RR). N + с низким триггером в H-RR (TN +) и P + с низким триггером в E-RR (TP +) также изготавливаются с помощью тех же процессов, что и область N + (или P +) в аноде (или катоде), чтобы гарантировать <я> V t1 в приемлемом диапазоне. В качестве положительного напряжения электростатического разряда ( В ESD ) поднимаясь до определенного уровня, переход TN + / P-well / TP + с низким напряжением пробоя сначала выйдет из строя, а затем произойдет возврат паразитных транзисторов, вызванный лавинным током. Сильная положительная обратная связь паразитных BJT ответственна за значительно низкий V h LVTSCR. В HHV-SCR N + в H-RR (или P + в E-RR) будет рекомбинировать неосновные носители, введенные с края анода P + (или катода N +), что снижает коэффициент усиления по току ( β ) паразитного PNP (или NPN) и устраняет поверхностный биполярный эффект. Важно отметить, что P + в H-RR (или N + в E-RR) блокирует поверхностный путь с низким сопротивлением, рекомбинируя поверхностные электроны (или дырки). По сравнению с H-RR без P + (или E-RR без N +), новый P + в H-RR (или N + в E-RR) обеспечивает дополнительную рекомбинацию для устранения поверхностных электронов (или дырок), инжектированных с катода ( или анод) и вызванные ударной ионизацией (показаны на рис. 3а), что приводит к дальнейшему увеличению V h . Комбинируя эти модификации, мы получаем значительное улучшение FOM проверено. Показатель качества (FOM) цитируется из [7] и определяется как допустимая удельная мощность отдельного устройства, определяемая как FOM =( V h · Я t2 ) / ( N · Вт ) для оценки V h и я t2 производительность одного устройства. Как правило, сопровождается улучшением V h производительность, это по-прежнему вызывает снижение I t2 из-за более высокого рассеяния мощности. Следовательно, более высокое значение FOM означает, что отдельное устройство может обеспечить более высокий ток при более высоком V h уровень ( N - номер штабелеукладчика; Вт ширина устройства).
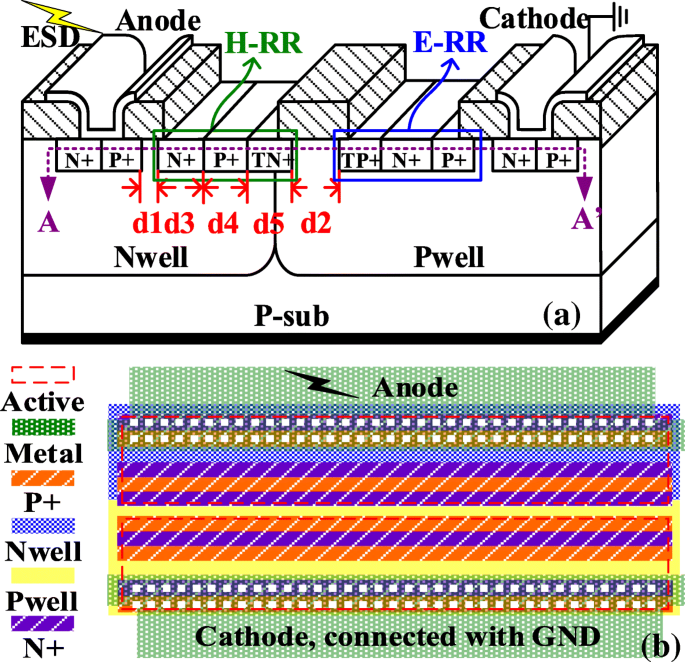
а Схематический вид в разрезе предлагаемого HHV-SCR. б Принципиальная схема предлагаемого HHV-SCR
Результаты и обсуждение
Результаты моделирования
Характеристики устройства были изучены и смоделированы TCAD Medici, где использовались соответствующие модели, такие как ударная ионизация и модель подвижности, зависящая от концентрации. Смоделированные кривые ВАХ LVTSCR и HHV-SCR показаны на рис. 2. V h LVTSCR составляет всего 1,8 В, а V h HHV-SCR улучшен с 4,6 В до 8,1 В с уменьшением d1 с 0,6 мкм до 0 мкм для d2 =0,5 мкм. Фактически, меньший d1 является предпочтительным для улучшенной способности рекомбинации N + в H-RR (или P + в E-RR) для получения более низкого β , что объясняет, что HHV-SCR всегда достигает наивысшего V h для d1 =0 мкм. Результаты моделирования на рис. 2b показывают, что V h HHV-SCR дополнительно улучшается с увеличением d2 с 0,5 до 1 мкм за счет увеличения длины устройства. Для демонстрации, P + в H-RR (или N + в E-RR) также является ключевым фактором для увеличения V h . Результаты моделирования показаны на рис. 2c. Когда H-RR (или E-RR) с фиксированным d3 + d4 полностью образован сильным легированием N + (или P +) (например, d3 =3,5 мкм, d4 =0 мкм), смоделированный V h составляет 7,1 В. Путем вставки P + внутрь H-RR и N + внутри E-RR с фиксированным d3 + d4 (например, d3 =2,5 мкм, d4 =1,0 мкм) смоделированный V h может быть увеличено примерно до 9,5 В. Можно сделать вывод, что новый P + в H-RR (или N + в H-RR) эффективен в рекомбинации поверхностных лавинообразных электронов (или дырок), чтобы заблокировать путь поверхностного тока. Следовательно, более высокий V h требуется, чтобы HHV-SCR выдерживал такой же ток удержания ( I h ). Кривая рекомбинации только AA 'линия, показанная на фиг. 3a, демонстрирует увеличение скорости рекомбинации, индуцированное новым P + в H-RR (или N + в E-RR). TN + и TP + приняты для обеспечения V t1 в приемлемом диапазоне. Регулируя d2 и d5 на фиксированных d5 + d2 + d5, V t1 напряжения HHV-SCR можно значительно уменьшить с 12 В до 9,0 В для соответствия проектному окну цепей 5 В с незначительным влиянием на V h , показанный на рис. 2г. Диаграммы распределения тока смоделированных устройств в точке удержания также показаны на рис. 3b, c соответственно. По сравнению с распределением тока в HHV-SCR с d3 =3,5 мкм, d4 =0 мкм, путь поверхностного тока в предлагаемом HHV-SCR заблокирован из-за дополнительной скорости рекомбинации, получаемой от P + в H-RR и N + в E -RR.

Смоделированная вольт-амперная характеристика обычного LVTSCR и предложенная HHV-SCR с увеличением d1 с 0 мкм до 0,6 мкм при a d2 =0,5 мкм и b d2 =1 мкм. c ВАХ HHV-SCR с разными d3 и d4 для фиксированного d3 + d4 (d3 + d4 =3,5 мкм). г ВАХ HHV-SCR с различным V t1
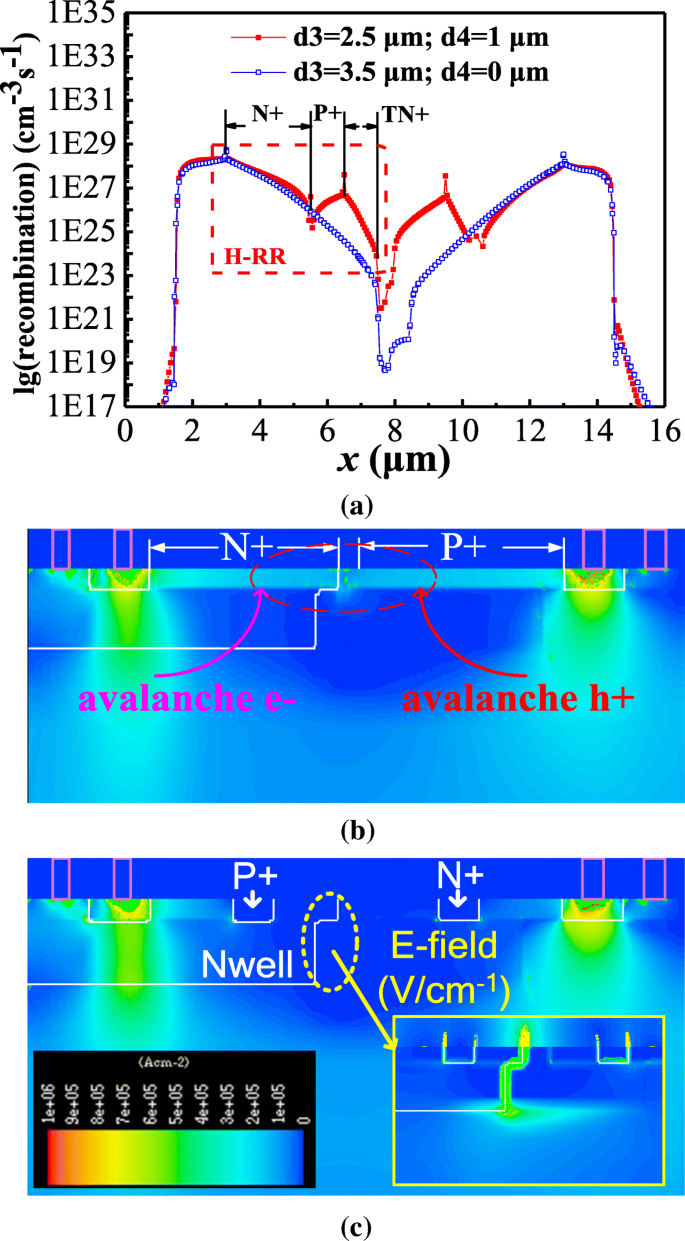
а Кривые распределения рекомбинации и текущие распределения HHV-SCR с ( b ) d3 =3,5 мкм, d4 =0 мкм и ( c ) d3 =2,5 мкм, d4 =1 мкм
Экспериментальные результаты
Изготовленные устройства проходят испытания по системе TLP. Общая ширина (W) всех протестированных SCR составляет 50 мкм и с одним пальцем для сравнения параметров (таблица 1). Все протестированные устройства занимают одинаковую площадь компоновки. Параметры устройства показаны в таблице 2. На рисунке 4a показаны кривые измерения TLP для HHV-SCR с d2 =0,5 мкм (называемых устройствами B1) и LVTSCR. Согласно результатам экспериментов, V h напряжения HHV-SCR увеличивается с 5,5 до 8,0 В с уменьшением d1 с 0,6 мкм до 0,0 мкм, что намного выше, чем 1,8 В, полученное в обычном LVTSCR. Когда d2 увеличивается с 0,5 до 1 мкм, соответствующие HHV-SCR (называемые устройствами B2) получают более высокое V h показано на рис. 4b. Учитывая окно проектирования, напряжение зажима ( В CL ) под данным индексом также является ключевым параметром для оценки зажимной способности. Судя по результатам тестирования, V CL однопальцевого HHV-SCR также находится в допустимом диапазоне при HBM =2 кВ ( I TLP =1,3 А), хотя ширина пальца составляет всего 50 мкм. Однако не все устройства могут предоставить подходящую V CL под более сильным напряжением электростатического разряда из-за высокого V h и большое динамическое сопротивление ( R dy ) из-за недостаточной ширины устройства. Для удовлетворения более высоких требований к статическому электричеству на кристалле ширина пальца увеличена до приемлемых 300 мкм для d1 =0,6 мкм, d4 =0,5 мкм и d1 =0,6 мкм, d4 =0 мкм. Тестирование TLP, показанное на рис. 5, демонстрирует, что HHV-SCR с d4 =0,5 мкм имеет чрезвычайно низкое R dy (около 0,7 Ом), превосходная устойчивость к электростатическому разряду ( I t2 > 10 А) и высокое V h 6,7 В. Можно заметить, что V CL составляет всего 6,7 В на I TLP =5,4 А (HBM =8 кВ). Кроме того, чем выше V h также доказана польза от P + в H-RR (или N + в E-RR) по сравнению с кривой TLP SCR с d4 =0 мкм. Результаты испытаний устройств с одним пальцем 50 мкм приведены в таблице 1.

Экспериментальный ток отказа при ширине блока и соответствующие ВАХ TLP обычного LVTSCR и предлагаемых HHV-SCR с a d2 =0,5 мкм и b d2 =1 мкм при W =50 мкм
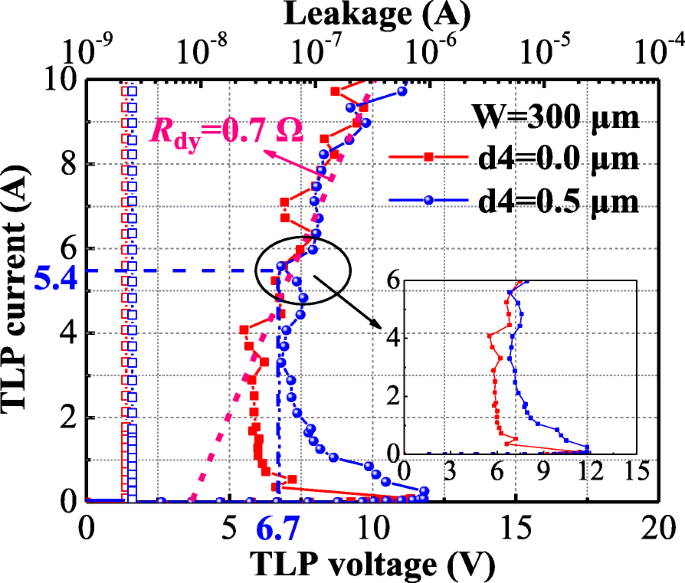
Экспериментальная характеристика TLP HHV-SCR с d4 =0,0 мкм и d4 =1,0 мкм при d1 =0,6 мкм, W =300 мкм
Заключение
Новый HHV-SCR, совместимый с CMOS-процессом, изучается и измеряется с помощью моделирования TCAD и системы TLP. По сравнению с обычным LVTSCR, HHV-SCR имеет значительно улучшенное V h (улучшение более чем на 450% в V h достигается) и без ущерба для площади микросхемы. Кроме того, V h HHV-SCR можно отрегулировать от 5,5 В до 8,1 В для удовлетворения различных требований V h требования с незначительной деградацией в I t2 . С точки зрения P M по сравнению с обычным LVTSCR также достигается улучшение более чем на 200%.
Доступность данных и материалов
Все данные, полученные или проанализированные в ходе этого исследования, включены в эту опубликованную статью.
Наноматериалы
- Краткое описание технологии ИС для микроконтроллеров и встроенных систем
- Maxim:двойной приемопередатчик IO-Link с регулятором DC-DC и защитой от перенапряжения
- TRS-STAR:надежные и безвентиляторные встраиваемые системы от avalue
- Новые биосовместимые наночастицы Au Nanostars @ PEG для КТ-визуализации in vivo и свойства очищения почек
- Монодисперсные углеродные наносферы с иерархической пористой структурой в качестве материала электродов дл…
- Улучшение частотной модуляции и поглощения ТГц микроболометра со структурой микромоста с помощью антенн спи…
- Новые наночастицы, нацеленные на двойные митохондрии и рецепторы CD44, для высвобождения, инициируемого окисли…
- Морфология, структура и оптические свойства полупроводниковых пленок с наноостровками GeSiSn и напряженными сл…
- Автоматизация и кибербезопасность:полная защита для клиентов
- Материалы и дизайн печатных плат для высокого напряжения



