Доминирующее влияние рассеяния шероховатости границы раздела на характеристики GaN-терагерцовых квантово-каскадных лазеров
Аннотация
С помощью формализма неравновесных функций Грина исследовано влияние шероховатости границы раздела квантовых ям, непреднамеренного легирования и беспорядка сплава на характеристики терагерцовых квантово-каскадных лазеров (ККЛ) на основе GaN. Было обнаружено, что влияние беспорядка сплава на оптическое усиление незначительно и непреднамеренное легирование должно оставаться ниже разумной концентрации 10 17 . см −3 для предотвращения деградации рассеяния электронов на примесях и поглощения свободных носителей. Что еще более важно, рассеяние по шероховатости поверхности раздела оказалось доминирующим фактором в ухудшении оптического усиления. Поэтому его точный контроль во время изготовления имеет решающее значение. Наконец, прирост 60 см −1 может быть получен при 300 К, что показывает возможность изготовления GaN-терагерцового ККЛ при комнатной температуре.
Введение
Терагерцовая (ТГц) область спектра является предметом интенсивных исследований из-за ее потенциальных применений в контроле качества и безопасности, медицинской диагностике и телекоммуникациях. Однако его развитию тормозило отсутствие доступных компактных устройств. Квантово-каскадный лазер (ККЛ) является перспективным кандидатом для создания мощных твердотельных источников ТГц диапазона [1, 2]. До сих пор лучший ТГц ККЛ основан на GaAs, максимальная рабочая температура которого составляет около 200 К из-за низкой энергии LO-фононов (36 мэВ) GaAs [3,4]. С помощью магнитного поля эту температуру можно повысить до 225 К. Однако этот метод непригоден для широкого применения [5, 6]. Когда температура увеличивается, электроны в состоянии верхнего уровня могут приобретать достаточно тепловой энергии для активации безызлучательной релаксации посредством испускания LO-фононов в направлении состояния нижнего уровня, тем самым разрушая инверсию населенностей. По сравнению с GaAs, GaN имеет гораздо более высокую энергию LO-фононов (92 мэВ) и, таким образом, обеспечивает возможность создания ТГц ККЛ, работающего при комнатной температуре [7,8,9]. Кроме того, ККЛ на основе GaAs не могут работать в диапазоне частот 4,6–12 ТГц из-за их полосы Рестстралена, спектральной области, где материал полностью непрозрачен из-за поглощения оптическими фононами. Большая энергия оптических фононов в GaN открывает перспективы для квантовых каскадных устройств ТГц диапазона, которые могут работать в гораздо более широком спектральном диапазоне от 1 до 15 ТГц.
Первым этапом исследования GaN THz QCL была настройка межподзонного перехода (ISB) в дальнюю инфракрасную область. ISB-поглощение на ТГц частотах наблюдалось в полярных [10, 11] и неполярных квантовых ямах (КЯ) на основе нитридов [12,13,14,15,16,17]. Детекторы на основе GaN, работающие в ТГц диапазоне, были продемонстрированы на частотах 13 ТГц [18] и 10 ТГц [19] соответственно. Демонстрация электролюминесценции в этом диапазоне до сих пор не достигнута, за исключением некоторого противоречивого отчета группы Hirayama о спонтанной электролюминесценции от структуры QCL [20, 21]. Было опубликовано несколько теоретических исследований [7, 9, 22, 23, 24, 25, 26], среди них некоторые исследуют ограничивающие факторы характеристик ТГц ККЛ GaN, такие как уширение спектра усиления из-за очень сильного взаимодействия между электронами и LO-фононами в GaN [23].
В этой статье мы предлагаем завершить эти исследования путем анализа других факторов, которые могут повредить оптическое усиление ТГц GaN ККЛ, таких как шероховатость интерфейса квантовых ям, непреднамеренное легирование и беспорядок в сплаве. Было обнаружено, что влияние беспорядка сплава на оптическое усиление незначительно, а непреднамеренное легирование должно оставаться ниже разумной концентрации 10 17 см −3 для предотвращения деградации рассеяния электронов на примесях и поглощения свободных носителей [27]. Наконец, мы обнаружили, что рассеяние шероховатости границы раздела является доминирующим фактором ухудшения оптического усиления. И прирост 60 см −1 может быть получен при 300 К, что намного выше теоретических потерь в двойном металлическом волноводе, что показывает возможность изготовления GaN ТГц ККЛ при комнатной температуре.
Методы
Известно, что для создания устройств ТГц ККЛ на основе GaN необходимо выращивать толстые активные области с малой плотностью дислокаций. Эта задача является сложной из-за несоответствия решеток GaN и AlGaN [28]. Могут появиться и другие нежелательные факторы, связанные с эпитаксией:шероховатость границы раздела (IFR) в зависимости от условий роста, непреднамеренное легирование n-типа (nid), возникающее из-за включения примесей (в основном кислорода) во время роста, и беспорядок сплава (AD), возникающий с поверхности Ga. сегрегация и низкая подвижность адатома алюминия. Чтобы исследовать, как эти явления влияют на характеристики ТГц GaN ККЛ, мы используем формализм неравновесных функций Грина (NEGF). Расчеты выполнены с использованием программного обеспечения Nextnano QCL [29,30,31]. Эта модель включает релаксацию, вызванную шероховатостью интерфейса, ионизированными примесями, беспорядком сплава, LO-фононом, акустическим фононом или электрон-электронным взаимодействием. Мы использовали ККЛ с тремя квантовыми ямами со схемой депопуляции резонансных фононов, поскольку эта конструкция ТГц ККЛ обеспечивает самую высокую рабочую температуру до сих пор [3, 32]. На рис. 1а показана спроектированная структура активной области. Последовательность слоев для одной квантовой структуры AlGaN / квантовой структуры AlGaN составляет 1,6 /6.2/1.6 /3.4/1.0 /3,4 нм, где курсивом показана толщина барьеров. На рис. 1б показана диаграмма зоны проводимости разработанной структуры ККЛ при смещении –84,5 кВ / см. Из предыдущего периода справа электроны инжектировались посредством резонансного туннелирования в верхнем лазерном состоянии, обозначенном цифрой 1. Затем они претерпевают излучательный переход в нижнее лазерное состояние 2. Это нижнее лазерное состояние опустошается посредством туннелирования в состояние 3. Наконец, электроны релаксируют в состояние 4 за счет испускания LO-фононов. Процесс повторяется для каждого периода.
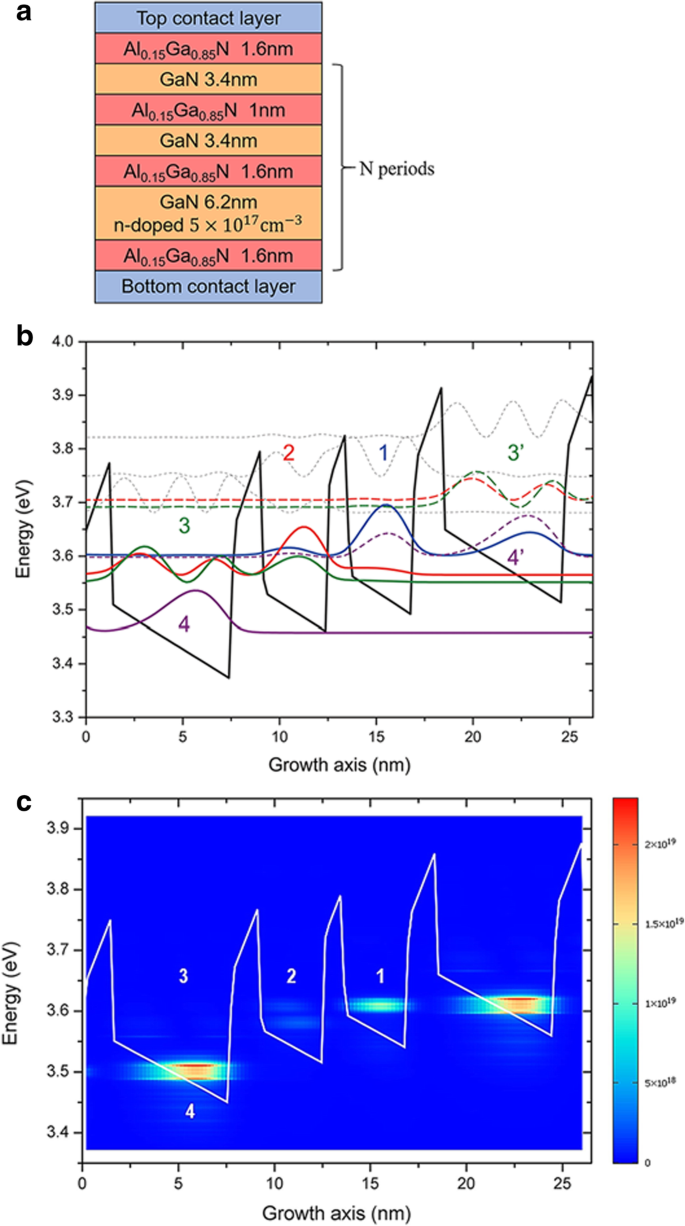
Разработана структура активной области, профиль зоны проводимости, квадраты функций огибающей и плотности носителей. а Последовательность слоев за один период составляет 1,6 /6.2/1.6 /3.4/1.0 /3,4 нм. Препятствия выделены курсивом. Яма толщиной 6,2 нм легирована n =5 × 10 17 см −3 . б Профиль зоны проводимости и квадрат огибающей GaN / Al 0,15 Ga 0,85 N QCL рассматривается в данном исследовании. Приложено электрическое поле - 84,5 кВ / см. c Плотности носителей и зона проводимости ККЛ, рассчитанные в модели NEGF. Приложенное электрическое поле - 84,5 кВ / см. Температура установлена на уровне 10 К.
В расчетах мы используем параметры, обычно встречающиеся в структуре GaN / AlGaN, выращенной с помощью плазменной молекулярно-лучевой эпитаксии (PAMBE):шероховатость интерфейса 0,25 нм [33] с корреляционной длиной 1 нм и непреднамеренно n- легирование с концентрацией носителей 10 17 см −3 . Рассеяние на беспорядке сплава также включено в моделирование.
Результаты и обсуждение
На рис. 1в показаны рассчитанные плотности носителей заряда этой структуры при рабочем смещении -84,5 кВ / см. Мы наблюдали антипересечение между предыдущим периодом и верхним состоянием генерации 1. Мы также видим, что нижнее состояние генерации 2 опустошается резонансным фононом в состояниях 3 и 4. Чтобы проанализировать и сравнить влияние IFR, nid, и AD, мы рассчитали характеристики оптического усиления и тока GaN THz QCL для нескольких конфигураций:эталонная конфигурация с учетом IFR, nid и AD, конфигурация без IFR, другая без nid и последняя без AD. На рисунке 2 показано максимальное оптическое усиление в зависимости от частоты (а) и плотности тока в зависимости от приложенного электрического поля (b) для каждой конфигурации, рассчитанной при температуре 10 К. Эталонная структура показывает максимальное усиление 142 см -1 на частоте 8,7 ТГц, недоступной для арсенидов. Давайте посмотрим, как n.i.d влияет на нашу производительность QCL. Без n.i.d максимальное усиление составляет 127 см −1 на 8,46 ТГц. Падение усиления происходит из-за того, что концентрация носителей уменьшается в верхнем состоянии генерации после удаления электронов, поступающих из н.у. Действительно, в эталонной конфигурации концентрация электронов верхнего и нижнего состояний генерации составляет ∆N = N 1 - N 2 =5,43 × 10 12 см −2 , а без n.i.d становится ∆N = N 1 - N 2 =5,06 × 10 12 см −2 . Приложенное электрическое поле смещается от -84,5 до -81,6 кВ / см. Пороговое значение тока падает и смещается с 25,11 кА / см 2 при - 84,49 кВ / см до 17,11 кА / см 2 при - 93,24 кВ / см. Падение плотности тока можно объяснить уменьшением рассеяния электронов на примесях, что увеличивает перенос электронов в расчетах без н.и.д. Еще одним намеком на эту гипотезу является пик при -64 кВ / см, который мы видим в случае без характеристик плотности тока n.i.d. Это межпериодный резонансный туннель между 4 ’и 3 (здесь не показан). Это явление скрывается рассеянием электронов на примесях на токовых характеристиках с учетом n.i.d. Пороговое значение тока и сдвиг приложенного электрического поля объясняются несовпадением зоны проводимости между конфигурациями с н.и.д. и без него. Интересно, что даже несмотря на то, что пик усиления больше в случае n.i.d, мы наблюдаем расширение спектра усиления, характерное влияние заряженных примесей [31] Непреднамеренное легирование должно оставаться на разумной концентрации 10 17 см −3 для предотвращения деградации рассеяния электронов на примесях и поглощения свободных носителей. В конфигурации без рассеяния AD максимальное усиление составляет 147 см −1 . на 8,7 ТГц. Мы наблюдаем, что пиковое усиление находится на той же частоте с рассеянием AD или без него. Оптическое усиление увеличивается только на 3%, если AD-рассеяние не учитывается в расчетах. Текущие характеристики также практически идентичны. Поскольку в нашей конструкции используется низкое содержание алюминия (15%) и довольно тонкие барьеры (1–1,5 нм), влияние AD-рассеяния в этом QCL незначительно.

Моделирование максимального оптического усиления в зависимости от частоты и моделирования электрического поля для различных процессов рассеяния. а Смоделированное оптическое усиление в зависимости от частоты с учетом различных процессов рассеяния. б Электрополевое моделирование GaN THz ККЛ с учетом различных параметров рассеяния. Температура установлена на уровне 10 К
Напротив, влияние рассеяния ППП на характеристики устройства очень важно. Без IFR-рассеяния мы наблюдаем максимальное усиление 191 см −1 . на 8,7 ТГц. Порог плотности тока 24,08 кА / см 2 . Это увеличение на 34% и падение порога плотности тока отражают тот факт, что большое количество электронов переносится посредством IFR-рассеяния. Чем больше ИСО-рассеяние, тем меньше радиационное рассеяние для генерации. При сравнении заселенности электронами эталонной конфигурации верхнего и нижнего состояний генерации ∆N = N 1 - N 2 =6,6 × 10 12 - 1,27 × 10 12 =5,43 × 10 12 см −2 к тому, без IFR ∆N = N 1 - N 2 =7,4 × 10 12 - 1,17 × 10 12 =6,23 × 10 12 см −2 , видно, что заселенность электронами верхнего состояния выше. Это связано с увеличением времени жизни верхнего состояния генерации из-за отсутствия ИСО-рассеяния. По сравнению со случаем без nid, в характеристиках плотности тока устройства без IFR-рассеяния мы наблюдаем пик при -67 кВ / см, характерный для межпериодного резонансного туннеля между 4 'и 3. Это явление более заметно. в случае без учета процесса рассеяния ИСО. Это доказательство его преобладания над резонансным туннелированием. Этими наблюдениями мы подчеркиваем преобладание влияния IFR-рассеяния на характеристики THz GaN QCL.
После того, как вы заметили важность рассеяния IFR для работы в ТГц диапазоне. Мы провели дальнейшее исследование, варьируя размер IFR. Мы добавили в наше исследование случай IFR =0,5 нм и 0,75 нм. Длина корреляции составляет 1 нм. На рисунке 3 мы показали максимальное усиление в зависимости от частоты (а) и плотности тока в зависимости от характеристик приложенного электрического поля (б). Во-первых, мы заметили, что для IFR =0,5 нм максимальное оптическое усиление уменьшается до 47,9 см −1 . и даже резко падает до - 8,8 см −1 потеря оптического усиления для IFR =0,75 нм. Также очевидно расширение коэффициента усиления в зависимости от длины IFR. Как мы видим на ВАХ, с увеличением размера ИСО увеличивается его роль в рассеянии электронов, увеличивая плотность тока и уменьшая процесс резонансного туннельного и радиационного рассеяния в устройствах. Этот эффект становится очевидным при сравнении эталонной конфигурации IFR =0,25 нм с крайним случаем IFR =0,75 нм, заселенность электронами верхнего и нижнего состояния генерации падает с ∆N =5,43 × 10 12 см −2 до ∆N = N 1 - N 2 =3,71 × 10 12 см −2 .
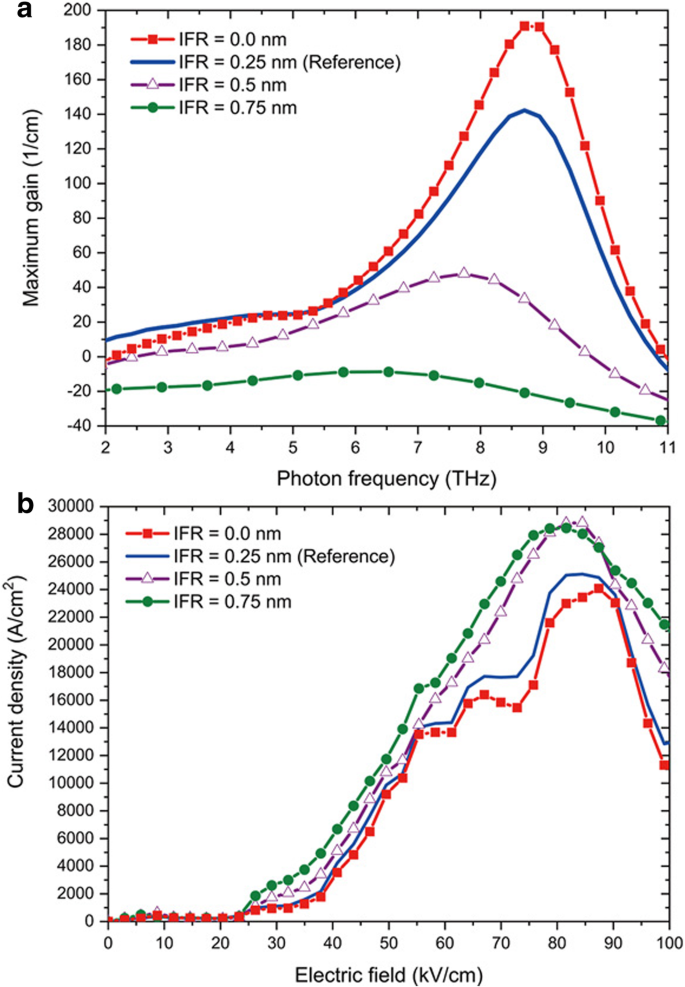
Моделирование максимального оптического усиления в зависимости от частоты и моделирования электрического поля для различных IFR. а Смоделировано максимальное оптическое усиление в зависимости от частоты для различных IFR. б Моделирование токового электрического поля GaN THz QCL с учетом различных IFR. Температура установлена на уровне 10 К
Последняя уменьшается до такой степени, что генерация в приборах перестает быть видимой. Как уже отмечалось в предыдущих исследованиях с использованием ТГц ККЛ на основе GaAs [25, 34,35,36], мы подчеркиваем важность учета размера ИСО во время эпитаксии и сохранения его меньше 0,5 нм для изготовления ТГц ККЛ на основе GaN, чтобы иметь возможность для обеспечения положительного оптического усиления.
Преимуществом ТГц ККЛ на GaN является его способность работать при более высоких температурах, чем ТГц ККЛ на основе GaAs. В этой части мы проанализировали производительность нашего устройства в зависимости от рабочей температуры. Мы продолжали использовать наши эталонные устройства с IFR =0,25 нм, н.и.д. и AD, включенными в расчет. На рис. 4 показано максимальное оптическое усиление для различных температур решетки. Значение усиления стабильно от 10 до 150 К на отметке 142 см −1 . , она начинает уменьшаться между 150 и 250 K, затем до 61 см −1 при 300 К. Действительно, с увеличением температуры инверсия населенностей уменьшается из-за теплового обратного заполнения, а увеличение LO-фононного рассеяния вызывает уширение коэффициента усиления. Это значение оптического усиления 61 см −1 все еще выше, чем потери в двойном металлическом волноводе GaN THz QCL (30 см −1 ), показывая, что эта конструкция GaN THz QCL должна работать при комнатной температуре. Мы также отмечаем, что помимо возможности работы при комнатной температуре, ТГц ККЛ на основе GaN имеет еще одно преимущество:из-за более высокой концентрации легирования, более низкого показателя преломления и более тонкой длины периода они могут обеспечить гораздо более высокое оптическое усиление, чем в ККЛ. их аналог из GaAs. Наша конструкция обеспечивает довольно высокое значение оптического усиления 142 см −1 . при 10 К, что является хорошим примером.
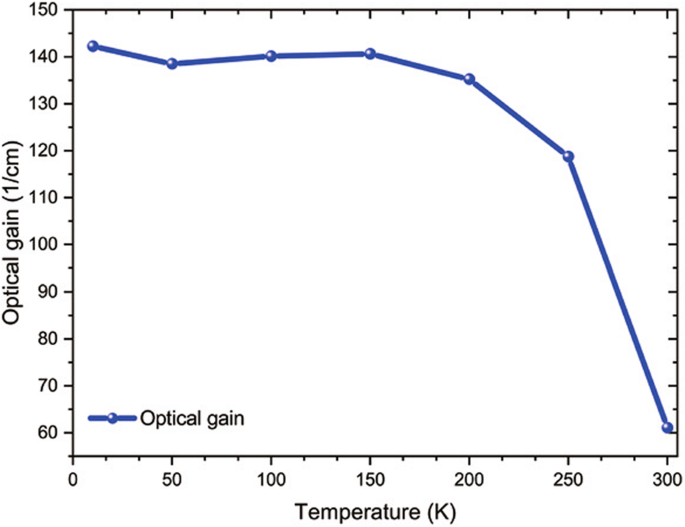
Характеристики рассчитанного максимального усиления в зависимости от температуры решетки
Выводы
В заключение мы сообщаем о конструкции GaN THz QCLs, работающей на частоте 8,7 THz. Моделирование показывает оптическое усиление 142 см −1 . при 10 К и 60 см −1 при комнатной температуре. Среди нежелательных явлений, возникающих в результате эпитаксии, мы вычислили влияние шероховатости интерфейса, непреднамеренного легирования и беспорядка сплава на характеристики усиления GaN THz QCL. Влияние беспорядка сплава незначительно:оптическое усиление падает всего со 147 до 142 см −1 . при добавлении рассеяния беспорядка сплава в моделирование. При проектировании следует учитывать непреднамеренное легирование, чтобы предотвратить смещение зоны проводимости. В нашем исследовании мы действительно наблюдали сдвиг приложенного электрического поля от -84,5 до -81,6 кВ / см, вызванный н.и.д. Наконец, мы наблюдали большое несоответствие в оптическом усилении для разных значений шероховатости границы раздела:191, 142, 47,9 и - 8,8 см −1 для шероховатости интерфейса равной 0, 0,25, 0,5 и 0,75 нм соответственно. Именно поэтому мы идентифицируем доминирующее влияние рассеяния шероховатости границы раздела на деградацию оптического усиления. Эта работа обеспечивает маршруты для оптимизации производительности будущего производства GaN THz QCL.
Доступность данных и материалов
Наборы данных, созданные во время и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- AD:
-
Беспорядок сплава
- IFR:
-
Шероховатость интерфейса
- ISB:
-
Межподполосный
- n.i.d:
-
Непреднамеренный допинг
- NEGF:
-
Неравновесные функции Грина
- QCL:
-
Квантово-каскадный лазер
Наноматериалы
- Влияние молибдена на характеристики нержавеющей стали
- Знакомство с терагерцовым диапазоном
- Характеристики стекловолокна
- Влияние воды на структуру и диэлектрические свойства микрокристаллической и наноцеллюлозы
- DFB квантовые каскадные лазеры с низким энергопотреблением, излучающие субстрат
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…
- Фотоэлектрические характеристики солнечного элемента с гибридной матрицей на основе нанопроводов и квантов…
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
- Понимание механизма роста эпитаксиальных слоев GaN на механически расслоенном графите
- Конические квантово-каскадные лазерные массивы, интегрированные с полостями Талбота



