Ge pMOSFET с пассивацией GeOx, образованной озоном и пост-окислением плазмы
Аннотация
Сравнительное исследование электрических характеристик Ge pMOSFET с GeO x пассивируется слой, образованный постокислением озоном (OPO) и постокислением плазмы (PPO). PPO и OPO проводились на Al 2 О 3 / n-Ge (001), за которым следует 5-нм HfO 2 диэлектрик затвора, нанесенный на месте в камеру ALD. Качество межфазного слоя диэлектрик / Ge охарактеризовано методами рентгеновской фотоэлектронной спектроскопии и просвечивающей электронной микроскопии. Обработка PPO приводит к положительному пороговому напряжению ( V TH ) сдвиг и нижний I ВКЛ / Я ВЫКЛ соотношение, подразумевающее низкое качество интерфейса. Ge pMOSFET с OPO демонстрируют более высокое значение I ВКЛ / Я ВЫКЛ соотношение (до четырех порядков), улучшенный подпороговый размах и улучшенные характеристики мобильности несущей по сравнению с устройствами PPO. Более толстый Al 2 О 3 блочный слой в процессе OPO приводит к более высокой мобильности в транзисторах Ge. Сравнивая два разных метода окисления, результаты показывают, что OPO является эффективным способом повышения качества интерфейсного слоя, что способствует повышению эффективной подвижности Ge pMOSFET.
Фон
С обычными комплементарными устройствами металл-оксид-полупроводник (CMOS), приближающимися к своему физическому пределу, трудно реализовать повышение производительности для высокоскоростных полупроводниковых устройств с кремнием (Si) в качестве материала канала. Замена материала подложки или канала другим материалом с высокой подвижностью является обязательным вариантом. Германий (Ge) рассматривался как многообещающий альтернативный материал канала из-за более высокой подвижности носителей, чем у Si. MOSFET обычно требует высококачественного интерфейса оксид / полупроводник для достижения высокой эффективной подвижности. Однако на протяжении довольно долгой истории полевые МОП-транзисторы Ge страдали от высокой плотности состояний интерфейса ( D это ) из-за плохой термостойкости GeO 2 и оборванные облигации [1]. Таким образом, было проведено множество исследований по пассивации интерфейса Ge.
Сообщалось о нескольких подходах к достижению высококачественного интерфейсного слоя Ge / диэлектрика, таких как пассивация Si путем равномерного нанесения нескольких монослоев Si на подложку Ge перед диэлектрической эпитаксией или самопассивация путем образования GeO 2 специально [2, 3]. Для формирования качественного GeO 2 слоя, существует множество процессов окисления для уменьшения D это и улучшить термическую стабильность, включая окисление под высоким давлением [4], окисление озоном [5], H 2 O плазма [6], и плазма после электронного циклотронного резонанса (ЭЦР) после окисления [7].
В последние годы было опубликовано множество работ о том, что высокопроизводительный полевой МОП-транзистор на основе Ge может быть реализован путем постокисления через Al 2 О 3 / Ge интерфейс. В 2014 году был реализован КМОП-инвертор Ge на подложке Ge-on-insulator (GeOI) с GeO x выращены путем быстрого термического отжига в среде чистого кислорода после 1 нм Al 2 О 3 был нанесен на Ge [8]. В исх. [7], Ge pMOSFET и nMOSFET с GeO x пассивация производилась с кислородно-плазменным постокислением и температурной зависимостью GeO x также обсуждались толщина и электрические характеристики. Термическое окисление Ge озоном можно проводить при более низкой температуре, поскольку озон более активен, чем кислород [5]. Влияние температуры на GeO x была продемонстрирована толщина, выращенная озоном на поверхности Ge. Ge pMOSFET с GeO x Также сообщалось о пассивации, производимой постокислением озоном [9].
В этой работе Ge pMOSFET с GeO x пассивация производится с использованием постокисления озоном (OPO) и постокисления кислородной плазмой (PPO) Al 2 О 3 / n-Ge интерфейс. Проведено сравнительное исследование электрических характеристик Ge pMOSFET с OPO и PPO. Все процессы, кроме пассивации, точно контролируются, чтобы быть одинаковыми. Последующее окисление проводили после Al 2 О 3 осаждение блочного слоя, которое отличается от [9], в котором постокисление проводилось после HfO 2 осаждение. Механизм дегенерации подвижности кулоновского рассеяние на шероховатостях. Влияние толщины Al 2 О 3 также обсуждается блочный уровень производительности устройства. В целом, мы демонстрируем, что OPO является многообещающим методом пассивации для будущего производства полевых МОП-транзисторов на основе Ge.
Методы
Ge pMOSFET были изготовлены на 4-дюймовом корпусе. Пластины n-Ge (001) с удельным сопротивлением 0,14–0,183 Ом · см. Были выполнены три различных процесса пассивации, и основные этапы процесса показаны на рис. 1а. Пластины очищали разбавленной HF (1:50) и деионизированной водой в течение нескольких циклов для удаления естественного оксида, а затем немедленно переносили в камеру PEALD (Picosun R200 Advanced) для осаждения атомных слоев. Затем тонкий Al 2 О 3 Пленка (~ 1 нм) была нанесена при 300 ° C с использованием триметилалюминия (ТМА) и деионизированной воды (H 2 O) как предшественники Al и O соответственно. Поскольку Аль 2 О 3 / GeO 2 слой слишком тонкий, чтобы иметь точное соотношение атомов кислорода, мы пометили эти два слоя как AlO x / GeO x . PPO проводился удаленным источником плазмы Litmas в течение 60 с. Для обработки OPO в 50% O 3 использовался генератор озона (генераторы озона серии AC IN USA) с входным потоком кислорода 750 sccm. / O 2 окружающий. Без нарушения вакуума, 60-тактный HfO 2 затем был нанесен на верхнюю часть AlO x / GeO x после обработки PPO или OPO при 300 ° C с использованием тетракисдиметиламиногафния (TDMAHf) и H 2 O как предшественники Hf и O соответственно. Затем методом реактивного распыления наносили TaN с длиной волны 100 нм в качестве затворного металла. После формирования затвора и травления, самовыравнивающийся BF 2+ имплантация в области истока / стока (S / D) с энергией 20 кэВ и дозой 1 × 10 15 см - 2 было проведено. Металл Ni S / D с толщиной 20 нм был нанесен и структурирован с помощью процесса отслаивания. Наконец, был проведен быстрый термический отжиг при 450 ° C в течение 30 с для активации легирующей примеси и омического контакта S / D. Схематические и микроскопические изображения изготовленных Ge pMOSFET показаны на рис. 1b и c соответственно.
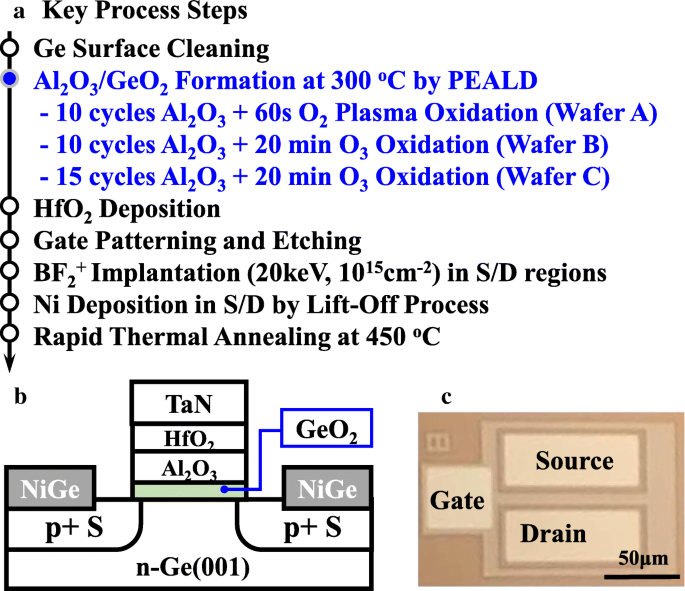
а Ключевой технологический процесс изготовления Ge pMOSFET с GeO 2 пассивация поверхности с помощью трех различных методов пассивации. б Схема и c микроскопические изображения изготовленного Ge-транзистора
Сечение TaN / HfO 2 / AlO x / GeO x Стек затворов / Ge был изображен с помощью просвечивающего электронного микроскопа (ТЕМ) для сравнения воздействия кислородной плазмы или озона на GeO x формирование. На рис. 2а и б показаны ПЭМ-изображения поперечного сечения TaN / HfO 2 . / AlO x / GeO x Стек затворов / Ge с PPO и OPO соответственно. Толщина аморфного HfO 2 слой в обоих устройствах составляет 6 нм. Пластина A с обработкой PPO 60 секунд имеет отчетливый AlO x / GeO x слой между HfO 2 и подложки Ge. Это AlO x / GeO x слой в пластине B, сформированный 20-минутным OPO, имеет неаккуратный край. Толщина GeO x слой соответствует данным [10].
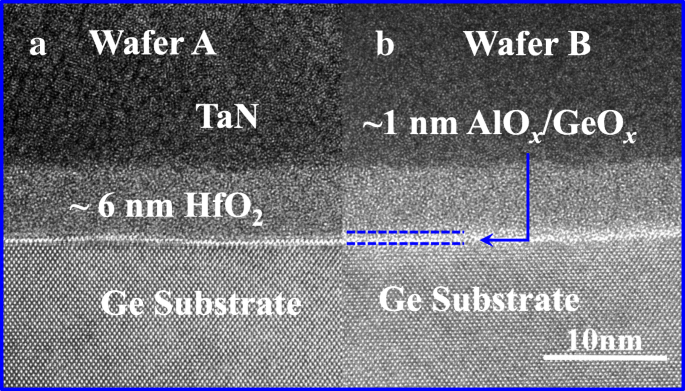
ПЭМ-изображения поперечного сечения стека затворов high-k / metal с AlO x / GeO x межфазный слой (ИС), изготовленный а OPO и b PPO на канале n-Ge (001)
Результаты и обсуждение
Выходные и передаточные характеристики в сочетании с высокочастотным емкостным напряжением затвор-исток (CV) были измерены Keithley 4200-SCS. На рисунке 3 показано сравнение передаточной и выходной характеристик Ge pMOSFET при трех различных условиях формирования AlO x / GeO x слой пассивации. Все устройства на разных пластинах имеют длину затвора ( L G ) 3 мкм. Устройства на пластине A демонстрируют более высокий ток насыщения стока ( I DS ) по сравнению с двумя другими пластинами. Но пластины B и C с OPO показывают гораздо более низкий ток в выключенном состоянии ( I ВЫКЛ ) по сравнению с пластиной A с PPO. Также видно, что пластины B и C с OPO работали в режиме улучшения, а пластина A работала в режиме истощения. Предполагается, что после обработки PPO поверхность n-Ge все еще остается p-типа из-за высокого D это значение, которое обсуждалось в [11]. Пластина C с более толстым Al 2 О 3 блочный слой показывает положительное значение V TH сдвиг по сравнению с пластиной B и более высоким D это чем пластина B. Из выходных характеристик, показанных на рис. 3b, видно, что при низком напряжении затвора ( V GS ) пластина A имеет нижний I DS по пластинам B и C из-за менее крутого подпорогового колебания (SS). Когда V GS увеличивается, I DS пластины A становится выше по сравнению с двумя другими устройствами. Следовательно, из рис. 3 и изображений ПЭМ на рис. 2 видно, что диффузия AlO x / GeO x слой может подавлять I ВЫКЛ , что приводит к улучшению эффектов пассивации.
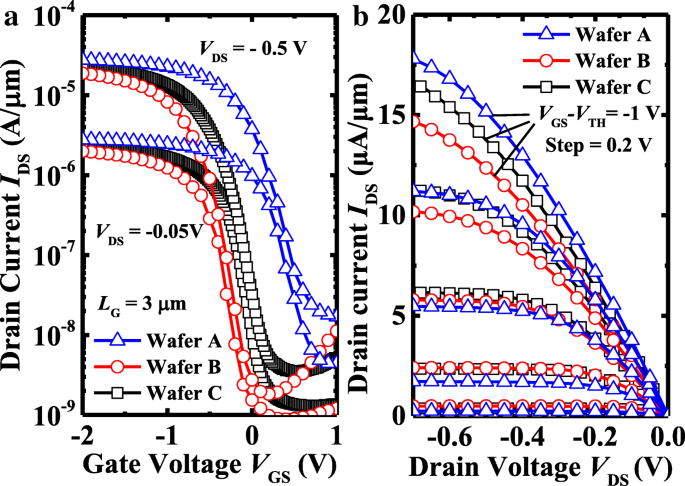
а Я DS –V GS и b Я DS –V DS характеристики Ge pMOSFET с Al 2 О 3 / GeO 2 слой пассивирования, изготовленный из PPO (пластина A) и OPO (пластины B и C)
На рисунке 4 представлены статистические результаты исследования I ВКЛ / Я ВЫКЛ соотношение и подпороговые колебания устройств на разных пластинах. Ge pMOSFET с OPO демонстрируют более высокое значение I ВКЛ / Я ВЫКЛ соотношение (~ 4 порядка) и заметно улучшенное SS по сравнению с устройством PPO, что указывает на более высокое качество интерфейса диэлектрик / канал. По сравнению с пластиной B пластина C показывает более высокий ток в открытом состоянии ( I ВКЛ ) но более низкий I ВКЛ / Я ВЫКЛ соотношение.
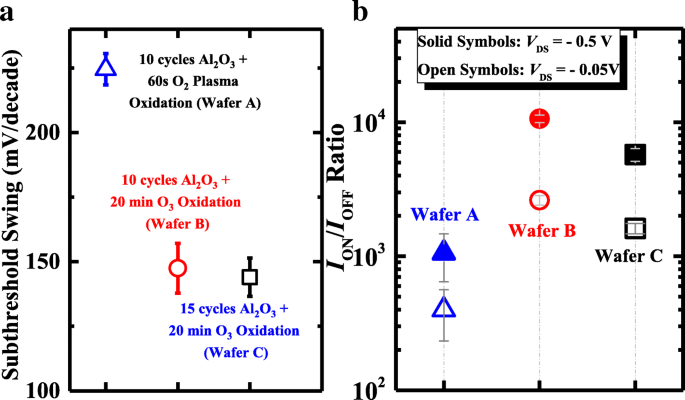
Статистические графики a СС и б Я ВКЛ / Я ВЫКЛ соотношение для Ge pMOSFET с различными условиями пассивации
Чтобы дополнительно представить качество межфазного слоя различных методов постокисления, пластины A, B и C (фиктивные образцы без HfO 2 и металлы затвора) были протестированы с помощью рентгеновской фотоэлектронной спектроскопии (XPS). Измерение XPS проводилось на трех образцах макета после окисления после обработки PPO или OPO без HfO 2 осаждение и распыление TaN. Стехиометрия GeO x в А1 2 О 3 Образцы / GeO / Ge исследовались с помощью источника монохроматического мягкого рентгеновского излучения Al Kα (1486,6 эВ). Ge 3 d пики и анализ дифференциации пиков показаны на рис. 5. Ge 3 d 5/2 пик трех образцов объединен при 29,7 эВ, а химические сдвиги Ge 3 d 3/2 , Ge 1+ , Ge 2+ , Ge 3+ , и Ge 4+ к Ge 3 d 5/2 установлены на 0,6, 0,8, 1,8, 2,75 и 3,4 эВ соответственно [12]. На рис. 5b пластина A показывает, что после PPO 60 секунд основная валентность Ge в GeO x Ge 1+ и Ge 3+ . Аналогичное распределение состояний Ge наблюдается в пластине C и Ge 3+ составляющая немного увеличена. На рис. 5b пластина B показывает, что устройство OPO с более тонким (10 циклов) Al 2 О 3 будет дополнительно окислять Ge 1+ в Ge 2+ , Ge 3+ , и Ge 4+ , а Ge 1+ значительно сокращается.
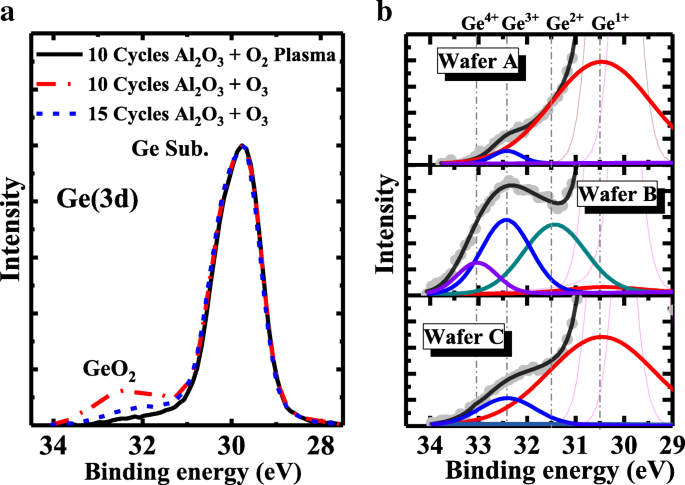
а Ge 3 d XPS-спектры Al 2 О 3 / GeO x / Ge образуется в разных условиях. б Пиковые фитинги Ge 3 d XPS-спектры от GeO 2 слой для трех образцов
ВАХ затвор-исток показаны на рис. 6. Из ВАХ 1 МГц, D это около середины промежутка оценивается Терманом метод [13], и значение эквивалентной толщины оксида (EOT) также оценивается, как указано в таблице 1. Двадцатиминутный OPO (пластины B и C) приводит к более высокому EOT по сравнению с PPO (пластина A). Пластина C демонстрирует более высокий EOT, чем пластина B, из-за более толстого Al 2 О 3 как блокирующий слой. Сообщалось, что толщина GeO x на голой поверхности Ge в O 3 окружающая среда достигает насыщения за несколько минут, а толщина насыщения определяется температурой, а не временем окисления [10]. Итак, в этой статье толщина GeO x озоном после окисления насыщается через несколько минут, а оставшееся время окисления предназначено только для отжига.
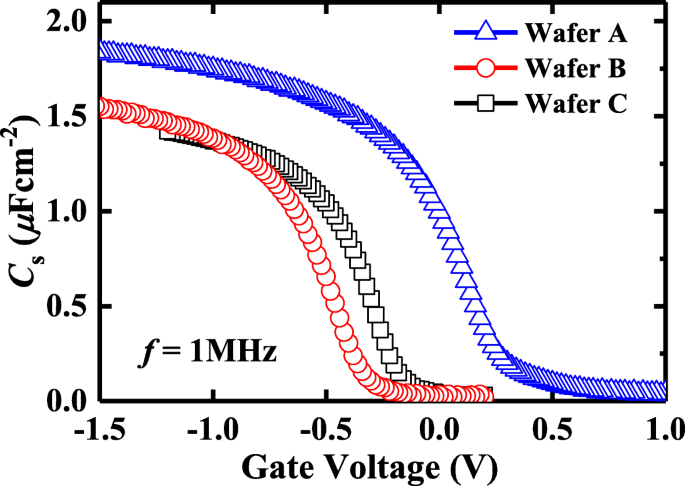
Емкость затвор-исток в зависимости от В GS характеристики Ge pMOSFET, пассивированных PPO (пластины A) и OPO (пластины B и C)
На рисунке 7 показано полное сопротивление ( R T ) по сравнению с L G каждого устройства в этой работе. Здесь R T определяется как V DS / Я DS в V DS =0,05 В и В GS - V TH =1 В. Последовательное сопротивление истока / стока (S / D) ( R SD ) и сопротивления канала ( R CH ) можно извлечь из точки пересечения и наклона линейной аппроксимации R T - L G линий, как показано на рис. 7. Извлеченные R SD и R CH результаты приведены в таблице 1. На рис. 7 показано, что полевые МОП-транзисторы Ge с PPO имеют более низкое значение R SD и R CH что согласуется с результатами измерения емкости, показанными на рис. 6.
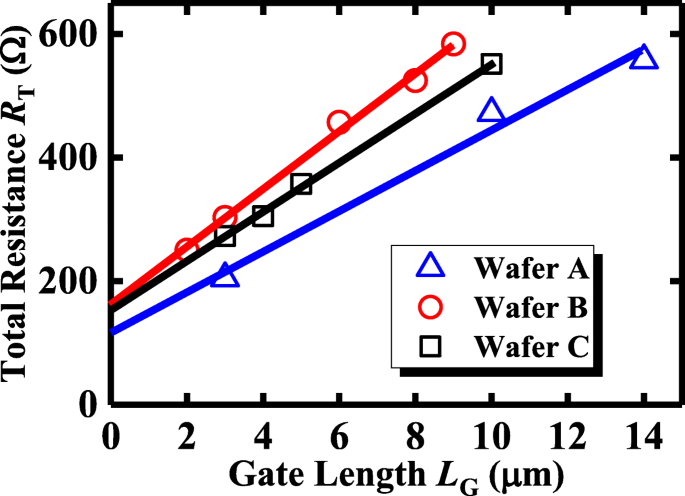
Общее сопротивление ( R T ) от длины ворот ( L G ) полевых МОП-транзисторов Ge
Эффективная подвижность дырок μ eff был извлечен на основе подхода, основанного на наклоне полного сопротивления. На рис. 8 мы сравниваем μ eff наших Ge pMOSFET с обработкой PPO и OPO с таковыми из других известных Ge pMOSFET [9, 14]. Q inv - инверсионная плотность заряда в канале устройства. Ge pMOSFET с OPO демонстрирует более высокий пик μ eff по сравнению с аппаратами с ППО. Пластина C с более толстым Al 2 О 3 блочный слой имеет более высокую пиковую подвижность дырок - 283 см 2 / V s по сравнению с пластиной B с более тонким Al 2 О 3 . Пластина A с PPO демонстрирует более низкое высокополевое отверстие μ eff с приборами с ПГС, что связано с меньшим рассеянием шероховатости. Но при низком поле транзисторы на пластине A с PPO достигают более низкого μ eff чем устройства OPO из-за более высокого кулоновского рассеяния [15]. Сообщается лишь о нескольких работах о Ge pMOSFET, изготовленных путем озоновой пассивации. Здесь проводится сравнение производительности ключевых устройств между нашими устройствами и зарегистрированными Ge pMOSFET, обработанными OPO [9, 14], и результаты показаны в таблице 2. Сделан вывод, что пластина C в этой работе достигает высоких значений. -поле μ eff улучшение и выше I ВКЛ / Я ВЫКЛ по сравнению с описанным устройством, обработанным ОПО. Кроме того, на Q inv из 5 × 10 12 см - 2 , пластина C демонстрирует в 2,37 раза больше μ eff по сравнению с Si универсальная мобильность. Я ВКЛ пластины C несколько ниже, чем в [5]. [9], что связано с большим EOT.
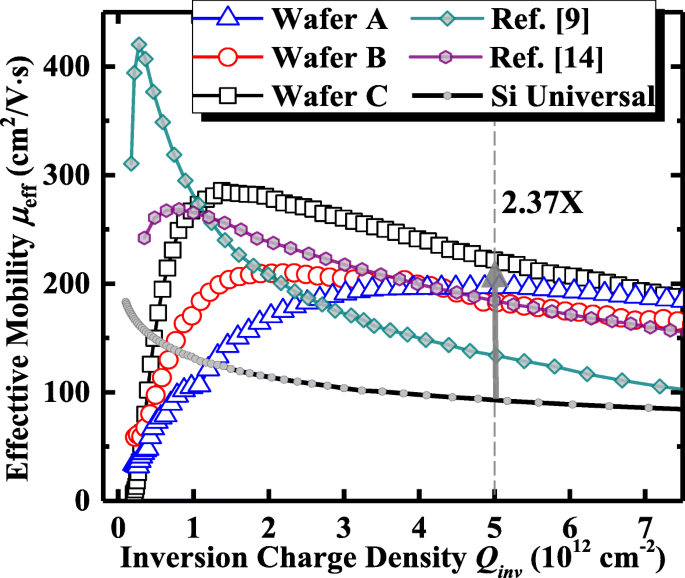
μ eff против Q inv Ge pMOSFET с различными условиями пассивации. Транзисторы Ge с 15 циклами Al 2 О 3 + 20 мин. O 3 окисление (пластина C) показывает пик μ eff 283 см 2 /Против. Влияние сопротивления S / D на μ eff извлечение было удалено методом извлечения эффективной подвижности канала на основе наклона полного сопротивления [16]
Выводы
Ge pMOSFET реализованы с использованием GeO x пассивация, которая образуется обработкой Al 2 OPO или PPO О 3 / n-Ge в PEALD. Устройства OPO демонстрируют лучшие передаточные и выходные характеристики, чем выше I ВКЛ / Я ВЫКЛ соотношение, улучшенное подпороговое колебание и более высокий пик μ eff по сравнению с приборами PPO. Для 15-тактного процесса OPO более толстый Al 2 О 3 слой приводит к более высокому значению EOT и улучшенному μ eff в устройствах по сравнению с 10-тактным случаем. Все результаты в этой работе показывают, что OPO является эффективным способом пассивации для достижения высококачественной границы раздела Ge / диэлектрик и, таким образом, может быть многообещающим кандидатом в метод пассивации для будущего изготовления полевых МОП-транзисторов на основе Ge.
Сокращения
- Al 2 О 3 :
-
Оксид алюминия
- ALD:
-
Осаждение атомного слоя
- BF 2 + :
-
Ион фторида бора
- EOT:
-
Эквивалентная толщина оксида
- Ge:
-
Германий
- GeO x :
-
Оксид германия
- HF:
-
Плавиковая кислота
- HfO 2 :
-
Диоксид гафния
- ТЕМ:
-
Просвечивающий электронный микроскоп
- МОП-транзисторы:
-
Полевые транзисторы металл-оксид-полупроводник
- OPO:
-
Последующее окисление озона
- PPO:
-
Пост оксидирование в плазме
- Q inv :
-
Плотность инверсионного заряда
- SS:
-
Подпороговое колебание
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- μ eff :
-
Эффективная подвижность ствола
Наноматериалы
- Создание роботов с Raspberry Pi и Python
- Настойчивость и настойчивость в руководстве
- Датчик Portenta и термопары (с MAX6675)
- Класс C++ и объект с примером
- Умный наноматериал и нанокомпозит с продвинутой агрохимической активностью
- Настройка химического состава поверхности полиэфирэфиркетона с помощью золотого покрытия и плазменной обра…
- Снижение контактного сопротивления между металлом и n-Ge за счет введения ZnO при обработке аргоновой плазмой
- Ge pMOSFET с высокой подвижностью и пассивированием аморфным Si:влияние ориентации поверхности
- Что такое плазменная резка и как работает плазменная резка?
- Node-RED и начало работы с Docker



