Высокопроизводительные прямоугольные полевые транзисторы с U-каналом с затвором и только 2-нм расстоянием между контактами истока и стока
Аннотация
В этой статье предлагается новый высокопроизводительный U-канальный полевой транзистор с прямоугольным затвором (RGUC FET) для экстремального интегрированного расстояния между контактами истока и стока. Полевой транзистор RGUC обеспечивает почти идеальные подпороговые характеристики до тех пор, пока расстояние между контактами исток / сток (S / D) не уменьшится до 2 нм. В отличие от других полевых транзисторов с углублением или U-образного канала, контакты затвора не нужно формировать в углубленной области, а только в слое прокладки для изоляции между двумя вертикальными частями по обе стороны от U-образного канала. Его конструктивные преимущества позволяют применять его для изготовления интегральных схем с более высокой степенью интеграции для экстремального интегрированного расстояния между контактами истока и стока. Электрические свойства полевого транзистора RGUC были тщательно исследованы путем изучения влияния конструктивных параметров, включая горизонтальное расстояние между S / D-контактами, высоту расширения S / D-области, а также толщину и материал оксидного слоя затвора. Электрические свойства полевого транзистора RGUC подтверждены квантовым моделированием. По сравнению с другими многозатворными полевыми транзисторами, не предназначенными для планирования каналов, новый полевой транзистор RGUC подходит для более высокой интеграции.
Введение
В качестве одного из наиболее многообещающих устройств, используемых в наноразмерных интегральных схемах (ИС), полевой транзистор без перехода (JL FET), который обладает замечательными электрическими характеристиками по сравнению с традиционными полевыми транзисторами на основе металлооксидных полупроводников (MOS), в дополнение к его простота изготовления была глубоко изучена в последние годы [1,2,3,4]. В то время как увеличение напряжения затвора формирует область накопления в канале, что приводит к увеличению тока [5], введение полевого транзистора с несколькими затворами (MG) усилило управляемость током исток-сток от напряжения затвора, в результате к гораздо лучшим подпороговым свойствам устройства. Беспереходные полевые транзисторы с несколькими затворами (JL MG) также широко изучаются в течение многих лет [6,7,8]. Хотя полевой МОП-транзистор с вертикальным каналом и затвором показывает почти идеальный I - V производительность с радиусом всего несколько нанометров, его вертикальный канал делает контакт истока и стока не может быть изготовлен в одном слое, что делает компоновку ИС несовместимой с технологией планировщика. Более того, поскольку производство полупроводников было вынуждено уменьшить длину канала до менее 10 нм, полевые транзисторы MG снова столкнулись с эффектом короткого канала [9,10,11]. Чтобы преодолеть эффект короткого канала, полевые МОП-транзисторы с утопленным каналом стали горячей темой в последние годы [12,13,14,15,16]. Работа по моделированию и моделированию полевых МОП-транзисторов с утопленным каналом также проводится всесторонне [17,18,19,20]. Полевой МОП-транзистор с утопленным каналом имеет как планировочные части вертикального канала под контактами истока и стока, так и горизонтальную плоскую часть канала. Фактически это увеличило эффективную длину канала по сравнению с обычными полевыми МОП-транзисторами, имеющими только горизонтальный планарный канал. Для устройства с одинаковым расстоянием между контактами истока и стока оно может быть более невосприимчивым к эффекту короткого канала по сравнению с обычными полевыми МОП-транзисторами с плоским каналом; однако экспериментальные данные показывают, что подпороговое колебание полевых МОП-транзисторов с каналом углубления не может реализовать идеальное подпороговое колебание с эффективной длиной канала менее 100 нм. Это потому, что, хотя длина канала увеличивается, управляемость затвора не усиливается, как у полевых транзисторов MG. Следует отметить, что вместо длины канала лучше определять новый ключевой геометрический параметр, связанный с описанием интегрирования. Расстояние между контактами истока и стока является более реалистичным и эффективным, поскольку конечной целью конструкции устройства наномасштаба является реализация наилучших характеристик в ограниченной заданной площади кристалла, а фактический размер устройства зависит от ширины канала. и расстояние между контактами истока и стока. Чтобы объединить преимущества полевых транзисторов MG и полевых МОП-транзисторов с утопленным каналом, в нашей предыдущей работе мы предложили седлообразные полевые транзисторы с затвором и U-образным каналом [21,22,23], что обеспечивает управляемость затвором в горизонтальном направлении. канальная часть утопленного канала от плоского одностворчатого типа к трехмерному трехзатворному. После этого мы модернизируем эту трехмерную функцию тройного затвора, сформированную не только в части горизонтального канала, но также и в обеих частях вертикального канала. Это устройство называется полевыми транзисторами с U-образным каналом с H-образным затвором, и утопленный канал, соответственно, модернизирован до 3-D U-образного трубчатого канала [24]. Как упоминалось выше, конечной целью разработки устройства в наномасштабе является достижение наилучшей производительности в ограниченной области кристалла за счет оптимизации. Чтобы реализовать оптимизированное высокопроизводительное устройство, необходимо хорошо продумать и спроектировать как структуру затвора, так и соответствующую структуру канала. Также следует учитывать сложность изготовления. Упомянутые выше устройства, такие как устройство с утопленным каналом, ранее предложенные седловые полевые транзисторы и полевые транзисторы HGUC, имеют общую основу, многослойная структура из оксида затвора / затвора / оксида затвора должна быть хорошо сформирована в небольшой углубленной области. Эта структурная особенность ограничивает дальнейшее продвижение интеграции. Кажется, что хороший способ способствовать интеграции - это упростить конструктивную функцию в углубленной области и одновременно сохранить возможность управления затвором для вертикальной и горизонтальной части U-образного канала. Чтобы реализовать эти особенности и функции устройства, в этой статье мы предложили новый полевой транзистор с U-каналом с прямоугольным затвором (RGUC FET) для экстремального интегрированного расстояния между контактами истока и стока. Он имеет U-образный канал, который может увеличить длину канала эффекта без увеличения расстояния между контактами истока и стока. По сравнению с другими полевыми транзисторами с U-образным каналом, полевой транзистор RGUC имеет более простую внутреннюю структуру в углубленной области U-образного канала; после этого можно реализовать более простое изготовление во внутренней части углубленной области и меньшее расстояние между контактами истока и стока (более высокая степень интеграции). Предлагаемая структура имеет лучшую управляемость затвором и меньший ток обратной утечки, сопровождаемый более высоким значением I . ВКЛ / Я ВЫКЛ соотношение. Расстояние между контактом истока и стоком можно уменьшить до менее 2 нм. Все электрические свойства анализируются с помощью квантового моделирования.
Методы
На рис. 1а представлен схематический трехмерный вид полевого транзистора RGUC, а на рис. 1b – d показаны профили устройства в плоскостях A, B, C и D, показанных на рис. 1a. Вт ширина тела кремния, t b толщина кремния, h в - внутренняя высота прокладки в углублении, h бывший высота области истока / стока расширения, t бык - толщина оксида затвора вокруг тела кремния, а t sp - толщина прокладки изоляционного слоя, нанесенного в углубленную область U-образного канала, которая равна расстоянию между контактом истока и контактом стока.
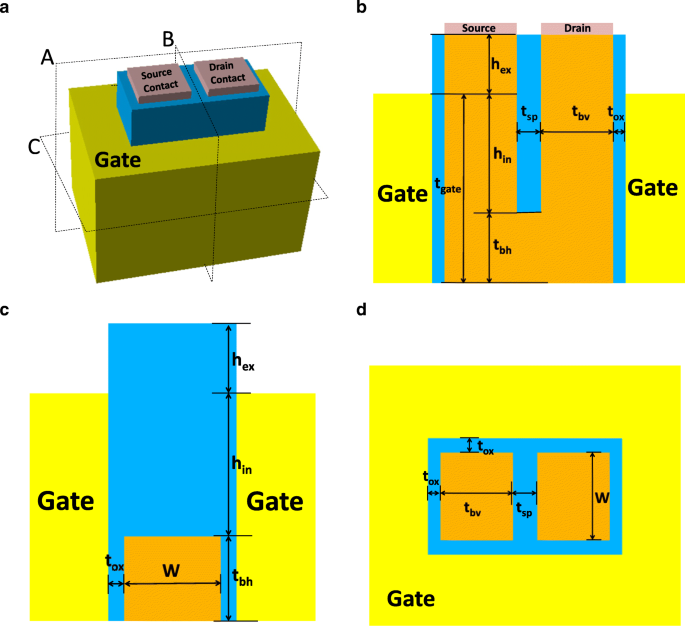
а Трехмерное схематическое изображение полевого транзистора RGUC. б Профили устройства прорезаны плоскостью А а . c Профили устройства прорезаны плоскостью B a . г Профили устройства прорезают плоскость C a
Поскольку толщина кремниевого тела меньше 6 нм, в этой статье вводится квантовое моделирование вместо классического моделирования для получения более точных результатов моделирования. Все симуляции выполняются с использованием TCAD моделирования устройства SILVACO Atlas 3D, с использованием модели подвижности, зависящей от концентрации, модели Шокли-Рида-Холла, зависящей от концентрации, модели рекомбинации Оже, модели сужения запрещенной зоны, стандартной модели межзонного туннелирования и Модель квантового потенциала Бома [25]. Параметры моделирования перечислены в таблице 1. Две вертикальные части тела на самом деле представляют собой кубы с четырьмя сторонами, верхние поверхности которых покрыты областью истока или стока, а нижняя поверхность соединена с горизонтальной частью тела. Внешние тройные стороны вертикальных частей корпуса окружены оксидом затвора и прямоугольным контактом затвора, а другая внутренняя сторона соединена с внутренней прокладкой в углубленной области. Все четыре стороны горизонтального корпуса окружены оксидом затвора и прямоугольным контактом затвора. Можно предположить, что прямоугольный затвор имеет сильную способность управления полевым эффектом как для горизонтального корпуса, так и для двух вертикальных частей из-за особенностей конструкции, упомянутых выше. И внутренняя прокладка фактически увеличила расстояние кратчайшего пути между контактами истока и стока в кремнии, что могло бы устранить эффект короткого канала, которого нельзя избежать для устройств с несколькими затворами с функциями плоского канала. По сравнению с другими устройствами с трехмерным каналом [21,22,23,24], предлагаемая структура не требует формирования затвора в углубленной области, что в значительной степени снижает сложность внутренней структуры углубленной области.
Результаты и обсуждения
Модель квантового потенциала Бома (BQP) вычисляет зависящий от положения член потенциальной энергии с использованием вспомогательного уравнения, полученного из интерпретации Бома квантовой механики. Эта модель основана на чистой физике и позволяет модели аппроксимировать квантовое поведение различных классов устройств, а также ряда материалов. Влияние квантового ограничения на производительность устройства, включая I - V характеристики, затем будут рассчитаны с хорошим приближением. Предыдущие исследования показали, что ток утечки затвора незначителен для случаев, когда толщина оксида превышает 0,5 нм [7, 26].
На рисунке 2a показано сравнение напряжения затвор-исток тока сток-исток ( I DS - V GS ) характеристики полевого транзистора RGUC с разными h в s как в логарифмической, так и в линейной шкале. На рисунке 2b показано сравнение подпороговых колебаний (SS) и I . ВКЛ / Я ВЫКЛ соотношение RGUC FET с разными h в с. При увеличении h в , вертикальный путь всего канала от истока к стоку непрерывно увеличивается, затем минимальная эффективная длина канала постепенно увеличивается, а эффект короткого канала постепенно ослабевает и, наконец, устраняется. SS может обеспечить почти идеальное значение 65 мВ / дек для h в достигает 10 нм. Я ВКЛ / Я ВЫКЛ соотношение также увеличивается примерно в 35 раз для h в увеличивается с 2 до 10 нм за счет непрерывного уменьшения SS. Продленный h в увеличивает расстояние кратчайшего пути от истока до стока с 6 до 22 нм, что равно 2 h в + t sp и эквивалентна эффективной длине канала предлагаемой конструкции. На рис. 2c и d показано двумерное распределение концентрации электронов в кремниевом корпусе в выключенном состоянии для устройства с 2 нм и 10 нм h в , соответственно. Для случая 2 нм максимальная концентрация электронов в горизонтальной части тела составляет около 10 12 см −3 и расстояние между контактом истока / стока и горизонтальной областью тела очень короткое. После этого смещение истока / стока серьезно влияет на распределение электронов в горизонтальной области тела; Решение состоит в том, чтобы удлинить вертикальный канал, который удерживает исток / сток от горизонтальной части тела. Для случая 10 нм на рис. 2d видно, что максимальная концентрация электронов в горизонтальной области тела уменьшена до 10 9 . см −3 , и это делает более идеальной полностью обедненную область для выключенного состояния, что обеспечивает гораздо более низкий уровень тока утечки.

а Сравнения I DS - V GS характеристики полевого транзистора RGUC с разными h в s как в логарифмической, так и в линейной шкале. б Сравнение подпороговых колебаний (SS) и I ВКЛ / Я ВЫКЛ соотношение RGUC FET с разными h в с. c Двухмерное распределение концентрации электронов в кремниевом теле в выключенном состоянии для устройства с 2 нм h в . г Двумерное распределение концентрации электронов в кремниевом теле в выключенном состоянии для устройства с 10 нм h в
На рисунке 3a показано сравнение I DS - V GS характеристики полевого транзистора RGUC при разных t sp s как в логарифмической, так и в линейной шкале. На рисунке 3b показано сравнение подпороговых колебаний (SS) и I . ВКЛ / Я ВЫКЛ соотношение RGUC FET с разными t sp с. При уменьшении t sp , расстояние между контактами истока и стока также постоянно уменьшается. Ток утечки в основном вызывается межзонным туннельным током. Вероятность туннелирования пропорциональна изгибу зон, который может быть эквивалентен напряженности электрического поля в определенной точке. Полный туннельный ток - это сумма туннельного тока, генерируемого в каждой точке области тела.
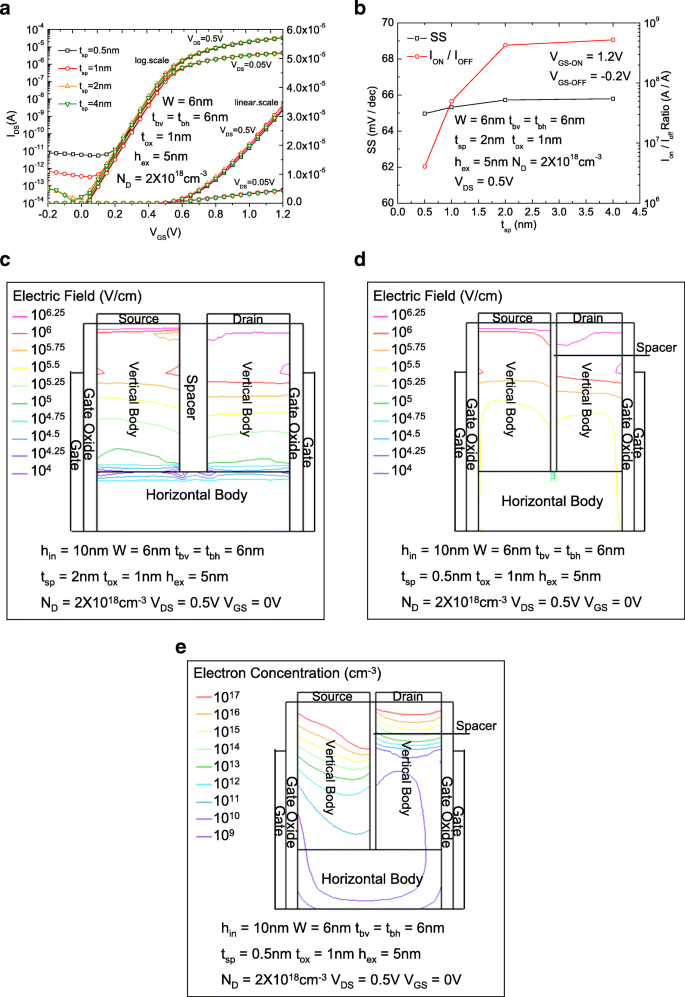
а Сравнения I DS - V GS характеристики полевого транзистора RGUC при разных t sp s как в логарифмической, так и в линейной шкале. б Сравнение подпороговых колебаний (SS) и I ВКЛ / I ВЫКЛ соотношение RGUC FET с разными t sp с. c Двухмерное распределение электрического поля в кремниевом корпусе в выключенном состоянии для устройства с 2 нм t sp . г Двухмерное распределение электрического поля в кремниевом корпусе в выключенном состоянии для устройства с 0,5 нм t sp . е Двумерное распределение концентрации электронов в кремниевом теле в выключенном состоянии для устройства с 0,5 нм t sp
На рисунках 3c и 2d показано двухмерное распределение электрического поля в кремниевом корпусе в выключенном состоянии для устройства с 2 нм и 0,5 нм t sp , соответственно. Для большей толщины прокладки или меньшего напряжения сток-исток ( В DS ) смещения напряженность электрического поля на границе раздела между прокладкой в углубленной области недостаточно велика для создания большого количества тока утечки. Наибольшая напряженность электрического поля появляется около границы раздела между оксидом затвора и вертикальной частью тела, что определяется как V GD . Однако, если расстояние от истока до стока уменьшается до менее 1 нм (меньше, чем толщина оксида затвора), наибольшая напряженность поля появляется около границы раздела между прокладкой в углубленной области и двумя вертикальными частями корпуса. Видно, что когда t sp меньше 1 нм, для большего V DS (Например, 0,5 В), ток утечки почти не зависит от смещения затвора и в основном определяется V DS . СС почти независима с t sp и поддерживает почти идеальное значение 65 мВ / дек в течение h в =10 морских миль до t sp меньше 2 нм. Я ВКЛ / Я ВЫКЛ соотношение составляет 10 8 до t sp =2 нм и серьезно ухудшается за t sp менее 2 нм из-за увеличения тока утечки, вызванного сильным электрическим полем, появляется около границы раздела между прокладкой в углубленной области и двумя вертикальными частями корпуса. Напряженность электрического поля кремниевого тела в области тела полностью увеличивается на 0,5 нм t sp кейс. На рисунке 3e показано двумерное распределение концентрации электронов в кремниевом корпусе в выключенном состоянии для устройства с 0,5 нм t sp . По сравнению с рис. 2г ясно видно, что концентрация электронов в горизонтальной части тела увеличена с 10 9 до 10 10 см −3 . Кроме того, размер разделительного слоя 0,5 нм очень близок к толщине одномолекулярного слоя, что может в некоторой степени вызвать нарушение изоляционных свойств разделительного слоя. По указанной выше причине t sp рекомендуется иметь длину 2 нм для конструкции с высокой степенью интеграции и низким уровнем утечек и низким энергопотреблением.
На рисунке 4 показан I DS - V DS предлагаемого полевого транзистора RGUC с оптимизированной структурой под разн.
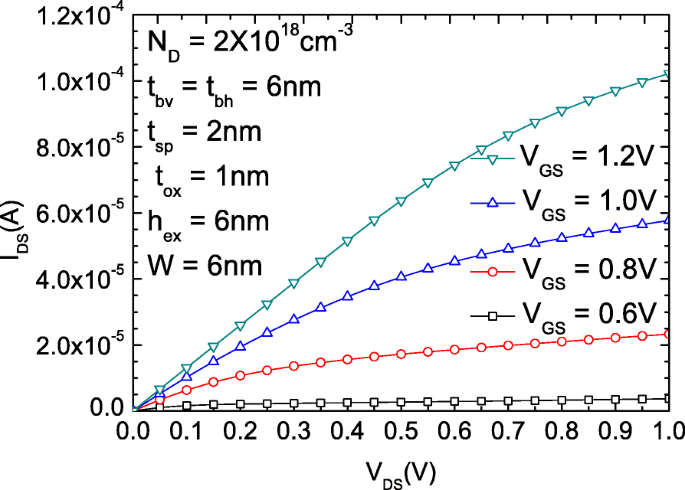
Я DS - V DS характеристика предлагаемого полевого транзистора RGUC с оптимизированными параметрами устройства
V GS значения, SS которых составляет около 63 мВ / дек, а I ВКЛ / Я ВЫКЛ 10 9 ~ 10 10 . Ток насыщения увеличивается как V . GS увеличивается.
Выводы
В этой статье предлагается новый полевой транзистор RGUC с высокой степенью интеграции и высокой производительностью, в котором представлены низко подпороговые колебания и более высокие значения I . ВКЛ / Я ВЫКЛ соотношение. Расстояние между контактами исток / сток (S / D) можно уменьшить до 2 нм с почти идеальными характеристиками, такими как SS, обратный ток утечки и I ВКЛ / Я ВЫКЛ соотношение. Все электрические свойства моделируются с помощью квантовых моделей, чтобы обеспечить более точные результаты.
Сокращения
- BQP:
-
Квантовый потенциал Бома
- FET:
-
Полевой транзистор
- h бывший :
-
Высота удлинения проставки между областью S / D
- h в :
-
Внутренняя высота проставки в углублении
- I ВЫКЛ :
-
Отключено от тока
- I ВКЛ :
-
В настоящее время
- JL:
-
Без стыков
- MOS:
-
Металлооксидный полупроводник
- N D :
-
Концентрация допинга
- RGUC:
-
Прямоугольный затвор П-образный
- S / D:
-
Источник / сток
- SS:
-
Подпороговое колебание
- t bh :
-
Толщина корпуса по горизонтали
- t bv :
-
Толщина корпуса по вертикали
- t ворота :
-
Длина ворот по вертикали
- t бык :
-
Толщина оксидного слоя затвора
- t sp :
-
Толщина прокладки между областями S / D
- V DS :
-
Напряжение сток-исток
- V GS :
-
Напряжение затвор-исток
- W:
-
Ширина корпуса
Наноматериалы
- Разница между структурой и классом:объяснение на примере C++
- Разница между while и do-while:объяснение с примерами
- Умный наноматериал и нанокомпозит с продвинутой агрохимической активностью
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Простой синтез серебряных нанопроволок с разным соотношением сторон и используемых в качестве высокоэффект…
- Серебряный затворный электрод с УФ-отверждением для струйной печати с низким электрическим сопротивлением
- Снижение контактного сопротивления между металлом и n-Ge за счет введения ZnO при обработке аргоновой плазмой
- Канальные плазмонные нанопроволочные лазеры с полостями с V-образной канавкой
- Термоинтерфейсные материалы с графеном и удовлетворительным уровнем контакта между матрицей и наполнителям…
- Высокопроизводительный катодный материал из FeF3 · 0,33H2O, модифицированный углеродными нанотрубками и графеном…



