Повышение диэлектрической проницаемости MIM-конденсаторов Al2O3 / ZrO2 / Al2O3 с атомным слоем за счет микроволнового отжига
Аннотация
Для конденсаторов металл-изолятор-металл (MIM), применяемых в областях RF, DRAM и аналоговых / смешанных сигналов, высокая плотность емкости является обязательной при уменьшении размера элемента устройства. В данной работе метод микроволнового отжига исследуется для улучшения диэлектрических характеристик Al 2 . О 3 / ZrO 2 / Al 2 О 3 на основе MIM конденсаторов. Результаты показывают, что диэлектрическая проницаемость ZrO 2 увеличивается до 41,9 (усиление ~ 40%) при микроволновом отжиге при 1400 Вт в течение 5 мин. Температура подложки ниже 400 ° C, что совместимо с производственным процессом на задней стороне линии. Плотность тока утечки составляет 1,23 × 10 −8 . и 1,36 × 10 −8 А / см 2 для образца после осаждения и образца мощностью 1400 Вт соответственно, что указывает на то, что свойство утечки не ухудшается. Механизм проводимости подтвержден как туннелирование с помощью поля.
Фон
Конденсаторы металл-изолятор-металл (MIM) широко используются в области радиочастот (RF), динамической памяти с произвольным доступом (DRAM) и аналоговых / смешанных интегральных схем. При уменьшении размера элемента устройства желательно получить еще более высокую плотность емкости. Например, требуется, чтобы плотность емкости была больше 10 фФ / мкм 2 . согласно узлу 2020 года Международной технологической дорожной карты для полупроводников (ITRS) [1]. Как следствие, было исследовано большое количество материалов с высоким κ, таких как HfO 2 [2,3,4,5,6], ZrO 2 [7,8,9,10,11,12,13,14], Ta 2 О 5 [15,16,17,18] и TiO 2 [19,20,21,22,23,24]. Среди этих материалов с высоким κ ZrO 2 имеет диэлектрическую проницаемость (κ) 16 ~ 25 (моноклинная фаза) и ширину запрещенной зоны 5,8 эВ. Однако значение κ ZrO 2 может быть увеличен до 36,8 и 46,6 при кристаллизации в кубическую и тетрагональную фазы соответственно [25]. Следовательно, можно дополнительно увеличить плотность емкости. Методика микроволнового отжига (MWA) была тщательно изучена для активации легирующей примеси в кремнии [26,27,28] и образования силицида [29, 30] из-за более низкой температуры процесса по сравнению с традиционными методами термической обработки. Кроме того, Shih et al. [31] исследовали влияние MWA на электрические характеристики TiN / Al / TiN / HfO 2 . / Si МОП конденсаторы. Были улучшены некоторые ключевые параметры, такие как эквивалентная толщина оксида, плотность состояний границы раздела и плотность тока утечки.
В этой работе влияние MWA на электрические свойства TaN / Al 2 О 3 / ZrO 2 / Al 2 О 3 Исследуются конденсаторы MIM / TaN (TaN / A / Z / A / TaN). При использовании MWA диэлектрическая проницаемость ZrO 2 заметно увеличивается, а плотность тока утечки немного увеличивается. Кроме того, изучается также лежащий в основе механизм проводимости.
Методы
Во-первых, SiO 2 толщиной 500 нм пленка была выращена на подложке Si методом PECVD с последующим осаждением пленок TaN (20 нм) / Ta (100 нм), а TaN был выращен путем распыления мишени Ta в N 2 / Ar плазма. Впоследствии пластина Si, покрытая пленками TaN / Ta, была перенесена в камеру ALD, и наностакан Al 2 О 3 (2 нм) / ZrO 2 (20 нм) / Al 2 О 3 (2 нм) наносили при 250 ° C. Аль 2 О 3 и ZrO 2 пленки были выращены из Al (CH 3 ) 3 / H 2 O и [(CH 3 ) 2 N] 4 Zr / H 2 O соответственно. Стоит отметить, что ультратонкий Al 2 О 3 слой между нижним электродом TaN и ZrO 2 слой был вставлен, чтобы ограничить образование межфазного слоя во время ALD и отжига после осаждения. После этого образцы подвергались микроволновому отжигу. MWA проводился в восьмиугольной камере DSGI на частоте 5,8 ГГц. Во время отжига образцы помещались в середину камеры, где электромагнитное поле наиболее однородно. Температуру образцов in situ контролировали инфракрасным пирометром Raytek серии XR, обращенным к обратной стороне образцов. Мощность варьировалась от 700 Вт до 1400 Вт при фиксированном времени отжига 5 мин. Наконец, верхний электрод из TaN толщиной 100 нм был сформирован по очереди с помощью реактивного распыления, литографии и реактивного ионного травления.
Толщину пленки ALD измеряли с помощью эллипсометра (SOPRA GES 5E) и подтверждали с помощью просвечивающего электронного микроскопа (ТЕМ). Емкость-напряжение ( C-V ) был измерен прецизионным анализатором импеданса (Agilent 4294A) с амплитудой 50 мВ переменного тока. Ток-напряжение ( I-V ) измерения проводились с помощью анализатора полупроводниковых приборов (Agilent B1500) в темном боксе. Смещение было приложено к верхнему электроду.
Результаты и обсуждение
Схематические структуры MIM-конденсатора на основе A / Z / A и камеры MWA показаны на рис. 1a и b соответственно. На рисунке 1c показано поперечное сечение ПЭМ-изображения конденсатора MIM на основе A / Z / A, который подвергается воздействию MWA при 1400 Вт в течение 5 минут. Замечено, что ZrO 2 слой полностью кристаллизован, и уложенные слои хорошо различимы, см. вставку. На рис. 2а показан график кумулятивной вероятности плотности емкости при различной мощности отжига. Результаты показывают, что удельные емкости конденсаторов MIM составляют 7,34, 8,87, 8,96 и 9,06 фФ / мкм 2 соответственно для 0, 700, 1050 и 1400 Вт с кумулятивной вероятностью 50%. Следовательно, плотность емкости увеличивается под действием микроволн. Очень узкое распределение плотности емкости для MIM-конденсаторов A / Z / A с MWA указывает на очень хорошую однородность отжига. На вставке к рис. 2а представлены типичные ВАХ всех образцов. Исключая влияние Al 2 О 3 (κ ≈ 8) диэлектрическая проницаемость ZrO 2 пленки извлекаются как 28,3, 40,1, 41 и 41,9 для 0, 700, 1050 и 1400 Вт соответственно, как показано на рис. 2b. Что касается микроволновой мощности 1400 Вт, диэлектрическая проницаемость ZrO 2 пленка увеличивается на 40% по сравнению с наплавленным образцом. Значительное увеличение диэлектрической проницаемости ZrO 2 можно объяснить высокой степенью кристаллизации во время микроволнового отжига, показанной на рис. 1в. Как упоминалось выше, диэлектрическая проницаемость ZrO 2 может быть увеличен до 36,8 и 46,6 при кристаллизации в кубическую и тетрагональную фазы соответственно [25]. Следовательно, измерение XRD было выполнено для дальнейшего исследования механизма увеличения диэлектрической проницаемости. Как показано на вставке к рис. 2b, пик существовал при ~ 30,7 ° после обработки MWA при 1400 Вт, что указывает на появление тетрагональной фазы (111) в ZrO 2 [32, 33]. Присутствие этой тетрагональной фазы приводит к увеличению диэлектрической проницаемости с 28,3 до более 40.

а Схематическая структура Al 2 О 3 / ZrO 2 / Al 2 О 3 конденсатор на основе MIM. б Схематическое строение камеры MWA. c ПЭМ изображение Al 2 О 3 / ZrO 2 / Al 2 О 3 конденсатор на основе MIM с MWA на 1400 Вт в течение 5 мин

а График накопленной вероятности плотности емкости для различных образцов; на вставке - плотность емкости в зависимости от смещения. б График накопленной вероятности диэлектрической проницаемости ZrO 2 для разных образцов; на вставке показаны дифрактограммы осажденных образцов и образцов мощностью 1400 Вт
Поскольку конденсаторы MIM изготавливаются в конце линии (BEOL) интегральных схем, температура процесса должна быть ниже 400 ° C [34]. Как показано на рис. 3, температурные кривые MWA показывают, что самые высокие температуры подложки составляют 260, 350 и 400 ° C для 700, 1050 и 1400 Вт соответственно. Следовательно, MWA совместим с процессом CMOS с точки зрения температуры процесса. Кроме того, в предыдущей работе [13] Al 2 О 3 (2 нм) / ZrO 2 Конденсаторы MIM на основе (20 нм) подвергались быстрому термическому отжигу (RTA) при 420 ° C в течение 10 мин в N 2 / H 2 окружающей среды и результирующая диэлектрическая проницаемость ZrO 2 был оценен как 40. Для RTA время отжига поддерживалось постоянным при 420 ° C в течение 10 минут, поэтому тепловой баланс был намного больше по сравнению с MWA. Для MWA [35, 36] дипольная поляризация считается наиболее важным механизмом передачи энергии на молекулярном уровне. Когда контактирующие материалы имеют разные диэлектрические свойства, микроволны будут избирательно взаимодействовать с материалами с более высокими диэлектрическими потерями. Напротив, обычный RTA передает тепло наиболее эффективно материалам с высокой проводимостью.
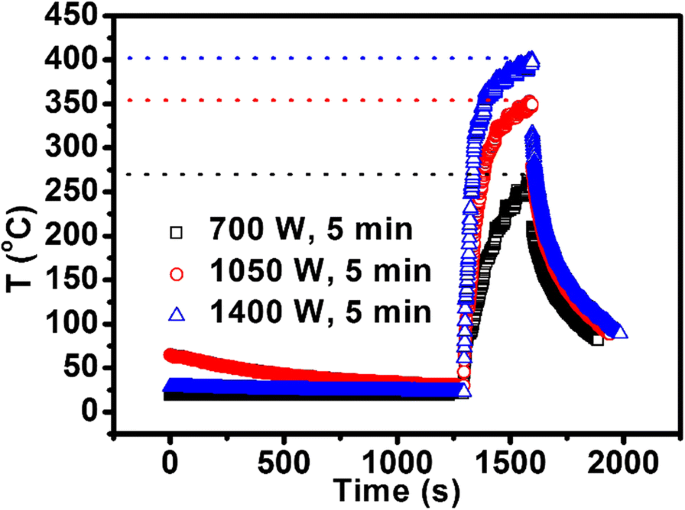
Кривые температуры подложки для различных образцов при микроволновом отжиге
Ток утечки - еще один важный параметр для конденсаторов MIM. Как показано на рис. 4а, кривую тока утечки для всех образцов можно разделить на два участка, поскольку имеется очевидная точка поворота, указывающая на различные механизмы электронной проводимости. Что касается образцов с обработкой MWA, напряжение, соответствующее точке поворота, меньше по сравнению с образцом после осаждения. В таблице 1 приведены значения плотности тока утечки при ± 4 В для всех образцов. Возьмем, например, 4 В, плотность тока утечки увеличена с 1,06 × 10 −7 . до 1,92 × 10 −5 А / см 2 , т.е. на два порядка амплитуды увеличиваются при увеличении мощности микроволн с 0 до 1400 Вт. Из-за высокой кристаллизации ZrO 2 На пленке появится большое количество границ зерен, которые будут служить каналом утечки, тем самым улучшая электронную проводимость в сильном электрическом поле. Однако, учитывая рабочее напряжение 2 В, плотности тока утечки составляют 1,23 × 10 −8 . и 1,36 × 10 −8 А / см 2 для образца после осаждения и образца мощностью 1400 Вт соответственно. Очевидно, что микроволновый отжиг мало влияет на характеристики утечки в слабом электрическом поле. Кроме того, напряжение пробоя было извлечено из I - V испытание и построено на рис. 4b. Для осажденного образца напряжение пробоя составляет около 9,8 В с кумулятивной вероятностью 50%. При применении MWA напряжение пробоя снижается до ~ 9 В. Это снижение напряжения пробоя может быть связано с изменением ZrO 2 микроструктура.
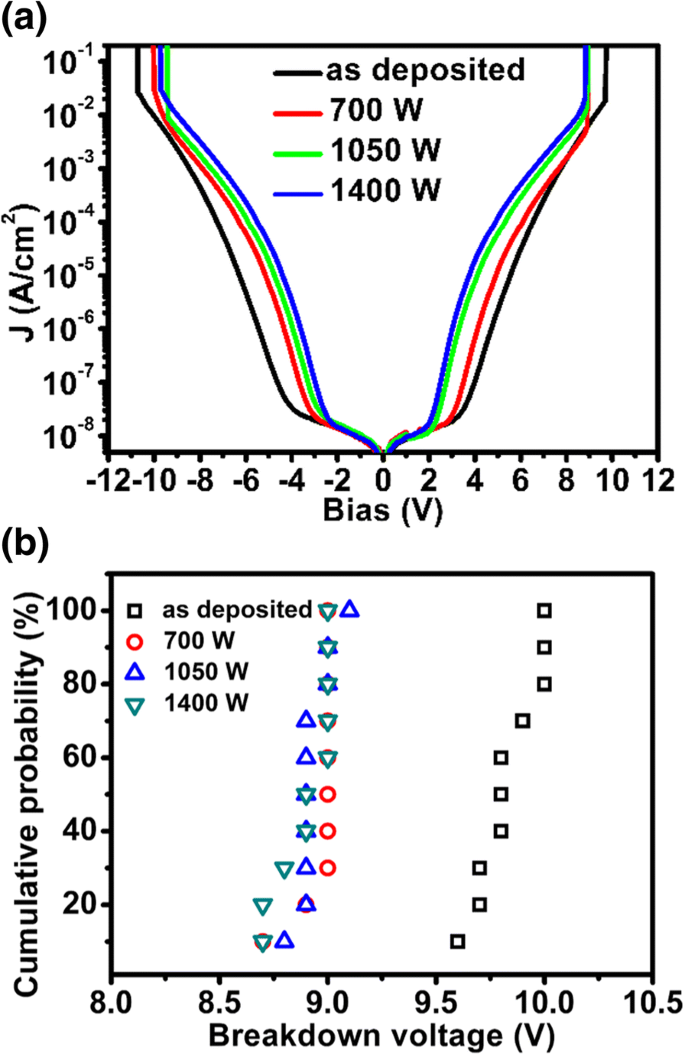
а График плотности тока утечки ( Дж ) vs bias и b график кумулятивной вероятности напряжения пробоя для разных образцов
Чтобы лучше понять влияние MWA на ток утечки, исследуются механизмы проводимости конденсаторов MIM. На основании предыдущего исследования Al 2 О 3 (2 нм) / ZrO 2 Конденсатор MIM на основе (20 нм) [13, 14], доминирующий механизм проводимости в сильном электрическом поле был подтвержден как полевое туннелирование (FAT). Для FAT, туннелирования, связанного с ловушками, электроны сначала захватываются ловушками в изоляторе, а затем туннелируют непосредственно в зону проводимости изолятора [37]. В текущей работе Аль 2 О 3 и ZrO 2 Пленки в конденсаторах MIM на основе A / Z / A были нанесены в тех же условиях, поэтому ток утечки, вероятно, также является преобладающим для FAT. Модель FAT может быть выражена формулой. (1) [37]
$$ J ={AE} ^ 2 \ exp \ left (- \ frac {8 \ pi \ sqrt {2 {m} ^ {\ ast} q {\ varphi} _t ^ 3}} {3 hE} \ right) $$ (1)где A постоянная, E - электрическое поле, q - электронный заряд, м * представляет собой эффективную массу электрона (около 0,25 м 0 , где м 0 - масса свободного электрона), k постоянная Больцмана, φ т - энергетический барьер, отделяющий ловушки от зоны проводимости, а h постоянная Планка.
Что касается многослойных диэлектриков, то электрическое поле, приложенное к каждому слою, отличается друг от друга из-за разной диэлектрической проницаемости и толщины. Следовательно, использование среднего электрического поля по всей стопке приведет к серьезным ошибкам при обсуждении механизма проводимости. Как следствие, электрическое поле на ZrO 2 слой должен быть извлечен аккуратно. Электрические поля на ZrO 2 равны 3,125 × 10 7 × V стек , 2,5 × 10 7 × V стек , 2,47 × 10 7 × V стек , и 2,44 × 10 7 × V стек соответственно для осажденного образца мощностью 700, 1050 и 1400 Вт согласно закону Гаусса и закону напряжения Кирхгофа [38, 39]:
$$ \ left \ {\ begin {array} {c} {k} _A {E} _A ={\ kappa} _Z {E} _Z \\ {} {d} _A {E} _A + {d} _Z {E } _Z ={V} _ {стек} \ end {array} \ right. $$ (2)где k A и κ Z представляют собой диэлектрическую проницаемость Al 2 О 3 и ZrO 2 , соответственно; E A и E Z обозначим электрические поля на Al 2 О 3 и ZrO 2 , соответственно; г A и d Z равны толщине Al 2 О 3 и ZrO 2 , соответственно; и V стек напряжение, приложенное к стеку. Соответственно, Ln ( J / E Z 2 ) против 1 / E Z был произвольно нанесен на рис. 5, где прямая аппроксимация была достигнута в области сильного поля для каждого образца при нижней инжекции электронов (см. фиг. 5a) или верхней инжекции электронов (см. фиг. 5b). Это означает, что механизм FAT преобладает в сильных электрических полях. Извлеченный φ t составляет 0,73, 0,51, 0,38 и 0,35 эВ соответственно для образца после осаждения, мощностью 700, 1050 и 1400 Вт при донной инжекции электронов. С точки зрения верхней инжекции электронов соответствующее значение φ t составляет 0,82, 0,53, 0,47 и 0,43 эВ соответственно. Следовательно, некоторые мелкие ловушки индуцируются MWA. Сообщается, что мелкие ловушки возникают из-за дефектов границ зерен, которые могут вводить дополнительные электронные состояния вблизи зоны проводимости [40]. Кроме того, механизм проводимости при низких полях, скорее всего, связан с туннелированием с помощью ловушек (TAT).
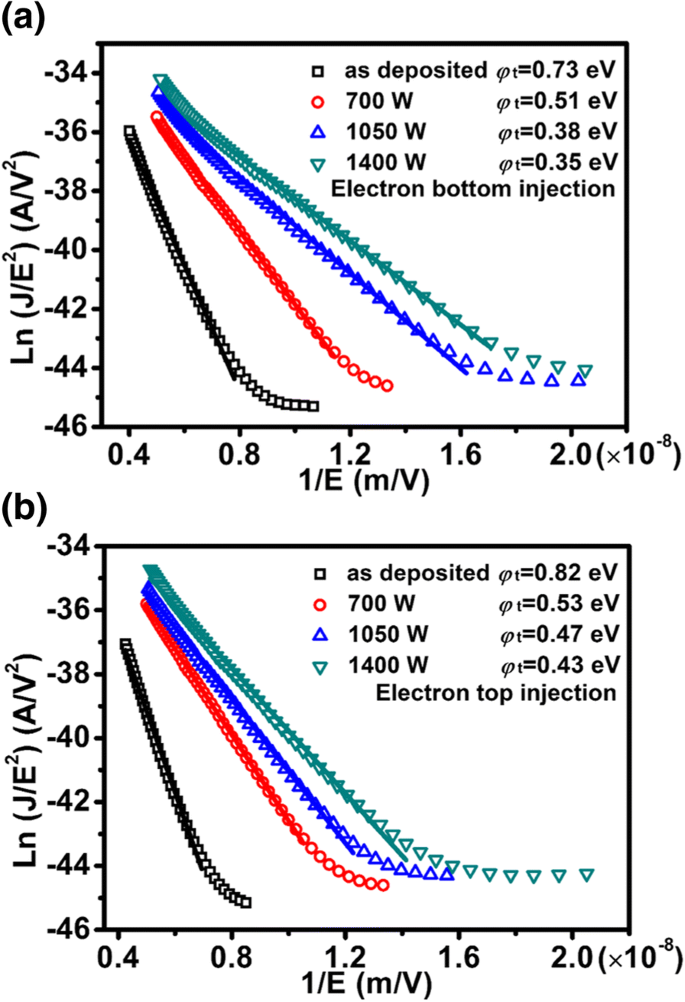
Сюжет о Ln ( J / E 2 ) против 1 / E для разных образцов. а Закачка электронов снизу и b верхняя инжекция электронов
Выводы
Al 2 с нанесенным слоем атомов О 3 / ZrO 2 / Al 2 О 3 нано-стек используется в качестве изолятора конденсаторов MIM. При воздействии MWA на 1400 Вт в течение 5 минут плотность емкости увеличивается до 9,06 фФ / мкм 2 . , увеличено примерно 23,4% емкости. Разделение влияния Al 2 О 3 , диэлектрическая проницаемость рассчитана как 41,9 для образца мощностью 1400 Вт (увеличение диэлектрической проницаемости на ~ 40%). Такое увеличение диэлектрической проницаемости происходит из-за высокой кристаллизации ZrO 2 фильм. Кроме того, температура подложки ниже 400 ° C, что обеспечивает совместимость MWA с процессом BEOL. Эта более низкая температура подложки может быть объяснена селективным нагревом материалов MWA. При рабочем напряжении 2 В плотности тока утечки составляют 1,23 × 10 −8 . и 1,36 × 10 −8 А / см 2 для образца после осаждения и образца мощностью 1400 Вт соответственно. Доминирующий механизм проводимости в сильных электрических полях подтверждается процессом FAT. Ток утечки в слабых электрических полях, вероятно, продиктован ТАТ. Исходя из вышеперечисленных фактов, микроволновый отжиг является многообещающим методом, используемым в процессе CMOS для улучшения диэлектрических характеристик конденсаторов MIM.
Сокращения
- А / Я / А:
-
Аль 2 О 3 / ZrO 2 / Al 2 О 3
- ALD:
-
Осаждение атомного слоя
- BEOL:
-
Задний конец строки
- C – V :
-
Емкость-напряжение
- DRAM:
-
Динамическая память с произвольным доступом
- FAT:
-
Полевое туннелирование
- ITRS:
-
Дорожная карта международных технологий для полупроводников
- I-V :
-
Ток-напряжение
- MIM:
-
Металл-изолятор-металл
- MWA:
-
Микроволновый отжиг
- PECVD:
-
Плазменное химическое осаждение из паровой фазы
- RF:
-
Радиочастота
- RTA:
-
Быстрый термический отжиг
- ТАТ:
-
Туннелирование с помощью ловушек
- ТЕМ:
-
Просвечивающий электронный микроскоп
Наноматериалы
- AVX выпускает новые сверхминиатюрные тонкопленочные линейные конденсаторы для высокопроизводительных микро…
- Отображение атомов на двумерных атомных кристаллах в жидкостях
- Углерод в океане, полученный в атомном масштабе
- Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом перек…
- Формирование и люминесцентные свойства нанокомпозитов Al2O3:SiOC на основе наночастиц оксида алюминия, модифици…
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Плазмонный датчик на основе диэлектрических нанопризм
- Фотодетектор с регулируемой длиной волны на основе одиночного нанопояса CdSSe
- Влияние последующего термического отжига на оптические свойства пленок InP / ZnS с квантовыми точками
- RRAM на основе HfAlOx с атомарным слоем и низким рабочим напряжением для вычислений приложений в памяти



