Одношаговая дифракционная литография на основе маски для изготовления трехмерных подвесных конструкций
Аннотация
Мы предлагаем новый метод одноэтапной экспозиции для изготовления трехмерных (3D) подвесных структур, использующий дифракцию рисунков маски с малой шириной линий. Построена оптическая модель процесса экспонирования, и трехмерное распределение интенсивности света в фоторезисте рассчитано на основе формулировки дифракции Френеля-Кирхгофа. Было создано несколько трехмерных подвесных структур фоторезиста, таких как балки, сетки, словосочетания и многослойные структуры. После пиролиза структур СУ-8 дополнительно получаются подвешенные и отдельно стоящие трехмерные углеродные структуры, которые демонстрируют большой потенциал в применении прозрачных электродов, полупрозрачных солнечных элементов и устройств хранения энергии.
Введение
Структуры трехмерных углеродных микроэлектромеханических систем (C-MEMS) привлекают все больше и больше внимания из-за их превосходной химической стабильности, электрохимической активности и биосовместимости [1,2,3,4,5]. Подвесные углеродные структуры - это типичные 3D C-MEMS-структуры, свободные от какой-либо межмолекулярности [2], которые обладают значительными преимуществами в сенсорах [6, 7], микроэлектродах [8, 9] и приложениях для накопления энергии [9]. Различные микроструктуры C-MEMS были получены путем пиролиза полимера, в котором SU-8 является наиболее широко используемым предшественником для пиролитических углеродных структур [10, 11]. Что касается его низкого поглощения света, из SU-8 легко изготавливать микроструктуры с высоким аспектным отношением [12]. Однако получение суспендированного полимерного шаблона по-прежнему представляет собой серьезную проблему.
Различные подходы были разработаны для изготовления подвешенных микроструктур, таких как электронно-лучевой писатель [13,14,15], рентгеновский [10,16] и двухфотонная литография [17,18,19]. Двухфотонная литография - это реальный способ получения сложных подвесных структур, таких как подвешенные полые микротрубки, с большой точностью, но низкой эффективностью [17]. Принимая во внимание эффективность и стоимость, УФ-литография может быть лучшим выбором для изготовления прекурсора фоторезиста. Продемонстрирован многоступенчатый процесс литографии с контролируемой дозой облучения для изготовления подвесных конструкций [3, 6, 7, 20]. Lim et al. [21] изготовили подвешенные нанопроволоки и наноячейки с помощью двухэтапного процесса УФ-литографии и получили наноструктуры стеклоуглерода с помощью процесса пиролиза. Также были предложены некоторые методы одноступенчатой литографии. Нет и др. [22] получили подвешенные микроструктуры с помощью процесса однократного экспонирования, во время которого на Cr-маски накладывалась пленка оптического рассеивателя. Пленка диффузора оказала значительное влияние на процесс экспонирования, что привело к деформации рисунков фоторезиста. Long et al. [2] успешно изготовили трехмерные подвесные структуры, контролируя дозу облучения и воздушный зазор между фоторезистом и фотошаблоном во время процесса экспонирования в непосредственной близости, тогда как режим экспонирования в непосредственной близости ограничивал разрешающую способность изготовления. Фотолитография в оттенках серого также применялась при изготовлении подвесных структур с полутоновыми масками или в системах литографии без масок [11, 23]. Поскольку СУ-8 почти прозрачен при длине волны света более 350 нм [12], очень сложно контролировать точность толщины взвешенного слоя путем регулировки дозы облучения [8, 10]. Hemanth et al. [10] оптимизировали длину волны УФ-излучения в процессе экспонирования в соответствии со свойствами СУ-8. Они выбрали длину волны УФ-излучения 405 нм для микроструктур с высоким соотношением сторон и 313 нм для взвешенного слоя. Однако сочетание экспонирования с различными длинами волн УФ-излучения увеличивает стоимость и трудности всего процесса изготовления.
В этом исследовании мы демонстрируем новый одностадийный процесс дифракционной литографии на основе маски, который совместим с большинством видов фоторезистов для изготовления трехмерных подвесных структур. Трехмерное распределение интенсивности света моделируется в фоторезисте в соответствии с теорией дифракции Кирхгофа и дополнительно подтверждается экспериментами. Толщина подвесных конструкций контролируется шириной узоров, а подвесные балки расширяются путем наложения нескольких линейных узоров бок о бок с надлежащим интервалом. Сложные трехмерные подвесные конструкции, такие как балки с градиентной толщиной и полные подвесные сетки с текстовыми рисунками, могут быть получены с помощью процесса одноэтапной литографии. Наконец, подвешенные углеродные балки, сетки и отдельно стоящие углеродные сетки также были получены с помощью процесса пиролиза.
Методы и эксперименты
Оптическая модель дифракционной литографии
Во время процесса УФ-литографии явление дифракции будет очень очевидным, если размер узора слишком мал. Здесь мы используем дифракцию узких структур с несколькими длинами волн для изготовления подвешенных пучков. Для анализа пространственного распределения интенсивности света в фоторезисте мы построили оптическую модель (рис. 1) дифракционной литографии на основе дифракции Френеля. Воздушным зазором между фоторезистом и фотошаблоном можно пренебречь, так как экспонирование проводится в режиме жесткого контакта. Маска освещается плоской волной с типичной длиной волны 365 нм, а фоторезист рассматривается как прозрачный материал с показателем преломления 1,659 (показатель преломления SU-8 на длине волны 365 нм, измеренный эллипсометром). P 0 - точка на маске с координатой ( x 0 , y 0 , 0) и P 1 - произвольная точка на фоторезисте с координатой ( x 1 , y 1 , z 1 ).
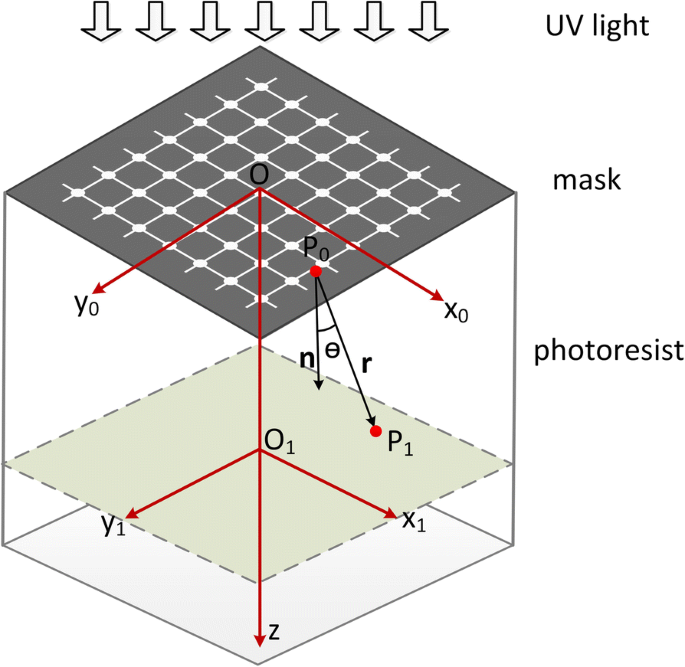
Оптическая модель дифракционной литографии
Согласно формулировке дифракции Френеля-Кирхгофа [24], амплитуда в точке P 1 в фоторезисте есть
$$ E \ left ({P} _1 \ right) =\ frac {1} {2 j \ lambda} \ underset {\ sum} {\ iint} E \ left ({P} _0 \ right) \ frac {\ ехр (jkr)} {r} \ left (1+ \ cos \ theta \ right) ds $$ (1)где k =2 π / λ , λ представляет длину волны УФ-излучения в фоторезисте, E ( P 0 ) - амплитуда световой волны в точке P 0 , θ угол между P 0 P 1 и z ось, r расстояние между P 1 и P 0 , и Σ представляет собой целостную область шаблона маски. Согласно геометрической зависимости на рис. 1, мы можем получить
$$ r =\ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1- {y} _0 \ right)} ^ 2+ {z_1} ^ 2} $$ (2) $$ \ cos \ theta ={z} _1 / r $$ (3)E ( P 0 ) является константой в модели. Таким образом, формула расчета принимает следующий вид:
$$ E \ left ({P} _1 \ right) =\ frac {E \ left ({P} _0 \ right)} {2 j \ lambda} \ underset {\ sum} {\ iint} \ frac {\ exp \ Big (jk \ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1- {y} _0 \ right)} ^ 2+ {z_1} ^ 2 \ Big)}} {\ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1- {y} _0 \ right)} ^ 2 + {z_1} ^ 2}} \ left (1+ \ frac {z_1} {\ sqrt {{\ left ({x} _1- {x} _0 \ right)} ^ 2 + {\ left ({y} _1 - {y} _0 \ right)} ^ 2+ {z_1} ^ 2}} \ right) {dx} _0 {dy} _0 $$ (4)Затем интегралы рассчитываются с использованием программного обеспечения Matlab, и распределение интенсивности света в фоторезисте может быть выражено как:
$$ I \ left (x, y, z \ right) ={\ left | E \ left ({P} _1 \ right) \ right |} ^ 2 $$ (5)где ( x , y , z ) равняется координате P 1 .
Для дальнейшего исследования поглощения фоторезиста мы изменили расчеты интенсивности света с учетом коэффициента поглощения. Когда световой луч проходит через фоторезист от P 0 в P 1 , интенсивность света можно рассчитать по следующей формуле [25].
$$ \ frac {I _ {\ alpha}} {I_0} =\ exp \ left (- \ alpha r \ right) $$ (6)где I 0 - начальная сила света в точке P 0 , Я α интенсивность света в точке P 1 , α - коэффициент поглощения фоторезиста, а r расстояние между P 0 и P 1 . Мы определяем I α = 0 как сила света в точке P 1 когда α =0 мкм −1 . Легко получить, что I α = 0 = Я 0 по формуле (6). Отношения между E ( P α = 0 ) (амплитуда, соответствующая I α = 0 ) и E ( P α ) (амплитуда, соответствующая I α ) может быть выражено как:
$$ \ frac {E \ left ({P} _ {\ alpha} \ right)} {E \ left ({P} _ {\ alpha =0} \ right)} =\ exp \ left (- \ alpha r / 2 \ вправо) $$ (7)Таким образом, при рассмотрении поглощения фоторезиста при дифракционной литографии амплитуда в точке P 1 (определяется как E ( P 1α )) можно рассчитать по:
$$ E \ left ({P} _ {1 \ alpha} \ right) =\ frac {1} {2 j \ lambda} \ underset {\ sum} {\ iint} \ exp \ left (- \ alpha r / 2 \ right) E \ left ({P} _0 \ right) \ frac {\ exp (jkr)} {r} \ left (1+ \ cos \ theta \ right) ds $$ (8)А интенсивность света можно получить по формулам (2), (3), (5) и (8).
Подробные сведения об эксперименте
Маски с линейным рисунком использовались для изготовления подвесных конструкций, а круги или квадраты были разработаны для изготовления столбов, поддерживающих подвешенный слой. В экспериментах использовались два вида толстого негативного фоторезиста, включая SU-8 2100 (Microchem Co., Ltd.) толщиной ~ 50 мкм и NR26-25000P (Futurrex Co., Ltd.) толщиной ~ 30 мкм. Процесс экспонирования выполнялся с помощью устройства выравнивания маски MJB4, где длина волны освещающего УФ-света составляла 365 нм. Подвесные конструкции могут быть получены после погружения образцов в проявитель на определенное время. В данном случае ацетат метилового эфира пропиленгликоля (PGMEA, Aladdin Co., Ltd.) был использован в качестве проявителя для образцов SU-8 2100, а проявитель RD6 (Futurrex Co., Ltd.) был выбран для образцов NR26-25000P. Наконец, в кварцевой печи (MTI GAL 1400X) был проведен процесс пиролиза [16, 26, 27], содержащий этап твердого обжига и этап обжига с карбонизацией, для получения трехмерных углеродных микроструктур. Весь процесс проиллюстрирован на фиг. 2a, а изменения температуры во время процесса пиролиза показаны на фиг. 2b. Образцы подвергали твердому спеканию при 300 ° C в течение 30 мин, а затем пиролизовали при 900 ° C в течение 60 мин. В процессе пиролиза образцы хранили в H 2 (5%) / Ar (95%) атмосфера со скоростью нагрева 10 ° C / мин. Полученные микроструктуры охарактеризованы с помощью сканирующего электронного микроскопа (SEM, Helios NanoLab G3, FEI).
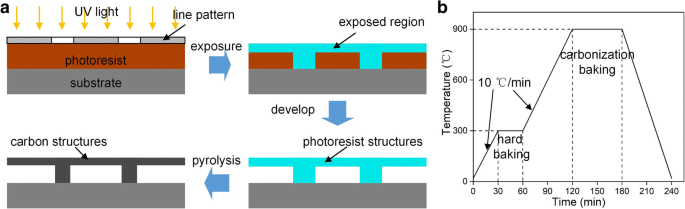
а Процесс изготовления трехмерных углеродных подвесных конструкций. б Температурная кривая пиролиза
Результаты и обсуждения
Распределение интенсивности света
На рисунке 3а показано сечение трехмерного распределения интенсивности света под маской в форме линии с шириной линии d . =1 мкм, 1,5 мкм, 2 мкм, 2,5 мкм, 3 мкм, 3,5 мкм и 4 мкм соответственно. Здесь принята относительная интенсивность, и интенсивность падающего света определяется как 1. Свет на дне фоторезиста будет постепенно рассеиваться из-за эффекта дифракции света. Как только интенсивность света достигнет порогового значения, фоторезист получит достаточно энергии, чтобы высвободить реакцию и стать твердым; в противном случае он будет удален в процессе разработки. Толщина области выше порога (0,75 в этом исследовании) определяется как глубина экспонирования, которая очень чувствительна к ширине рисунка. Глубина экспонирования составляет 5,3 мкм при d =1 мкм и 18,2 мкм при d =2 мкм. Далее он увеличится до 33,5 мкм при d =3 мкм и 47,5 мкм при d =4 мкм. Если ширина линии меньше 1 мкм, глубина экспонирования будет слишком мала для изготовления, потому что воздушный зазор между маской и фоторезистом, вызванный неровностями толстого фоторезиста, приведет к неудачной экспозиции. На рис. 3b, c показаны образцы масок для изготовления подвесных конструкций и соответствующее распределение интенсивности света при z =5, 10, 15 и 20 мкм, где ширина линии установлена равной 2 мкм. Глубина экспонирования линий и сеток составляет от 15 до 20 мкм, тогда как глубина экспонирования больших квадратов и кругов достаточно велика, чтобы образовывать столбы во время литографии. Таким образом, можно изготавливать подвесные балки и сетки, опирающиеся на колонны. Поскольку сложно изготовить подвесные конструкции, когда ширина линии больше 5 мкм, линейные узоры накладываются друг на друга для изготовления широких подвесных балок или сеток, как показано на рис. 3d.
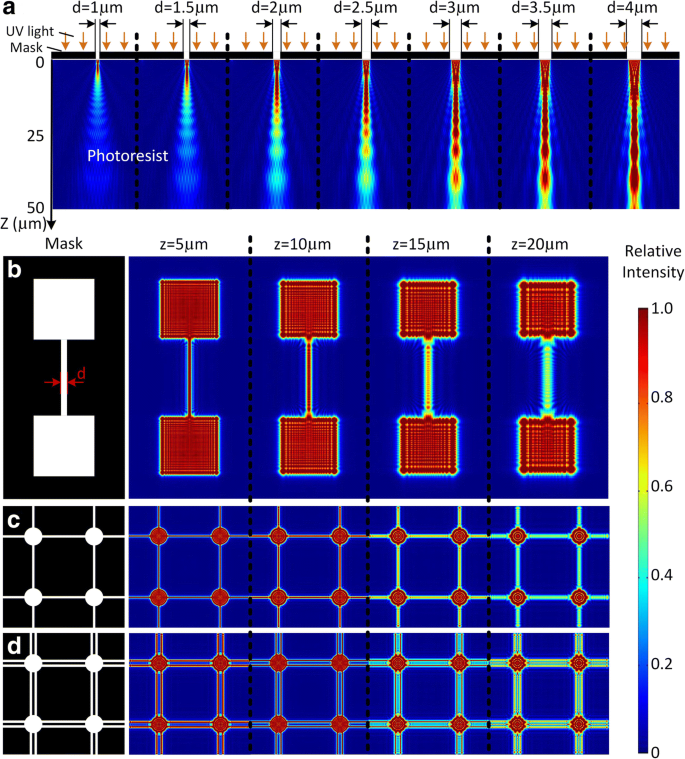
Шаблоны маски и результаты моделирования в фоторезисте. а Распределение интенсивности света под фотошаблоном d =1 мкм, 1,5 мкм, 2 мкм, 2,5 мкм, 3 мкм, 3,5 мкм и 4 мкм, где d ширина рисунка линии. Шаблон маски для b подвесные балки, c сетки и d сетки с набором линий и соответствующие распределения интенсивности света под z =5 мкм, 10 мкм, 15 мкм и 20 мкм в фоторезисте. Здесь z расстояние между плоскостью сечения и фото-маской
Подвесные конструкции из фоторезиста
Были проведены эксперименты по изготовлению подвесных конструкций. Мы проверили минимальное время выдержки для получения столбиков фоторезиста и определили его как порог выдержки. Затем четырех или трехкратное пороговое значение было принято за дозу облучения, и порог относительной интенсивности света был оценен как 0,75 в соответствии с моделированием. На рис. 4 показаны подвешенные балки фоторезиста при различных d ценность. Установлено, что толщина подвешенного слоя h положительно связан с d . Для фоторезиста НР26-25000П, h составляет 10,9 мкм при d =2 мкм (рис. 4a) и увеличивается до 25,5 мкм при d =4 мкм (рис. 4д). Как d доходит до 5 мкм, глубина экспонирования достаточна для достижения подложки, и никаких подвесных структур не получается (рис. 4е). На рис. 4ж – к изображены подвесные конструкции СУ-8. Функция h по сравнению с d как для экспериментов, так и для моделирования показано на рис. 4l, где прямые линии аппроксимируются методом наименьших квадратов. Коэффициент линейной корреляции R подогнанных линий - R 2 =0,963, 0,988 и 0,858 для моделирования без учета поглощения, NR26-25000P и SU-8 соответственно. Видно, что результаты экспериментов СУ-8 очень близки к результатам моделирования. Напротив, подвешенный слой NR26-25000P намного тоньше, чем слой моделирования без поглощения. В основном это связано с прозрачностью СУ-8 и высокой абсорбционной способностью NR26-25000P. Вот почему серая экспозиция может использоваться для изготовления подвесных конструкций для некоторых фоторезистов, но не подходит для СУ-8.
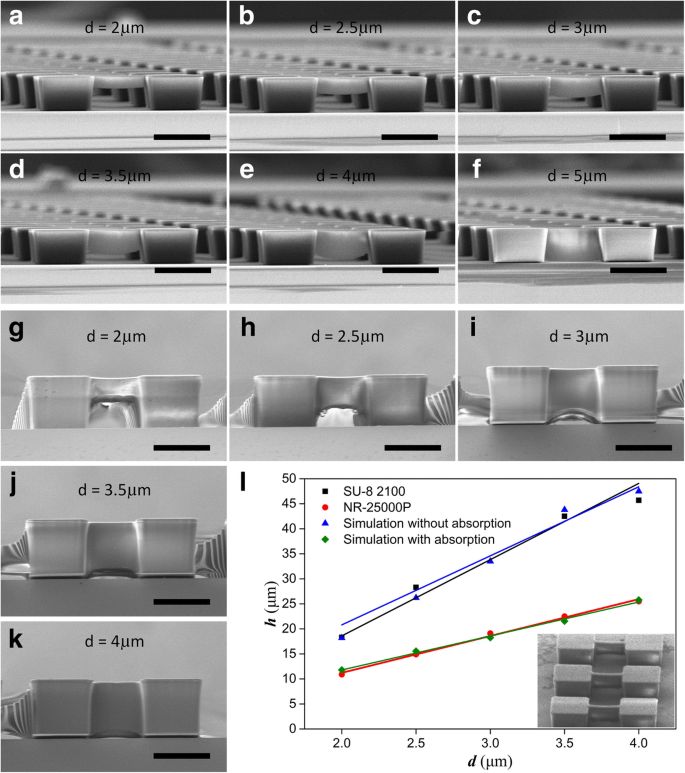
Подвешенные пучки фоторезиста получены в результате одноступенчатой дифракционной литографии с различной шириной линии d используя шаблон маски на рис. 3b. Лучи фоторезиста НР26-25000П под а г =2 мкм, b 2,5 мкм, c 3 мкм, d 3,5 мкм, e 4 мкм и f 5 мкм; Лучи фоторезиста СУ-8 2100 под г г =2 мкм, h 2,5 мкм, i 3 мкм, j 3,5 мкм и k 4 мкм; l зависимости толщины экспонирования от ширины линии при моделировании без поглощения, NR26-25000P и SU-8 2100, а также при моделировании с коэффициентом поглощения α =0,0374 мкм -1 , где на врезке - вид под наклоном подвесных балок СУ-8. Толщина лучей увеличивается с шириной линии рисунка маски. Масштабная линейка составляет 50 мкм
Затем вводим коэффициент поглощения α в оптической модели и провести расчеты по формуле (8). Результаты под α =0,0374 мкм -1 (коэффициент поглощения NR21-25000P при 365 нм, проверенный спектрофотометром УФ-видимой области, UV 2600, Shimadzu Co., Ltd.) показаны на рис. 4l, где аппроксимированная линия с R 2 =0,986 хорошо согласуется с экспериментальными результатами NR26-25000P. Таким образом, наш метод доступен практически для всех видов толстого негативного фоторезиста для изготовления подвесных структур с одноступенчатой экспозицией, в которой глубина экспозиции может контролироваться посредством моделирования.
На рис. 5a – c показаны различные схемы перекрестных соединений и соответствующие результаты моделирования в z =15 мкм. Три линии накладываются друг на друга, образуя широкую подвесную балку, у которой ширина линии и ширина интервала составляют 2 мкм. Схема перекрестного соединения с кругом 20 мкм используется для изготовления стойки для поддержки подвешенных балок (рис. 5а). Шаблоны полых поперечных соединений предназначены для изготовления подвешенных сеток, как показано на рис. 5b, c. Полученные соединения фоторезиста NR26-25000P показаны на рис. 5d – f, где четко видны текстуры поверхности на перекрестных соединениях вместе с балками, что хорошо согласуется с моделированием (рис. 5a – c). Подвесные сетки с тремя типами перекрестных соединений показаны на рис. 5g – i, а опорные стойки также получены, как и ожидалось (рис. 5g). На рис. 5h показаны тонкие столбы под поперечными соединениями из-за плотных рисунков с высоким соотношением. Схема перекрестного соединения на рис. 5c имеет более низкую продолжительность включения, где интенсивность света мала, что приводит к полностью подвешенной сетке (рис. 5f). Таким образом, соотношение схем перекрестных соединений может быть уменьшено для изготовления полных подвесных конструкций, в то время как опорные стойки могут быть легко сформированы с прочным соединением. Между тем, шириной луча также можно управлять, регулируя количество уложенных друг на друга шаблонов линий.
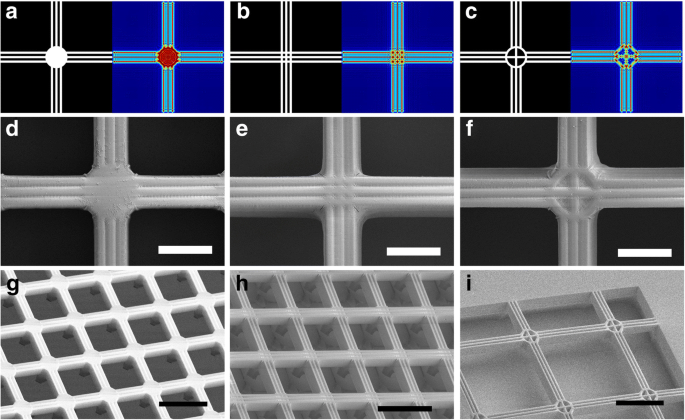
Различные схемы перекрестных соединений с NR26-25000P. а - c Три шаблона перекрестных соединений на маске и соответствующие результаты моделирования в z =15 мкм, где ширина линии составляет 2 мкм с шагом 2 мкм и z - расстояние между плоскостью сечения и фото-маской. г - е Текстуры на полученном фоторезисте перекрестные соединения и широкие балки, где масштабные линейки 20 мкм. г Подвесные сетки с опорными столбами. ч Подвешенные сетки с тонкими опорными столбами, где столбы являются результатом плотных перекрестных соединений с высоким соотношением. я Полностью подвесные сетчатые узоры. Масштабные линейки в g - я 100 мкм
Некоторые сложные трехмерные микроструктуры также были изготовлены с помощью метода однократного экспонирования (рис. 6a – c, e, f) или двухэтапного воздействия (рис. 6d). Подвесные балки с градиентной толщиной показаны на рис. 6а, где ширина рисунков линий варьируется от 2 до 4 мкм и от 4 до 6 мкм в двух областях. Толщина подвешенного слоя увеличивается с увеличением ширины линии в соответствии с результатами, показанными на рис. 4. Подвешенные концентрические кольца и подвешенные шаблоны слов также могут быть легко приготовлены (рис. 6b, c). За счет объединения двух процессов экспонирования два подвесных слоя были интегрированы в NR26-25000P, как показано на рис. 6d. После завершения первого экспонирования второй слой наносится методом центрифугирования на первый слой и экспонируется. Сложенные сетки получаются после двух процессов экспонирования, за которыми следует процесс проявления. Поскольку второе воздействие может вызвать повреждение первого слоя, необходимо тщательно оптимизировать конструкции, чтобы получить более качественные многослойные подвесные конструкции. Подвешенные сетки из фоторезиста SU-8 с текстовыми рисунками также успешно созданы (рис. 6d – f), хотя контролировать параметры экспозиции труднее, чем NR26-25000P, из-за высокой прозрачности.
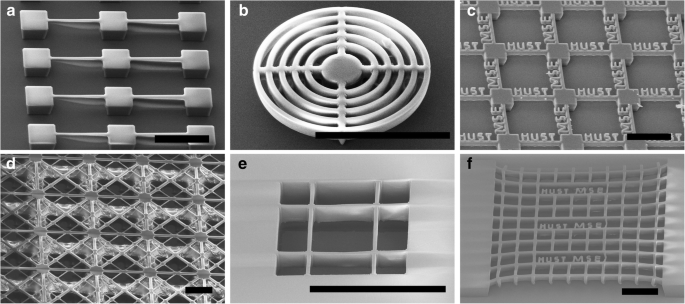
3D подвесные фоторезистивные конструкции. а Подвесные балки градиентной толщины, б подвесные концентрические кольца, c подвешенные словосочетания и d многослойные подвесные сетки, в которых фоторезист НР26-25000П. е Подвесная сетка СУ-8. е Подвесные сетки СУ-8 со словосочетаниями. Масштабные линейки составляют 100 мкм. Подвесные конструкции в d достигается за счет двухэтапной экспозиции, а остальные - за счет одноступенчатой экспозиции
По сравнению с предыдущими работами [2, 11, 22, 23], мы формируем трехмерную модель распределения интенсивности света в фоторезисте, используя дифракцию узоров малых масок. Трехмерные подвесные конструкции можно хорошо контролировать и прогнозировать с помощью моделирования. Здесь также учитывается коэффициент поглощения фоторезиста. Подвесные конструкции различной толщины, такие как градиентные балки, легко образуются за счет одностадийной экспозиции. Более того, процесс экспонирования выполняется с помощью обычной маски в типичном режиме контактного экспонирования, и никаких специальных масок или оборудования не требуется, что обеспечивает отличную совместимость с высоким разрешением при изготовлении.
Структуры пиролитического углерода
SU-8 является типичным предшественником для изготовления углеродных микроструктур, в то время как другие фоторезисты, такие как NR26-25000P, не могут выдерживать высокие температуры. На рис. 7a – c показаны подвешенные структуры SU-8, в то время как соответствующие структуры пиролитического углерода представлены на рис. 7d – f. Большая усадка происходит во время процесса пиролиза из-за множества одновременных реакций, включая дегидрирование, циклизацию, конденсацию, перенос водорода и изомеризацию [8, 28]. Таким образом, в пиролитических структурах, особенно в асимметричных, будет существовать значительное остаточное напряжение. Балки из пиролитического углерода сжимаются и растягивают стойки с обоих концов, вызывая трещины внизу (рис. 7d). Что касается крупномасштабных сеток, напряжение поддерживает относительный баланс в каждом направлении, и никаких явных трещин в структурах пиролитического углерода не обнаружено (рис. 7e, f). Получены свободно стоящие углеродные сетки размером 12 мм × 20 мм, как показано на рис. 7g – i. Пластовое сопротивление углеродных сеток составляет около 182 Ом / кв., А коэффициент пропускания света достигает ~ 67% на всей длине волны. Свежеприготовленные углеродные сетки с превосходной проводимостью и прозрачностью могут применяться в перовскитных солнечных элементах в качестве электрода [29,30,31], предлагая доступный метод изготовления полупрозрачных солнечных элементов. Кроме того, предварительно подготовленные углеродные сетки обладают превосходной гибкостью, демонстрируя большой потенциал в применении гибких прозрачных электродов.

Подвесные сетки СУ-8 и угольные сетки. а Подвесные балки СУ-8. б , c Подвесные сетки СУ-8 с опорными стойками. г Подвесные углеродные балки, где в углеродных структурах остались большие напряжения, а в нижней части колонны образовались трещины. е , f Подвесные углеродные сетки. г Свободностоящая угольная сетка после пиролиза. ч Увеличение отдельно стоящей угольной сетки. я Отдельно стоящая углеродная сетка размером 12 мм × 20 мм, которая обеспечивает хорошую гибкость и прозрачность. Масштабная линейка составляет 100 мкм
Выводы
Таким образом, мы продемонстрировали изготовление подвесных структур с помощью нового метода одностадийной дифракционной литографии на основе маски. Было смоделировано трехмерное распределение интенсивности света в фоторезисте, показав, что глубина экспонирования увеличивалась с увеличением ширины штриховых узоров под d <5 мкм. Это явление можно было использовать для изготовления подвесных структур с определенной толщиной фоторезиста SU-8, который был почти прозрачным и который трудно формировать подвесные структуры с помощью литографии в градациях серого. Здесь же проводились соответствующие эксперименты. Мы обнаружили, что толщина подвешенных балок СУ-8 была очень близка к результатам моделирования, в то время как толщина NR26-25000P была намного меньше, чем глубина воздействия при моделировании. Это было вызвано высоким свойством поглощения света NR26-25000P. Затем в оптическую модель был введен коэффициент поглощения фоторезиста, и результаты моделирования хорошо согласились с экспериментами. Для изготовления подвесных трехмерных сеток с опорными столбами или без них были разработаны три различных шаблона перекрестных соединений, а текстуры поверхности хорошо воспроизводились. Также были успешно созданы сетки со столбами и полностью подвешенные сетки. Другие сложные трехмерные подвесные структуры фоторезиста, включая подвесные балки с градиентной толщиной, подвешенные концентрические кольца и подвешенные структуры слов, были получены с помощью одноступенчатой дифракционной литографии на основе маски.
Углеродные подвесные конструкции и отдельно стоящие углеродные сетки были изготовлены с помощью типичного двухступенчатого процесса пиролиза. Подвешенные трехмерные углеродные структуры могут применяться в электрохимических электродах, суперконденсаторах и сенсорах благодаря большой площади поверхности. Отдельно стоящие сетки показали отличную проводимость, гибкость и высокую прозрачность. Таким образом, мы разработали упрощенный и многообещающий метод изготовления трехмерных подвесных конструкций и углеродных сеток, который показал большой потенциал в применении прозрачных электродов, полупрозрачных солнечных элементов и устройств хранения энергии.
Сокращения
- 3D:
-
Трехмерный
- C-MEMS:
-
Углеродные микроэлектромеханические системы
Наноматериалы
- Зрение:для слепых
- Ученые IBM изобрели термометр для наномасштаба
- Важность моделей САПР для проектов по изготовлению металлоконструкций
- Каковы преимущества нержавеющей стали для производственных проектов?
- В чем преимущества порошковой окраски металлоконструкций?
- 5 советов по выбору правильной компании по изготовлению на заказ
- Наилучшие способы подготовки производственного цеха к новой машине
- Спасибо за воспоминания!
- Как выбрать подходящие материалы для изготовления гибких печатных плат?
- Сосредоточьтесь на важных рекомендациях по проектированию для простоты изготовления печатных плат



