Рекомбинация с контролем деформации в множественных квантовых ямах InGaN / GaN на кремниевых подложках
Аннотация
В этой статье описываются свойства фотолюминесценции (ФЛ) светодиодов InGaN / GaN с множественными квантовыми ямами (МКЯ), выращенных на кремниевых подложках, которые были спроектированы с различной архитектурой контроля растягивающего напряжения, такой как периодическое δ-легирование Si для слоя GaN n-типа или вставка слоя InGaN / AlGaN для исследования механизма рекомбинации под контролем деформации в системе. Результаты ФЛ показали, что образцы, снятые с растягивающим напряжением, имели лучшие характеристики ФЛ, поскольку их внешняя квантовая эффективность увеличилась до 17%, что в 7 раз больше, чем у обычного образца. Детальный анализ подтвердил, что у них были меньшие скорости безызлучательной рекомбинации ((2,5 ~ 2,8) × 10 −2 s −1 по сравнению с (3,6 ~ 4,7) × 10 −2 s −1 ), что было связано с лучшим качеством кристаллизации и отсутствием дислокаций и трещин. Кроме того, их скорости излучательной рекомбинации оказались более стабильными и были намного выше ((5,7 ~ 5,8) × 10 −3 s −1 по сравнению с [9 ~ 7] × 10 −4 s −1 ) при комнатной температуре. Это приписывают подавлению мелких локализованных состояний на границах раздела МКЯ, в результате чего глубокие центры радиационной локализации внутри слоев InGaN доминируют в излучательной рекомбинации.
Фон
Структуры InGaN / GaN с множественными квантовыми ямами (МКЯ), выращенные на кремниевых подложках вместо обычного сапфира, привлекают все большее внимание в связи с их потенциальными приложениями в недорогом твердотельном освещении, панельных дисплеях и кремниевой фотонике [1,2,3,4, 5]. Критическим препятствием при изготовлении высококачественной пленки GaN на Si является несоответствие теплового расширения (56%) между GaN и Si, которое вызывает большие растягивающие напряжения и трещины в выращенных пленках GaN [6,7,8,9]. Кроме того, легированный кремнием слой GaN n-типа под слоями МКЯ необходим для светодиодов (LED) или лазерных диодов (LD). В этих случаях будет добавлено дополнительное растягивающее напряжение из-за легирования Si. В последние годы были предприняты усилия для преодоления этих трудностей путем использования промежуточных слоев с подходящим сжимающим напряжением для уравновешивания растягивающего напряжения [10,11,12,13,14, 15,16], дельта-легирование для релаксации деформации [17, 18] или нанесение буферного слоя с согласованной решеткой [19, 20]. Согласно предыдущим работам [17], периодическая архитектура δ-легирования Si в слое GaN n-типа может обеспечить более гладкий слой GaN с более высоким качеством кристаллизации и более низкой плотностью трещин, чем на однородно легированном Si GaN. Это было связано с уменьшением растягивающего напряжения. Был проведен ряд работ по исследованию морфологии поверхности, плотности дислокаций и электрических свойств кристаллических GaN / Si-легирующих δ-слоев GaN на сапфировых [21, 22] или кремниевых подложках [23]. К сожалению, немногие из них непосредственно исследовали люминесцентные свойства структур InGaN / GaN с МКЯ поверх Si δ-легирующего слоя GaN и прояснили взаимосвязь между повышением эффективности люминесценции и снятием деформации, вызванной улучшениями структуры пленки, которые имеют решающее значение для устройства. изготовление. Также стоит упомянуть, что прямое измерение деформации или наблюдение искажений решетки без разрушения образцов светодиодов затруднено. Для оценки внутренней деформации всегда применяются косвенные методы. Например, для модуляции внутренней деформации применялось механическое давление, что приводило к изменениям пьезоэлектрического поля внутри МКЯ, а также к оптоэлектронным характеристикам светодиодных устройств [24,25,26,27]. В любом из этих случаев было обнаружено, что измерения спектров люминесценции необходимы для оценки характеристик устройства, связанных с деформацией.
Поэтому в данной работе светодиодные структуры с МКЯ InGaN / GaN наносились на подложки из кристаллического кремния. Для сравнения выращивался либо однородно легированный Si GaN, либо периодический Si, δ-легированный GaN, работающий как слой GaN n-типа. Кроме того, были подготовлены еще два контрольных образца на основе равномерно легированных Si слоев GaN n-типа с добавлением тонкого слоя AlGaN или InGaN соответственно для подтверждения анализа влияния сжимающего напряжения или растягивающего напряжения на характеристики устройства, как AlGaN имеет меньшую постоянную решетки, чем GaN, что частично снимает растягивающее напряжение с поверхности, а вставленный слой InGaN, наоборот, увеличивает растягивающее напряжение. Относительные эффективности фотолюминесценции (ФЛ) и время жизни (скорости) рекомбинации для каждого образца были извлечены из спектров стационарной (SS) ФЛ при изменении температуры и спектров ФЛ с временным разрешением (TR), а затем систематически проанализированы. Результаты показали, что образцы, снятые с растягивающим напряжением, обладают лучшими характеристиками ФЛ, поскольку как безызлучательная рекомбинация, связанная с дефектами структуры, была подавлением, так и излучательная рекомбинация больше связана с состояниями глубокой рекомбинации внутри ямных слоев InGaN, что привело к излучательной рекомбинации, которая более стабильна с температурой. .
Методы
Как показано на схеме на рис. 1, эпитаксиальный рост МКЯ InGaN / GaN проводился методом химического осаждения из газовой фазы из металлоорганических соединений, о котором сообщалось в предыдущей работе [17]:слой AlN толщиной 100 нм, слой AlGaN с линейным градиентом толщиной 660 нм и слой AlGaN 200 нм. Номинально нелегированный слой GaN был выращен на подложке Si (111) в качестве буфера при 1060, 1060 и 1020 ° C соответственно. Для образцов S1, S3 и S4 на буфер был нанесен однородно легированный слой GaN толщиной 1 мкм с расчетной концентрацией атомов Si около 10 18 см −3 . Для образцов S3 и S4 после однородно легированного слоя GaN кремния n-типа наносили слой InGaN толщиной 20 нм с In% ~ 10 ат.% Или слой AlGaN толщиной 20 нм с Al% ~ 20%. Для образца S2 на буфер было выращено 20 периодов δ-легированных Si-плоскостей, каждая из которых сопровождалась 50 нм номинально нелегированным GaN с общей толщиной 1 мкм вместо однородно легированного Si-слоя GaN. После этого на каждом образце S1 – S4 было выращено 6 периодов квантовых ям InGaN / GaN при 800 ° C, в которых состав индия составляет около 22,0 ат.%. Средняя толщина ямы / барьера была оценена как 2,4 нм / 10 нм. После этого при 1020 ° C были выращены легированные магнием слои GaN p-типа толщиной 220 нм. Для тестирования спектров ФЛ в качестве источника возбуждающего света использовалась система Zolix-750 PL с импульсным лазером мощностью 10 мВт, 377 нм, а в качестве фотодетектора - ПЗС-матрица ANDOR Newton с разрешением 0,09 нм. При измерениях TRPL затухания ФЛ регистрировались коррелированной по времени системой однофотонного счета в диапазоне 10–300 К.
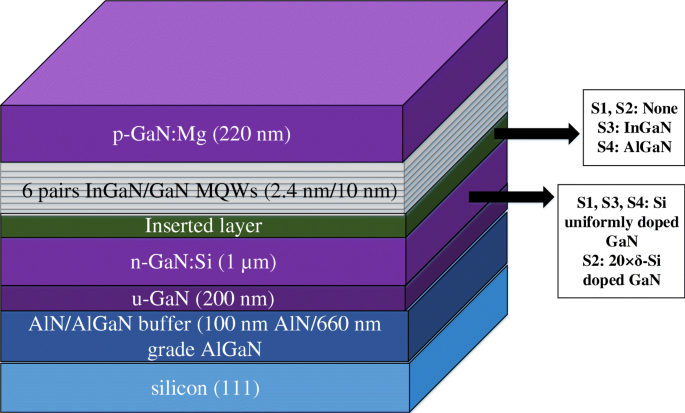
Структуры образцов светодиодов МКЯ, выращенных на подложках Si. S1, S3 и S4 содержат однородно легированный слой GaN n-типа толщиной 1 мкм. S3 содержит вставленный слой InGaN толщиной 20 нм. S4 содержит вставленный слой AlGaN толщиной 20 нм. S2 содержит 20 периодов плоскостей, легированных Si-δ, за каждой из которых следует 50 нм номинально нелегированного GaN с общей толщиной 1 мкм вместо однородно легированного Si слоя GaN n-типа
Результаты и обсуждение
Обзор свойств SSPL для каждого протестированного образца МКЯ при 10 К показан на рис. 2. Как видно на вставке, исходная МКЯ на Si-структурированном S1 демонстрирует пики излучения около 500-650 нм с осцилляцией Фабри-Перо. Спектры ФЛ для всех четырех образцов имеют одинаковый характер. Это явление обычно наблюдается в светодиодах на основе GaN, выращенных на подложках Si [28,29,30], поскольку граница раздела буфер / Si имеет большой коэффициент отражения, поэтому значительная нисходящая доля интенсивности ФЛ от МКЯ отражается и мешает прямому восходящему направлению. дробная часть. Эти пики колебаний можно просто описать как гауссовские сигналы PL, умноженные на элемент колебания (1 + Acos (4 πnd / λ )) (показано красной кривой на вставке к рис. 1), где A представляет силу колебаний, n - средний показатель преломления пленки МКЯ, d - вся толщина пленки МКЯ, а λ - длина волны ФЛ. Согласно модели, описанной выше, исходный пик гауссовой ФЛ можно подобрать и выделить из пиков сложных колебаний (показанных синей кривой на вставке на рис. 1). Результат SSPL показал, что S1 имеет острый зеленый пик ФЛ при 531 нм, в соответствии с шириной запрещенной зоны кристалла InGaN с In% ~ 22at%. Для сравнения, S2 со слоем GaN n-типа, легированным Si, имеет заметно смещенный в красную сторону пик ФЛ при 579 нм, S3 со вставленным слоем InGaN имеет слегка смещенный в синюю пик пик ФЛ при 517 нм, а S4 со вставленным слоем AlGaN имеет слегка красное смещение. пик при 545 нм. Учитывая, что вставленный слой AlGaN играет роль снятия растягивающего напряжения, знакомого с функцией δ-легирования Si, тогда как вставленный слой InGaN усиливает растягивающее напряжение, эти результаты показывают, что растягивающее напряжение на подложке приведет к синему смещению положения ФЛ МКЯ. или увеличение средней ширины запрещенной зоны InGaN хорошо. Эффект снятия деформации у Si-легированного δ-легированным слоем GaN намного сильнее, чем у вставленного слоя.
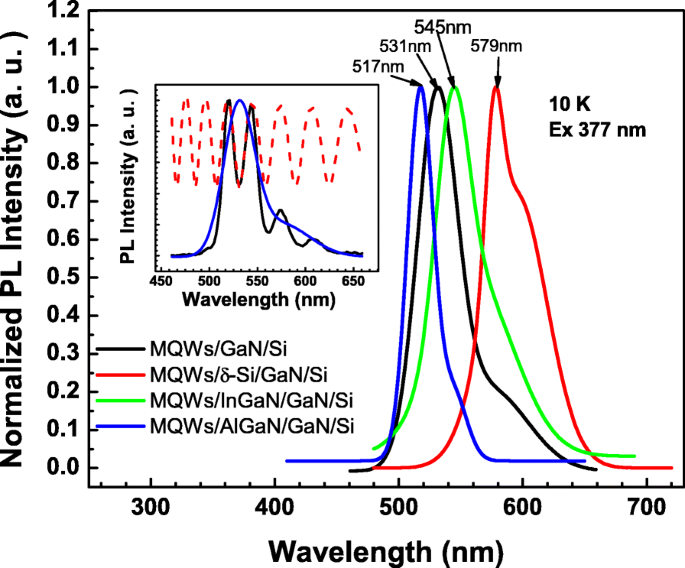
Обзор SSPL для S1 – S4, возбуждаемого лазером 377 нм при 10 K. Исходные сигналы PL содержат колебания Фабри-Перо, которые показаны черной кривой на вставке (например, S1). Элемент осцилляции (красная штриховая кривая) и пик гауссовой ФЛ (синяя кривая) разделены путем подгонки исходных сигналов. Все данные PL для S1 – S4 обрабатываются одним и тем же методом, а затем разделенный гауссовский PL показан на рисунке
Для понимания природы рекомбинации в МКЯ критически важно проверить их свойства затухания ФЛ, поскольку времена жизни ФЛ, связанные со скоростями излучательной / безызлучательной рекомбинации, могут быть непосредственно извлечены из кривых затухания. Здесь затухание ФЛ измерялось с фиксацией обнаруженной длины волны при пиковых значениях S1 – S4, а измерения проводились при различных температурах в диапазоне от 10 до 300 К. На рисунке 3 показаны три типичные кривые затухания ФЛ для S1, испытанные при 10, 100. , и 300 К. Обнаружено, что затухания ФЛ для всех S1 – S4 имеют тенденцию изменяться с температурой. Это явление отражает температурные зависимости как скоростей излучательной рекомбинации, так и скоростей безызлучательной рекомбинации в образцах. Для каждой кривой затухания использовалась следующая функция экспоненциального затухания:
$$ I (t) ={I} _0 {e} ^ {- t / \ tau} $$ (1)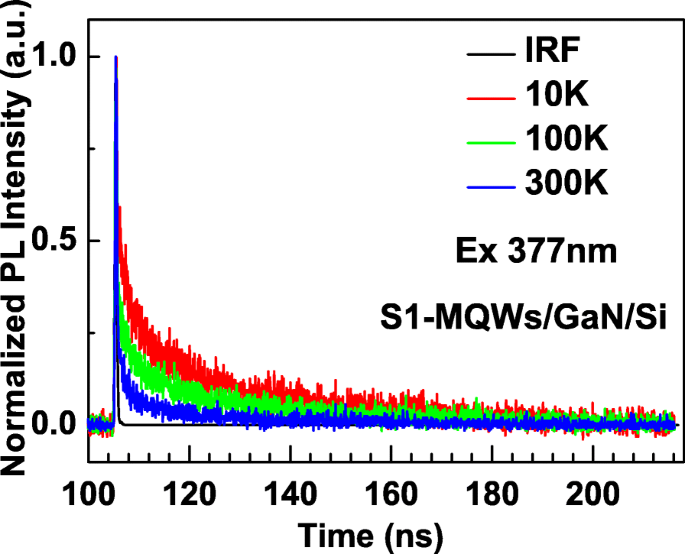
Кривые затухания фотолюминесценции S1 при возбуждении импульсным лазером 377 нм при 10 К, 100 К и 300 К
где I 0 представляет интенсивность ФЛ при t =0 и τ представляет собой время жизни PL. Следует отметить, что не вся кривая затухания может быть идеально описана вышеупомянутой функцией экспоненциального затухания. Это широко обсуждалось несколькими группами [31,32,33,34]. Разумным предположением было то, что в системе существует несколько центров рекомбинации. Иногда для подгонки кривых использовалась многоэкспоненциальная функция затухания. Здесь, чтобы не вводить слишком много допущений, которые трудно наконец проверить, или чтобы анализ неправильно отражал только второстепенные части всех свойств ФЛ, мы использовали простейшую модель для извлечения среднего времени жизни ФЛ для каждого образца, которое может отражать общие динамические свойства PL. Полученные времена жизни для S1 – S4 собраны на рис. 4а. Чтобы связать динамические результаты PL с вероятностью рекомбинации, скорость рекомбинации k был определен как k =1 / τ . Пятна k от температуры для S1 – S4 также показаны на рис. 4б. Результаты ясно показывают два различных типа эволюции k при температуре, что скорости рекомбинации для образцов S2 и S4, снятых с растягивающим напряжением, меньше, чем для исходного образца S1, или для образца с обостренным растягивающим напряжением S3 во всем диапазоне температур и сильнее возрастают с повышением температуры. Обратите внимание, что k = k r + к № , в котором k r представляет скорость излучательной рекомбинации и k № представляет собой скорость безызлучательной рекомбинации. Ожидается, что k № увеличивается при повышении температуры и преобладает k при комнатной температуре, поскольку это всегда связано с процессами энергообмена с теплом [35]. Итак, k результаты на высокотемпературной стороне на рис. 4b демонстрируют твердое доказательство того, что процессы снятия напряжения, такие как δ-легирование Si и введение AlGaN, оказывают положительное влияние на подавление безызлучательной рекомбинации в МКЯ посредством уменьшения дислокационных дефектов или трещин, которые имеют большое влияние на k № . Но к r становится незаменимым в условиях низких температур. Следовательно, для объяснения поведения k необходимы дополнительная информация и дальнейший анализ. на стороне низких температур.

а Времена жизни ФЛ в зависимости от температуры для S1 – S4. Обнаруженная длина волны сохраняется в каждой позиции пика в соответствии с результатами SSPL на рис. 2. b Соответствующие скорости рекомбинации для S1 – S4, которые получаются с помощью k =1 / τ
Следовательно, для разделения k r и k № от каждого k значения были измерены спектры SSPL при различных температурных режимах для каждого образца. Затем интенсивность каждого пика PL, соответствующая их длинам волн, обнаруженным в предыдущих тестах TRPL, была записана как I ( Т ). После этого относительную эффективность ФЛ определяли как η = Я ( Т ) / Я 0 , в котором I 0 представляет интенсивность ФЛ при 0 К. Полученные значения эффективности ФЛ для S1 – S4 собраны на рис. 5а. Можно обнаружить, что эффективность фотолюминесценции для S2 и S4 составляет около 17%, что в 7 раз больше, чем у S1. Известно, что только излучательная рекомбинация вносит вклад в интенсивность ФЛ; следовательно, эта относительная эффективность ФЛ отражает отношение скорости излучательной рекомбинации к общей скорости рекомбинации:
$$ \ eta ={k} _r / \ left ({k} _r + {k} _ {nr} \ right) ={k} _r / k $$ (2)
а Относительная эффективность фотолюминесценции в зависимости от температуры для S1 – S4. Обнаруженная длина волны сохраняется в каждой позиции пика в соответствии с результатами SSPL на рис. 2. b Полная скорость рекомбинации, скорость излучательной рекомбинации и скорость безызлучательной рекомбинации в зависимости от температуры для S1
Таким образом, он способен разрешить k r = kη и k № = k (1 - η ) из результатов TRPL в сочетании с η . Соответствующий расчет для k r и k № S2 показан на рис. 5б в качестве примера. Результаты показали, что даже для S2 с δ-легирующей модификацией Si скорость безызлучательной рекомбинации больше, чем скорость излучательной рекомбинации до достижения очень низкой температуры 50 К. Это объясняет причину, по которой k продолжает увеличиваться при повышении температуры, потому что она преобладает в k № . Это также указывает на высокую потребность в дальнейшем улучшении кристаллического качества МКЯ на структурах Si. Скорость излучательной рекомбинации k r было обнаружено, что оно монотонно снижается с ростом температуры, что не согласуется с типичными свойствами ФЛ, возникающими в результате рекомбинации свободных электронно-дырочных пар, которые k r свободен от температуры. Однако это разумно, если процесс ФЛ является доминирующим в локализации экситона. Экситоны имеют тенденцию делокализоваться в более высоком температурном диапазоне; в результате повышение температуры приведет к снижению скорости локализации [32]. к № и k r в зависимости от температуры для S1 – S4 приведены на рис. 6a, b соответственно. Как показано, результаты k № при 300 К для S2 и S4 равны 2,5 × 10 −2 s −1 и 2,8 × 10 −2 s −1 соответственно, что ниже, чем у S1 (3.6 × 10 −2 s −1 ) и S4 (4,7 × 10 −2 s −1 ). Это дополнительно подтверждает, что процессы снятия напряжения подавляют образование дислокаций и трещин в МКЯ, что, в свою очередь, снижает плотность центров безызлучательной рекомбинации. Этот эффект подавления становится более чувствительным при понижении температуры. Полученные k r результаты более сложные. Как показано, k r для S1 и S3 снижается гораздо сильнее, чем для S2 и S4 после повышения температуры. В результате получено k r при 300 К для S2 (5,7 × 10 −3 s −1 ) и S4 (5,8 × 10 −3 s −1 ) намного выше, чем для S1 (9 × 10 −4 s −1 ) и S3 (7 × 10 −4 s −1 ). Это явление разумно отнести к процессам снятия деформации:согласно вышеизложенному, излучательные процессы в этих образцах МКЯ в основном связаны с рекомбинацией экситонов в локализованных состояниях. Здесь k r в основном определяется скоростью локализации экситона k loc . Резкое падение k loc с ростом температуры указывает на то, что средняя глубина локализованных состояний в системе относительно мала, что облегчает делокализацию экситона при высокой температуре. Другими словами, средние глубины локализованных состояний в образцах с деформацией снятия как S1 и S3 меньше, чем у образцов без деформации. Основываясь на предыдущих работах [36], центры локализованной излучательной рекомбинации в МКЯ InGaN / GaN часто возникают из-за структурных дефектов в слоях ям InGaN, таких как вариации толщины ям и кластеры с высоким содержанием индия, в которых вариации толщины ям предлагают мелкие состояния, а также Кластеры, богатые индием, предлагают состояния с гораздо большей глубиной [33]. Здесь результат k r указывает на то, что сильное растягивающее напряжение на границах раздела МКЯ между подложкой Si и GaN, легированным кремнием, может улучшить образование радиационных мелких структурных дефектов, поэтому глубина локализованных состояний для S1 и S3 меньше, а также изменения толщины являются доминирующими в процессах локализации экситонов. . Для S2 и S4 вариации толщины ям подавляются, поэтому процессы локализации экситонов доминируют в глубоких состояниях внутри ям InGaN, демонстрируя гораздо большие средние глубины локализованных состояний и более стабильные k r в зависимости от температуры. Следовательно, образцы S1 и S3 демонстрируют более высокие k r чем S2 и S4 на низкотемпературной стороне, где эффект делокализации экситона слаб, но намного меньше k r при комнатной температуре.

а Зависимость скоростей безызлучательной рекомбинации от температуры для S1 – S4. б Скорость излучательной рекомбинации в зависимости от температуры для S1 – S4
Выводы
Таким образом, варьируемые по температуре спектры SSPL и TRPL были исследованы для различных МКЯ InGaN / GaN на структурах Si с обработкой для снятия растягивающего напряжения или без нее. Было обнаружено, что образец с δ-легированным Si слоем GaN или вставленным слоем AlGaN имел меньшую скорость рекомбинации и более высокую эффективность ФЛ (до 17%), чем обычный образец (2,5%) или образец со вставленным слоем InGaN (1,6%). Дальнейший анализ показал, что меньшие скорости рекомбинации в основном обусловлены меньшими преобладающими скоростями безызлучательной рекомбинации (2,5 × 10 −2 s −1 для образца с δ-легированием 3,6 × 10 −2 s −1 для вставленного образца AlGaN по сравнению с 3,6 × 10 −2 s −1 для обычной выборки и 4,7 × 10 −2 s −1 для вставленного образца InGaN), что объясняется подавлением образования дислокаций или трещин. Помимо меньших скоростей безызлучательной рекомбинации, лучшие характеристики ФЛ также обусловлены более стабильными и высокими скоростями излучательной рекомбинации при комнатной температуре (5,7 × 10 −3 s −1 для образца с δ-легированием 5,8 × 10 −3 s −1 для вставленного образца AlGaN по сравнению с 9 × 10 −4 s −1 для обычной выборки и 7 × 10 −4 s −1 для вставленного образца InGaN). Они также были приписаны подавлению вариаций толщины ям на границах раздела МКЯ, в результате чего глубокие центры радиационной локализации внутри слоев InGaN доминируют в процессе излучательной рекомбинации. Приведенные выше результаты показали четкую картину процессов рекомбинации светодиодных устройств InGaN / GaN MQW на кремниевых подложках, которые могут служить ориентиром при производстве устройств в будущем.
Сокращения
- IQE:
-
Внутренняя квантовая эффективность
- LD:
-
Лазерный диод
- Светодиод:
-
Светодиод
- MQW:
-
Множественная квантовая яма
- PL:
-
Фотолюминесценция
- SSPL:
-
Стационарная фотолюминесценция
- TRPL:
-
Фотолюминесценция с временным разрешением
Наноматериалы
- Квантовый транспорт становится баллистическим
- Создание одноатомных кубитов под микроскопом
- Нанокремний для производства водорода
- Нанопокрытие для нескольких цветов
- Нанографема, гибкая прозрачная память на основе кремния
- Атомная перестройка множественных квантовых ям на основе GaN в смешанном газе H2 / NH3 для улучшения структурных …
- Многоцветное излучение ультрафиолетовой фотонной квазикристаллической нанопирамиды на основе GaN с полуполя…
- Трибохимический износ безоксида кремния, зависящий от скорости скольжения,
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…



