Теоретическое моделирование радиационного отклика сверхрешетки Si, Ge и Si / Ge на низкоэнергетическое облучение
Аннотация
В этом исследовании низкоэнергетические радиационные отклики Si, Ge и Si / Ge сверхрешетки исследуются методом молекулярной динамики ab initio и исследуются причины их различного радиационного поведения. Обнаружено, что радиационная стойкость атомов Ge, которые находятся вокруг границы раздела Si / Ge сверхрешетки, сравнима с объемным Ge, тогда как атомы Si вокруг границы раздела сложнее смещать, чем объемный Si, что демонстрирует повышенную радиационную стойкость, поскольку по сравнению с объемным Si. Механизмы генерации дефектов в объемных структурах и структурах сверхрешетки несколько различаются по характеру, а связанные с ними дефекты в сверхрешетке более сложны. Расчеты образования и миграции дефектов показывают, что в структуре сверхрешетки точечные дефекты образуются сложнее, а вакансии менее подвижны. Повышенная радиационная стойкость сверхрешетки Si / Ge будет полезна для ее применения в качестве электронных и оптоэлектронных устройств в условиях радиационной обстановки.
Фон
В течение последних десятилетий сверхрешетка (СР) Si / Ge привлекала большое внимание в исследованиях полупроводников из-за ее потенциального вклада в разработку новых электронных и оптоэлектронных устройств [1,2,3,4,5,6]. Например, исследование фотопроводимости Si / Ge SL имеет большое значение для фотодиодов как излучателя и приемника для быстрой оптической связи [5]. В таких приложениях, как космический электронный компонент, микроэлектронный компонент, солнечная батарея и космическая электроника [1, 4, 6], оптические и электронные свойства Si / Ge SL могут быть изменены из-за бомбардировки высокой энергия ионов из космической среды, что приводит к снижению производительности электронных устройств. Следовательно, необходимо исследовать радиационные характеристики этого полупроводникового материала в экстремальных рабочих условиях.
В последнее время многие исследователи изучали эффекты радиационного повреждения сверхрешетки Si / Ge [7,8,9,10,11,12,13,14,15,16]. Соболев и др. исследовали влияние электронного облучения на фотолюминесценцию (ФЛ) Si / Ge SL, содержащего монослой чистого Ge, и обнаружили повышенную радиационную стойкость структуры SL по сравнению с объемным кремнием [12]. Fonseca et al. облучил Si / Ge SL с внедренными квантовыми точками (КТ) Ge, используя облучение протонами 2,0 МэВ, и обнаружил необычайно высокую радиационную стойкость структуры QD-in-SL [13]. Аналогичные результаты были получены Leitão et al., Которые сообщили, что квантовые ямы (КЯ) Ge, нанесенные на диодную структуру, содержащую многослойную структуру Si / Ge, были более устойчивы к протонному облучению по сравнению с одиночными квантовыми ямами Ge [14]. Как перспективные термоэлектрические материалы, термоэлектрические характеристики системы Si / Ge могут также изменяться в радиационной среде [11,15]. Zheng et al. облучил несколько периодических слоев Si 1 - x Ge x / Si с использованием ионов Si с энергией 5 МэВ, и они обнаружили, что термоэлектрическая добротность увеличивается с увеличением плотности потока ионов Si [11]. Дефекты и структурный беспорядок уменьшают теплопроводность поперечной плоскости за счет поглощения и рассеивания фононов вдоль решетки, а плотность электронных состояний в мини-зоне структуры КТ увеличивает электропроводность и коэффициент Зеебека, которые все способствуют увеличению рисунка заслуг [11].
Теоретически Сайед и Виндл исследовали атомные смещения объемного Si, используя метод классической молекулярной динамики (МД) [17, 18]. Они обнаружили, что пороговые энергии смещения (E d s) зависят от направления выбивания, а поврежденные состояния - это в основном дефекты пар Френкеля (ФП) [17, 18]. Caturla et al. исследовали влияние массы и энергии ионов на радиационное повреждение объемного Si с помощью метода МД [19]. Они сообщили, что образование аморфизации, а также отдельных точечных дефектов и небольших кластеров сильно зависит от массы иона и слабо - от энергии ионов [19]. Holmström et al. вычислил E d s для германия методом МД и обнаружил, что стабильные дефекты являются дефектами ФП [20]. Shaw et al. применил ab initio метод для изучения влияния дефектов сурьмы и германия на электронную структуру гетероструктур Si / Ge и обнаружил, что эти дефекты взаимодействуют с интерфейсами Si / Ge, что приводит к локализованным резонансам на границе раздела и большим локальным возмущениям в электронной структуре. структура [21]. Несмотря на указанные исследования, теоретического моделирования динамического процесса радиационного повреждения Si / Ge SL в литературе до сих пор не сообщалось. По-прежнему отсутствует понимание на атомном уровне эволюции микроструктуры и лежащего в основе механизма образования дефектов в полупроводниковых сверхрешетках.
Метод неэмпирической молекулярной динамики (AIMD) оказался важным инструментом для выяснения процессов радиационного повреждения и действительно оказался успешным при моделировании событий отдачи в ряде полупроводниковых и керамических материалов [22,23,24, 25,26,27]. По сравнению с классическим методом МД, межатомные потенциалы получают из расчетов электронной структуры, а не эмпирической подгонки экспериментальных результатов. Следовательно, множество физических параметров, таких как E d s может быть определено с точностью ab initio. В данном исследовании метод AIMD используется для сравнения поведения отклика объемных Si, Ge и Si / Ge SL при низкоэнергетическом облучении. Определены пороговые энергии смещения, а также указано распределение дефектов и пути их образования. Возможная причина расхождения в радиационной стойкости между объемным Si (Ge) и Si / Ge SL также исследуется. Представленные результаты дают фундаментальное представление о микроскопическом механизме событий смещения в объемных Si, Ge и Si / Ge SL и способствуют пониманию радиационных откликов этих материалов в радиационной среде.
Методы
События низкоэнергетического смещения объемных Si, Ge и Si / Ge SL моделируются программой Испанской инициативы по электронному моделированию с тысячами атомов (SIESTA). Сохраняющие норму псевдопотенциалы Труллье-Матрина [28] используются для определения взаимодействия между ионами и электронами, а обменно-корреляционный потенциал описывается приближением локальной плотности (LDA) в параметризации Чеперли-Альдера [29]. Волновые функции валентности расширяются базисным набором локализованных атомных орбиталей, и используются базисные наборы с одним ζ плюс поляризационная орбиталь (SZP) с дискретизацией по K-точкам 1 × 1 × 1 в зоне Бриллюэна и разрезом от энергии 60 Ry. В настоящем исследовании Si 2 / Ge 2 Рассмотрена СЛ, состоящая из двух слоев Si, чередующихся с двумя слоями Ge, содержащими всего 288 атомов. На рис. 1 показана геометрическая конфигурация объемного Si и Si / Ge SL. Конкретный атом выбирается как первичный ударный атом (PKA), и ему дается кинетическая энергия, чтобы инициировать событие отдачи. Если PKA возвращается в исходное положение в конце события смещения, моделирование перезапускается с более высокой энергией отдачи с приращением энергии 5 эВ. После того, как PKA окончательно смещается из своего узла решетки, выполняются дополнительные прогоны для повышения точности до 0,5 эВ. Для каждого типа атомов учитываются четыре и пять главных направлений падения для объемного Si (Ge) и Si / Ge SL соответственно. Моделирование проводится с помощью ансамбля NVE, и максимальная продолжительность каждого запуска составляет 1,2 пс, чтобы избежать нестабильности системы.

Схематическое изображение геометрических структур а объемный Si и b Сверхрешетка Si / Ge. Синие и зеленые сферы представляют собой атомы Si и Ge соответственно
Результаты и обсуждение
События смещения в массовом кремнии и германии
Постоянная решетки объемного Si определена равной 5,50 Å, что хорошо согласуется с теоретическим результатом 5,48 Å [30] и экспериментальным результатом 5,43 Å [31]. По сравнению с объемным Si постоянная решетки объемного Ge больше, т.е. 5,71 Å, что согласуется с расчетным результатом 5,65 Å [30] и экспериментальным значением 5,77 Å [31]. Рассчитанные нами пороговые энергии смещения для объемных Si и Ge приведены в Таблице 1 вместе с соответствующими дефектами после событий смещения. Конфигурации для конечных состояний повреждения Si- и Ge-отдачи показаны на рис. 2 и 3 соответственно.

а - г Схематическое изображение геометрических структур повреждений Si после событий отдачи. Зеленая и красная сферы представляют собой вакансию и межузельный дефект соответственно. V Si :вакансия кремния; Si int :кремний межстраничный

а - г Схематическое изображение геометрических структур повреждений Ge после событий отдачи. Красные и синие сферы представляют собой вакансию и межузельный дефект соответственно. V Ge :вакансия германия; Ge int :межузельный германий
Для объемного Si, E d значения немного меньше экспериментальных результатов 21 эВ для [001] [32], ~ 47,6 эВ для [110] [33] и ~ 12,9 эВ для направлений [111] [34], и как эксперимент, так и наши расчеты показывают, что поврежденные конечные состояния являются дефектом пары Френкеля (FP). Также отмечается, что E d значения в настоящем исследовании в целом сопоставимы с результатами MD, сообщенными Windl et al. [18], за исключением случая [110], для которого наше вычисленное значение 47 эВ намного больше, чем результат МД 24 эВ. Предыдущее моделирование взаимодействий ион-твердое тело в SiC с помощью AIMD показало, что событие смещения на самом деле является процессом переноса заряда, а перенос заряда к атомам отдачи и от них может изменить энергетические барьеры и динамику для стабильного образования дефектов [35]. Меньшие значения E d найденное AIMD по сравнению с определенным классическим MD может быть связано с тем, что перенос заряда, который происходит во время событий отдачи, учитывается методом AIMD, тогда как в классическом MD-моделировании заряд атомов является фиксированным. В исследовании Виндла и др. Кинетическая энергия передается в PKA для создания одной кремниевой вакансии (V Si ) и одно кремниевое межузельное пространство (Si int ) дефекты [18]. Напротив, в нашем исследовании связанные дефекты для события смещения Si [110] содержат два V Si и два Si int дефекты, приводящие к более высоким энергиям для образования поврежденных состояний. E d значения для Si [111] и Si \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) очень близки друг к другу, т.е. 9,5 и 10 эВ соответственно. В обоих случаях созданные дефекты - это V Si и Si int (см. рис. 2в, г), тогда как механизмы генерации дефектов имеют другой характер. В случае Si [111] Si PKA движется в направлении \ (\ left [11 \ overline {1} \ right] \) из-за отталкивающих взаимодействий и сталкивается со своим соседним атомом Si. Затем Si PKA рассеивается, занимая промежуточный сайт (Si int ), а замещенный Si возвращается обратно в узел решетки PKA. Связанные дефекты - это один V Si и один Si int дефекты. Что касается Si \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), событие смещения относительно проще, то есть Si PKA перемещается на 4,69 Å от узла своей решетки к сформировать Si int дефект. В случаях Si [001] и Si [110] E d s определены равными 20 и 47 эВ, соответственно, что указывает на то, что атомам Si труднее смещаться в направлении [110]. Концевые состояния повреждения для Si [001] и Si [110] несколько различаются. В случае Si [001] PKA получает кинетическую энергию и движется в направлении [001], сталкиваясь с соседними атомами. Замещенный атом Si продолжает движение и занимает позицию внедрения, как показано на рис. 2а. Что касается Si [110], PKA рассеивается в направлении \ (\ left [11 \ overline {1} \ right] \) из-за отталкивающих взаимодействий между PKA и соседними атомами и попадает в один соседний атом Si (Si1). . Затем Si PKA отскакивает в направлении [111], чтобы заменить другой атом Si (Si2), и атом Si2 в конце концов занимает позицию внедрения. Атом Si1 получает энергию, достаточную для движения в направлении [110], и замещает свой соседний атом Si (Si3), который образует межузельный дефект. В конце концов, связанные дефекты - это два V Si и два Si int дефекты, как показано на рис. 2b.
Для объемного Ge значения E d хорошо согласуются с экспериментальным значением ~ 18 эВ [36] и теоретическим значением 18,5 эВ [20] для направления [001]. Следует отметить, что текущее значение 9,5 эВ сравнимо с результатом Холмстрёма 12,5 эВ [20] для направления [111], что меньше экспериментального значения ~ 15 эВ [36]. Для Ge [111] и Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) определенное E d значения всего 9,5 эВ, что указывает на то, что атомы Ge легко перемещаются в этих двух направлениях. В обоих случаях ассоциированными дефектами являются вакансия германия и междоузлия германия (см. Рис. 3в, г). Для Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) Ge PKA не следует по прямому пути, а сильно отклоняется одним из ближайших соседей и занимает межстраничный сайт (Ge int ). Напротив, в случае Ge [111], Ge PKA перемещается на 4,92 Å вдоль направления [111], образуя межузельный дефект (Ge int ). По сравнению с E d Для Ge [001] значение Ge [110] на 10 эВ больше, что указывает на то, что атом Ge сложнее смещать в направлении [110]. Хотя связанные дефекты для Ge [001] и Ge [110] похожи, механизмы генерации дефектов несколько различаются. Ge PKA получает кинетическую энергию и движется в направлении [001], сталкиваясь с соседними атомами. Замещенный атом Ge продолжает движение и занимает позицию внедрения, как показано на рис. 3а. Что касается Ge [110], то отдача Ge сталкивается с его первым соседним атомом Ge (Ge1) вдоль направления [110] и отскакивает вдоль направления [111], в результате чего образуется Ge int . Атом Ge1 покидает узел своей решетки и замещает соседний атом Ge (Ge2). Впоследствии атом Ge2 возвращается в узел решетки Ge1, и в конечном итоге только один V Ge и один Ge int образуются дефекты, как показано на рис. 3б. Эти результаты показывают, что в объемных Si и Ge E d s сильно зависят от кристаллографического направления, и атомы сложнее смещать вдоль направления [110]. Конечные состояния радиационного повреждения в объемных Si и Ge представляют собой в основном дефекты FP, то есть вакансионные и межузельные дефекты.
События смещения в сверхрешетке Si / Ge
В этом исследовании события смещения Si 2 / Ge 2 Рассмотрены СЛ, состоящие из двух слоев Si, чередующихся с двумя слоями Ge (см. Рис. 1б). Атомы Si и Ge, которые примыкают к границе раздела Si / Ge, выбираются в качестве PKA. E d s для Si и Ge отдачи и связанные с ними дефекты перечислены в таблице 2. Конфигурации дефектов для Si и Ge отдачи показаны на рис. 4 и 5 соответственно. Отмечается, что в случае Si [111] дефекты не создаются даже при энергиях до 100 эВ. Из-за вычислительных ограничений мы не проводили дальнейшее моделирование событий отдачи при энергиях выше 100 эВ, а точное значение E d значение для Si [111] не определено.

а - г Схематическое изображение геометрических структур поврежденной сверхрешетки Si / Ge после событий отдачи Si. Синие и зеленые сферы представляют атомы Si и Ge соответственно. V X : X вакансия ( X =Si или Ge); X int : X межстраничное ( X =Si или Ge); X Y : X занимая Y узел решетки ( X и Y =Si или Ge). Фиолетовые и красные сферы представляют собой вакансию и межузельный дефект соответственно
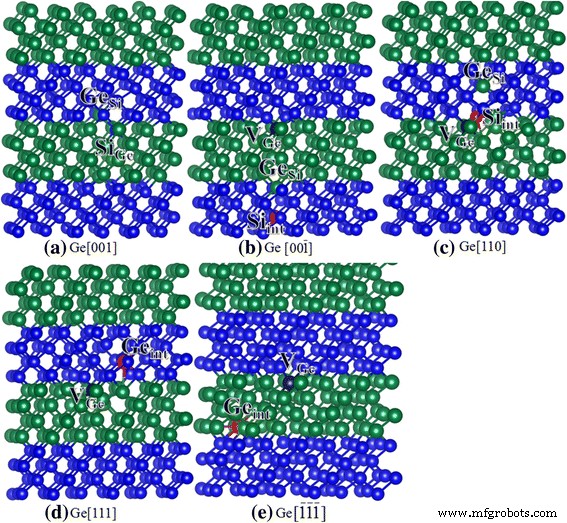
а - е Схематическое изображение геометрических структур поврежденной сверхрешетки Si / Ge после событий отдачи Ge. Синие и зеленые сферы представляют атомы Si и Ge соответственно. V X : X вакансия ( X =Si или Ge); X int : X межстраничное ( X =Si или Ge); X Y : X занимая Y узел решетки ( X и Y =Si или Ge). Фиолетовые и красные сферы представляют собой вакансию и межузельный дефект соответственно
В структуре Si / Ge SL Si PKA легко перемещается в направлении \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), как показано маленький E d значение 10 эВ. Путь образования дефектов очень прост, то есть Si PKA перемещается на 4,61 Å от своего узла решетки и образует Si int дефект. Для Si [001] и Si \ (\ left [00 \ overline {1} \ right] \) E d s определены равными 46,5 и 42,5 эВ соответственно, а поврежденные дефекты отличаются, как и ожидалось. В случае Si [001], Si PKA перемещается в направлении [001], замещая свой соседний атом Ge (Si Ge ), а замещенный атом Ge сталкивается со своим соседним атомом Si и занимает его узел решетки, образуя Ge Si антисайтовый дефект. Замещенный атом Si получает достаточную энергию и в дальнейшем заменяет другой атом Ge (Si Ge ), который, наконец, занимает промежуточный сайт. В конечном итоге связанные дефекты составляют один V Si , один Ge int , и три антисайтовых дефекта. Что касается Si \ (\ left [00 \ overline {1} \ right] \), два соседних атома Ge и один соседний атом Si также участвуют в событии смещения, а поврежденные состояния содержат две вакансии, два междоузлия и два антиструктурные дефекты, как показано на рис. 4b. В случае Si [110] атом Si движется, чтобы столкнуться с соседним атомом Si, и рассеивается в направлении \ (\ left [11 \ overline {1} \ right] \). Затем Si PKA замещает один соседний атом Ge, который в конце концов занимает междоузлие. После событий смещения связанные дефекты содержат один V Si , один Si Ge, и один Ge int дефекты. По сравнению с объемным Si, атомы Si в СР Si / Ge, как правило, сложнее смещать, за исключением случая [110], и механизмы генерации дефектов более сложны, что указывает на то, что в СР объемного Si и Si / Ge разные радиационные реакции на облучение. Наши результаты согласуются с экспериментами, проведенными Fonseca et al. и Leitão et al. [13, 14], которые также обнаружили, что радиационная стойкость структуры SL была увеличена по сравнению с массивным кремнием.
При отдаче Ge в Si / Ge SL атомы Ge легко перемещаются в направлениях [111] и \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \), которые аналогичны событиям отдачи Ge в массивном Ge. Хотя конечные состояния радиационного повреждения для Ge [111] и Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) очень похожи, т.е. дефекты Ge FP, механизмы дефекта генерации разные. В случае Ge [111], Ge PKA перемещается на 4,77 Å от своего узла решетки и образует Ge int дефект. Для Ge \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) атом Ge движется по \ (\ left [\ overline {1} \ overline {1} \ overline {1} \ right] \) вместо соседнего атома Ge. Столкнувшийся атом Ge движется в этом направлении и в конце занимает междоузлие. Отмечается, что E d значения 16 эВ для Ge [001] и 17,5 эВ для Ge \ (\ left [00 \ overline {1} \ right] \) сравнимы со значением 18 эВ для Ge [001] в объемном Ge, тогда как соответствующие дефекты проявляют разный характер. В случае Ge [001], Ge PKA получает достаточную энергию, но рассеивается в направлении [111], замещая свой соседний атом Si, образуя Ge Si антисайтовый дефект. Затем замещенный атом Si занимает узел ПКА решетки Ge и образует антиструктурный дефект (Si Ge ). В случае Ge \ (\ left [00 \ overline {1} \ right] \), Ge PKA перемещается на 5,63 Å, чтобы заменить соседний атом Si. Атом Si движется в этом направлении и образует Si int дефект. По сравнению с Ge [110] в объемном Ge, E d для Ge [110] в Si / Ge SL на 8,5 эВ меньше, а связанные с ними дефекты более сложные, на что указывает один V Ge , один Ge Si , и один Si int дефекты. Сравнивая события отдачи Ge в объемных Ge и SL, мы обнаруживаем, что атомы Ge в Si / Ge SL более устойчивы в направлении [110]. Для других событий смещения E d s обычно сравнимы с таковыми для объемных состояний. Однако конечные состояния радиационных повреждений в объемных СР Ge и Si / Ge различны, и в структуре СР Si / Ge создаются некоторые антиструктурные дефекты. Эти результаты позволяют предположить, что отдача Ge в структуре Si / Ge SL демонстрирует различный радиационный отклик на облучение. Сравнивая отдачу Si и Ge в структуре SL, мы обнаруживаем, что события смещения атомов Si подвержены гораздо большему влиянию, чем Ge, то есть E d s для атомов Si в структуре SL обычно увеличиваются, что может привести к повышенной радиационной стойкости Si / Ge SL. Соболев и др. обнаружили, что SL Si / Ge демонстрируют чрезвычайно высокую радиационную стойкость по сравнению с объемным Si [12], что согласуется с нашими результатами.
Энергия образования дефектов и миграционный барьер в объемной сверхрешетке Si, Ge и Si / Ge
В объемных Si и Ge поврежденными состояниями являются в основном вакансионные и межузельные дефекты. Что касается Si / Ge SL, связанные дефекты содержат вакансионные, межузельные и антиструктурные дефекты, а механизмы генерации дефектов, как правило, более сложны. Несоответствие в сопротивлении дефектообразованию между материалами объемных компонентов и Si / Ge SL может привести к их разной радиационной стойкости. Для дальнейшего изучения происхождения различных радиационных откликов этих полупроводниковых материалов мы рассчитываем энергии образования вакансионных, межузельных и антиструктурных дефектов в объемных состояниях и SL-структурах, а также миграционный барьер наиболее подходящих дефектов, используя метод теории функционала плотности. Вычисления основаны на суперячейке, состоящей из 64 атомов, с дискретизацией 6 × 6 × 6 k-точек в реальном пространстве и энергией отсечки 500 эВ.
Энергии образования дефектов в объемных Si, Ge и Si / Ge SL приведены в таблице 3 вместе с другими результатами расчетов. В массивном Si энергии образования V Si , Si int , и Si FP-дефекты рассчитаны на 3,60, 3,77 и 4,62 эВ соответственно, что находится в разумном согласии с другими расчетами [37,38,39,40]. Наши результаты показывают, что V Si дефект легче создать в массивном Si. Точно так же V Ge объемный дефект Ge энергетически более выгоден, чем Ge int и Ge FP-дефекты, на что указывает наименьшая энергия образования дефектов 2,23 эВ, что хорошо сравнимо с теоретическим значением 2,09 эВ [39]. Что касается СР Si / Ge, энергия образования V Ge определяется равным 2,73 эВ, что меньше энергии образования других дефектов. Следующий благоприятный дефект - V Si . дефект, а энергия образования определена равной 2,85 эВ. Отмечается, что значение 3,52 эВ для Ge int меньше, чем значение 3,77 эВ для Si int дефект. Что касается дефекта FP, энергия образования, очевидно, больше, то есть 5,19 эВ для Si FP и 5,01 эВ для Ge FP, что свидетельствует о том, что дефекты FP трудно создать. По сравнению с объемными состояниями энергии образования дефектов для структуры Si / Ge SL обычно больше, за исключением дефектов V Si и Si int , что указывает на то, что в структуре SL образование точечных дефектов, как правило, сложнее. Такое несоответствие в сопротивлении дефектообразованию между объемными состояниями и структурой Si / Ge SL может привести к их разной реакции на облучение.
На основе оптимизированных структур поведение миграции V Ge и V Si Далее исследуются дефекты, которые являются наиболее подходящими дефектами в объемных структурах и структурах Si / Ge SL. V Ge и V Si учитываются дефекты, которые примыкают к границе раздела Si / Ge, а миграционные барьеры сведены в Таблицу 4. Следует отметить, что миграционные барьеры вдоль направлений [100] и [110] для V Ge дефекты меньше, чем у V Si дефекты, а энергетический барьер для V Ge миграция в направлении [111] немного больше, чем для V Si миграции, что согласуется с результатами, полученными Cowern et al. [41].
Энергетические ландшафты миграции дефектов вдоль направлений [100], [110] и [111] показаны на рис. 6. На рис. 6а показаны миграционные барьеры V Si Дефект вдоль направления [100] определен как 4,32 и 3,92 эВ в объемном Si и Si / Ge SL соответственно. Что касается направления [110], миграционный барьер 2,14 эВ для V Si в структуре Si / Ge SL очень близко к значению 2,12 эВ в объемном Si. Сравнивая миграционный барьер вдоль каждого направления, мы обнаруживаем, что направление [111] является наиболее благоприятным направлением миграции как для вакансий Si, так и для Ge, на что указывают значительно меньшие миграционные барьеры. В частности, V Si дефекты легче мигрируют вдоль направления [111] в объемном Si, чем Si / Ge SL, поскольку энергетический барьер 0,11 эВ в объемном состоянии намного меньше (см. рис. 6e). Что касается V Ge Для дефектов миграционные барьеры в направлении [100] рассчитаны равными 3,67 эВ в объемном Ge и 2,87 эВ в Si / Ge SL. В случае направления [110] энергетические барьеры определены равными 1,94 и 1,39 эВ в объемной и SL-структурах соответственно. Как и в случае миграции вакансии Si, V Ge дефекты легче перемещаются в направлении [111]. Кроме того, миграция происходит легче в объемном Ge, чем в Si / Ge SL, как показано на рис. 6f. Наши расчеты показывают, что вакансии Si и Ge более подвижны в объемных состояниях, чем структура SL, что может приводить к образованию пустот и даже к объемному распуханию. Это может способствовать разным ответам на облучение для объемных и SL структур.
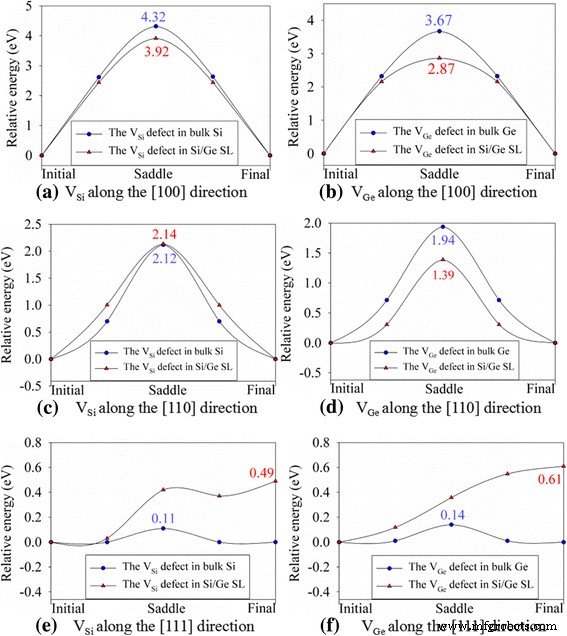
Миграционный барьер кремниевой вакансии (V Si ) и вакансии германия (V Ge ) дефекты, полученные методом кластерной подталкиваемой резинки. а V Si по направлению [100]; б V Ge по направлению [100]; c V Si по направлению [110]; г V Ge по направлению [110]; е V Si по направлению [111]; е V Ge по направлению [111]
Выводы
Таким образом, события низкоэнергетического смещения в объемной сверхрешетке (СР) Si, Ge и Si / Ge были исследованы методом молекулярной динамики ab initio. Показано, что в объемных Si и Ge пороговые энергии смещения зависят от кристаллографического направления, и атомы труднее смещать вдоль направления [110]. Поврежденные состояния в объемных состояниях - это в основном вакансионные и межузельные дефекты. В структуре Si / Ge SL атомы Si более устойчивы в направлении [111], а атомы Ge сложнее смещаться в направлении [110]. Наши расчеты показывают, что энергии отдачи Ge в структуре SL в целом сопоставимы с энергиями отдачи в объемном Ge, тогда как энергии отдачи Si в структуре SL обычно намного больше, чем в объемном Si, что свидетельствует о повышенной радиационной стойкости. Si / Ge SL. Расчеты энергии образования дефектов показывают, что точечные дефекты в SL Si / Ge обычно имеют более высокие энергии образования, что указывает на то, что в структуре SL точечные дефекты, как правило, образовывать труднее. Также обнаружено, что направление [111] является наиболее благоприятным путем миграции как для вакансий Si, так и для Ge, и обе вакансии более подвижны в объемных состояниях, чем в структуре SL. Наши расчеты показывают, что повышенная радиационная стойкость Si / Ge SL выгодна для его применения в качестве электронных и оптоэлектронных устройств в экстремальных рабочих условиях, таких как радиация.
Сокращения
- AIMD:
-
Молекулярная динамика ab initio
- E d :
-
Пороговая энергия смещения
- FP:
-
Пара Френкеля
- Ge:
-
Германий
- Ge int :
-
Межстраничный германий
- Ge Si :
-
Германий, занимающий узел кремниевой решетки
- LDA:
-
Приближение локальной плотности
- MD:
-
Молекулярная динамика
- NVE:
-
Микроканонический ансамбль
- PKA:
-
Первичный ударный атом
- PL:
-
Фотолюминесценция
- QD:
-
Квантовая точка
- QW:
-
Квантовая яма
- Si:
-
Кремний
- SIESTA:
-
Испанская инициатива по электронному моделированию тысяч атомов
- Si Ge :
-
Кремний, занимающий узел решетки германия
- Si int :
-
Кремний межстраничный
- SL:
-
Сверхрешетка
- SZP:
-
Базисные наборы с одним ζ плюс поляризационная орбиталь
- V Ge :
-
Вакансия германия
- V Si :
-
Вакансия кремния
Наноматериалы
- Оценка IoT и влияния 5G
- Раскрытие атомной и электронной структуры углеродных нановолокон с набором чашек
- Моделирование молекулярной динамики и имитация алмазной резки церия
- Исследование первых принципов стабильности и STM-изображения борофена
- Исследование структурных, электронных и магнитных свойств кластеров Ag n V (n =1–12)
- Влияние отжига на микроструктуру и упрочнение сплавов с последовательным имплантированным гелием и водород…
- Изготовление и характеристика ZnO Nano-Clips с помощью процесса, опосредованного полиолом
- Быстро развивающийся мир моделирования
- Разница между двигателями постоянного и переменного тока
- Мощь 3D-моделирования и симуляции стимулирует инновации в производственных процессах



