Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал мягкого ограничения восьмипериодных квантовых ям In0.2Ga0.8N / GaN синего цвета Светодиоды
Аннотация
Особенности восьмипериодного В 0.2 Ga 0.8 Исследованы квантовые ямы (QW) N / GaN с легированием кремнием (Si) в первых двух-пяти квантовых барьерах (QB) в последовательности роста синих светодиодов (LED). Эпитаксиальные слои структур квантовых ям выращены на 20 парах In 0,02 Ga 0,98 Сверхрешетка N / GaN, действующая как слои снятия напряжения (SRL) на сапфировых подложках с рисунком (PSS) с помощью системы химического осаждения из паровой фазы (LP-MOCVD) при низком давлении. Спектры температурно-зависимой фотолюминесценции (ФЛ), зависимость тока от напряжения ( I - V ) кривые, выходная мощность света в зависимости от тока инжекции ( L - Я ) кривые и изображения просвечивающей электронной микроскопии высокого разрешения (HRTEM) эпитаксиальных слоев. Последствия показывают, что квантовые ямы с четырьмя КЯ, легированными кремнием, имеют большую энергию локализации носителей (41 мэВ), более низкие напряжения включения (3,27 В) и пробоя (-6,77 В), а также более высокую выходную мощность свечения синих светодиодов при более высокой инжекции. тока, чем другие образцы. Низкая высота барьера QB в образце QB, легированном четырьмя Si, приводит к мягкому ограничению потенциала QW и более низкому напряжению включения и пробоя диода. Изображения HRTEM свидетельствуют о том, что этот образец имеет относительно диффузные границы раздела квантовых ям. Равномерное распределение носителей среди восьми квантовых ям и превосходная локализация носителей в каждой лунке ответственны за увеличение выходной мощности света, в частности, за высокий ток инжекции в образце QB, легированном четырьмя Si. Результаты показывают, что четыре QB из восьми In 0,2 Ga 0.8 КЯ N / GaN с легированием Si не только уменьшают квантово-ограниченный эффект Штарка (QCSE), но также улучшают распределение и локализацию носителей в квантовых ямах для улучшения оптических характеристик синих светодиодов.
Фон
Легирование кремнием (Si) в квантовые барьеры (КБ) GaN может вызвать кулоновское экранирование поляризационного поля и вызвать подавление квантово-ограниченного эффекта Штарка (КВШ) в квантовых ямах (КЯ) InGaN / GaN. Излучательная рекомбинация экситонов в квантовых ямах InGaN / GaN может быть значительно усилена за счет использования КД, легированных кремнием [1,2,3,4]. Флуктуации состава индия (In) и спинодального фазового разделения происходят в тройном сплаве InGaN из-за присущей твердофазной зазоры смешиваемости GaN и InN. Формирование кластеров с высоким содержанием In может действовать как сильная локализация носителей, предотвращая ловушки центров безызлучательной рекомбинации (NRC) и облегчая излучательную рекомбинацию экситонов в квантовых ямах InGaN / GaN [5,6,7,8,9,10]. Колебания состава индия в квантовых ямах InGaN / GaN оказывают значительное влияние на поведение устройств, например, на внутреннюю квантовую эффективность (IQE), внешнюю квантовую эффективность (EQE) и вольт-амперные характеристики. Следует учитывать флуктуацию индия в квантовых ямах InGaN / GaN для лучшего объяснения характеристик устройств [11]. КЯ InGaN / GaN с КЯ, легированными кремнием, продемонстрировали свойства модификации наноструктуры материала и образования островков нанометрового размера из-за спирального роста слоев квантовых ям [12], повышения термической стабильности квантовых ям InGaN / GaN [13], улучшение светоотдачи и характеристик электростатического разряда (ESD) светодиода по мере увеличения концентрации легирования в QB [14], простая блокировка переноса дырочных носителей, приводящая к рекомбинации экситонов в ямах между GaN p-типа (p-GaN ) и легированные барьеры [15] и др.
Сообщается о благоприятных периодах и толщине квантовых ям InGaN / GaN для высокой яркости и высокого EQE при высоком токе инжекции (выше нескольких десятков мА) синих светодиодов [16,17,18]. В отчетах девять периодов квантовых ям InGaN / GaN, выращенных на узорчатых сапфировых подложках (PSS), демонстрируют значительное улучшение мощности светового излучения и характеристик спада EQE [16]. Лучшие оптические и электрические характеристики синих светодиодов демонстрируются, если активная область состоит из 12 периодов квантовых ям InGaN / GaN при токе инжекции 42 А / см 2 [17]. Очевидное уменьшение спада EQE и улучшение IQE продемонстрировано для толщины QB, уменьшенной с 24,5 до 9,1 нм, в результатах моделирования светодиодов InGaN / GaN [18]. Легирование кремнием необходимой толщины и количества квантовых ям в квантовых ямах InGaN / GaN имеет решающее значение для дальнейшего повышения яркости и эффективности синих светодиодов InGaN, работающих при высоком токе инжекции. В этом отчете мы представляем оптические, электрические и материальные характеристики восьмипериодного In 0,2 Ga 0.8 КЯ N / GaN с первыми двумя-пятью КД в последовательности роста, легированные кремнием синих светодиодов. Результаты дают более глубокое понимание механизмов локализации носителей, потенциала ограничения и QCSE квантовых ям в зависимости от поведения синих светодиодов при высоком токе инжекции.
Экспериментальные методы
На рисунке 1 схематически показаны структуры слоев материала образцов синих светодиодов. Эпитаксиальные слои осаждаются в горизонтальном реакторе системы химического осаждения из паровой фазы (LP-MOCVD) при низком давлении на PSS с ориентацией (0001) (c-плоскость). Диаметр, высота и интервал правильных пирамидальных структур на ФПС составляют 2, 1,5 и 1 мкм соответственно. PSS имеют толщину 3 мкм и предварительно нагреваются до 1150 ° C в среде водорода перед ростом эпитаксиальных слоев. Триметилгаллий (TMGa), триметилиндий (TMIn), триметилалюминий (TMAl) и газообразный NH 3 используются в качестве парофазных предшественников элементарного галлия (Ga), In, алюминия (Al) и азота (N) соответственно. Силан (SiH 4 ) и бис-циклопентадиенилмагний (Cp 2 Mg) являются предшественниками примеси Si и магния (Mg) в веществах n- и p-типа соответственно. Газы-носители прекурсоров - смесь водорода (H 2 ) и азот (N 2 ) с соотношением 1:1, который химически неактивен.
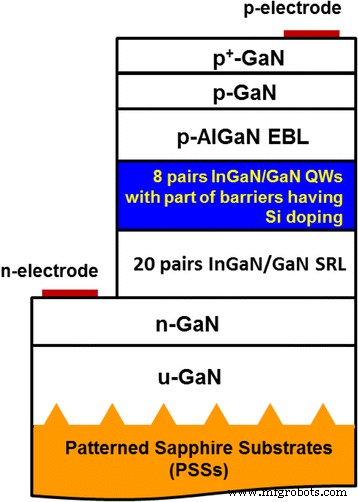
Принципиальная схема слоистой структуры изготовленных микросхем синих светодиодов. Эти схематические рисунки толщины эпитаксиального слоя преувеличены для ясности и не в масштабе
На PSS выращивают нелегированный буферный слой GaN (u-GaN), а затем GaN n-типа, легированный кремнием (n-GaN) толщиной 3 и 3,3 мкм. Концентрация легирования n-GaN составляет 10 19 см −3 . Двадцать пар In 0,02 Ga 0,98 Затем на n-GaN наносится сверхрешетка N / GaN толщиной 2/2 нм. Он играет роль слоев разгрузки натяжения (ССС), которые используются для уменьшения распространения деформации от эпитаксиальных слоев на ПСС.
Активные слои синих светодиодов содержат восьмипериодный In 0,2 Ga 0.8 КЯ N / GaN. Толщина КЯ и КЯ составляет 2.5 и 8 нм с температурой роста 750 и 900 ° C соответственно. Легирование Si с концентрацией около 3 × 10 17 см −3 в первых двух, трех, четырех и пяти QB в последовательности роста обозначены как образцы A, B, C и D соответственно. p-тип Al 0,16 Ga 0,84 Слой блокировки электронов азота (EBL) имеет толщину 20 нм и выращивается при 950 ° C с легированием Mg. слой окна p-GaN и p + -Контактный слой GaN выращивают при 950 ° C с толщиной 100 и 20 нм, а концентрация легирования составляет 10 19 и 10 20 см −3 .
Эпитаксиальные слои избирательно вытравливаются на слой n-GaN с помощью системы с индуктивно связанной плазмой (ICP) для формирования светодиода мезаструктуры. Прозрачный контактный слой (TCL) оксида индия и олова (ITO) наносится на p + -GaN с помощью электронно-лучевого испарителя. Слои многометаллических контактных электродов хром / платина / золото (Cr / Pt / Au) впоследствии испаряются на p + -Слои GaN и n-GaN для хорошего омического контакта. Пластины светодиодов шлифуются и полируются до толщины примерно 120 мкм для нарезания кристаллов. Стандартные светодиодные устройства меза-типа с квадратным кристаллом размером 1 мм 2 производятся.
Зависимость тока от напряжения ( I - V ) кривые и светоотдача ( P вне ) от тока впрыска ( L - Я ) измерены кривые от 20 до 300 мА при комнатной температуре (КТ) диодов. Спектры температурно-зависимой фотолюминесценции (ФЛ) восьмипериодного In 0,2 Ga 0.8 Рассмотрены квантовые ямы N / GaN. Источником возбуждающего света ФЛ является He-Cd лазер (325 нм) со средней мощностью 45 мВт. Изображения, полученные с помощью просвечивающей электронной микроскопии высокого разрешения (HRTEM), были получены с помощью автоэмиссионного просвечивающего электронного микроскопа EM-3000F (FE-TEM) с ускоряющим напряжением 300 кВ и разрешением 0,14 нм.
Результаты и обсуждение
На рис. 2 представлены спектры ФЛ образцов при различных температурах от 10 до 300 К. Наблюдается монотонное уменьшение интенсивности пика ФЛ с повышением температуры. Это происходит из-за усиления процесса безызлучательной рекомбинации с повышением температуры. Все спектральные профили ФЛ аппроксимируются гауссовыми функциями формы линий для нахождения изменений максимальной энергии пика в зависимости от температуры, как показано на рис. 3. Максимальная энергия пика излучения ФЛ для нелегированного In 0,2 Ga 0.8 КЯ N / GaN составляет 2,68 эВ при комнатной температуре. Это означает, что энергии пиков ФЛ образцов с первыми двумя-пятью КД, легированными кремнием, демонстрируют голубой сдвиг по сравнению с нелегированным. Первые два-пять квантовых ям с легированием кремнием могут эффективно снизить QCSE в квантовых ямах. Следует отметить, что использование PSS и SRL в структурах эпитаксиальных слоев может уменьшить долю пьезоэлектрического (PZ) поля, а также QCSE в In 0.2 Ga 0.8 N / GaN QW.

Температурно-зависимые спектры ФЛ образцов при различных температурах от 10 до 300 К

Зависимость максимальной энергии пика ФЛ от температуры образцов. Наиболее подходящие кривые, использующие уравнение Варшни, показаны жирными и черными сплошными линиями
На рис. 3 могут быть показаны вариации максимальной энергии пика ФЛ в зависимости от температуры, которые имеют S-образные кривые для всех образцов. На S-образных кривых сначала отображается красный цвет, затем синий, а затем красный сдвиг с повышением температуры. Такое поведение объясняется температурно-зависимой коллективной люминесценцией сильных локализованных экситонов в квантовых ямах. Эмпирическое уравнение Варшни, показанное ниже, можно использовать для подбора диапазона сдвига от синего к красному для вариаций S-формы [19,20,21].
$$ {E} _ {\ mathrm {g}} (T) ={E} _ {\ mathrm {g}} (0) - \ frac {\ alpha {T} ^ 2} {\ left (T- \ beta \ right)} - \ frac {\ sigma ^ 2} {k _ {\ mathrm {B}} T} $$ (1)где E g (0), α , β , и σ - подгоночные параметры. E g (0) - ширина запрещенной зоны КЯ при абсолютной температуре 0 К. α и β - термические коэффициенты, зависящие от материала. σ - параметр гауссова уширения, который физически отражает степень теплового распределения носителей в локализованных состояниях зонного хвоста. Второй член в формуле. (1) указывает на то, что ширина запрещенной зоны полупроводников имеет тенденцию к уменьшению с повышением температуры, и это известно как сокращение запрещенной зоны из-за увеличения амплитуды колебаний атомов. Третий член используется для характеристики степени локализации носителей в зависимости от температуры в предположении невырожденного распределения носителей и гауссовской локализованной плотности состояния. Сильная локализация носителей является ключевым аспектом в реализации увеличения излучательной рекомбинации и IQE в квантовых ямах InGaN из-за улучшения перекрытия между волновыми функциями электронов и дырок. Уравнение Варшни неприменимо в области красного смещения энергии пика ФЛ при низкой температуре из-за сильного вырождения в распределении носителей заряда. Наилучшие результаты подгонки образцов показаны жирными и черными сплошными кривыми на рис. 3. Энергия локализации образцов A, B, C и D составляет 24, 28, 41 и 13 мэВ соответственно. Образец C обладает наибольшей энергией локализации σ (41 мэВ). Локализация носителей заряда в квантовых ямах с четырьмя квантовыми ящиками, легированными кремнием, сильнее остальных. Наименьшая энергия локализации ( σ ) происходит в образце D со значением 13 мэВ.
Ток-напряжение ( I - V ) характеристики при прямом и обратном смещении синих светодиодов показаны на рис. 4. На этом рисунке напряжения включения для образцов A, B, C и D составляют 3,41, 3,47, 3,27 и 4,03 В при прямом токе. 20 мА соответственно. Напряжения пробоя для образцов A, B, C и D составляют -8,85, -9,99, -6,77 и -11,55 В при обратном токе 1 мкА соответственно. Образец C имеет наименьшее напряжение включения и пробоя. Образец D имеет наибольшее напряжение включения и пробоя. Соответственно, более низкая высота барьера QB предлагается в образце C. Мягкий (плавный) ограничивающий потенциал QW ожидается в образце с первыми четырьмя QB, имеющими легирование Si. Профиль потенциала мягкого ограничения подразумевает, что смещения зоны проводимости и валентной зоны квантовых ям не рассматриваются как функции резкого скачка, т.е. не прямоугольный ограничивающий потенциал. Плавные ограничивающие потенциалы могут в значительной степени подавить оже-рекомбинацию и предотвратить накопление большого количества носителей в первых нескольких скважинах в направлении закачки квантовых ям InGaN / GaN [22,23,24]. Плавный ограничивающий потенциал также может быть получен за счет линейного уменьшения состава In вдоль направления роста квантовых ям InGaN / GaN. Это может привести к лучшему распределению носителей между квантовыми ямами и транспортировке дырок, что приведет к улучшению быстрого падения EQE и выходной мощности [25,26,27,28,29,30].
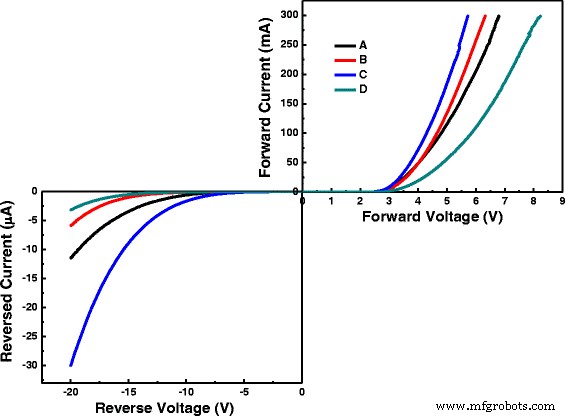
Ток-напряжение ( I - V ) кривые при прямом и обратном смещении диодов
На рисунке 5 показаны измерения выходной мощности света ( P вне ) светодиодов в зависимости от тока инжекции ( L - Я ) от 0 до 300 мА тестером микросхемы. Увеличение P вне при повышении тока впрыска на л - Я кривые можно наблюдать. Самый высокий и самый низкий P вне для высокого тока инжекции показаны на образцах C и D соответственно. Насыщенность P вне при токе инжекции 300 мА показаны во всех образцах, кроме образца C. Эффект насыщения P вне относится к току, выходящему за пределы квантовых ям. Меньший ток, протекающий через квантовые ямы, происходит за счет потенциала мягкого ограничения квантовых ям и сильной локализации носителей заряда внутри образца квантовой ямы. Лучшее распределение носителей среди восьми квантовых ям и сильная излучательная рекомбинация носителей внутри квантовых ям проявляются в образце с четырьмя квантовыми ящиками, содержащими легирование кремнием.

Выходная мощность света ( P вне ) от тока впрыска ( L - Я ) кривые от 0 до 300 мА диодов
Темнопольные, светлопольные и увеличенные светлопольные изображения поперечных сечений просвечивающего электронного микроскопа высокого разрешения (ПЭМВР) представлены на рис. 6, 7 и 8. На рис. 6 яркие и темные контрасты соответствуют эпитаксиальным слоям InGaN и GaN. Можно наблюдать восемь периодов квантовых ям и 20 пар сверхрешеток. На рис. 7 вариации темного контраста представляют собой флуктуации локального содержания In и образование кластеров, богатых индием, в квантовых ямах [31,32,33,34]. Кластеры, богатые индием, действуют как относительно глубокие локализованные состояния носителей, приводящие к сильной излучательной экситонной рекомбинации. Вокруг этих богатых индием кластеров отмечаются искажение решетки и дефекты упаковки, что указывает на частичное ослабление энергии деформации в слое InGaN, как показано на увеличенном изображении красного квадрата на рис. 8a. По сравнению с увеличенными изображениями в светлом поле видны более диффузные (не резкие) границы раздела КЯ в образцах C и D, как показано на рис. 8c, d. Агент возникает в результате хорошо известной взаимной диффузии атомов In и Ga на границе раздела яма / барьер. В образце D произошло очень слабое удержание и локализация носителей заряда квантовых ям, что соответствует наихудшему оптоэлектронному поведению этого образца. На изображениях пронизывающие дислокации (ПД) образуются не во всех образцах. NRC происходят в основном на сайтах TD. В этих образцах показано лучшее качество эпитаксиальных слоев, как и ожидалось, благодаря использованию PSS и SRL [35,36,37]. Четыре QB с легированием Si в восьмипериодных квантовых ямах являются благоприятным условием для изменения потенциала ограничения для достижения потенциала мягкого ограничения квантовых ям InGaN / GaN, что приводит к лучшим оптоэлектронным характеристикам синего светодиода.
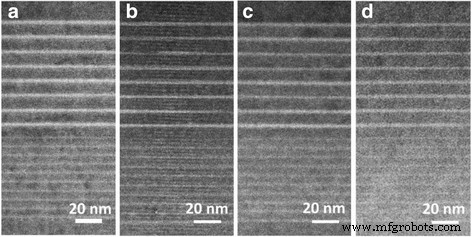
Темнопольные изображения образцов. а Образец А. б Образец Б. c Образец C. d Образец D
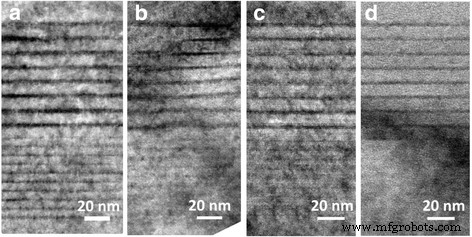
Яркие полевые изображения образцов. а Образец А. б Образец Б. c Образец C. d Образец D
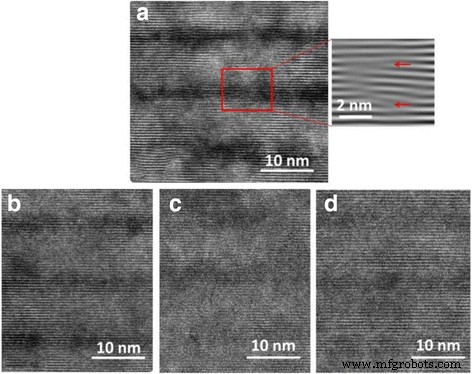
Увеличенные светлопольные изображения образцов. а Образец А. б Образец Б. c Образец C. d Образец D
Выводы
Температурно-зависимые спектры ФЛ, I - V кривые, L - Я кривые и изображения ВРЭМ синих светодиодов с восьмипериодом In 0,2 Ga 0.8 Были исследованы квантовые ямы N / GaN, содержащие от двух до пяти первых квантовых точек в последовательности осаждения, содержащие легирование кремнием. Результаты демонстрируют, что образец с первыми четырьмя КЯ, содержащими легирование кремнием, имеет относительно меньшую высоту барьера и большую энергию локализации носителей, о чем свидетельствуют диффузные границы раздела КЯ на изображениях ПЭМ ВР. Потенциал мягкого ограничения квантовых ям, сопровождающийся более сильной локализацией носителей заряда внутри квантовых ям, приводит к более равномерному распределению носителей заряда между восемью квантовыми ямами и более высокой излучательной рекомбинации носителей внутри квантовых ям в этом образце. Уменьшение оже-процессов и утечки носителей, а также увеличение излучательной рекомбинации квантовых ям происходило в синих светодиодах с четырьмя КД, легированными кремнием, при высоком токе инжекции. Результаты обеспечивают оптимальные условия для КД с легированием Si благодаря анализу влияния локализации носителей заряда, потенциала ограничения, поля PZ и наноструктур материала на люминесцентные свойства In 0,2 Ga 0.8 N / GaN квантовых ям синих светодиодов.
Сокращения
- Al:
-
Алюминий
- CP 2 Mg:
-
Бис-циклопентадиенилмагний
- EBL:
-
Слой блокировки электронов
- EQE:
-
Внешняя квантовая эффективность
- FE-TEM:
-
Автоэмиссионный просвечивающий электронный микроскоп
- Ga:
-
Галлий
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- ICP:
-
Индуктивно-связанная плазма
- В:
-
Индий
- IQE:
-
Внутренняя квантовая эффективность
- ITO:
-
Оксид индия и олова
- I - V :
-
Зависимость тока от напряжения
- L - Я :
-
Выходная мощность света в зависимости от тока инжекции
- LP-MOCVD:
-
Осаждение металлоорганических соединений из газовой фазы при низком давлении
- Mg:
-
Магний
- N:
-
Азот
- n-GaN:
-
GaN n-типа
- NRC:
-
Центры безызлучательной рекомбинации
- PL:
-
Фотолюминесценция
- PSS:
-
Сапфировые подложки с рисунком
- PZ:
-
Пьезоэлектрический
- QBs:
-
Квантовые барьеры
- QCSE:
-
Квантово-ограниченный эффект Штарка
- QWs:
-
Квантовые ямы
- RT:
-
Комнатная температура
- Si:
-
Кремний
- SiH 4 :
-
Силан
- SRL:
-
Слои для снятия натяжения
- TCL:
-
Прозрачный контактный слой
- TMAl:
-
Триметилалюминий
- TMGa:
-
Триметилгаллий
- TMIn:
-
Триметилиндий
- u-GaN:
-
Нелегированный GaN
Наноматериалы
- 5G и GaN:переход от LDMOS к GaN
- Атомная перестройка множественных квантовых ям на основе GaN в смешанном газе H2 / NH3 для улучшения структурных …
- Влияние состояний поверхности и мольной доли алюминия на поверхностный потенциал и 2DEG в HEMT из AlGaN / GaN
- Многоцветное излучение ультрафиолетовой фотонной квазикристаллической нанопирамиды на основе GaN с полуполя…
- Анализ инфракрасного отражения эпитаксиальных легированных слоев GaN n-типа, выращенных на сапфире
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Преодоление ширины мульмеза-канала, ограниченной обычно выключенными GaN HEMT, путем модуляции длины сквозного …
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Понимание механизма роста эпитаксиальных слоев GaN на механически расслоенном графите
- Подготовка массива периодических полистирольных наносфер методом погружения-капли с травлением после осажд…



