Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэлектронной спектроскопии с угловым разрешением
Аннотация
Поверхностная поляризация нитрида галлия на поверхности Ga (GaN) (2 нм) / AlGaN (22 нм) / канал GaN (150 нм) / буфер / Si с Al 2 О 3 Покрывающий слой исследуется методом рентгеновской фотоэлектронной спектроскопии с угловым разрешением (ARXPS). Обнаружено, что энергетическая полоса изменяется от изгиба вверх до изгиба вниз в области границы раздела, что, как полагают, соответствует изменению поляризации. Между верхним слоем GaN и Al 2 образуется межфазный слой. О 3 из-за возникновения разрыва связи Ga – N и образования связи Ga – O во время Al 2 О 3 осаждение посредством осаждения атомных слоев (ALD). Считается, что этот межфазный слой устраняет поляризацию GaN, тем самым уменьшая индуцированные поляризацией отрицательные заряды. Кроме того, этот межфазный слой играет ключевую роль для введения положительных зарядов, которые направляют энергетическую полосу вниз. Наконец, N 2 наблюдается отжиг при 400 ° C для увеличения роста межфазного слоя, что увеличивает плотность положительных зарядов.
Фон
Нитрид галлия (GaN) считается одним из наиболее привлекательных полупроводниковых материалов во многих областях, от светодиодной промышленности до энергетики электронной [1, 2]. Популярность обусловлена рядом преимуществ по сравнению с кремнием:высоким пробивным электрическим полем, высокой подвижностью электронов и отличной термической стабильностью [3, 4]. GaN-транзистор с высокой подвижностью электронов (HEMT) широко изучается для мощных и высокочастотных приложений [1, 5, 6]. В HEMT, если используется затвор Шоттки, этот интерфейс затвора приводит к большим состояниям интерфейса, которые усугубляют большой ток утечки и низкое поле пробоя [7]. Изолятор, индуцированный как поверхностный пассивирующий слой и диэлектрик затвора, может помочь смягчить вышеуказанные проблемы [8,9,10].
Аль 2 О 3 является предпочтительным для такого изолятора из-за его большой запрещенной зоны, высокой диэлектрической проницаемости и большей отрицательной свободной энергии Гиббса по сравнению с Ga 2 О 3 , поэтому считается, что Al 2 О 3 может пассивировать поверхностные состояния и улучшать поле электрического пробоя [5]. Однако на границе GaN / Al 2 неизбежно образуется межфазный слой. О 3 граница раздела после осаждения Al 2 О 3 [11, 12]. Считается, что этот межфазный слой коррелирует с надежностью порогового напряжения и свойствами двумерного электронного газа (2DEG) и играет ключевую роль в управлении изгибом полосы [2, 13,14,15,16].
Хотя межфазный слой изучался несколькими исследовательскими группами, роль, которую играет межфазный слой, не исследовалась глубоко [12, 17]. Поэтому в этой статье мы используем рентгеновскую фотоэлектронную спектроскопию с угловым разрешением (ARXPS) для обнаружения постепенных изменений изгиба зон и получения атомной структуры межфазного слоя [11]. Различная толщина Al 2 О 3 осаждаются на образцы GaN методом атомно-слоистого осаждения (ALD). ALD использует технологию низкотемпературного послойного осаждения, которая ограничивает термическую реакцию между GaN и Al 2 О 3 . Таким образом, промышленность отдает предпочтение ALD для осаждения диэлектриков с высоким k из-за его высокой приспосабливаемости и однородности, точности контроля толщины, высокого качества пленки и низкой плотности дефектов [4]. Это позволяет получить гладкий и малодефектный Al 2 О 3 / GaN интерфейс. После Ала 2 О 3 При осаждении также готовится образец для отжига после осаждения (PDA) при 400 ° C, чтобы усилить реакцию межфазного слоя, улучшая формирование межфазного слоя. На основе результатов ARXPS обнаружено, что полоса изначально изгибается вверх от подложки GaN к ближней границе раздела из-за индуцированных поляризацией отрицательных зарядов. Однако по мере увеличения угла обнаружения θ полоса постепенно изгибается вниз из-за образования положительных зарядов [5, 11,12,13].
Методы
Пластина GaN / AlGaN / GaN-на-Si (111) с поверхностью GaN была приобретена у коммерческой компании (Enkris.com). Эпитаксиальная структура вюрцита включает слой GaN толщиной 2 нм поверх слоя AlGaN толщиной 22 нм, и два эпитаксиальных слоя выращены на слое i-GaN толщиной 150 нм. Буферный слой служит переходным слоем, соединяющим эпитаксиальный слой GaN и подложку Si. Готовят три образца:S1, S2 и S3. Все образцы сначала обрабатывали ацетоном на 5 мин, затем погружали в изопропиловый спирт и промывали проточной деионизированной (ДИ) водой. Затем природный оксид вытравливали, погружая его в разбавленный раствор HCl (HCl:H 2 O =1:10) в течение ~ 1 мин с последующим ополаскиванием деионизированной водой. Аль 2 О 3 осаждаются методом ALD поверх GaN с триметилалюминием (TMA) и H 2 О как предшественник металла и окислитель соответственно. Аль 2 О 3 толщина составляет 1 нм для образца S1 и 3 нм для образцов S2 и S3. Толщина измеряется эллипсометром. Причем S3 подвергся КПК в N 2 при 400 ° C в течение 5 мин.
Измерения ARXPS проводились в системе Thermo Fisher Scientific Theta Probe, оснащенной монохроматическим микрофокусированным источником рентгеновского излучения Al Kα (1486,6 эВ) и полусферическим анализатором энергии электронов. Калибровка энергии связи (BE) была выполнена с использованием чистых стандартных образцов Ni, Au, Ag и Cu путем установки края Ферми Ni, Au 4 f 7/2 , Ag 3 d 5/2 , и Cu 2 p 3/2 пики при 0,00 ± 0,02, 83,98 ± 0,02, 368,26 ± 0,02 и 932,67 ± 0,02 эВ соответственно. Полную ширину спектра данного компонента можно было изменять только в узком диапазоне (± 0,1 эВ). Наименьшее количество компонентных спектров было использовано для получения приемлемо низких остаточных значений [11]. Спектры XPS регистрировались при разных углах обнаружения ( θ ) в диапазоне от 27,5 ° до 72,5 ° относительно нормали к образцу параллельно без наклона образца. Чтобы удалить возможный сдвиг BE, вызванный положительной зарядкой, полученные XPS-спектры были привязаны к C 1 s пик при 285,0 эВ. Количественный анализ, включая определение отношения элемент / связь, был проведен с использованием коэффициентов относительной чувствительности и алгоритмов, встроенных в программное обеспечение Avantage [11].
Результаты и обсуждение
Ga 3 d Спектры остовного уровня для S1 – S3 при разных углах регистрации фотоэлектронов показаны на рис. 1a – c соответственно. Для S1 каждый Ga 3 d Спектр можно описать двумя пиками, соответствующими связям Ga – N и Ga – O. Связи Ga – O обусловлены образованием оксида в результате воздействия кислородсодержащего вещества в ALD, и кислородный агент проник в исходный тонкий слой Al 2 О 3 слой [3]. Для S2 и S3 можно выделить три пика, обозначенные как Ga – N, Ga – O и O 2 s . , соответственно. O 2 s пик приписывается связям Ga – O и Al – O и становится очевидным при увеличении угла обнаружения. Поскольку эта статья не посвящена этому пику, дальше он обсуждаться не будет. На рис. 2 представлена зависимость BE пиков Ga – N от θ . для S1 – S3. Уменьшение на 0,2 эВ получается из θ =От 27,5 ° до 72,5 ° для S1. Это предполагает изгиб полосы вверх, что согласуется с публикациями [3, 11]. Для S2 BE показывает уменьшение на 0,1 эВ, что указывает на умеренный изгиб полосы вверх вблизи границы по сравнению с S1 или плоскую энергетическую полосу без изгиба полосы с учетом экспериментальной ошибки. Однако для S3 наблюдается увеличение BE на 0,2 эВ, в отличие от образцов S1 и S2, предполагающих изгиб полосы вниз. На рисунке 3 показано Al 2 p спектры для всех образцов, и в БЭ нет изменений. Кроме того, пик отмечен как связь Al – O, и, следовательно, слой AlGaN оказывает незначительное влияние на изменение Ga – N BE. В таблице 1 приведены БЭ Ga 3 d . и Al 2 p при разных углах регистрации для всех образцов с погрешностью ± 0,1 эВ.

XPS Ga 3 d спектры основного уровня для a S1, b S2 и c S3

БЭ пика спектра Ga – N как функция угла обнаружения θ (относительно нормали) для S2. Полоса погрешности составляет ± 0,1 эВ

XPS Al 2 p спектры основного уровня для a S1, b S2 и c S3, а пик указывает на связь Al – O. Более того, нет значительных вариаций BE
Отношения между пиками Ga – O и Ga – N для всех образцов приведены в таблице 2. Отношение составляет около 0,2 для образцов S1 и S2, что согласуется с предыдущими результатами [3]. Однако после лечения PDA соотношение увеличивается до ~ 0,3 и означает увеличение GaO x межфазный слой. Кроме того, соотношение Ga / N также приведено в таблице 2. Отношение рассчитывается путем сравнения интегральных интенсивностей Ga 3 d и N 1 s пики с атомными факторами чувствительности [18]. Для образцов S1 и S2 отношение около 1,7 предполагает наличие обогащенного галлием межфазного слоя. Однако после N 2 при отжиге отношение уменьшается до ~ 1.0. Кроме того, глубина отбора проб также указана в таблице 2 для каждого угла. Из-за экспоненциального затухания фотоэлектронов 63 и 95% обнаруженных электронов происходят с расстояния 1λ (т.е. λ представляет собой неупругую длину свободного пробега электрона (IMFP)) и 3λ соответственно от поверхности. Таким образом, глубина выборки XPS определяется как 3λ нанометров от поверхности образца. В нашем случае Al 2 О 3 покрывающий слой и λ Ga 3 d фотоэлектроны в Al 2 О 3 оценивается как ~ 3,4 нм. Для грубой оценки глубина выборки под разными углами задается как 3λcos θ . Однако фактическая глубина отбора проб Ga – N BE должна учитывать толщину Al 2 О 3 , поэтому глубина дискретизации оценивается как 3λcos θ без заглушки Al 2 О 3 толщина. Поскольку GaO x слой находится поверх гетероструктуры GaN, сигнал этого слоя включается для каждого угла обнаружения. Однако с увеличением угла обнаружения интенсивность сигнала связи Ga – N уменьшается, что приводит к увеличению отношения Ga – O / Ga – N. По сравнению с S2 и S3 увеличение отношения Ga – O / Ga – N и уменьшение отношения Ga / N предполагает, что богатый Ga слой окислился с образованием GaO x .
Чтобы проиллюстрировать представленные здесь экспериментальные данные, модель схематически предложена на рис. 4. Уровень энергии Ферми подложки GaN / AlGaN / GaN откалиброван как 0 эВ во время измерения XPS [19]. Приведены максимум зоны проводимости (CBM), максимум валентной зоны (VBM) и основной уровень. BE - это разность энергий между уровнем ядра и уровнем Ферми. При осаждении методом ALD O из кислородсодержащего вещества может замещать N в связи Ga – N для окисления GaN, а окружающие атомы N могут образовывать N 2 молекул [20], что приводит к образованию слоя, обогащенного Ga, и оксида галлия (GaO x ) межфазный слой [11, 18]. Это подтверждается отношением Ga / N, которое больше 1 в таблице 2. Это отношение указывает на изменение стехиометрии GaN, и собственный эффект спонтанной поляризации GaN должен исчезнуть [21,22,23]. В результате слой с высоким содержанием Ga, как GaN-to-GaO x переходный слой устраняет индуцированные поляризацией отрицательные заряды и приводит к образованию плоской зоны проводимости [11], как показано на рис. 4.
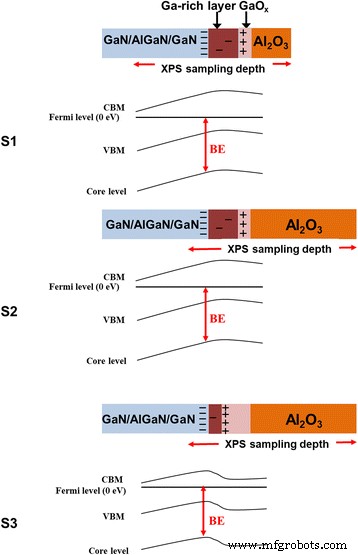
В области интерфейса O, заменяющий N в связи Ga – N, приводит к богатому Ga слою и GaO x слой. Слой с высоким содержанием Ga действует как преобразователь GaN в GaO x переходный слой. Образование Ga – O устраняет поляризацию GaN и действует как положительный заряд. В результате зона проводимости постепенно изгибается снизу вверх и соответственно изменяется BE
Кроме того, в процессе отжига обогащенная Ga поверхность окисляется с образованием более толстого GaO x слой. Поскольку окисление является кинетически ограниченной реакцией и ограничивается примерно двумя поверхностными монослоями, основная масса не будет сильно нарушена [24]. Следовательно, сигнал связи Ga – N в основном исходит от неокисленного нижележащего объема, что приводит к стехиометрическому отношению Ga / N, равному 1 для S3. GaO x Сообщалось, что слой приносит положительные заряды, которые могут быть фиксированными на границе раздела фаз с энергетическими состояниями между минимумами зоны проводимости естественного оксида и GaN, что искривляет зону вниз [4, 11, 13, 14]. Следовательно, зона проводимости слоя с высоким содержанием Ga начинает уменьшаться в области около GaO x слой. Более толстый GaO x ожидается, принесет большую плотность положительных зарядов. Что касается константы BE Ga – O и Al – O в S3, это указывает на то, что положительный заряд должен располагаться на границе раздела обогащенного Ga / GaO x слой. Положительные заряды и индуцированные поляризацией отрицательные заряды создают внутреннее электрическое поле, которое изменило изгиб полосы от восходящего изгиба полосы к изгибу полосы вниз, как показано на рис. 4. Из-за изгиба полосы вниз BE увеличивается с увеличением угла обнаружения. .
GaO x межфазный слой приносит положительные заряды, которые увеличивают высоту межфазного барьера ɸ b . ɸ b определяется как разность энергий между уровнем Ферми и минимумом зоны проводимости на поверхности или границе раздела [25]. В результате после A 2 О 3 осаждения подвижность 2DEG увеличивается, а электронная плотность 2DEG уменьшается [16, 25, 26].
С увеличением Al 2 О 3 толщины, сигнал XPS больше отражается на границе раздела между закрытым алюминием 2 О 3 и GaN / AlGaN / GaN, что подтверждается глубиной выборки XPS, показанной в таблице 2. Это объясняет, что только часть профиля изгиба полосы могла быть обнаружена для S2 [27]. В результате вариация BE составляет 0,1 эВ, что меньше 0,2 эВ для S1. Для S3 с более толстым межфазным слоем плотность положительных зарядов увеличивается, что приводит к изгибу полосы вниз.
Выводы
Таким образом, поляризация интерфейса Al 2 О 3 -кэпированный GaN / AlGaN / GaN исследуется ARXPS. Собственная поляризация GaN устраняется из-за слоя с высоким содержанием Ga и GaO x формирование слоя. Кроме того, связи Ga – O из GaO x слой вносит положительные межфазные фиксированные заряды. Из-за такого изменения поляризации полоса изменяется от изгиба вверх до изгиба вниз в области границы раздела.
Наноматериалы
- 5G и GaN:будущие инновации
- Влияние состояний поверхности и мольной доли алюминия на поверхностный потенциал и 2DEG в HEMT из AlGaN / GaN
- Анализ инфракрасного отражения эпитаксиальных легированных слоев GaN n-типа, выращенных на сапфире
- Нацеливание на эндотелиальные клетки с помощью многофункциональных наночастиц GaN / Fe
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…
- Исследование солнечного элемента из кристаллического кремния с черным слоем кремния на задней панели
- Понимание механизма роста эпитаксиальных слоев GaN на механически расслоенном графите
- Рекомбинация с контролем деформации в множественных квантовых ямах InGaN / GaN на кремниевых подложках
- Зависимость толщины от межфазных и электрических свойств в атомарном слое, нанесенном на GaN c-плоскости



