Преодоление ширины мульмеза-канала, ограниченной обычно выключенными GaN HEMT, путем модуляции длины сквозного отверстия
Аннотация
Мы представляем новые нормально выключенные GaN-транзисторы с высокой подвижностью электронов (HEMT), которые преодолевают типичные ограничения ширины мульти-меза-канала (MMC) за счет модуляции длины сквозных отверстий для регулирования эффекта экрана нейтральности заряда. Мы подготовили GaN HEMT в режиме усиления (E-режим) с шириной до 300 нм на основе усиленного эффекта поверхностного пиннинга. GaN HEMT с E-модой, имеющий структуру и ширину MMC, а также длину сквозных отверстий 100 нм / 2 мкм и 300 нм / 6 мкм, соответственно, демонстрировали положительные пороговые напряжения ( V th ) 0,79 и 0,46 В соответственно. Сопротивление в открытом состоянии MMC и структур со сквозными отверстиями было ниже, чем у типичных GaN HEMT с трехзатворной нанолентой. Кроме того, устройства не только достигли E-режима, но также улучшили энергетические характеристики GaN HEMT и эффективно уменьшили тепловой эффект устройства. Мы контролировали эффект закрепления поверхности боковых стенок на длине сквозных отверстий для получения GaN HEMT с E-модой. Наши результаты показывают, что сквозные отверстия, длина которых обычно выходит за пределы GaN-HEMT, имеют большой потенциал для использования в силовой электронике следующего поколения.
Фон
Нитриды III – V с широкой запрещенной зоной являются перспективными полупроводниковыми материалами для работы при частоте и напряжении из-за их превосходных свойств материала, включая большую ширину запрещенной зоны, высокие критические электрические поля, высокие скорости электронов насыщения и высокую проводимость [1, 2]. Соответственно, они широко используются в различных приложениях, включая светодиоды (LED) и транзисторы [3]. Кроме того, гетероструктуры из нитрида алюминия и галлия / нитрида галлия (AlGaN / GaN) образуют двумерные электронные газы (2DEG), подходящие для разработки высокоэффективных устройств, используя преимущества спонтанной и пьезоэлектрической поляризации соединений III-нитрида [4,5 , 6]. На количество 2DEG влияет доля поляризационно-индуцированного легирования, которое напрямую влияет на характеристики устройства [7,8,9]. Несмотря на то, что они обладают многими привлекательными свойствами, AlGaN / GaN-транзисторы с высокой подвижностью электронов (HEMT) не нашли универсального применения, поскольку их электронные характеристики могут требовать сложных конфигураций схем для цифровых, силовых, высокочастотных и микроволновых схем. Соответственно, для любых будущих полупроводниковых устройств III – V необходимо нормальное отключение [10, 11]. Несмотря на то, что были протестированы некоторые специальные технологии изготовления (например, использование утопленных затворов [12,13,14], введение закрывающих слоев p-типа под затвором [15, 16], туннельные переходные структуры [17], имплантация фторид-ионов в барьер под затвором [18], а также включение тонких барьерных слоев AlGaN со специальным металлическим затвором и обработкой методом быстрого термического отжига (RTA) [19]), они могут ухудшить характеристики устройства и вызвать проблемы со стабильностью из-за повреждения материала, вызванного технологией, и усиление теплового и электрического поля.
В качестве альтернативы, группа из Университета Хоккайдо обнаружила, что AlGaN / GaN HEMT, изготовленные с использованием ребристых наноканалов, демонстрируют сдвиг порогового напряжения ( V th ) в положительном направлении [20, 21]. Группа из Университета Сучжоу сообщила, что значение V th подвергались систематическому положительному сдвигу при ширине наноканала менее 90 нм [22]. Исследователи из Национального университета Кёнпук рассмотрели частичную релаксацию деформации сторон каналов для объяснения такого поведения [23]. Команда из Массачусетского технологического института смоделировала пороговое напряжение после пассивации поверхности HEMT на основе GaN и определила, что положительные значения возникают, когда ширина канала составляет менее 100 нм [24], что является результатом эффектов боковых стенок и повышенного растягивающего напряжения. что уменьшило концентрацию электронов в канале. Ребристые структуры не только смещают пороговое напряжение, но и улучшают управляемость затвором благодаря трехмерной структуре, которая обеспечивает работу в открытом состоянии, улучшая характеристики в закрытом состоянии. Нормализованный максимальный ток стока ( I D / мм) в HEMT AlGaN / GaN с ребристой структурой выше, чем в соответствующей планарной структуре [25]. Хотя эти методы использовались для изготовления HEMT в E-режиме, разработка высокопроизводительных силовых транзисторов на основе GaN остается очень сложной задачей. Прежде всего, сочетание низкого сопротивления во включенном состоянии ( R на ), а низкая общая мощность устройства должна быть достигнута, когда ширина канала ограничена менее 100 нм. Хотя значение R на канала можно уменьшить за счет уменьшения длины нормально закрытого затвора, управление током утечки стока в закрытом состоянии представляет собой еще одну проблему, поскольку ширина затвора влияет на крутизну и утечку затвора через поляризационное рассеяние кулоновского поля и пути утечки затвора [26, 27 ]. Напыленные пленки можно использовать в качестве диэлектрика затвора для решения этих проблем [28].
В этом письме мы описываем прорыв в ограничении ширины трехэлементных каналов и предлагаем метод регулирования длины сквозных отверстий в каналах. Наше устройство достигло E-режима с шириной структуры MMC 300 нм и длиной сквозных отверстий 6 мкм и показало пороговое напряжение 0,46 В. Этот подход не только уменьшил сопротивление устройства в открытом состоянии ( R на ), но также может уменьшить эффект нагрева Джоуля. Комбинируя трехмерный треугольный затвор с различной шириной канала и длиной сквозных отверстий, мы добились нормального выхода GaN HEMT с положительными значениями V th 0,79 и 0,46 В при ширине канала / длине сквозных отверстий 100 нм / 2 мкм и 300 нм / 6 мкм соответственно.
Методы
Эпи-пластина AlGaN / GaN была выращена на сапфировой подложке (0001) с использованием системы химического осаждения из газовой фазы (MOCVD) Nippon Sanso SR-2000. Рост эпитаксиальной структуры начинался с зародышеобразования GaN, нанесенного при 600 ° C. Затем при 1180 ° C были нанесены непреднамеренно легированный буферный слой GaN толщиной 2 мкм, непреднамеренно легированный барьерный слой AlGaN толщиной 21,8 нм с номинальным составом 23% алюминия и покрывающий слой GaN толщиной 2 нм. Обработка устройства была начата с использованием системы реактивного ионного травления (RIE) с индуктивно связанной плазмой (ICP) с BCl 3 / Cl 2 газовой смеси для выделения мезы глубиной 130 нм и травления периодической структуры канавок. Впоследствии были применены два процесса для восстановления кристаллических граней области углубления и боковых стенок мезы и уменьшения уровней поверхностных дефектов и повреждений ионной бомбардировкой. Первый включал использование расплавленного КОН для кристаллографического влажного химического травления для удаления повреждений поверхности, вызванных сухим травлением, и одновременного получения гладких вертикальных боковых стенок; второй - нанесение раствора пираньи (смесь H 2 SO 4 и H 2 О 2 ) для очистки поверхностей и удаления органических остатков. Обычная фотолитография с ртутной лампой применялась для определения стока, истока, затвора и контактных площадок для измерений постоянного тока. Омические контакты к гетеропереходу AlGaN / GaN, состоящие из титана / алюминия / никеля / золота (Ti / Al / Ni / Au, 30/120/20/80 нм), были нанесены на области стока / истока посредством электронно-лучевого испарения и отжиг при 850 ° С в течение 30 с в вакууме. Чтобы завершить канал транзистора, электрод затвора был изготовлен путем электронно-лучевого испарения Ni / Au (20/80 нм). На рисунке 1 представлены схематические изображения поперечного сечения конструкции HEMT, вид сверху устройства и трехмерная структурная диаграмма устройства. Длина ворот ( L g ), Ширина структуры MMC ( W MMC ), Длина сквозного отверстия в структуре MMC ( L MMC ) и высоту структуры MMC ( H MMC ) составляли 2 мкм, 100–500 нм, 1–6 мкм и 130 нм соответственно. Ребра были соединены параллельно. Чтобы усилить эффект закрепления поверхности, структура GaN HEMT с продольными отверстиями не подвергалась пассивации. На рис. 2а представлено изображение металлической поверхности в области истока и стока, полученное с помощью сканирующей электронной микроскопии (СЭМ) сверху. Изображение оптической микроскопии (ОМ) на рис. 2b показывает полные ворота и каналы; наблюдение за количеством каналов в устройстве было полезно при расчете фактического тока. Поверхность на изображении выглядела неровной, потому что после отжига атомы мигрировали в кристаллической решетке, и количество дислокаций уменьшилось, что эффективно уменьшило сопротивление. СЭМ-изображение на рис. 2в подтвердило размеры канала.
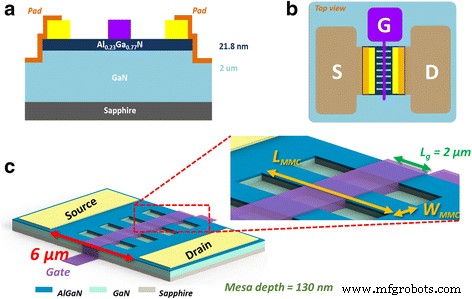
Схематические изображения a поперечное сечение HEMT-структуры, если смотреть с направления, параллельного каналу транзистора; б вид сверху на структуру HEMT; и c трехмерная структура HEMT
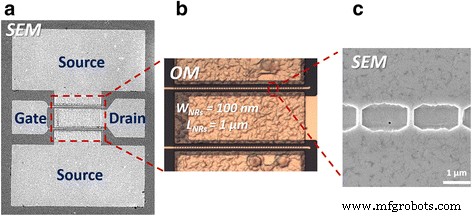
а СЭМ-изображение устройства сверху; б ОМ-изображение устройства сверху, показывающее ширину и длину канала 100 нм и 1 мкм соответственно; и c СЭМ-изображение канала сверху
Результаты и обсуждение
На сегодняшний день большинство технологических разработок высоковольтных транзисторов на основе GaN основано на AlGaN / GaN HEMT, которые по своей сути являются устройствами с обедненным режимом (D-режимом) из-за поляризационно-индуцированного двумерного электронного газа на границе раздела AlGaN – GaN. [29]. Тем не менее, если промышленность силовой электроники намерена широко внедрять технологии GaN, потребуются обычно отключенные GaN-транзисторы.
Количество оборванных связей на поверхности (Al) GaN составляет примерно 10 15 см −2 ; эти оборванные связи вызывают изгиб ленты с обедненной поверхностью в результате эффекта поверхностного закрепления. На рис. 3а показаны области бокового канала с обедненной поверхностью от боковых затворов в конструкции с тройным затвором. Исследователи из Национального университета Кёнпук сообщили о подобном явлении [21]. На рисунке 3b представлен I DS - V G передаточные характеристики устройств с фиксированным значением L MMC 2 мкм и значения W MMC 100, 300 и 500 нм. Когда напряжение сток-исток составляло 8 В, значения V th из этих устройств были +0,79, -1,32 и -2,18 В соответственно. Таким образом, по мере сужения каналов происходил положительный сдвиг порогового напряжения. Это явление могло быть связано с истощением бокового канала и закреплением на поверхности сквозного отверстия длиной 2 мкм от боковой стенки в структуре сквозного отверстия MMC из-за эффектов истощения бокового канала и изгиба поверхности сквозного отверстия. .

а Схематическое изображение HEMT AlGaN / GaN с широкими и узкими каналами. б Я DS - V G передаточные характеристики, измеренные для устройства, имеющего значение L MMC 2 мкм и различные значения W MMC
На рисунке 4 показан I DS . –V G передаточные характеристики устройств, имеющих фиксированное значение W MMC 300 нм и значения L MMC 1, 2 и 6 мкм. Когда напряжение сток-исток составляло 8 В, значения V th составили −2,12, −1,07 и +0,46 В соответственно. Устройство нормально выключилось, когда длина и ширина MMC составляли 6 мкм и 300 нм соответственно. Регулировка длины сквозного отверстия и ширины канала может обеспечить нормальное отображение устройства в выключенном состоянии. В таблице 1 перечислены пороговые напряжения, измеренные для различных длин сквозных отверстий и ширины нескольких мезаканалов. Когда ширина канала была зафиксирована на уровне 500 нм, а длина сквозного отверстия была увеличена с 0,8 до 6 мкм, значение V th увеличился с -2,62 до -1,62 В, ток насыщения стока уменьшился с 747 до 98 мА / мм, а крутизна снизилась с 270 до 40 мСм / мм. Когда ширина канала была зафиксирована на уровне 300 нм, а длина сквозного отверстия была увеличена с 0,8 до 6 мкм, значение V th увеличился с -2,15 до +0,46 В, ток насыщения стока уменьшился с 685 до 6,8 мА / мм, а крутизна снизилась с 290 до 7,4 мСм / мм. Когда ширина канала была зафиксирована на уровне 100 нм, а длина сквозного отверстия была увеличена с 0,8 до 2 мкм, значение V th увеличился с -0,41 до +0,79 В, ток насыщения стока уменьшился с 547 до 53 мА / мм, а крутизна снизилась с 400 до 67 мСм / мм. На токоподъемность HEMT сильно влияет концентрация носителей [20, 21]. Соответственно, на токи стока насыщения и крутизны устройства сильно влияли общие поверхностные состояния боковой стенки и эффект истощения поверхности трехзатворного канала при изменении ширины и длины сквозных отверстий GaN HEMT. По сравнению с устройствами, о которых сообщалось ранее [23], наше устройство достигло нового рубежа в области низкого сопротивления, как правило, без GaN HEMT.

Я DS - V G передаточные характеристики устройств, имеющих фиксированное значение W MMC 300 нм и различные значения L MMC
Выводы
Мы подготовили GaN HEMT с E-модой, имеющую мульти-мезаканальную (MMC) структуру; они показали положительное пороговое напряжение 0,46 В при ширине канала и длине сквозного отверстия 300 нм и 6 мкм соответственно. Мы предполагаем, что это влияние как истощения бокового канала, так и изгиба поверхности сквозного отверстия. При наличии тройного затвора, имеющего структуру длины сквозных отверстий MMC, новые GaN HEMT в нормальном состоянии показали очень низкое сопротивление в открытом состоянии, даже при увеличении ширины структуры MMC до 300 нм (ранее ограничивавшейся менее 100 нм). Кроме того, модуляция структуры MMC со сквозными отверстиями, обычно обеспечиваемая GaN HEMT, улучшает превосходные энергетические характеристики в результате увеличения ширины устройства MMC структуры.
Наноматериалы
- Приварные и сквозные ручки:в чем разница?
- Разрушение анатомии винта
- Широтно-импульсная модуляция
- Открытый исходный код и Интернет вещей:инновации через сотрудничество
- Прокладывая путь через лабиринт безопасности Интернета вещей
- Прерывание цикла долга перед технологиями цепочки поставок
- Преобразование процесса закупок с помощью робототехники
- ProtoPumpkins сквозь годы
- Охлаждающие осушители воздуха — основные принципы
- Разбор основ изготовления воздуховодов



