Влияние ультрафиолетового излучения на характеристики 4H-SiC PiN диодов
Аннотация
В данной работе исследуется влияние ультрафиолетового (УФ) излучения на статические характеристики высоковольтного 4H-SiC PiN. Не наблюдается значительных изменений в прямом включении, характерном для 4H-SiC PiN-диодов до и после облучения ультрафиолетом. Однако обнаружено, что блокирующее напряжение значительно увеличивается при УФ-облучении, что является результатом расширения ширины обедненной области с накоплением положительных зарядов при увеличении поверхностной плотности отрицательного заряда. Переходная спектроскопия глубоких уровней показывает, что дефекты глубокого уровня, вызванные УФ-облучением, играют доминирующую роль по сравнению с захваченными отрицательными зарядами и, следовательно, приводят к увеличению блокирующего напряжения 4H-SiC PiN-диодов.
Введение
Ожидается, что карбид кремния (SiC) станет многообещающим материалом-кандидатом для мощных и высокотемпературных электронных устройств следующего поколения из-за его широкой запрещенной зоны, высокой критической напряженности электрического поля, высокой скорости насыщения электронами и превосходной теплопроводности [1 , 2,3,4]. Устройства SiC разрабатываются для замены многих устройств, используемых в настоящее время на кремнии, особенно в тех случаях, когда требуется работа при высоких уровнях напряжения и тока и при температурах выше 200 ° C. По сравнению с униполярными устройствами, биполярные устройства из SiC в последние годы вызывают значительный интерес из-за применения сверхвысоких напряжений из-за эффекта модуляции проводимости. В качестве типичного биполярного устройства был продемонстрирован высоковольтный 4H-SiC PiN диод, который является потенциальным выбором для приложений с высоковольтными выпрямителями, включая усовершенствованные интеллектуальные сети, накопители энергии и импульсное питание [5,6,7,8]. В процессе изготовления силовых устройств на основе SiC широко используются несколько плазменных процессов, таких как сухое травление и напыление. Сообщалось о нескольких работах по индуцированному технологическим процессом повреждению устройств SiC, вызывающему электрическую деградацию [9, 10]. Кроме того, предыдущие исследования показали, что УФ-облучение значительно снижает производительность полевых транзисторов SiC металл – оксид – полупроводник (MOSFET) за счет бомбардировки ионами высокой энергии и фотоэмиссии плазмы [11, 12]. Недавно сообщалось, что импульсное УФ-лазерное облучение 4H ‑ SiC металл – оксид – полупроводник (МОП) может вызвать образование оксидной ловушки на границе раздела и вызвать дрейф производительности устройства и снижение надежности [13]. Однако, насколько нам известно, УФ-облучение устройств SiC PiN до сих пор не исследовалось, и необходимо понимать его влияние на характеристики устройств SiC PiN.
В этом исследовании мы исследовали влияние УФ-излучения на 4H-SiC PiN-диоды на прямую и обратную блокирующие характеристики с использованием УФ-излучения с длиной волны 184,9 нм. Влияние накопления поверхностного заряда на напряжение пробоя SiC-PiN-диодов показано с помощью моделирования с помощью технологии компьютерного проектирования (TCAD). SiO 2 / Плотность состояний SiC до и после облучения была охарактеризована с помощью системы глубокой нестационарной спектроскопии (DLTS) на SiC MOS. DLTS широко используется для изучения распределения плотности интерфейсных состояний (Dit) и глубоких дефектов в МОП-конденсаторе [14, 15].
Методы
Схематическая структура 4H-SiC PiN-диода, представленная в этой статье, показана на рис. 1. Буферный слой толщиной 2 мкм, легированный 1 × 10 18 см −3 и дрейфовый n-слой толщиной 60 мкм с концентрацией легирования 2 × 10 14 см −3 были непрерывно выращены на сильно легированных подложках 4H-SiC (0001) n-типа n-типа. Затем верхний слой представлял собой анод p + толщиной 2 мкм и концентрацией легирования 2 × 10 19 . см −3 . После эпитаксиального роста была сформирована круглая изолирующая меза-структура с высотой 2,5 мкм и диаметром 300 мкм с использованием индуктивно связанной плазмы, реагирующей через p + анодный слой в дрейфовый слой n-типа. Травильные газы и материал маски - SF 6 . / O 2 и нанесены плазменно-химическим осаждением из газовой фазы, соответственно. После изоляции мезы двойной Al-имплант размером 1 × 10 17 см −3 Основанный на переходе терминатор расширения (JTE) был сформирован, чтобы уменьшить скопление электрического поля возле края мезы. Имплантаты были активированы отжигом в Ar при 1650 ° C в течение 30 мин. Жертвенный SiO 2 Слой выращивали при 1100 ° C в течение 1 ч и погружали в HF, чтобы обеспечить свежую поверхность для термического окисления. Затем термическое окисление в сухом O 2 при температуре окружающей среды 1100 ° C в течение 3 часов с SiO 2 толщиной около 40 нм с последующим отжигом в среде Ar при 1100 ° C в течение 1 ч. Контактными материалами были Ni / Ti / Al для анода и Ni для катода. Эти металлы отжигались при 800 ° C и 1000 ° C в течение 2 мин для получения высококачественного омического контакта соответственно. Удельное контактное сопротивление, определенное методом линейной переносимой длины, составило 1 × 10 −5 Ом см 2 и 3,75 × 10 −5 Ом см 2 для омических контактов Ni / Ti / Al p-типа соответственно. На анод и катод наносился наплавочный металл с толстым алюминием. Слой диоксида кремния и толстый слой полиимида были нанесены на лицевую часть, чтобы избежать искрения на поверхности во время измерений высокого напряжения. Кроме того, конденсаторы SiC-MOS были изготовлены на высококачественном конденсаторе n-типа (7 × 10 15 см −3 ) слой эпитаксии на сильно легированной подложке 4H-SiC. Термический оксид 40 нм был выращен по стандартному процессу SiC PiN. Электрод затвора и задний омический контакт были сформированы из алюминия и никеля соответственно.

Схематическое сечение 4H-SiC PiN диодов
4H-SiC-PiN-диоды и SiC-MOS-конденсаторы облучались УФ-светом с использованием ртутной лампы с длиной волны 184,9 нм на воздухе в течение 72 ч без напряжения смещения. Электрические характеристики 4H-SiC PiN до и после УФ-облучения оценивались с помощью зонда Вентворта и системы определения характеристик полупроводников Agilent B1505A. Затем состояния интерфейса SiC-MOS конденсаторов и фиксированные заряды были охарактеризованы с помощью системы DLTS с преобразованием Фурье PhysTech. Применяемое обратное смещение V R и напряжение наполняющего импульса В P составляли 15 В и 2 В соответственно. Период выборки t w импульса смещения от V R в V P было 1,5 с.
Результаты и обсуждение
Влияние УФ-облучения на статические характеристики SiC PiN показано на рис. 2 и 3, где сравниваются характеристики, измеренные до и после облучения для устройства 1 (D1) и устройства 2 (D2). Диаметр круглых SiC-PiN-диодов составляет 3,5 мм, а активная площадь составляет около 10 мм 2 . . Прямое падение напряжения для SiC PiN составляет около 3,95 В при плотности тока 100 А / см 2 . для обоих двух устройств до УФ-облучения. На рис. 2 четко видно, что нет значительных изменений в прямом включении, характерном для двух устройств, с 3,95 до 4,0 В после УФ-облучения. Достигнутые запирающие напряжения устройств 1 и 2, изготовленных на эпитаксиальном слое n-дрейфа толщиной 60 мкм, составляют 7 кВ и 7,2 кВ при токе утечки менее 1 мкА соответственно. Следует отметить, что эффективность блокировки диодов PiN составляет около 70% от теоретического значения 9,7 кВ для дрейфового слоя толщиной 60 мкм, что неточность активации примеси, вероятно, приводит к отклонению от оптимального окна имплантата JTE. После УФ-облучения блокирующее напряжение устройства 1 заметно возрастает с 7 до 9,2 кВ с улучшением на 2,2 кВ, приближаясь к значению идеальной параллельной плоскости. Соответственно, улучшение на 1,7 кВ достигается для устройства 2 после УФ-облучения.

Прямая характеристика состояния 4H-SiC PiN-диода до и после УФ-облучения
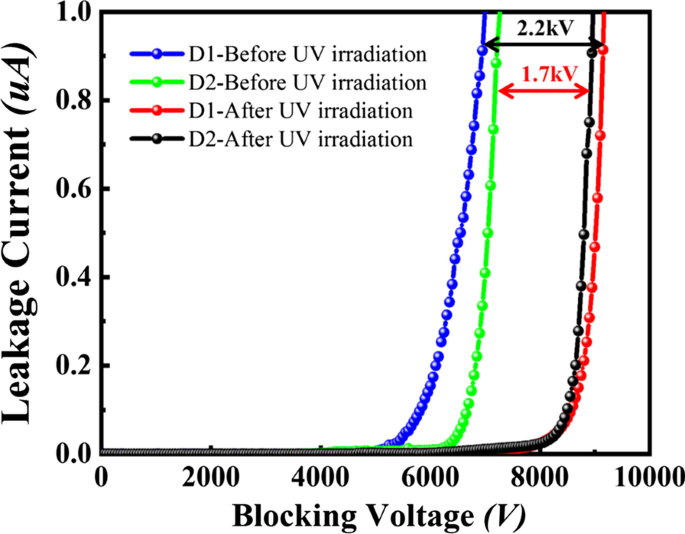
Обратная характеристика диода 4H-SiC PiN до и после УФ-облучения
Хорошо известно, что поверхностные ловушки оказывают существенное влияние на распределение электрического поля в области вывода, а затем влияют на характеристики обратной блокировки в силовом устройстве из SiC. Ikeguchi et al. показали, что высокоэнергетическое УФ-излучение с энергией фотонов ≥ 5 эВ может преобразовать ранее существовавшие напряженные двойные связи C – C в активные электронные ловушки и, таким образом, приводит к образованию отрицательно заряженных дефектов интерфейса, наблюдаемых при положительном V FB сдвиг C / V кривых [11, 12]. Между тем, электрон, генерируемый УФ-облучением, может быть захвачен дефектами на границе раздела с глубокими ловушками и, таким образом, получить отрицательный заряд с увеличением плотности фиксированного заряда. На рисунке 4 показана зависимость моделируемых характеристик блокировки от концентрации имплантата для двойного имплантата SiC PiN-диода JTE с различными отрицательными зарядами на поверхности. Очевидно, что поверхностные заряды в области JTE оказывают значительное влияние на эффективность обратного блокирования, особенно когда концентрация имплантата JTE отклоняется от оптимального окна. Для данной структуры двойного замыкания имплантата по мере увеличения поверхностных отрицательных зарядов может быть достигнуто более широкое оптимальное окно целевого значения блокировки. Понятно, что структура JTE менее чувствительна к интерфейсному заряду ниже 1 × 10 11 см −2 и напряжение блокировки не имеет очевидных изменений. С плотностью поверхностных зарядов более 5 × 10 11 см −2 , напряжение пробоя резко возрастет. Удивительно, но напряжение пробоя приблизительно достигает теоретического значения с окном имплантата от 2 × 10 16 см −3 до 8 × 10 17 см −3 при плотности поверхностных зарядов 1 × 10 13 см −2 .

Смоделированное напряжение пробоя в зависимости от концентрации имплантата JTE для отрицательного заряда поверхности, включая отсутствие заряда, 1 × 10 11 см −2 , 5 × 10 11 см −2 , 1 × 10 12 см −2 , 5 × 10 12 см −2 , и 1 × 10 13 см −2 соответственно
На рис. 5 сравнивается влияние накопления отрицательного поверхностного заряда на профиль электрического поля при блокирующей характеристике. Распределение электрического поля с эволюцией обедненной области в 4H-SiC PiN-диодах показано на рис. 5а. Когда отрицательный заряд увеличивается до 5 × 10 12 см −2 на SiO 2 / SiC (область JTE-структуры) SiC PiN положительный заряд дрейфового слоя N собирается на поверхность раздела, что приводит к значительному расширению обедненной области [16]. На рис. 5b показан разрез электрического поля ниже перехода JTE / n-дрейфовой области с поверхностной плотностью отрицательного заряда 1 × 10 11 . и 5 × 10 12 см −2 . В случае низкого заряда поверхности 1 × 10 11 см −2 , сильное скопление электрического поля появляется в краевой оконечной области с максимальным значением 2,5 МВ / см и напряжением пробоя около 8 кВ. По мере увеличения плотности зарядов до 5 × 10 12 см −2 , пиковое электрическое поле падает до 2,2 МВ / см, а сгущение электрического поля в краевой области по сравнению с этим подавляется. Между тем распределение электрического поля более равномерное, и напряжение пробоя явно увеличивается. Следовательно, отрицательный поверхностный заряд может вызвать расширение истощения и уменьшить скопление электрического поля, что приведет к повышению напряжения пробоя.

Моделирование распределения электрического поля SiC PiN с поверхностной плотностью отрицательного заряда 1 × 10 11 см −2 и 5 × 10 12 см −2 : а распределение электрического поля с эволюцией обедненной области b линия разреза электрического поля ниже перехода JTE / n-дрейфовой области. Используется концентрация имплантата 6 × 10 16 см −3
Для дальнейшего подтверждения физических механизмов генерации электронных дефектов, индуцированных облучением, улучшенные электрические характеристики SiO 2 Интерфейс / SiC требуется для более подробного изучения. Спектры DLTS для конденсаторов 4H-SiC SiC-MOS характеризовались истощением от 15 до 2 В до и после УФ-облучения, как показано на рис. 6. Из спектров DLTS наблюдались два пика в конденсаторах 4H-SiC MOS как до и после УФ-облучения при 210 К и 490 К соответственно. Отрицательные пики DLTS указывают на то, что уровни P1 и P2 являются ловушками для электронов. Широкий и значительный уровень P2 показывает значительное увеличение амплитуды пика, что означает, что концентрация электронной ловушки увеличивается при УФ-облучении. Кроме того, обнаружено, что сигнал DLTS увеличивается пропорционально времени заполнения, демонстрируя кинетику заполнения ловушек, характерную для протяженных дефектов, таких как дефекты интерфейса, а не точечные дефекты. На вставке показаны распределения плотности состояний интерфейса в зависимости от энергии активации E T . . Плотность состояний интерфейса рассчитывается как \ (D _ {{{\ text {it}}}}} =\ varepsilon _ {{{\ text {sic}}}}} C _ {{{\ text {ACC}}}}} AN _ {{ \ text {D}}} \ Delta C / \ left [{C_ {R} ^ {3} kT} \ right] \) [17]. Из рисунка видно, что дефект интерфейса приводит к появлению энергетической зоны в запрещенной зоне от E C - от 0,65 эВ до E C - 1,25 эВ, а его плотность значительно увеличилась с 2 × 10 12 см −2 эВ −1 до 6 × 10 12 см −2 эВ −1 после УФ-облучения. Комбинируя измерения переходной емкости, просвечивающую электронную микроскопию с высоким разрешением и расчеты теории функционала плотности, Донг и др. предположили, что эти интерфейсные дефекты возникли из-за отрицательно заряженного избыточного расщепленного межузельного углерода на границе [18]. Пик P1 при 210 k соответствует ловушке электронов при E C - 0,41 эВ. Его концентрация не претерпевает существенных изменений после УФ-облучения, и предположительно ловушка P1 была отнесена к точечным дефектам в эпитаксиальном слое SiC. Однако его атомарная конфигурация все еще неясна и требует уточнения в будущих исследованиях.
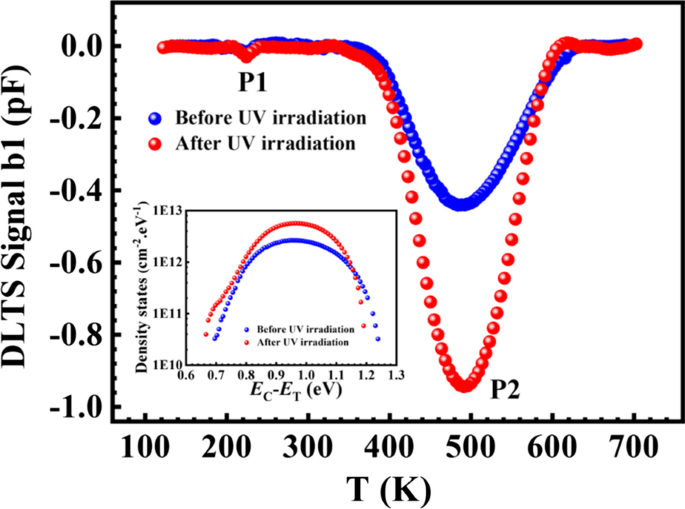
Спектры DLTS для 4H-SiC PiN-диодов до и после УФ-облучения. Вставка показывает D Распределение для 4H-SiC PiN-диодов до и после УФ-облучения
Выводы
Исследовано влияние УФ-излучения на электрические характеристики 4H-SiC PiN-диодов. По результатам электрических экспериментов, после УФ-облучения наблюдается незначительное изменение прямого тока. Однако УФ-облучение приводит к значительному увеличению блокирующего напряжения. Обнаружено, что УФ-облучение создает дефекты глубокого уровня на границе раздела PiN-диодов, что приводит к увеличению глубоких акцепторных уровней в запрещенной зоне. Эти глубокоуровневые дефекты служат центром захвата электронов и приводят к значительному увеличению отрицательного заряда в SiO 2 / SiC интерфейс. Положительные заряды N дрейфового слоя собираются на поверхности раздела и дополнительно способствуют расширению обедненной области с более равномерным распределением электрического поля, что приводит к увеличению блокирующего напряжения.
Доступность данных и материалов
Все данные доступны без ограничений.
Наноматериалы
- Диоды
- Диоды специального назначения
- Скалка
- Боулинг
- Характеристики стекловолокна
- Влияние распределения наночастиц золота в TiO2 на оптические и электрические характеристики сенсибилизирован…
- Влияние полиэтиленгликоля на фотокатод NiO
- Влияние отжига на микроструктуру и упрочнение сплавов с последовательным имплантированным гелием и водород…
- Влияние нанослойного покрытия вольфрамом на кремниевый электрод в литий-ионной батарее
- Ультрафиолетовые светодиоды на основе AlGaN с почти нулевым КПД и специально разработанным слоем блокировки эл…



