Сегнетоэлектрические полевые транзисторы на основе ZrO2, активируемые переключаемыми диполями вакансий кислорода
Аннотация
В этой статье исследуется влияние пост-быстрого термического отжига (RTA) и толщины ZrO 2 по поляризации P и электрические характеристики TaN / ZrO 2 Конденсаторы / Ge и полевые транзисторы FeFET соответственно. После RTA от 350 до 500 ° C, TaN / ZrO 2 / Ge конденсаторы с аморфным ZrO2 толщиной 2,5 и 4 нм 2 фильм экспонат стабильный P . Предполагается, что сегнетоэлектрическое поведение происходит из-за миграции диполей под действием напряжения, образованных кислородными вакансиями и отрицательными зарядами. FeFET с 2,5 нм, 4 нм и 9 нм ZrO 2 продемонстрировать приличное окно памяти (MW) с импульсами программирования / стирания 100 нс. ZrO 2 толщиной 4 нм FeFET имеет значительно улучшенные характеристики усталости и удержания по сравнению с устройствами с 2,5 и 9 нм ZrO 2 . Удерживающая способность ZrO 2 FeFET можно улучшить с увеличением температуры RTA. МВт ~ 0,46 В экстраполируется для сохранения в течение 10 лет для устройства с 4 нм ZrO 2 . .
Фон
Легированный поли-HfO 2 сегнетоэлектрические полевые транзисторы (FeFET) вызвали значительный интерес в приложениях энергонезависимой памяти (NVM) из-за их совместимости с процессами CMOS [1]. Хотя приличные электрические характеристики были продемонстрированы в легированном HfO 2 На основе FeFET [2] некоторые фундаментальные ограничения все еще мешают их практическому применению, включая высокий тепловой баланс при отжиге 500 ° C, необходимый для образования фаз ромбического кристалла, и нежелательный ток утечки по границам зерен с уменьшением толщины сегнетоэлектрика. Сегнетоэлектричество широко наблюдается в различных материалах, например, Sb 2 S 3 нанопроволоки [3], GaFeO 3 фильм [4], LaAlO 3 -SrTiO 3 пленка [5], и аморфный Al 2 О 3 содержащие нанокристаллы [6, 7]. Недавно мы сообщили о FeFET с частично кристаллизованным ZrO 2 вентильный изолятор, выполняющий функции NVM и аналогового синапса [8]. Хотя ZrO 2 транзисторы показали хорошие электрические характеристики при меньшей толщине по сравнению с легированным HfO 2 . , лежащий в основе механизм сегнетоэлектричества в ZrO 2 фильм остается неясным. Очень важно выяснить происхождение переключаемой поляризации P для оценки предела производительности ZrO 2 FeFET.
В этой работе TaN / ZrO 2 / Ge FeFET с изоляторами толщиной 2,5 нм, 4 нм и 9 нм. Переключаемый P в TaN / ZrO 2 Предполагается, что конденсатор / Ge возникает в результате миграции кислородных вакансий и отрицательных зарядов под действием напряжения. Воздействие ZrO 2 толщину и постбыстрый термический отжиг (RTA) на P из TaN / ZrO 2 / Ge и окно памяти (MW), выносливость и характеристики удержания FeFET исследуются.
Методы
FeFET с ZrO 2 изолятор затвора изготовлен на 4 дюйма. Подложка n-Ge (001) с использованием аналогичной технологии [8, 9]. После предварительной очистки затвора в разбавленном растворе HF (1:50) пластины Ge загружали в камеру осаждения атомных слоев (ALD). ZrO 2 Пленки толщиной 2,5 нм, 4 нм и 9 нм были нанесены при 250 ° C с использованием TDMAZr и H 2 O как предшественники Zr и O соответственно. Электрод затвора из TaN толщиной 100 нм наносился методом реактивного распыления. После формирования электрода затвора области истока / стока (S / D) были имплантированы BF 2 + в дозе 1 × 10 15 см −2 и энергия 20 кэВ. Всего с помощью процесса отрыва были сформированы S / D-контакты никеля (Ni) 15 нм. Наконец, был проведен RTA при 350, 450 и 500 ° C в течение 30 с.
На рис. 1а представлена схема изготовленного транзистора. На рис. 1b – d показаны изображения TaN / ZrO 2 , полученные с помощью просвечивающего электронного микроскопа (ПЭМ). / Ge с ZrO 2 толщиной 2,5, 4 и 9 нм , соответственно. Все образцы подвергались RTA при 500 ° C в течение 30 с. 2,5 нм ZrO 2 После отжига образец остается диэлектрической пленкой. Для образца 4 нм, хотя наблюдаются некоторые нанокристаллы, ZrO 2 остается аморфным слоем. В то время как полная кристаллизация происходит для 9 нм ZrO 2 фильм. Примечательно, что межфазный слой (ИС) GeO x существует между ZrO 2 и область канала Ge, хотя она слишком тонкая, чтобы ее можно было наблюдать на изображениях ПЭМ.
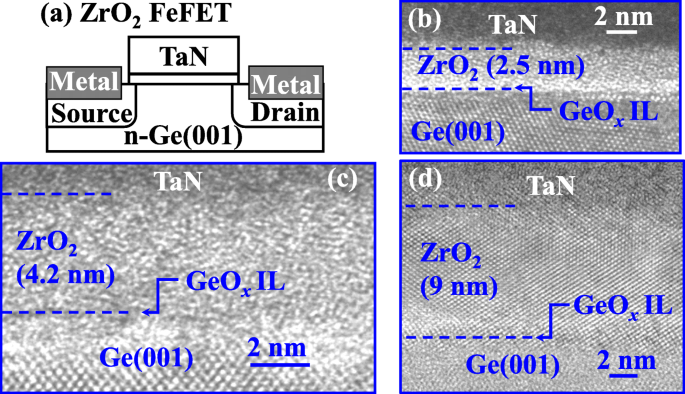
а Схема изготовленного TaN / ZrO 2 / Ge FeFET. б , c , и d ВРЭМ изображения TaN / ZrO 2 / Ge стеки с разными ZrO 2 толщины. Образцы подвергались RTA при 500 ° C в течение 30 с
Результаты и обсуждение
На рисунке 2 показан P от напряжения ( В ) кривые для TaN / ZrO 2 / Ge конденсаторы с разными ZrO 2 толщины и разные температуры отжига. Сплошные линии разного цвета представляют второстепенные контуры с различным диапазоном качающегося напряжения ( В диапазон ). Частота измерения 1 кГц. 2,5 нм и 4 нм ZrO 2 устройства могут демонстрировать стабильное сегнетоэлектричество после RTA при 350 ° C. На рисунке 3 показан остаток P ( P r ) как функция развертки V кривые диапазона для конденсаторов, отожженных при различных температурах.

Измерено P по сравнению с V характеристики TaN / ZrO 2 / Ge конденсаторы с разными ZrO 2 толщины и различные температуры отжига
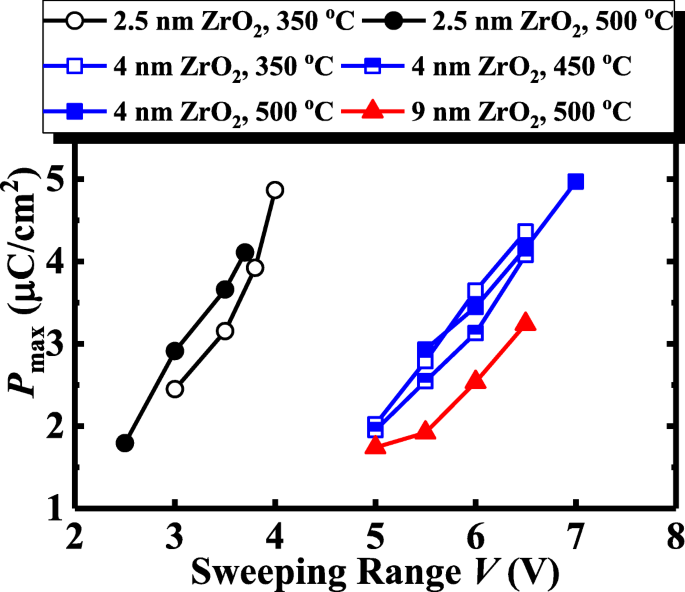
Сравнение P макс как функция от V диапазон для TaN / ZrO 2 / Ge конденсаторы с разными ZrO 2 толщины и различные температуры отжига
На рисунке 3 показано сравнение P макс как функция от V диапазон для TaN / ZrO 2 Конденсаторы / Ge с разными ZrO 2 толщины и различных температур RTA. Для 4 нм ZrO 2 устройств, при увеличении температуры отжига с 350 до 450 ° C увеличивается V диапазон требуется для получения фиксированного P макс . Это связано с тем, что более высокая температура отжига дает более толстые межфазные слои (ИЖ) между Ge / ZrO 2 и ZrO 2 / TaN, что приводит к увеличению унифицированной эквивалентной толщины емкости (CET). Для 2,5 нм ZrO 2 конденсаторов, образец с отжигом 500 ° C имеет более низкое V диапазон чем образец отжига при 350 ° C с тем же P макс . Хотя ИЖ становятся толще с повышением температуры RTA, некоторые ZrO 2 поглощается поглощением кислорода и взаимной диффузией на границе раздела. Для очень тонкого ZrO 2 устройство, последнее является доминирующим. По сравнению с 2,5 нм ZrO 2 конденсатор, гораздо больше V диапазон требуется для достижения аналогичного P макс . Однако 9 нм ZrO 2 конденсатор не показывает более высокое V диапазон по сравнению с устройством 4 нм. Это связано с кристаллом ZrO 2 с гораздо более высоким κ по сравнению с аморфной пленкой, что значительно снижает CET 9-нм устройства.
На рисунке 4а показана извлеченная эволюция положительного и отрицательного значений P . r , обозначаемые \ ({P} _ {\ mathrm {r}} ^ {+} \) и \ ({P} _ {\ mathrm {r}} ^ {-} \), соответственно, для 4 нм- толстый ZrO 2 конденсаторы с RTA на разные температуры более 10 6 циклы развертки измерены на частоте 1 кГц. Устройства, отожженные при 350 ° C и 450 ° C, демонстрируют очевидный пробуждающий эффект. Для 4 нм ZrO 2 не наблюдается пробуждения или отпечатка. сегнетоэлектрический конденсатор прошел отжиг при 500 ° C. На рисунке 4b сравнивается P r как функция циклов развертки для устройств с различным ZrO 2 толщины. 4 нм ZrO 2 сегнетоэлектрический конденсатор обеспечивает повышенную стабильность P r выносливость по сравнению с устройствами 2,5 и 9 нм в течение 10 6 испытание на выносливость.

а P r в зависимости от количества циклов развертки мс-импульсов для 4 нм ZrO 2 конденсаторы с разной температурой RTA. б P r в зависимости от количества циклов развертки мс-импульсов для ZrO 2 конденсаторы после отжига при 500 ° С
Переключение P наблюдается в аморфном ZrO 2 емкости, и предполагается, что механизм должен отличаться от механизма легированного поли-HfO 2 , о котором сообщается. сегнетоэлектрические пленки. Мы предполагаем, что основной механизм сегнетоэлектрического поведения связан с диполями кислородных вакансий. Хорошо известно, что по мере осаждения металла TaN слои поглотителя кислорода Ta будут увеличивать концентрацию кислородных вакансий внутри ZrO 2 . [10]. Кислородные вакансии также появляются в ZrO 2 / Ge интерфейс. На рисунке 5 показана схема переключаемого P в TaN / ZrO 2 / Ge возникает в результате миграции кислородных вакансий и отрицательных зарядов с образованием положительных и отрицательных диполей. Предполагается, что отрицательные заряды в ZrO 2 связаны с вакансией Zr [11], аналогичной вакансии в Al 2 О 3 фильм [12]. Миграция кислородных вакансий, управляемых напряжением, была широко продемонстрирована в резистивных устройствах оперативной памяти [13, 14]. Примечательно, что это первая демонстрация трехконтактных энергонезависимых транзисторов, в которых преобладают кислородные вакансии, управляемые напряжением.
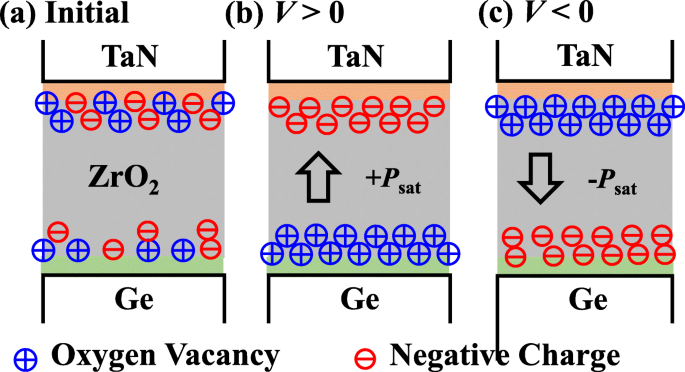
Схема механизма переключаемого P в ZrO 2 конденсаторов, что связано с миграцией кислородных вакансий под действием напряжения и отрицательных зарядов с образованием диполей
P-V гистерезис включает ZrO 2 FeFET для получения большого и стабильного MW для встроенных приложений NVM (eNVM). На рисунке 6 показаны измеренные значения I DS - V GS кривые 2,5, 4 и 9 нм ZrO 2 FeFET для двух состояний поляризации с условиями программирования / стирания (P / E) длительностью 1 мкс. Транзисторы отжигались при 500 ° C. Операция программирования (стирания) достигается путем подачи положительных (отрицательных) импульсов напряжения на затвор ZrO 2 FeFET для повышения (понижения) его порогового напряжения ( V TH ). V TH определяется как V GS при 100 нА · Вт / л, а МВт определяется как максимальное изменение V TH . Все FeFET с различным ZrO 2 толщины имеют MW выше 1 В с импульсами P / E длительностью 1 мкс. Для достижения аналогичной молекулярной массы требуется более высокое напряжение стирания для 9 нм ZrO 2 FeFET по сравнению с двумя другими транзисторами. Видно, что стирание большей величины V GS требуется для получения примерно равного сдвига I-V относительно исходной кривой по сравнению с программой V GS . Предполагается, что кислородные вакансии, вносящие вклад в P в основном происходят из реакции между TaN и ZrO 2 , как и исходное состояние устройства на рис. 5а. В качестве положительного V GS (программа) кислородные вакансии диффундируют и накапливаются в слое около ZrO 2 / Ge (рис. 5б), где распределение диполей кислородных вакансий существенно отличается от исходного состояния. Так что легко изменить I-V кривая к более высокому | V TH | с положительным V GS . Однако в качестве отрицательного V GS (стирание), обратная диффузия кислородных вакансий возвращает стопку затворов в исходное состояние (рис. 5c). Итак, величина отрицательного стирания V GS должен быть увеличен для достижения эквивалентного сдвига I-V к позитивной программе V GS .
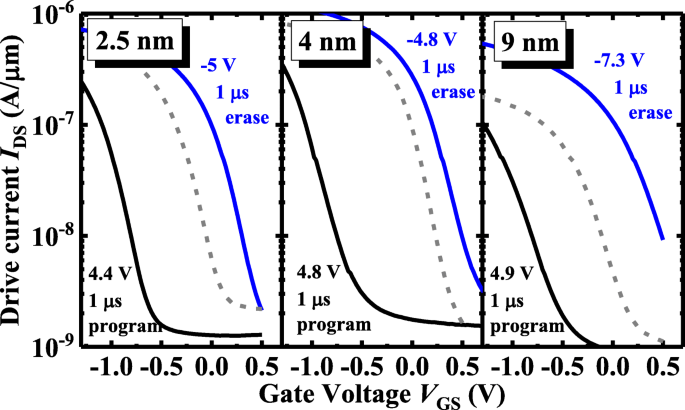
Измерено I DS - V GS кривые ZrO 2 толщиной 2,5, 4 и 9 нм FeFET для начального и двух состояний поляризации с импульсами P / E длительностью 1 мкс
Поскольку ширина импульса P / E уменьшается до 100 нс, ZrO 2 FeFET по-прежнему демонстрируют приличную молекулярную массу, как показано на рис. 7a. В частности, транзистор с 2,5 нм ZrO 2 после отжига при 350 ° C достигается молекулярная масса 0,28 В. На рис. 7b представлены графики зависимости молекулярной массы от числа циклов для FeFET с различным ZrO 2 толщины с состоянием импульса P / E 100 нс. 4 нм ZrO 2 Устройство обеспечивает значительно улучшенные характеристики выносливости по сравнению с 2,5 и 9 нм ZrO 2 FeFET, которые демонстрируют очевидный эффект пробуждения и утомляемость в пределах 10 3 циклов.
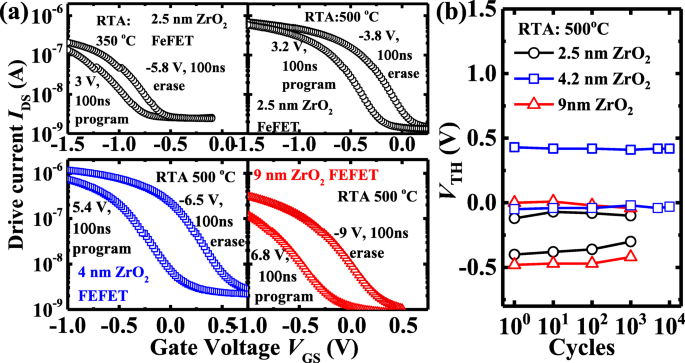
а Я DS - V GS кривые ZrO 2 толщиной 2,5, 4 и 9 нм FeFET для двух состояний поляризации с импульсами P / E 100 нс. Устройства прошли RTA при 500 ° C. б FeFET с 4 нм ZrO 2 обладает повышенной износостойкостью по сравнению с 2,5 и 9 нм ZrO 2 транзисторы
Наконец, тестирование удержания ZrO 2 Характеристики FeFET показаны на рис. 8 и 9. На рис. 8а показана эволюция I DS - V GS кривые для двух состояний поляризации 4 нм ZrO 2 FeFET подвергались RTA при 350, 450 и 500 ° C. Улавливание заряда приводит к уменьшению количества устройств со временем. Как показано на фиг. 8b, удерживающие характеристики устройств могут быть улучшены с увеличением температуры RTA. МВт ~ 0,46 В экстраполируется на 10 лет. На рисунке 9 сравниваются удерживающие характеристики FeFET с различным ZrO 2 . толщины. 4 нм ZrO 2 устройство имеет улучшенную удерживающую способность по сравнению с транзисторами с ZrO2 толщиной 2,5 и 9 нм 2 .
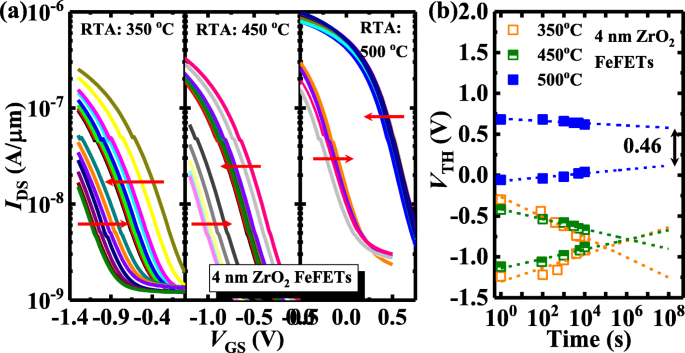
а Эволюция I DS - V GS кривые для двух состояний поляризации 4 нм ZrO 2 FeFET с разными температурами RTA. б 4 нм ZrO 2 устройство, отожженное при 500 ° C, имеет гораздо лучшие удерживающие характеристики по сравнению с транзисторами с RTA при более низких температурах
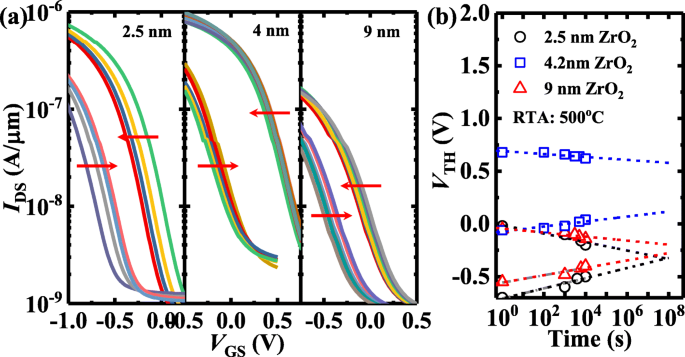
а Эволюция I DS - V GS кривые для двух состояний поляризации для ZrO 2 толщиной 2,5, 4 и 9 нм FeFET-транзисторы прошли RTA при 500 ° C. б 4 нм ZrO 2 устройство имеет улучшенную удерживающую способность по сравнению с транзисторами с ZrO2 толщиной 2,5 и 9 нм 2
Выводы
Таким образом, аморфный ZrO 2 Экспериментально продемонстрированы сегнетоэлектрические конденсаторы, и предполагается, что сегнетоэлектричество возникает из-за миграции управляемых напряжением диполей, образованных кислородными вакансиями и отрицательными зарядами. FeFET с 2,5 нм, 4 нм и 9 нм ZrO 2 иметь MW выше 1 В с импульсами P / E длительностью 1 мкс. Улучшенные характеристики усталости и удерживания получены в ZrO 2 толщиной 4 нм. FeFET в сравнении с приборами с 2,5 и 9 нм ZrO 2 . Тест на удерживание показывает, что 4 нм ZrO 2 транзистор сохраняет экстраполированную 10-летнюю МВт ~ 0,46 В.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- RTA:
-
Быстрый термический отжиг
- IL:
-
Межфазный слой
- TaN:
-
Нитрид тантала
- FeFET:
-
Сегнетоэлектрические полевые транзисторы
- TDMAZr:
-
Тетракис (диметиламидо) цирконий
- Ge:
-
Германий
- ZrO 2 :
-
Диоксид циркония
- ALD:
-
Осаждение атомного слоя
- HF:
-
Плавиковая кислота
- BF 2 + :
-
Ион фторида бора
- MW:
-
Окно памяти
- NVM:
-
Энергонезависимая память
- P r :
-
Остаточная поляризация
- ТЕМ:
-
Просвечивающий электронный микроскоп
- Ни:
-
Никель
- P макс :
-
Максимальная поляризация
- RTA:
-
Оплаченный термический отжиг
- V диапазон :
-
Диапазон переменного напряжения
Наноматериалы
- DDS с поддержкой Интернета, Интернет вещей и облако
- Транзисторы, переходный полевой транзистор (JFET)
- Транзисторы, полевой эффект с изолированным затвором (IGFET или MOSFET)
- Переходные полевые транзисторы
- Полевые транзисторы с изолированным затвором (MOSFET)
- Введение в полевые транзисторы (JFET)
- Введение в полевые транзисторы с изолированным затвором
- Настройка токсичности активных форм кислорода для расширенной терапии опухолей
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Преимущества производства кислорода на месте



