Высокопроизводительный фотодетектор глубокого ультрафиолета на основе гетероперехода NiO / β-Ga2O3
Аннотация
Ультрафиолетовый (УФ) фотодетектор вызвал широкий интерес в связи с его широким спектром приложений от оборонной техники до оптической связи. Использование металлооксидных полупроводниковых материалов с широкой запрещенной зоной представляет большой интерес при разработке УФ-фотодетекторов из-за их уникальных электронных и оптических свойств. В данной работе фотоприемник глубокого УФ-излучения на основе NiO / β-Ga 2 О 3 гетеропереход. Β-Ga 2 О 3 Слой был приготовлен магнетронным распылением и после отжига демонстрировал селективную ориентацию вдоль семейства кристаллических плоскостей (\ (\ overline {2} \) 01). Фотоприемник продемонстрировал хорошие характеристики с высокой чувствительностью ( R ) 27,43 AW −1 при освещении 245 нм (27 мкВт / см −2 ) и максимальной обнаружительной способности ( D *) из 3,14 × 10 12 смГц 1/2 W -1 , который был отнесен к p-NiO / n-β-Ga 2 О 3 гетеропереход.
Фон
Разработка фотодетекторов ультрафиолетового (УФ) диапазона вызывает большой интерес в связи с их широким спектром приложений, таких как предупреждение о ракетах, биохимический анализ, обнаружение пламени и озона, а также оптическая связь. По сравнению с полупроводниками SiC и GaN УФ-фотодетекторы на основе металлооксидных полупроводников с широкой запрещенной зоной обладают многими преимуществами. Например, фотодетекторы на основе оксидов металлов нелегко окисляются и демонстрируют чувствительный отклик. Кроме того, они просты в эксплуатации и могут быть выполнены небольшими по размеру [1, 2]. Следовательно, оксиды металлов с широкой запрещенной зоной и устройства на их основе в последние годы привлекли большое внимание исследователей. На сегодняшний день оксиды металлов, такие как ZnO [3,4,5], TiO 2 [6, 7], SnO 2 [8], NiO [9] и Ga 2 О 3 [10, 11] изучались для использования в качестве высокопроизводительных УФ-фотоприемников. Среди них стабильная фаза Ga 2 О 3 (β-Ga 2 О 3 ) становится предпочтительным материалом для УФ-фотодетекторов, поскольку это полупроводник с прямой запрещенной зоной со сверхширокой запрещенной зоной ~ 4,9 эВ, который эффективно реагирует на УФ-полосу. Дополнительным преимуществом является легкий процесс роста материала.
Несколько групп пытались улучшить характеристики УФ-фотодетекторов, разработав устройства с гетеропереходом, состоящие из двух различных полупроводников на основе оксидов металлов. Например, Zhao et al. сообщил об исследованиях ZnO-Ga 2 О 3 УФ-фотодетекторы с гетероструктурой ядро-оболочка, которые продемонстрировали сверхвысокую чувствительность и обнаруживающую способность за счет эффекта лавинного умножения [12, 13]. В этой работе гетеропереход другого оксида металла, например NiO / β-Ga 2 О 3 , был исследован для создания высокопроизводительного УФ-фотодетектора. Во-первых, рассогласование решеток β-Ga 2 О 3 и NiO относительно невелик. Кроме того, ширина запрещенной зоны у NiO больше, чем у ZnO, использованного в предыдущем исследовании. Поведение NiO p-типа и β-Ga n-типа 2 О 3 привело к появлению нескольких отчетов об исследованиях электрических свойств NiO / β-Ga 2 О 3 гетеропереход для приложений силовой электроники [14]; однако имеется ограниченное сообщение об использовании гетероперехода в фотоприемнике. В этом исследовании NiO / β-Ga 2 О 3 Фотоприемник на основе УФ-излучения был изготовлен методом магнетронного распыления на прозрачную подложку из оксида индия и олова (ITO). Результаты показали, что NiO / β-Ga 2 О 3 фотодетектор показал отличную чувствительность к УФ-свету (245 нм) с хорошей стабильностью.
Методы
Ga 2 О 3 и керамические мишени NiO (99,99%) были приобретены у Zhongnuo Advanced Material (Beijing) Technology Co. Ltd. Сапфировая подложка с плоскостью (0001) была приобретена у Beijing Physike Technology Co. Ltd. Кварцевая подложка с покрытием ITO была приобретена у Beijing Jinji Aomeng Technology Co. Ltd. Все химические реагенты, использованные в экспериментах, использовали без дополнительной очистки.
β-Ga 2 О 3 Пленка была приготовлена методом высокочастотного магнетронного распыления при комнатной температуре. Для характеризации пленка наносилась на сапфировую подложку плоскостью (0001). Перед нанесением подложка подвергалась влажной очистке в смешанном растворе аммиачной воды, пероксида водорода и деионизированной воды (1:1:3) при 80 ° C в течение 30 мин. Его неоднократно промывали деионизированной водой и сушили с использованием азота для удаления поверхностного загрязнения, что улучшило бы однородность и адгезию пленки к субстрату. Распыление проводили при давлении 0,7 Па с потоком кислорода и аргона со скоростью 5 и 95 см3 соответственно. При осаждении пленки использовалась мощность распыления 200 Вт в течение 60 мин. Наконец, осажденная пленка была отожжена на воздухе при 800 ° C (60 мин) и скорости нагрева 10 ° C / мин.
Кристаллическая структура Ga 2 О 3 Пленку исследовали с помощью рентгеновской дифракции (XRD, EMPYREAN) и просвечивающего электронного микроскопа (TEM, JEM-2100). Спектры поглощения Ga 2 О 3 пленка на сапфировой подложке были измерены с помощью УФ-видимой спектроскопии (iHR-320), которая также предоставила оценку оптической ширины запрещенной зоны пленки. Морфология поверхности и толщина осажденного Ga 2 О 3 пленку характеризовали с помощью атомно-силового микроскопа (AFM, SPA-400) и оптического микроскопа (LEICA DM 2700 M). Элементный анализ Ga 2 О 3 пленка была выполнена методом рентгеновской фотоэлектронной спектроскопии (XPS, K-Alpha +). Ток-напряжение ( Дж - V ) измерения на NiO / β-Ga 2 О 3 Фотоприемник выполнен с помощью измерителя источника Keithley 2400. Все измерения проводились при комнатной температуре.
Результаты и обсуждение
На рисунке 1а показаны дифрактограммы Ga 2 . О 3 пленка, выращенная на плоскости (0001) сапфировой подложки до и после отжига. Перед отжигом осажденная пленка находилась в аморфном состоянии, так как на шаблоне наблюдались только два пика (отмеченные как «*»), связанные с подложкой. После отжига пленки при 800 ° C рентгенограмма показала шесть характерных пиков, соответствующих кристаллическим плоскостям β-фазы Ga 2 О 3 , который принадлежит к моноклинной кристаллической системе. Наблюдаемая картина согласуется с ранее опубликованными работами [15, 16]. Эти характерные пики отожженного β-Ga 2 О 3 пленка показала хорошую кристалличность с преимущественной ориентацией по семейству кристаллических плоскостей (\ (\ overline {2} \) 01).
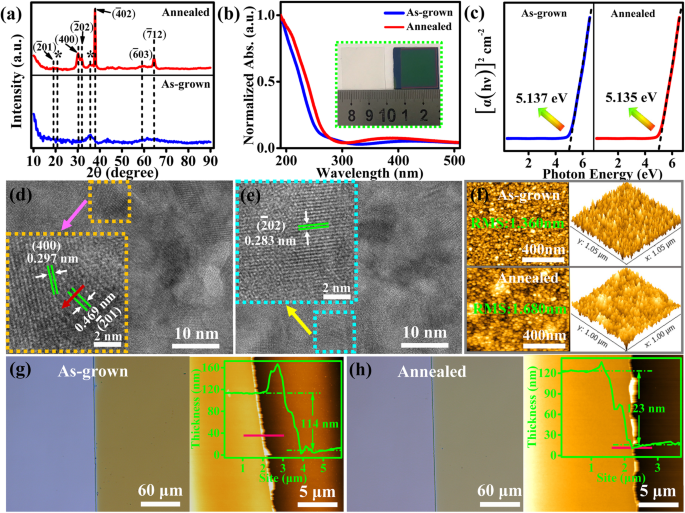
а Рентгенограммы β-Ga 2 О 3 пленка, нанесенная на плоскость сапфировой подложки (0001), а вершины сапфировой подложки отмечены звездочками (*). б Спектры поглощения в УФ и видимой областях β-Ga 2 О 3 фильм. c Графики [α ( hν )] 2 против энергии фотона. г – д Изображения β-Ga 2 с помощью ПЭМ и ВРТЭМ О 3 пленка после отжига. е АСМ изображения β-Ga 2 О 3 фильм. г – ч Оптические и АСМ изображения на границе ступени между пленкой и подложкой
На рисунках 1d и e представлены изображения β-Ga 2 с помощью ПЭМ и ВРТЭМ. О 3 пленка после отжига. Как показано, шаг решетки кристаллических плоскостей (\ (\ overline {2} \) 01), (400) и (\ (\ overline {2} \) 02) составлял 4,69 Å, 2,97 Å и 2,83 Å. соответственно, что снова свидетельствует о хорошей кристалличности и хорошо согласуется с ранее опубликованными работами [17, 18].
АСМ изображение β-Ga 2 О 3 Пленка, нанесенная на сапфировую подложку, показана на рис. 1е. Пленка после осаждения демонстрировала однородный гранулированный рельеф поверхности с относительно небольшой среднеквадратичной (RMS) шероховатостью поверхности 1,36 нм. После отжига среднеквадратичная шероховатость пленки увеличилась до 1,68 нм. О таком увеличении среднеквадратичной шероховатости после отжига также сообщили Hao et al [19]. Не исключено, что обработка отжигом может привести к дефектам структуры поверхности. Необходимы дальнейшие исследования, чтобы понять причину изменения морфологии поверхности после отжига. АСМ-изображения топографии края ступеньки между пленкой и подложкой до и после отжига показаны на рис. 1 g и h, профили линий которых (на вставке) показывают толщину пленки 114 ± 6,4 нм и 123 ± 2,0 нм ( около 8%) соответственно. Увеличение толщины пленки и RMS после отжига может быть связано с тем, что фазовый переход от аморфного состояния к кристалличности приводит к росту зерен нанокристаллов.
Спектры поглощения в УФ и видимой областях β-Ga 2 О 3 пленки до и после отжига показаны на рис. 1б. Обе пленки демонстрировали сильное УФ-поглощение в диапазоне 190–300 нм и почти полное отсутствие поглощения в видимой полосе света. Это показало, что обработка отжигом не оказала существенного влияния на край поглощения. Это привело только к небольшому красному смещению около 10 нм с небольшим усилением пика поглощения. Уравнение (1) можно использовать для оценки оптической запрещенной энергии ( E г) фильма.
$$ \ alpha \ left (h \ nu \ right) =A {\ left (h \ nu -E \ mathrm {g} \ right)} ^ {1/2} $$ (1)где α коэффициент поглощения, hν - энергия фотона, а A является константой. Принимая во внимание толщину пленки, измеренную с помощью АСМ, E g для осажденных и отожженных пленок можно определить по графикам на рис. 1c, которые показывают значения 5,137 эВ и 5,135 эВ, соответственно. Эти значения близки к теоретическому E g 4,9 эВ для β-Ga 2 О 3 .
XPS-спектры β-Ga 2 О 3 пленки показаны на рис. 2. На рис. 2a – c и d – f показаны XPS-спектры полного сканирования, элементов Ga и O до и после отжига, соответственно. Элемент C, наблюдаемый при полном сканировании, был добавочным углеродом. После отжига пик C 1 s значительно уменьшился, указывая на то, что большая часть углерода была удалена во время обработки отжигом. Энергия связи Ga3d на рис. 2b и e соответствует 21,14 эВ и 20,70 эВ, соответственно, что соответствует связи Ga-O в образцах, а энергия связи после отжига снижается на 0,44 эВ. Пики O 1 s соответствовали двум компонентам, связанным с кислородными вакансиями (O V ) и решеточный кислород (O L ). Соотношение площадей O V и O L (например, S OV :S OL) до и после отжига составляли 0,47 и 0,12 соответственно. Это свидетельствует об увеличении количества атомов кислорода в решетке из-за обработки отжигом, приводящей к кристаллизации, когда атомы кислорода перемещаются в свои соответствующие узлы решетки.

XPS-спектры β-Ga 2 О 3 фильм. Обзорное сканирование, пики уровней ядра Ga 3d и O1s, полученные до отжига, показаны на a – c . и после отжига показаны на d – f соответственно
УФ-фотоприемник, состоящий из β-Ga 2 О 3 фильм был изготовлен. Для фотоприемника была разработана простая вертикальная структура, состоящая из ITO / NiO / Ga 2 О 3 / Ал. Принципиальная схема конструкции устройства представлена на рис. 3а. Слой NiO был сначала напылен на кварцевую подложку, покрытую ITO, после применения тех же процедур влажной очистки, что и сапфировая подложка, а подробная подготовка и характеристики пленки NiO показаны в Дополнительном файле 1:Рисунок S1 и Рисунок S2. Ga 2 О 3 Затем слой напыляли с использованием указанных выше параметров осаждения. Подготовленный гетеропереход отжигали на воздухе при 600 ° C в течение 30 мин, чтобы избежать теплового повреждения ITO (при этом известно, что β-Ga 2 О 3 может быть сформирован при температуре отжига выше 550 ° C) с последующим осаждением из паровой фазы алюминиевых электродов (2 × 2 мм 2 ) на поверхности Ga 2 О 3 фильм. Наконец, алюминиевые электроды и подложка ITO использовались в качестве верхнего и нижнего электродов соответственно.

а Принципиальная схема, показывающая структуру устройства, состоящего из ITO / NiO / β-Ga 2 О 3 / Ал. б Зонная диаграмма фотоприемника. c – d Измерено J-V и войдите в J-V кривые фотоприемника соответственно при освещении светом с разной длиной волны и в темноте. е – е Измерено J-V и войдите в J-V кривые фотоприемника при УФ-освещении 245 нм с разной плотностью мощности соответственно. г – ч Отзывчивость ( R ) и обнаруживаемость ( D *) соответственно фотоприемника при разных напряжениях смещения при освещении 245 нм
На рис. 3б показана зонная диаграмма фотоприемника. Мы рассчитали E г пленки NiO согласно формуле. (1) как показано в Дополнительном файле 1:Рисунок S3. E г пленки NiO составляет около 3,4 эВ после отжига. Широкая запрещенная зона β-Ga 2 О 3 Слои (5,1 эВ) и NiO (3,4 эВ) чувствительны к УФ-излучению. При УФ-освещении ( hν ) электроны набирают достаточно энергии для перехода в зону проводимости, генерируя электронно-дырочные пары. Эти фотогенерированные электронно-дырочные пары были разделены встроенным электрическим полем и собраны соответствующими электродами. Здесь гетероструктура с соответствующим выравниванием полос может облегчить разделение и сбор зарядов.
Работоспособность фотоприемника на гетеропереходе исследовалась по измеренным значениям J - V и log J - V сюжеты, снятые с устройства подсветки инцидентов. Рисунки 3 c и d иллюстрируют J - V и log J - V кривые фотоприемника при освещении светом с разной длиной волны и в темноте соответственно. Когда фотоприемник освещался УФ-светом с длиной волны 245 нм и мощностью 27 мкВт / см −2 , резкое увеличение плотности тока, до 1,38 мА · см −2 Наблюдалась при приложенном напряжении 10 В. Плотность тока также увеличивается при освещении УФ-светом с длиной волны 285 и 365 нм. Однако большее количество электронно-дырочных пар может быть эффективно возбуждено УФ-светом с длиной волны 245 нм по сравнению с двумя другими УФ-светами, что свидетельствует о глубоком УФ-обнаружении устройства.
Дж - V и log J - V Кривые фотодетектора были измерены при УФ-освещении 245 нм с изменяющейся плотностью мощности, как показано на рис. 3e и f соответственно. Измерения проводились в темноте и в условиях УФ-света. Плотность тока увеличивается с интенсивностью света при УФ-освещении 245 нм, что предполагает, что фотодетектор обладает способностью генерировать фототок в ответ на УФ-излучение 245 нм.
Влияние напряжения смещения на чувствительность ( R ) устройства показано на рис. 3ж. R связана с плотностью фототока ( J ph ) согласно формуле. (2) [5]:
$$ R ={J} _ {\ mathrm {ph}} / {P} _ {\ mathrm {opt}} $$ (2)где P opt - плотность мощности фотонов, имеющая значение 1,5 мВт / см −2 . Увеличение R было видно из рис. 3g, когда напряжение смещения устройства увеличивается при фиксированной плотности мощности фотонов. Максимальный R было 27,43 AW −1 измерено при освещении 245 нм (27 мкВт / см −2 ) при напряжении смещения 10 В.
Обнаружение ( D *) - еще один важный параметр для оценки работы фотоприемников. Д * фотоприемника можно рассчитать по формуле. (3) следующим образом [20, 21]:
$$ {D} ^ {\ ast} =R / {\ left (2q \ left | {J} _ {\ mathrm {d}} \ right | \ right)} ^ {1/2} $$ (3)где q - абсолютный заряд электрона (1.602 × 10 −19 C) и J d - плотность темнового тока. Отношения между D * и напряжение смещения показано на рис. 3h, который показывает увеличение D * по мере увеличения напряжения смещения. Максимальный D * было 3,14 × 10 12 смГц 1/2 W -1 измерено при освещении 245 нм (27 мкВт / см −2 ) при напряжении смещения - 10 В. Исходя из значений R и D *, NiO / β-Ga 2 О 3 фотодетектор продемонстрировал высокую производительность при обнаружении УФ-излучения по сравнению с другими на основе NiO и Ga 2 О 3 УФ-детекторы показаны в Таблице 1.
Выводы
В заключение, β-Ga 2 О 3 Пленка была приготовлена методом высокочастотного магнетронного распыления и показала хорошую кристалличность после отжига при 800 ° C. Материал с широкой запрещенной зоной показал сильное УФ-поглощение в диапазоне 190–300 нм. Фотоприемник глубокого УФ-излучения на основе NiO / β-Ga 2 О 3 гетероструктура была высокочувствительной к УФ-свету 245 нм с высокой чувствительностью ( R ) и обнаруживаемость ( D *) до 27,43 AW −1 и 3,14 × 10 12 смГц 1/2 W -1 , соответственно. Считается, что характеристики УФ-фотодетектора могут быть дополнительно улучшены за счет легирования или оптимизации конструкции устройства.
Доступность данных и материалов
Выводы, сделанные в этой рукописи, основаны на данных (основной текст и рисунки), представленных и показанных в этой статье.
Сокращения
- AFM:
-
Атомно-силовой микроскоп
- ITO:
-
Оксид индия и олова
- ТЕМ:
-
Просвечивающий электронный микроскоп
- UV:
-
Ультрафиолет
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Нанографема, гибкая прозрачная память на основе кремния
- Влияние полиэтиленгликоля на фотокатод NiO
- Плазмонный датчик на основе диэлектрических нанопризм
- Чувствительное неферментативное электрохимическое определение глюкозы на основе полого пористого NiO
- Высокопроизводительный автономный УФ-детектор на основе массивов наночастиц SnO2-TiO2
- Фотодетектор с регулируемой длиной волны на основе одиночного нанопояса CdSSe
- Высокоэффективный ультрафиолетовый фотодетектор на основе графеновых квантовых точек, украшенных наностер…
- Недорогой гибкий матричный ультрафиолетовый фотодетектор ZnO из микропроводов, встроенный в подложку PAVL
- О слое распространения тока p-AlGaN / n-AlGaN / p-AlGaN для светодиодов глубокого ультрафиолетового излучения на основе…
- Влияние ширины квантовых ям на электролюминесцентные свойства светодиодов AlGaN, излучающих глубокий ультрафи…



