Исследование зависящих от размера проводящих свойств отдельных кремниевых нанопроволок
Аннотация
Периодически упорядоченные массивы вертикально ориентированных Si нанопроволок (Si ННК) успешно изготавливаются с помощью наносферной литографии в сочетании с химическим травлением с помощью металла. Регулируя время травления, можно хорошо контролировать как диаметр, так и длину нанопроволоки. Проводящие свойства таких Si ННК и, в частности, их зависимость от размера исследуются с помощью проводящей атомно-силовой микроскопии (CAFM) на отдельных нанопроволоках. Результаты показывают, что проводимость Si ННК во многом зависит от их диаметра и длины. Si ННК меньшего диаметра и меньшей длины обладают лучшими проводящими свойствами. Вместе с характеристикой ВАХ предполагается возможный механизм с точки зрения зависящей от размера высоты барьера Шоттки, что дополнительно подтверждается измерениями электростатической силовой микроскопии (EFM). Это исследование также предполагает, что CAFM может действовать как эффективное средство для изучения зависимости проводящих свойств от размера (или других параметров) отдельных наноструктур, что должно иметь важное значение как для оптимизации производства, так и для потенциальных применений наноструктур.
Введение
Кремниевые нанопроволоки (Si ННК) нашли многообещающее применение в электронной, фотонной, оптоэлектронной и многих других областях благодаря их высокому соотношению сторон и уникальным электрическим, термоэлектрическим и фотоэлектрическим свойствам, а также совместимости с традиционной кремниевой технологией [1,2,3 , 4,5]. В последние десятилетия исследования Si NW в основном были сосредоточены на улучшении роста и измерении свойств. Для приготовления Si ННК было разработано множество методов, включая восходящие методы, такие как метод пар-жидкость-твердое тело, химическое осаждение из паровой фазы и молекулярно-лучевая эпитаксия [6,7,8,9,10], а также подходы сверху вниз с использованием электронов. -лучевая литография, реактивное ионное травление или химическое травление с помощью металла [11,12,13,14,15,16]. Среди этих методов наносферная литография (NSL) в сочетании с химическим травлением с использованием металла (MACE) интенсивно применялась для изготовления упорядоченных массивов вертикально ориентированных Si ННК большой площади из-за своей простоты, низкой стоимости и универсальности [15,16,17 , 18,19,20,21,22,23]. Si ННК, получаемые с помощью MACE, обычно имеют очень грубую и даже пористую поверхность [18,19,20,21], что просто придает им большую удельную поверхность и отличные свойства, что приводит к большим возможностям применения в биосенсорах, термоэлектрических устройствах, литиевых -ионовые батареи, солнечные элементы и др. [22,23,24]. Чтобы реализовать эти приложения, важно хорошо понимать их электрические свойства. В настоящее время для исследования электрических свойств нанопроволок часто применяют два вида методов. Один из них выполняется обычными макроскопическими методами, что относительно легко сделать, но может обеспечить только усредненные результаты по большой совокупности нанопроволок [24, 25]. Другой выполняется на отдельных нанопроволоках с помощью специальных устройств, изготовленных из одиночных нанопроволок [21, 26, 27, 28], что может исключить влияние неоднородности размеров, но его нелегко достичь, особенно при измерении зависимости свойств. Поэтому настоятельно требуются более удобные методы исследования электрических свойств отдельных ННК без сложных нанофабрикатов.
В последние десятилетия электрические измерения на основе сканирующей зондовой микроскопии (СЗМ) проявили себя как мощный метод определения электрических характеристик на наномасштабе [29, 30]. Среди этих методов СЗМ, проводящая атомно-силовая микроскопия (CAFM) успешно применялась для изучения проводящих свойств отдельных или отдельных наноструктур [30,31,32]. Уже сообщалось об исследованиях CAFM различных нанопроволок, таких как ZnO, InAs, CdS, CdSe, GaAs, InAsSb и Si ННК [33,34,35,36,37,38]. В то время как большинство исследований было сосредоточено на проводящих свойствах нанопроволок с фиксированными параметрами, некоторые исследования были выполнены для изучения легирующей зависимости проводящих свойств [37,38,39]. Зависимости проводящих свойств нанопроволок от размера еще менее изучены. Сообщалось лишь о нескольких исследованиях, посвященных зависимым от диаметра проводящим свойствам нанопроволок, даже не ограничиваясь CAFM, и значительная часть из них касалась зависимости удельного сопротивления нанопроволок от диаметра [25, 40, 41, 42]. Например, пара исследований нанопроволок GaN показала, что удельное сопротивление было высоким при критическом диаметре (20 ~ 80 нм, в зависимости от методов изготовления) и оставалось неизменным за его пределами [41, 43], тогда как другие исследования нанопроволок Si сообщили, что удельное сопротивление нанопроволоки уменьшалось с увеличением диаметра в диапазоне от десятков до сотен нанометров [40, 44]. Для полупроводниковых нанопроволок с металлическими контактами барьер Шоттки может играть важную роль в их проводящих свойствах. Поэтому, кроме удельного сопротивления, барьер Шоттки следует учитывать при наличии полупроводниковых нанопроволок. В нескольких статьях основное внимание уделялось зависимости высоты барьера Шоттки (SBH) от диаметра, но результаты не согласуются друг с другом. Например, Calahorra et al. рассчитал SBH, решив уравнение Пуассона в нанопроволоке, и обнаружил четкую тенденцию увеличения высоты барьера с уменьшением размера [45]. Подобная зависимость диаметра была экспериментально обнаружена Soudi et al. при исследовании зависящей от диаметра поверхностной фотоэдс и плотности поверхностных состояний на устройстве с одиночной нанопроволокой ZnO. Они обнаружили, что высота поверхностного барьера увеличивается с уменьшением диаметра (20–60 нм), что было интерпретировано с помощью плотности поверхностного состояния, смоделированной с использованием уравнения Пуассона [46]. Напротив, измерения с помощью сканирующей микроскопии фототока на полевых транзисторах с одиночной Si-нанопроволокой, выполненные Yoon et al. выявили обратную зависимость:высота барьера уменьшалась с уменьшением диаметра из-за вклада интерфейсных состояний [47]. Другая экспериментальная работа Mao et al. на одиночных диодах Шоттки с Pt / ZnO с наноиглами также сообщалось, что высота барьера уменьшалась с уменьшением диаметра, что объяснялось эффектом джоулева нагрева и / или электронной неоднородностью границы раздела [48]. Поэтому до сих пор зависимость проводящих свойств нанопроволок от диаметра еще не достигла консенсуса и еще далека от полного понимания. В частности, не сообщалось о зависящих от размера проводящих свойствах, а также об исследованиях SBH, зависящих от размера, для отдельных Si ННК, изготовленных методом MACE, которые имеют довольно шероховатую поверхность для многообещающих применений.
В данной работе периодические массивы вертикально ориентированных Si ННК разного диаметра и длины готовятся методом NSL в сочетании с MACE. И диаметр, и длину КНН можно хорошо контролировать, регулируя время травления. Проводящие свойства отдельных Si ННК внутри массива исследуются с помощью CAFM без каких-либо дополнительных нанофабрикатов, которые могут исследовать зависящие от размера проводящие свойства на отдельных Si ННК, просто заменяя образец. Результаты показывают, что ток, измеренный на отдельных Si ННК, сильно зависит от диаметра и длины ННК. Si ННК меньшего диаметра и меньшей длины обладают лучшими проводящими свойствами. Посредством аппроксимации ВАХ можно получить зависящие от размера высоты барьера Шоттки, который, как обнаружено, действует как ключевой фактор для определения зависящих от размера проводящих свойств нанопроволок. Кроме того, аналогичная величина SBH, зависящая от размера, была получена с помощью измерений электростатической силовой микроскопии (EFM). Таким образом, наше исследование не только выявляет зависящие от размера свойства Si ННК, но также предполагает, что CAFM может действовать как эффективное средство для изучения зависимости проводящих свойств от размера (или других параметров) отдельных наноструктур от размера (или других параметров).
Материалы и методы
Материалы
Пластины Si были закуплены у MTI (Китай). Суспензии (2.5 мас.% В воде) полистирольных сфер (ПС, диаметр 490 нм) были закуплены у Duke Scientific (США). Ацетон, метанол, серная кислота, перекись водорода и плавиковая кислота для изготовления Si ННК были закуплены у Sinopharm Chemical Reagent (Китай). Деионизированная вода (DI, 18,2 МОм · см) была получена из системы ультрафильтрации (Milli-Q, Millipore, Мальборо, Массачусетс).
Изготовление Si NW
Вертикально упорядоченные массивы кремниевых нанопроволок изготавливаются с помощью NSL в сочетании с MACE, которые были подробно описаны в предшествующей литературе [49, 50]. Основной производственный процесс показан на рис. 1а. Во-первых, монослой полистирольных сфер (ПС) диаметром 490 нм самособирался на химически очищенной плоской кремниевой пластине (n-типа, 0,01 Ом · см) с образованием гексагонального монослоя с плотной упаковкой. Впоследствии покрытый PS образец был протравлен реактивным ионным травлением (RIE, Trion Technology) (50 Вт, 70 мТорр) с O 2 газ (20 см3) для уменьшения диаметра PS, который служил маскирующим слоем в следующих процедурах. После этого пленка Au толщиной 20 нм была нанесена ионным распылением на образец, замаскированный слоем PS, который служил катализатором для последующей обработки MACE. Образец был обработан MACE в HF (40%) и H 2 О 2 (30%) смешанный раствор (объемное соотношение 4:1) при комнатной температуре. В процессе MACE поверхность Si, покрытая Au, подвергалась эффективному травлению, в то время как поверхность, покрытая PS (без Au), защищалась, что приводило к образованию Si NW. Наконец, оставшийся слой Au и сферы PS были удалены путем вымачивания образца в KI / I 2 . и растворы тетрагидрофурана соответственно. С помощью этого метода изготовления могут быть получены периодические массивы большой площади вертикально ориентированных массивов Si NW.

а Схематическое изображение процедуры изготовления вертикально ориентированного массива Si нанопроволок. б Принципиальная схема экспериментальной установки для измерений CAFM и EFM на отдельных Si нанопроводах
Характеристика Si NW
Морфология изготовленных Si ННК была проверена с помощью сканирующей электронной микроскопии (SEM, SIGMA300), а их структурные свойства были исследованы с помощью спектроскопии комбинационного рассеяния (система Jobin Yvon HR-Evolution 2) с длиной волны возбуждения 532 нм и малой мощностью около 1 мВт. .
Электрические свойства Si ННК были исследованы методами CAFM и EFM с использованием коммерческого оборудования для СЗМ (Multimode V, Bruker Nano Surfaces), как показано на рис. 1b. Наконечники с покрытием Cr / Pt (Multi75E-G, Budget Sensors, радиус приблизительно 25 нм) использовались как для измерений CAFM, так и EFM. В CAFM проводящий наконечник сканировался по поверхности образца в контактном режиме с приложением постоянного напряжения смещения к подложке, когда наконечник был заземлен, и измерялся ток между наконечником и образцом. Поскольку анодное окисление поверхности является серьезным при положительных смещениях образца, все текущие изображения были измерены при отрицательных смещениях образца. В экспериментах CAFM были испытаны различные отрицательные напряжения в диапазоне от -0,5 до -3,0 В. Было обнаружено, что при установке напряжения смещения ниже -1,5 В ток был слишком мал, чтобы его можно было обнаружить для образцов с плохой проводимостью. Хотя напряжение смещения было установлено равным –2,0 В или больше, измерения были нестабильными, вероятно, из-за повреждения наконечника и / или образца под действием большого электростатического поля. Поэтому для измерения текущего изображения было выбрано напряжение смещения -1,5 В. Измерения ЭСМ проводились на Si ННК в двухпроходном режиме. В первом проходе он работал в режиме постукивания, чтобы получить изображение топографии, а во втором проходе наконечник был поднят достаточно высоко, чтобы игнорировать силу Ван-дер-Ваальса. При поднятом проходе между образцом и заземленным наконечником добавлялось постоянное напряжение, и регистрировался сигнал фазового сдвига, индуцированный электростатической силой. Все эксперименты проводились в проточном потоке N 2 окружающей среды для стабильных электрических измерений, и образцы были предварительно погружены в раствор HF (5%) на 30 с, чтобы эффективно уменьшить влияние оксидного слоя на характеристики проводимости. Поскольку измерения проводились сразу после HF погружения, слой риформированного кислорода должен быть достаточно тонким, чтобы в него мог проникнуть проводящий наконечник, и его влияние на проводимость минимально.
Результаты и обсуждения
Изготовление Si NW
Изготовление массивов упорядоченных по вертикали Si нанопроволок большой площади показано на рис. 1а. Изменяя время RIE, диаметр сфер PS может быть уменьшен до желаемых значений, и, следовательно, могут быть получены Si NW с контролируемым диаметром. СЭМ-изображения Si ННК, полученные после травления РИЭ на 90, 120 и 150 с, представлены на рис. 2 a, b и c соответственно. Можно заметить, что Si ННК выровнены по вертикали в периодически гексагональном расположении на большой площади. Эти вертикально ориентированные Si ННК имеют одинаковый период 490 нм и одинаковую длину около 350 нм (то же время MACE 40 с). Диаметр Si ННК на (а), (б) и (в) составляет около 350, 260 и 190 нм соответственно. Зависимость диаметра ННК от времени травления РИТ показана на рис. 2г, демонстрируя хорошую линейную корреляцию. С другой стороны, длину нанопроволок можно регулировать, изменяя время MACE в HF и H 2 О 2 смешанный раствор. SEM-изображения поперечного сечения Si ННК после 40, 60, 80 и 100 с MACE показаны на рис. 2e. Видно, что длина ННК увеличивается с 350 до 960 нм за счет увеличения времени MACE. Точно так же длина Si ННК показывает хорошую линейную зависимость от времени MACE, как показано на рис. 2f. Эти результаты показывают, что заказанные Si NW с регулируемыми диаметром и длиной успешно изготавливаются методом NSL в сочетании с MACE.
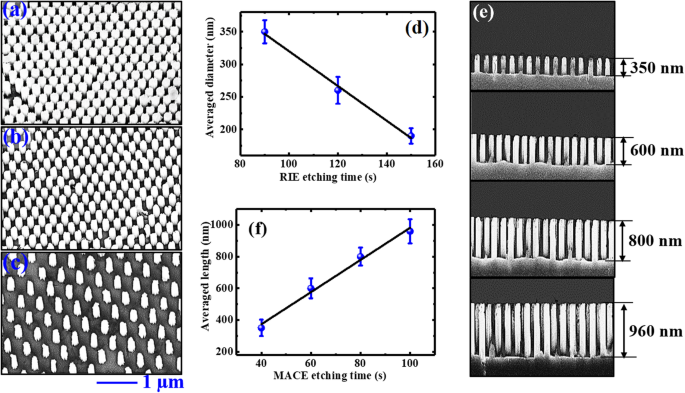
Вид сверху СЭМ-изображения Si ННК с одинаковой длиной 350 нм, но разными диаметрами a 350 нм; б 260 нм; и c 190 нм. Зависимость диаметра ННК от времени травления РИТ показана на д . . е СЭМ-изображения поперечного сечения Si ННК с одинаковым диаметром 260 нм, но разной длиной 350, 600, 800 и 960 нм. е Представляет зависимость длины NW от времени MACE
Из изображений SEM также можно обнаружить, что Si ННК имеют очень шероховатую поверхность после химического травления, а их боковая поверхность особенно шероховатая. Чтобы проверить микроструктуру поверхностного слоя в зависимости от диаметра и длины, спектры комбинационного рассеяния были измерены как на объемных Si, так и на Si ННК разного диаметра и разной длины. Каждый спектр был нормализован с использованием максимальной интенсивности пика при 520 см - 1 . , а результаты для разного диаметра и разной длины показаны на рис. 3 а и б, соответственно. Спектр объемного кремния показывает острый пик, расположенный при ~ 520,1 см - 1 . . Как красное смещение положения пика, так и расширение ширины пика (называемое полной шириной на полувысоте, FWHM) можно наблюдать на Si ННК, как показано на рис. 3 c и d, соответственно. Пиковое красное смещение и уширение довольно малы для нанопроволок с короткой длиной 350 и 600 нм и становятся относительно очевидными при увеличении длины нанопроволоки до 800 нм и выше. Такое красное смещение и уширение рамановского пика иногда связывают с изменениями уровня примеси или содержания кристаллов. Согласно предыдущей литературе [5, 51], для Si ННК, изготовленных тем же методом MACE, концентрация легирования может иметь тот же уровень легирования, что и исходная пластина. Из-за ограничений оборудования мы не смогли подтвердить этот результат. С другой стороны, хотя эти Si ННК имеют шероховатую поверхность, в предыдущей литературе было обнаружено, что Si ННК, изготовленные методом MACE, могут в основном сохранять свою кристаллическую структуру как для n-, так и для p-легирования, а также для легкого и сильного легирования [5, 51 , 52]. На поверхности стенки ННК наблюдался только тонкий аморфный слой. Аналогичные результаты были получены на Si ННК разного диаметра и длины разными группами. Таким образом, можно было предположить, что Si ННК, изготовленные методом MACE, могут сохранять уровень примеси и кристаллическое содержание почти неизменными, как их объемные аналоги, за исключением тонкого поверхностного слоя.

Типичные рамановские спектры объемных Si и нанопроволок Si с a та же длина 350 нм, но разные диаметры и b тот же диаметр 190 нм, но разная длина. c и d представляют красное смещение положения пика и уширение на полувысоте как функцию длины нанопроволоки
Следовательно, сдвиг и уширение рамановского пика, скорее всего, вызваны повреждением шероховатой поверхности нанопроволок [53]. В нескольких статьях сообщается о результатах комбинационного рассеяния кремниевых нанокристаллов, изготовленных тем же методом MACE. Например, Feser et al. обнаружили, что значительное расширение пика на 520 см - 1 увеличивается со временем MACE и объясняет уширение этого пика беспорядком кристалла (например, кластеры точечных дефектов), вызванным процессом травления [23]. Lajvardi et al. обнаружили, что красное смещение комбинационного рассеяния увеличивается со временем MACE, т.е. е. пик комбинационного рассеяния света TO был расположен при 521,1 см - 1 для объемного Si и сдвинуто до 518,7 см - 1 для 80-минутных образцов соответственно [54]. Они заявили, что причиной рамановского сдвига может быть образование нанокристаллов Si на стенке нанопроволоки. Lin et al. заметил, что пик комбинационного рассеяния света сместился с 520 до 516 см - 1 когда длина ННК увеличивается с 0 (объемный Si) до 2,73 мкм, а ширина пика увеличивается с 3 до 9 см - 1 с увеличением длины ННК с 0,19 до 2,73 мкм [55]. Они думали, что уширение пика комбинационного рассеяния определялось взаимодействием фонон-деформация, и было доказано, что сдвиг пика комбинационного рассеяния пропорционален вызванному деформацией искажению поверхностной решетки. Поскольку деформация, вызванная травлением HF, увеличивалась с увеличением длины NW (большее время травления), как красное смещение пика комбинационного рассеяния, так и уширение увеличивались с увеличением длины NW. В нашем случае из спектров комбинационного рассеяния, показанных на рис. 3 a и b, мы можем обнаружить, что пик комбинационного рассеяния TO сдвигается от 520 до 519,4 см - 1 когда длина ННК увеличивается с 0 (объемный Si) до 960 нм, а ширина на полувысоте увеличивается с 4,41 до 4,47 см - 1 при увеличении длины ННК с 350 до 960 нм. Мы предпочитаем, чтобы этот зависящий от длины сдвиг пика комбинационного рассеяния и уширение происходили из-за поврежденной поверхности (деформации или беспорядка). Однако из-за очень небольшого разброса как красного смещения, так и уширения пиков для нанопроволок разного диаметра и разной длины (<1.0 см - 1 ), изменение деформации / беспорядка с размером можно считать минимальным. Таким образом, деформация / беспорядок может изменять проводимость ННК, но ее влияние на зависимость проводимости от размера не рассматривается в следующих разделах.
Измерения проводящих свойств на одиночных Si НН
Проводящие свойства Si ННК измеряются методом CAFM на отдельных ННК разного диаметра и длины. Типичные изображения топографии вертикально ориентированных Si ННК с одинаковой длиной 350 нм, но с разными диаметрами 350, 260 и 190 нм показаны на рис. 4 a, b и c соответственно, а их соответствующие текущие изображения, полученные на образце. напряжение смещения -1,5 В представлено на рисунках (d), (e) и (f). Следует отметить, что поскольку острие АСМ с покрытием Cr / Pt представляет собой клин с большим углом, Si ННК имеют больший диаметр, чем их реальный диаметр. Кроме того, ток, выходящий из нанопроволок, не может быть хорошо обнаружен, так как наконечник может не контактировать с подложкой, поэтому во внимание принимаются только токи, измеренные на нанопроволоке. Из текущих изображений можно заметить, что большинство краев нанопроволок Si демонстрируют немного лучшую проводимость, чем центр. Это может быть результатом бокового контакта между острием АСМ и Si ННК с большей площадью контакта. Кроме того, из-за очевидной шероховатости на верхней поверхности в некоторых областях в центральной области может также наблюдаться большой ток, подобный краю, что не приводит к отчетливому кольцевому распределению тока. С другой стороны, проводимость Si ННК, очевидно, связана с диаметром нанопроволоки. Можно видеть, что как отношение проводящих площадей нанопроволок, так и абсолютные значения тока значительно увеличиваются при уменьшении диаметра с 350 до 190 нм. Результаты показывают, что кремниевые нанокристаллы меньшего диаметра обладают большей проводимостью, чем наночастицы большего диаметра. Чтобы получить зависимость диаметра более интуитивно, профили тока вдоль отмеченных линий на рис. 4d - f отображаются на рис. 4g. Из него ясно видно, что Si ННК диаметром 190 нм намного более электропроводны, чем ННК диаметром 260 и 350 нм. Такую зависимость диаметра также можно получить из статистических гистограмм распределений тока на Si ННК разного диаметра, как показано в Дополнительном файле 1:Рисунок S1 (a), который демонстрирует смещение распределения тока к высоким значениям при уменьшении диаметра. Усредненные токи ( I av ) Si ННК рассчитываются путем усреднения тока по всем нанопроволокам на текущих изображениях, который показан на рис. 4h как функция диаметра ННК. Усредненный ток Si ННК резко увеличивается в девять раз при уменьшении диаметра ННК с 350 до 190 нм. Подобная зависимость тока от диаметра была достигнута как на одиночных нанопроволоках InAs, так и на устройствах с одиночными нанопроволоками Si [35, 47].

Изображения топографии Si ННК одинаковой длины 350 нм, но разного диаметра a 350 нм, b 260 нм, c 190 нм. Соответствующие им текущие изображения, полученные при смещении выборки -1,5 В, приведены в d . , e и е , соответственно. Текущие профили вдоль отмеченных линий в d - е нанесены в г , и h представляет усредненный ток ( I av ) по нанопроволоке в зависимости от диаметра ННК. Соответствующие линии добавляются на изображения топографии a - c и профильные кривые в g смещены по вертикали для ориентации
Типичные текущие изображения Si ННК разной длины и одинакового диаметра 190 нм, измеренные при смещении образца - 1,5 В, представлены на рис. 5. На рис. 5 а - d показаны текущие изображения Si ННК длиной 350, 600, 800 и 960 нм соответственно. Видно, что на этих токовых изображениях проводящие области явно уменьшаются с увеличением длины, в то время как уменьшение абсолютного тока не так очевидно, особенно для ННК с длиной 350 нм и 600 нм. Возможно, из-за наличия локальной неравномерной шероховатости поверхности в некоторых точках на рис. 5б наблюдался еще больший ток. Тем не менее, средний ток на рис. 5б был намного меньше, чем на рис. 5а. Используя тот же анализ, что и выше, текущие профили вдоль отмеченных линий представлены на Рис. 5e, а статистические гистограммы показаны в Дополнительном файле 1:Рисунок S1 (b). Оба они явно демонстрируют значительное уменьшение тока с увеличением длины ННК. Усредненные токи нанопроволок в зависимости от длины ННК показаны на рис. 5f, и они составляют порядка десятков и сотен пА, что намного меньше, чем показанное на рис. 5а-е, порядка нА. . Это связано с тем, что нанопроволоки демонстрируют относительно большой ток только в нескольких токопроводящих точках, когда большинство областей являются непроводящими. Из рис. 5f, усредненный ток показывает уменьшение более чем в три раза при увеличении длины с 300 до 960 нм, что указывает на уменьшение проводимости нанопроволоки с увеличением длины. Зависимость сопротивления нанопроволоки от длины ранее исследовалась с помощью четырехточечных измерений сопротивления полупроводниковых нанопроволок, которые предполагали, что при омическом контакте сопротивление нанопроволоки увеличивалось с увеличением ее длины линейно с крутизной сопротивления [56, 57]. В нашем случае из графика I ~ 1 / L, приведенного в Дополнительном файле 1:Рисунок S2, зависимость заметно нелинейна; следовательно, удельное сопротивление не могло быть правильно получено из наклона кривой. Следует отметить, что при измерениях CAFM общее измеренное сопротивление включает контактное сопротивление между наконечниками с покрытием Cr / Pt и Si NW ( R tip / NW ), сопротивление Si NW ( R NW ) и сопротивление кремниевых пластин ( R навалом ). Поскольку сопротивление, измеряемое CAFM, в основном возникает из локальной области поверхности под наконечником, оно быстро уменьшается с увеличением площади вдоль пути тока, R навалом намного меньше по сравнению с R NW и R tip / NW . С другой стороны, из-за очень маленькой площади контакта металл-полупроводник между наконечником и нанопроволокой, контактное сопротивление R tip / NW намного больше, чем сопротивление нанопроволоки R NW . Нелинейность зависимости тока от 1 / L как раз указывает на наличие большого контактного сопротивления. Поэтому при измерениях, проводимых с помощью CAFM, следует особо учитывать сопротивление контакта металл-полупроводник, в котором барьер Шоттки играет важную роль.

Текущие изображения Si ННК при смещении образца - 1,5 В с тем же диаметром 190 нм, но разной длиной a 350 нм, b 600 нм, c 800 нм и d 960 нм соответственно. Текущие профили по отмеченным линиям в a - г нанесены на e , и f представляет усредненные токи нанопроволок ( I av ) как функция длины ННК. Кривые профиля на e смещены по вертикали для ориентации
Чтобы проверить сделанный выше вывод, были записаны вольт-амперные кривые (ВАХ) на отдельных Si ННК для исследования барьера Шоттки на контакте металлический наконечник / Si нанопроволока. Типичные ВАХ на Si ННК с одинаковой длиной 350 нм, но с разными диаметрами представлены на рис. 6а, а кривые на Si ННК с тем же диаметром 190 нм, но разной длины показаны на рис. 6b соответственно. Все ВАХ показывают большие токи в области отрицательного напряжения образца, что соответствует типичным ВАХ с контактом Шоттки между металлическим наконечником и полупроводником n-типа. Поскольку ВАХ демонстрируют хорошие характеристики металл-полупроводник, это указывает на то, что влияние слоя кислорода на проводимость не является серьезным и, таким образом, предполагается минимальным в последующем обсуждении. Между тем, результаты показывают, что меньшие и более короткие нанопроволоки демонстрируют большую проводимость, чем более крупные и длинные, что хорошо согласуется с результатами, полученными из текущих изображений. Для количественного анализа принята хорошо известная модель термоэмиссии для контакта металл-полупроводник [58, 59]. В этой модели ВАХ контакта Шоттки с полупроводником n-типа при наличии последовательного сопротивления можно аппроксимировать как [59]:
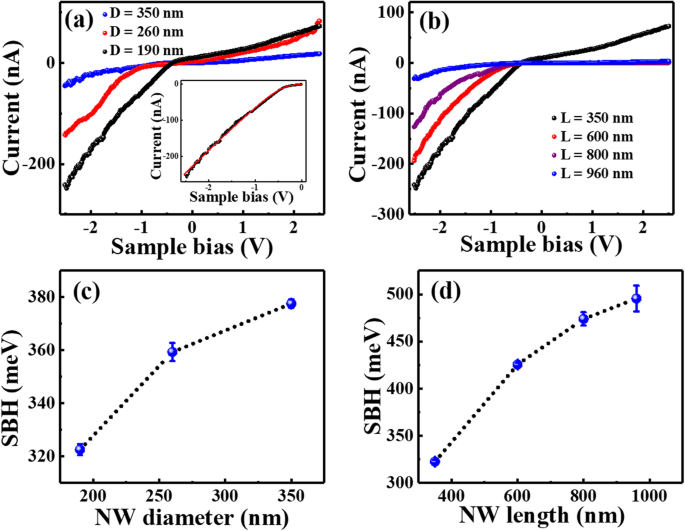
Типичные ВАХ на Si ННК с одинаковой длиной 350 нм, но разным диаметром ( a ) и одинакового диаметра 190 нм, но разной длины ( b ). Вставка в a показывает типичный результат подгонки Si ННК диаметром 190 нм и длиной 350 нм. c и d представляют высоту барьера Шоттки, полученную по результатам подгонки, как функцию диаметра и длины ННК соответственно
$$ I ={I} _S \ left [\ exp \ left (\ frac {q \ left (VI {R} _S \ right)} {\ mathrm {n} kT} \ right) -1 \ right], $ $ (1)где n является идеальным фактором и R S - последовательное сопротивление. Я S ток насыщения, который может быть выражен как:
$$ {I} _S =\ mathrm {AA} \ ast {T} ^ 2 \ exp \ left (- \ frac {\ varphi_B} {kT} \ right), $$ (2)где A - площадь контакта, A * - постоянная Ричардсона и φ B - высота барьера Шоттки (SBH) между металлическим наконечником и нанопроволокой Si. Таким образом, SBH можно получить по формуле:
$$ {\ varphi} _B =kT \ ln \ left (\ frac {\ mathrm {AA} \ ast {T} ^ 2} {I _ {\ mathrm {S}}} \ right), $$ (3)Кривые ВАХ на рис. 6а и б могут быть хорошо подогнаны уравнением. (1), а типичная аппроксимирующая линия в передней части показана на вставке к рис. 6а. Чтобы получить значения SBH из тока насыщения, предполагается, что эффективная постоянная Ричардсона A * приблизительно равна таковой для объемного кремния, то есть 112 А · см - 2 K - 2 для кремния n-типа [59]. Предполагается, что площадь контакта составляет 2 × 10 - 11 см 2 приняв радиус острия, покрытого Cr / Pt, равным 25 нм. Полученные значения SBH составляют около 322, 359 и 377 мэВ для Si ННК с одинаковой длиной 350 нм и разными диаметрами 190, 260 и 350 нм соответственно. Для Si ННК с одинаковым диаметром 190 нм и разной длиной 350, 600, 800 и 960 нм значения SBH составляют 322, 425, 473 и 495 мэВ соответственно. Для сравнения, типичная ВАХ была измерена на кремниевой пластине того же типа, как показано в Дополнительном файле 1:Рисунок S3 (a). Это ясно показывает, что проводимость Si-пластины намного меньше, чем у полученных ННК. Обнаруживаемый ток можно было измерить только при высоких напряжениях смещения (-4 ~ -10 В). После подгонки ВАХ с указанной выше моделью термоэлектронной эмиссии (дополнительный файл 1:рис. S3 (b)) для объемного Si было получено значение SBH, равное 0,60 эВ. Obviously, all of the measured SBH values for Si NWs with different diameters and lengths are smaller than that of the bulk Si. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Мао и др. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
EFM Measurements on Single Si NWs
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)где C , V EFM , и V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ образец − φ подсказка )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)where Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
Из уравнения. (5), it can be seen that the EFM phase shift should be equal to zero at V EFM = V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E F ). Как E n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). c и d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a и b are vertically shifted for guidance
Заключение
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
Доступность данных и материалов
The datasets used for supporting the conclusion are included in the article and the supporting file.
Сокращения
- CAFM:
-
Conductive atomic force microscopy
- CPD:
-
Contact potential difference
- EFM:
-
Electrostatic force microscopy
- MACE:
-
Химическое травление с использованием металла
- NSL:
-
Nanosphere lithography
- PS:
-
Polystyrene spheres
- RIE:
-
Реактивное ионное травление
- SBH:
-
Высота барьера Шоттки
- SEM:
-
Сканирующая электронная микроскопия
- Si NWs:
-
Si nanowires
- SPM:
-
Scanning probe microscopy
Наноматериалы



