Влияние Cu-допинга на производительность устройств RRAM на основе La
Аннотация
В этой статье было исследовано влияние слоя вставки Cu и быстрого термического отжига на поведение резистивного переключения устройств с резистивной коммутационной памятью (RRAM) на основе La. По сравнению с нелегированным контрольным образцом (Cu / LaAlO 3 / Pt) устройства со встроенным Cu демонстрируют более высокий выход устройства и напряжение остановки сброса, что указывает на то, что надежность RRAM на основе La была эффективно улучшена. Однако неотожженный Cu / LaAlO 3 :Устройство Cu / Pt RRAM по-прежнему страдает серьезным разбросом параметров. Было доказано, что устройство RRAM с введенным слоем Cu и обработкой отжигом демонстрирует лучшие характеристики резистивного переключения, такие как низкое напряжение формования, высокое соотношение включения / выключения и прекрасная электрическая однородность. Эти улучшения можно объяснить диффузией атомов Cu и образованием нанокристаллов Cu (Cu-NC) после процесса отжига, поскольку диффузные атомы Cu и Cu-NC могут усиливать локальное электрическое поле и ослаблять хаотичность образования / разрыв токопроводящих нитей.
Введение
Резистивная память с произвольным доступом (RRAM) рассматривается как направление развития энергонезависимых запоминающих устройств следующего поколения, которые привлекают большое внимание благодаря своей простой структуре, низкому энергопотреблению, высокой масштабируемости, высокой скорости работы и многозначности. емкость памяти [1]. RRAM часто превращается в многослойную структуру металл – изолятор – металл (M – I – M), и промежуточный диэлектрический слой оказывает значительное влияние на его характеристики резистивного переключения (RS). Таким образом, широкий спектр материалов, в том числе многие широко используемые материалы с высокой диэлектрической проницаемостью (high- k ) материалы (такие как HfO 2 [2], Al 2 О 3 [3], и ZrO 2 [4]), были тщательно исследованы для приложений RRAM. Среди всех оксидных материалов оксид на основе лантана является одним из наиболее многообещающих материалов с высоким k диэлектрические материалы, которые вызвали большой исследовательский интерес из-за их высокого - k значение, большая ширина запрещенной зоны и прекрасная термическая стабильность [5]. В последнее время в RRAM на основе La были обнаружены хорошие характеристики переключения сопротивления, такие как низкое рабочее напряжение, окно с высоким сопротивлением, длительное время выдержки, долговечность при длительном цикле и хорошая стабильность, что указывает на потенциальное применение высокоэффективных соединений на основе La.> k материалы в RRAM [6, 7].
Кроме того, благодаря преимуществам превосходной однородности, точного контроля толщины и совместимости с процессом CMOS, технология осаждения атомных слоев (ALD) была одним из наиболее часто используемых методов выращивания для производства диэлектрических пленок на основе La [8]. К сожалению, в устройствах RRAM с ALD-осаждением всегда требуются нежелательные высокие формовочные напряжения из-за хорошего качества диэлектрических пленок, что может привести к высокому уровню отказов, низкому коэффициенту включения / выключения, плохой стойкости и широкому разбросу устройств [9] . Чтобы получить устройства RRAM с лучшими характеристиками RS, необходимо использовать материалы / конструкцию устройства, включая ионную имплантацию [10], диффузию легирующей примеси [11] или введение нанокристаллов (NC) [12], в изготовленные методом ALD La на основе RRAM.
Согласно недавним отчетам, различные технологии допинга для улучшения поведения RS традиционного k материалы (HfO 2 [13], ZrO 2 [14] и др.) Широко изучены. Однако до сих пор не сообщалось об улучшенном с помощью NC поведении RS устройств RRAM на основе La. Таким образом, внедренный в Cu LaAlO 3 устройство со структурой Cu / LaAlO 3 / Cu / LaAlO 3 / Pt разработан для приложения памяти, и внимание было сосредоточено на влиянии легирования Cu на производительность и механизм переключения устройств RRAM на основе La.
Методы
Принципиальная схема изготовленного устройства со структурой Cu / LaAlO 3 / Cu / LaAlO 3 / Pt показана на рис. 1. Процесс изготовления устройства RRAM на основе La выглядит следующим образом:двухслойный металл, Pt 100 нм / 10 нм Ti, сначала был нанесен на 2-дюймовую пленку. SiO 2 / Si пластина в качестве нижнего электрода (BE) путем электронно-лучевого испарения. Впоследствии температура реактора ALD Picosun R-150 была установлена на уровне 300 ° C и ~ 10 нм LaAlO 3 . (Соотношение La / Al как 3:1) тонкая пленка была нанесена на Pt / Ti / SiO 2 / Si подложки с использованием La ( i- PrCp) 3 в качестве предшественника La Al (CH 3 ) 3 в качестве предшественника Al и O 3 как окислитель. Затем на LaAlO 3 был выращен слой Cu толщиной ~ 2 нм. со скоростью 0,1 Å / с с использованием электронно-лучевого испарителя (ЭЛЭ). Опять же, ~ 10 нм LaAlO 3 Тонкая пленка (соотношение La / Al 3:1) была нанесена методом ALD при 300 ° C. После LaAlO 3 / Cu / LaAlO 3 коммутирующий слой был подготовлен с использованием процесса ALD-EBE-ALD, процесс быстрого термического отжига (RTA) проводился в N 2 при температуре окружающей среды 600 ° C в течение 30 с. Верхний электрод (ТЕ) из 10 нм Au / 150 нм Cu был нанесен на LaAlO 3 диэлектрика путем электронно-лучевого испарения после литографии с последующим отслаиванием для изготовления устройств размером от 50 × 50 мкм 2 до 250 × 250 мкм 2 . Чтобы лучше понять влияние легирования Cu на характеристики устройств RRAM на основе La, два контрольных образца S1:Au / Cu / LaAlO 3 / Pt (неотожженный) и S2:Au / Cu / LaAlO 3 :Cu / Pt (неотожженные). И образец с Au / Cu / LaAlO 3 :Структура Cu-NC / Pt была обозначена как S3.
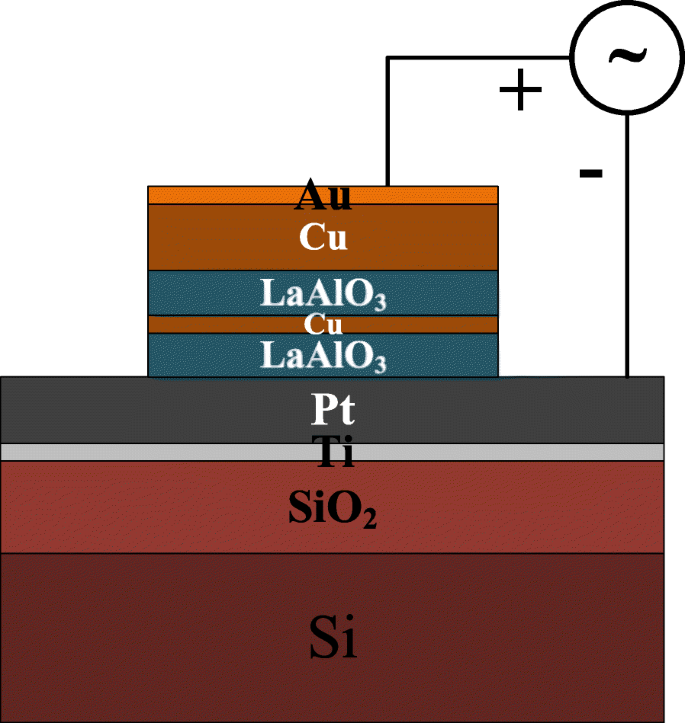
Принципиальная схема LaAlO 3 с внедренной Cu устройство со структурой Cu / LaAlO 3 / Cu / LaAlO 3 / Pt
Рентгеновская фотоэлектронная спектроскопия (XPS) использовалась для анализа распределения легированных атомов Cu, а поперечная просвечивающая электронная микроскопия (TEM) использовалась для наблюдения микроструктуры изготовленных устройств RRAM. Свойства КР измеряли в различных режимах с помощью анализатора параметров полупроводников Agilent B1500A. Соответствие току 1 мА было введено для защиты изготовленных устройств от повреждений высокими токами во время процессов формовки и настройки.
Результаты и обсуждение
На рисунке 2 показан глубинный рентгеновский фотоэлектронный анализ (XPS) спектров Cu 2p в LaAlO 3 , легированном Cu. пленка (Параметры травления:ион Ar 2 КВМ, скорость травления ~ 1 Å / с). Как видно на рис.2, пик Cu 2p с трудом можно найти в неотожженном образце (S2) после травления в течение 30 или 60 с, а после травления в течение 90 с появляется заметный пик Cu 2p, указывающий на то, что Cu 2p атомы в основном концентрируются в слое, содержащем Cu. Иными словами, атомы Cu наблюдаются во всем LaAlO 3 После отжига пленки, то есть после травления в течение 30, 60 и 90 с, в S3 можно наблюдать явные пики Cu 2p. Результаты XPS подтверждают, что высокотемпературный отжиг приведет к перераспределению легированных атомов Cu, что может помочь улучшить электрические характеристики RRAM на основе La.
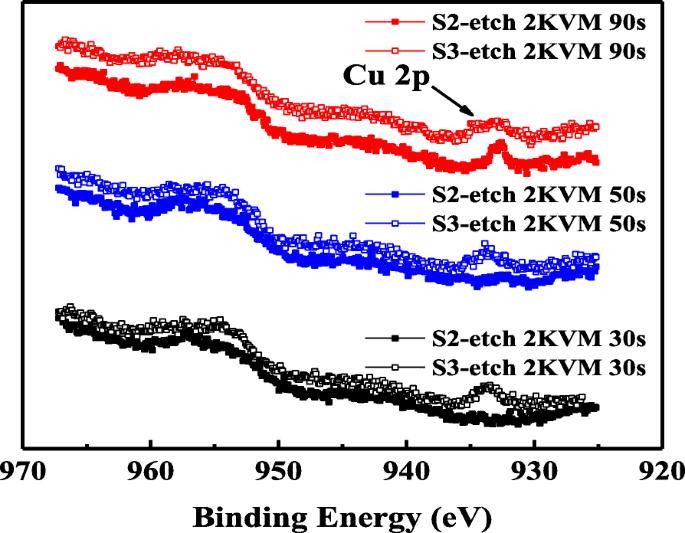
Результаты РФЭС спектров Cu 2p для S2 и S3 после травления ионами Ar в течение 30, 60 и 90 с
На рис. 3 показано типичное изображение в поперечном сечении, полученное с помощью просвечивающего электронного микроскопа (ПЭМ), двух включенных в Cu LaAlO 3 . RRAM (например, S2 и S3). Как показано на рис. 3а, слоистая структура неотожженного Cu / LaAlO 3 / Cu / LaAlO 3 Устройство / Pt можно было четко распознать на ПЭМ-изображении S2. Стоит отметить, что после осаждения верхнего слоя LaAlO 3 при 300 ° C процесса ALD, внедренный нанослой Cu толщиной ~ 2 нм был незначительно затронут термодиффузией. Следовательно, из изображения с высоким разрешением на рис. 3b видно, что нерегулярные и разделенные наночастицы Cu размером 2 ~ 6 нм, внедренные в LaAlO 3 слой можно четко наблюдать. Дополнительная обработка отжигом после процесса ALD еще больше усилит термодиффузию атомов Cu, что затруднит определение наличия нанослоя Cu, как показано на рис. 3c. С помощью ПЭМ-изображения с более высоким разрешением, показанного на рис. 3d, приблизительно 25 нм толщиной LaAlO 3 Можно было наблюдать слой, залитый несколькими сферическими и разделенными Cu-NC, что указывает на то, что часть нанослоя Cu уже диффундировала в LaAlO 3 диэлектрик с некоторыми Cu-NC меньшего размера, оставшимися после обработки отжигом при 600 ° C.
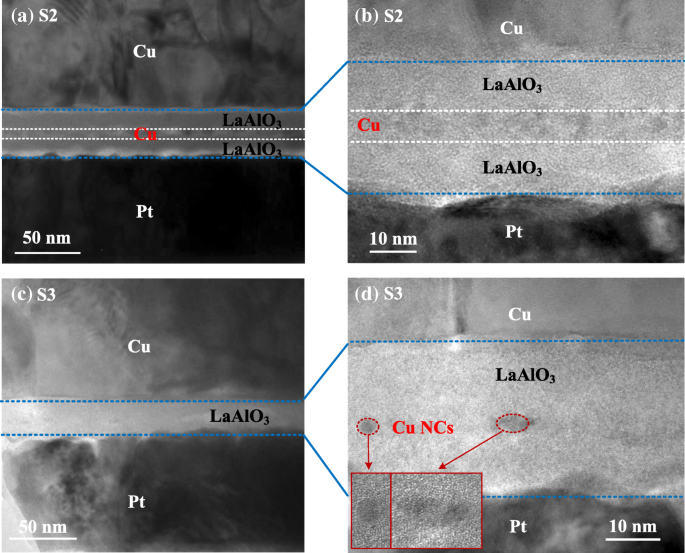
ПЭМ-изображения устройств RRAM со встроенной медью. а Типичное ПЭМ-изображение поперечного сечения S2. б Изображение S2. c Изображение S3 в поперечном сечении, полученное методом просвечивающей электронной микроскопии. г Изображение S3 в формате HRTEM
Процесс электрического формования образцов S1, S2 и S3 показан на рис. 4. Как видно на рис. 4, для процесса формования S1 требуется высокое напряжение около 12 В и гораздо более низкое напряжение формования. (~ 7 В) требуется в S2 и S3, показывая, что формирующее напряжение устройств на основе La можно эффективно снизить, вставив нанослой Cu в диэлектрическую пленку. Кроме того, по сравнению с начальным значением сопротивления S1 (2,51 × 10 12 Ом, значение 1 В), сопротивление S2 намного ниже (2,65 × 10 6 Ω, считывается при 1 В), и это значение увеличивается после процесса отжига (S3, 2,83 × 10 12 Ω, считайте при 1 В). Вышеуказанные вариации формирующего напряжения и начального сопротивления можно отнести к изменению диэлектрических свойств LaAlO 3 пленки через проектирование материалов / конструкции устройства. Из-за превосходного качества диэлектрических пленок на основе La, полученных методом ALD, для разрушения изолятора требуется чрезвычайно высокая напряженность электрического поля (т. Е. S1). После того, как нанослой Cu был вставлен в диэлектрическую пленку, высококачественный переключающий слой, выращенный методом ALD, будет подвержен влиянию этого металлического нанослоя, что упростит пробой диэлектрика и, в конечном итоге, приведет к гораздо более низкому формирующему напряжению в S2. Кроме того, энергетический барьер образования кислородной вакансии может быть эффективно уменьшен, и в диэлектрическую пленку будет внесено больше метастабильных дефектов из-за структурных различий между Cu и LaAlO 3 материалы (решетчатая, термическая и т. д.) [15]. Следовательно, большее количество дефектов (ловушки заряда, ионы металлов, кислородные вакансии и т. Д.) Будет введено в LaAlO 3 резистивный коммутирующий слой, приводящий к снижению начального сопротивления S2 [16]. Однако такое большое количество дефектов в диэлектрических тонких пленках S2 может быть эффективно уменьшено (или устранено) с помощью дополнительной обработки отжигом, что приведет к высокому начальному сопротивлению S3 [17]. Кроме того, дополнительная обработка отжигом привела к тому, что некоторые Cu-NC и диффузные атомы Cu попали в LaAlO 3 диэлектрические пленки, которые дополнительно усиливают локальное электрическое поле и приводят к низкому формирующему напряжению S3 [18].
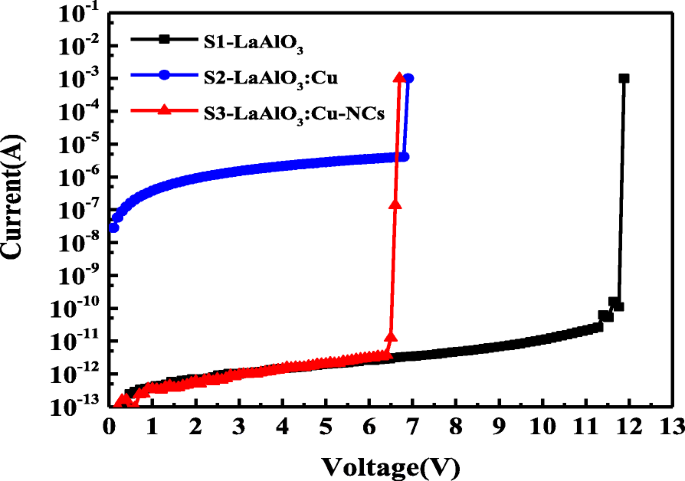
Процесс формирования трех видов RRAM на основе La
Типичный биполярный ток – напряжение ( I - V ) кривые ~ 100 циклов развертки постоянного тока (DC) для трех типов устройств RRAM на основе La (размер области 50 мкм × 50 мкм) получены на рис. 5a – c. Испытательное напряжение (от 0 до - 1,5 В и от - 1,5 до 0 В для процесса сброса; от 0 до 5 В и от 5 до 0 В для процесса установки) смещается на TE (Cu), в то время как BE (Pt) заземлен. . Хотя три устройства RRAM на основе La демонстрируют 100 последовательных циклов повторяемого поведения биполярного RS, между ними есть некоторые большие различия. Во-первых, по сравнению с S2 и S3, нелегированный образец S1 легче повредить во время операций циклического набора – сброса с напряжением остановки сброса ( V стоп ) - 1,5 В (как показано на вставке к рис. 5а), что указывает на то, что максимальное V стоп S1 ниже, чем у S2 и S3. Учитывая это, относительно низкий V стоп В случае образца S1 используется - 1,4 В. Еще одно отличие состоит в том, что I - V кривые S1 и S2 показывают аномальные колебания (подъем и спад) во время установленного процесса, который сильно отличается от плавного I - V кривые S3. Это явление тесно связано с остатками некоторых проводящих нитей (CF) в нелегированном (или легированном, но неотожженном) LaAlO 3 диэлектрические пленки после процесса сброса. Кроме того, по сравнению с S1 и S2, S3 имеет I - V кривые, показывающие большую согласованность и меньшее распределение напряжений установки / сброса, подразумевая, что стабильность устройств RRAM может быть эффективно улучшена путем легирования и обработки отжигом. Рисунки 5d – f представляют собой испытание на долговечность (~ 100 циклов, считывание при –0,1 В) S1 – S3, извлеченное из левой части рис. 5a – c. Максимальное соотношение сопротивлений Cu / LaAlO 3 / Pt RRAM устройства, а именно, состояние с максимальным высоким сопротивлением (HRS) до состояния с минимальным низким сопротивлением (LRS) может достигать 6 порядков величины. Однако широкое случайное колебание HRS S1 и S2 приводит к очень низкому уровню включения / выключения окна (~ 10). В отличие от S1 и S2, окно включения / выключения S3 примерно в 100 раз больше, чем у S1 и S2, что указывает на то, что характеристика согласованности устройств RRAM на основе La, легированного медью, эффективно улучшается после отжига. Обработка отжигом в S3 не только заставляет атомы Cu диффундировать вокруг всего LaAlO 3 . пленка, но также образует Cu-NC в диэлектрике. Таким образом, местное электрическое поле было усилено; случайность образования / разрыва CF контролировалась, а распределение HRS (LRS) было улучшено [19]. Приведенные выше результаты предполагают, что идея внедрения нанослоя Cu в RRAM на основе La требует определенной степени термической обработки для достижения лучших характеристик устройства.

а - c Типичный биполярный I - V кривые и d - е испытание на выносливость S1, S2 и S3
На рис. 6а показана совокупная вероятность сопротивлений HRS и LRS (при - 0,1 В), а на рис. 6b записана совокупная вероятность установленных напряжений и напряжений сброса. На рис. 6а средние значения ( μ ) LRS и HRS в S1, S2 и S3 получаются равными 50,7 Ом и 1,59 МОм, 100,6 Ом и 1,51 МОм и 80,6 Ом и 1,95 МОм соответственно. Однако коэффициент вариации ( σ / μ ) LRS и HRS сильно различаются по сравнению с примерно одинаковыми средними значениями в S1, S2 и S3. Среди них S3 имеет минимальное значение σ / μ (LRS - 0,74, HRS - 1,02), за ним следует S2 (LRS - 1,33, HRS - 1,23), а σ / μ S1 является наихудшим (LRS - 1,22, HRS. - 3,00). Как показано на рис. 6b, средние значения напряжений сброса / установки составляют около - 0,79 В / 2,36 В, - 0,83 В / 2,49 В и - 1,25 В / 2,59 В для образцов S1, S2 и S3 соответственно. Стандартное отклонение ( σ ) напряжения сброса / установки, которые используются для оценки разброса параметров, составляют 0,20 / 0,82 (S1), 0,23 / 1,16 (S2) и 0,13 / 0,45 (S3) соответственно. Можно обнаружить, что широкие вариации HRS, LRS, V установить , и V сброс в S1 и S2 улучшаются после отжига. По сравнению с S1 и S2, легированный и отожженный (S3) демонстрирует лучшую однородность, что указывает на то, что S3 имеет лучшую стабильность работы среди трех. Как упоминалось выше, в S2 может быть внесено большое количество дефектов, что вызовет проблемы с надежностью и стабильностью устройств. Для S3 такое большое количество дефектов устраняется термическим процессом, а случайность образования / разрушения CF уменьшается из-за существования Cu-NC. Таким образом, в S3 достигается тонкая однородность с небольшими вариациями коммутируемых напряжений и значений сопротивления.
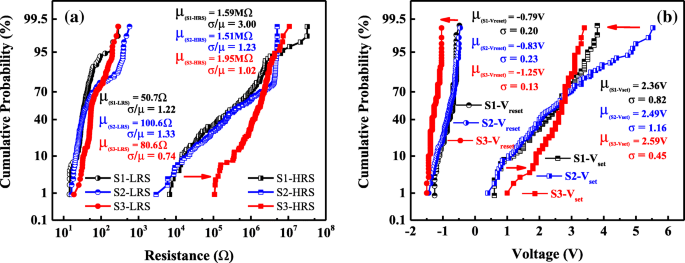
Кумулятивная вероятность а HRS и LRS (показание - 0,1 В) и b установить и сбросить напряжения
Характеристики удерживания трех типов устройств RRAM на основе La при считывающем напряжении -0,1 В при комнатной температуре показаны на рис. 7. Во время теста удерживания Cu / LaAlO 3 :Устройства Cu-NC / Pt демонстрируют стабильную удерживающую способность более 10 4 s при комнатной температуре с почти постоянным R HRS / R LRS до трех порядков, что соответствует энергонезависимым характеристикам RRAM на основе La. DC SET / RESET Биполярный выход за 10 циклов измеряется для оценки коммутационной способности S1, S2 и S3. Как показано на рис. 8, лучшая доходность у S3, за ней идет S2, а у S1 - худшая. Этот результат показывает, что внедренный слой Cu полезен для увеличения выхода RRAM на основе La, а выход устройств может быть дополнительно улучшен за счет дополнительной термической обработки. Более того, на рис. 8 можно увидеть, что производительность устройств увеличивается с уменьшением площади устройства. Это явление указывает на то, что резистивный механизм переключения Cu / LaAlO 3 Устройства / Pt RRAM могут быть тесно связаны с тепловым эффектом Джоуля, то есть джоулева теплота участвует в образовании / разрыве проводящих нитей и, по-видимому, более заметна в устройствах меньшего размера.
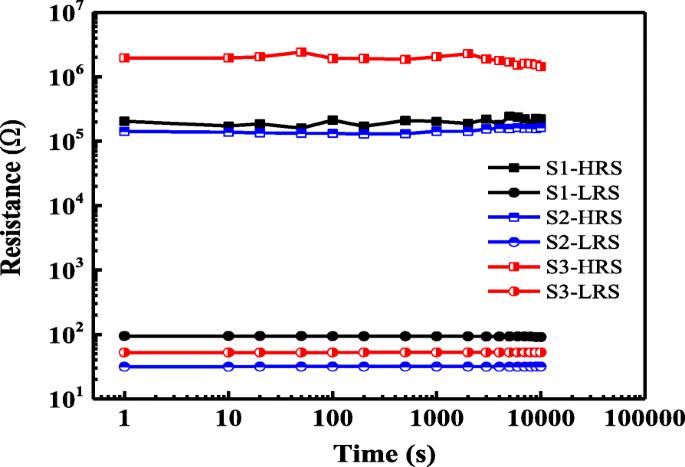
Характеристики удержания устройств RRAM на основе La при комнатной температуре
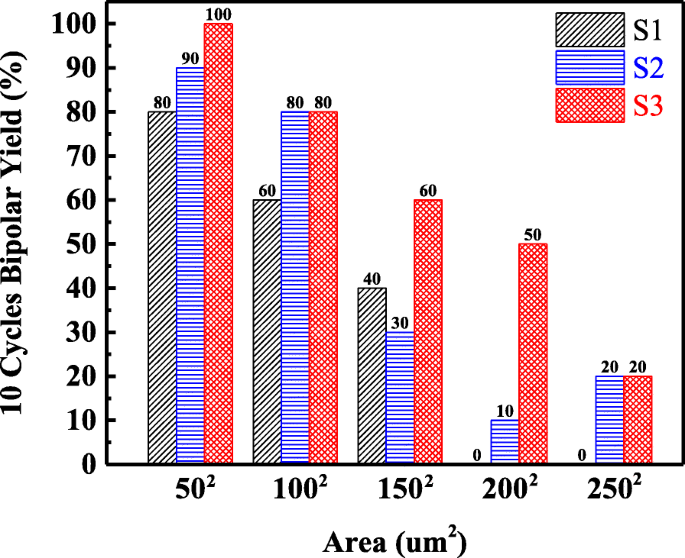
DC SET / RESET 10-тактный биполярный выход устройств RRAM на основе La
Чтобы получить больше информации о RRAM на основе La, обработанных Cu-NC, дальнейший анализ был сосредоточен на механизме переключения сопротивления S3. Как показано на рис. 9a, напряжение настройки и сброса в разных направлениях применяется в I - V измерение S3. Результаты испытаний показывают, что S3 имеет как униполярное, так и биполярное поведение резистивного переключения, указывая на то, что RRAM на основе La, обработанные Cu-NC, неполярны. Исследователи полагают, что неполярное (униполярное) резистивное переключение тесно связано с джоулевым тепловым образованием / разрывом CF [7]. В процессе сброса RRAM на основе La наблюдается явление сильного выброса тока, а затем индуцируется эффект джоулева нагрева, приводящий к плавлению, спеканию или термическому окислению CF. На рисунке 9b показан график двойного логарифма I - V кривые и линейные фитинги S3, а на вставке показано ln ( I / V ) - V 1/2 кривая заданного процесса. Очевидно, что I - V соотношение в LRS демонстрирует поведение омической проводимости с наклоном около 1, что подразумевает наличие CF в диэлектрике после установленного процесса. Однако проводящий механизм HRS немного сложен, и I - V кривые на HRS можно разделить на три прямые с тремя разными наклонами. В области низких напряжений (<0,8 В, оранжевая линия) наклон аппроксимирующей линии составляет около 1,33, что близко к механизму омического переноса. С увеличением напряжения (от ~ 0,8 до ~ 2 В, зеленая линия) наклон аппроксимирующей линии увеличивается до 1,93 ( I ~ V 1,93 ), что соответствует квадратическому закону Чайлда ( I ~ V 2 ). В третьей области (> 2 В, фиолетовая линия) наклон аппроксимирующей линии будет продолжать увеличиваться (например, в данном случае 2,86), и ток резко возрастет, когда V установить достигается. Режим проводимости HRS, который состоит из области омического переноса и области закона Чайлда, хорошо согласуется с классическим механизмом тока, ограниченного пространственным зарядом (SCLC) [20, 21]. Появление механизма проводимости SCLC указывает на образование и разрыв локального пути проводимости [22], который рассматривается как основной механизм RS Cu / LaAlO 3 :Устройства Cu-NC / Pt. Кроме того, HRS-проводимость также хорошо согласуется с механизмом проводимости Пула – Френкеля (вставка). Эффект Пула – Френкеля в основном вызван прыжками возбужденных электрическим полем носителей заряда через захваченные состояния [23], что позволяет предположить, что в LaAlO 3 все еще существует большое количество дефектов. пленки даже после отжига.
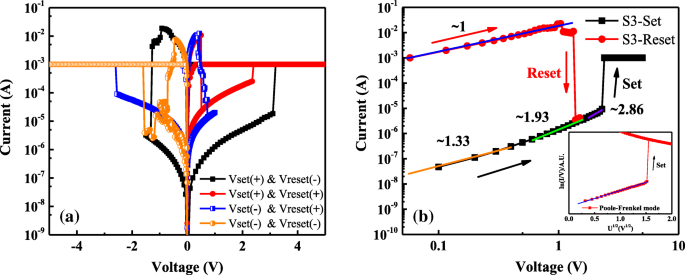
а Я - V измерение S3 в разных направлениях напряжения. б Двойное логарифмическое построение I - V кривые и линейные фитинги S3, а на вставке показано ln ( I / V ) - V 1/2 построение заданного процесса
Зависимость S3 от площади электрода (рис. 10a) и температуры (рис. 10b) была изучена для дальнейшего понимания механизма RS. Из рис. 10а видно, что сопротивление LRS не зависит от площади электрода, в то время как сопротивление HRS (и начальное сопротивление) уменьшается с увеличением площади устройства, что указывает на то, что механизм RS S3 возникает из-за образования и разрушения CFs. На рис. 10b сопротивление HRS уменьшается с повышением температуры, показывая, что выключенное состояние S3 может быть связано с полупроводниковым поведением. Напротив, сопротивление LRS увеличивается с повышением температуры, что указывает на металлическую характеристику во включенном состоянии [24]. Согласно литературным данным, связь между сопротивлением металла и температурой обычно изучается уравнением R ( Т ) = R 0 [1 + α ( Т - Т 0 )] [25]. А синяя линейная аппроксимация на рис. 10b определяет температурный коэффициент ( α ) равным 1,03 × 10 −3 К -1 . Это значение немного меньше, чем значения, указанные для нанопроволок Cu в другой литературе (2,5 × 10 −3 К -1 [26], 2.39 × 10 −3 К -1 [27]). Благодаря тому, что в LaAlO 3 , легированный Cu-NC, введено большое количество дефектов. пленки, более низкие α значение CF Cu получено в этой статье.
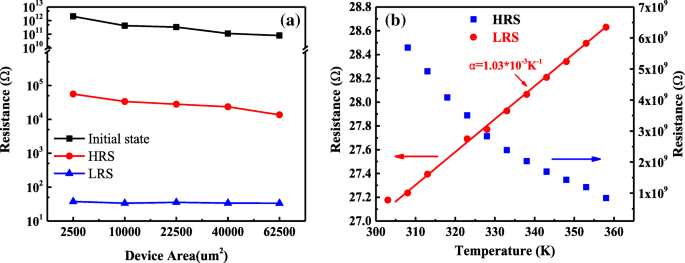
а Зависимость HRS и LRS от площади электрода. б Температурная зависимость HRS и LRS
Поэтому было предложено разумное объяснение RS-эффекта Cu / LaAlO 3 :В нашем случае устройства Cu-NC / Pt. Образование и разрыв CF Cu, скорее всего, опосредованы электрохимической металлизацией (ECM) и тепловым эффектом Джоуля. На рисунке 11 показаны схематические диаграммы для механизма RS устройств Cu / LaAlO3:Cu-NC / Pt в (а) исходном состоянии; (б), (в) процесс установки; (d) состояние ВКЛ; и e) процесс сброса. Когда к TE (Cu) прикладывается положительное напряжение, реакция окисления, которая описывается как Cu → Cu 2+ + 2e - , происходит на электрохимически активном материале (рис. 11б). Под действием электрического поля подвижный Cu 2+ катионы мигрируют в сторону BE (Pt) через LaAlO 3 пленка, и реакция восстановления Cu 2+ + 2e - → Cu находится на катоде (рис. 11в). Стоит отметить, что в диэлектриках S3 на основе La, которые являются естественными путями образования CF Cu, присутствуют некоторые Cu-NC и диффузные атомы Cu. Таким образом, непрерывно осаждаемые атомы металла Cu будут стремиться расти по этим естественным путям и в конечном итоге достигать ТЕ, образуя проводящий канал (рис. 11d). Когда полярность приложенного напряжения меняется на противоположную, процесс растворения, который тесно связан с электрохимическим эффектом и тепловым эффектом Джоуля, происходит где-то вдоль нити, что приводит к почти полному разрушению CF и устройства в выключенное состояние (рис. 11e). ).
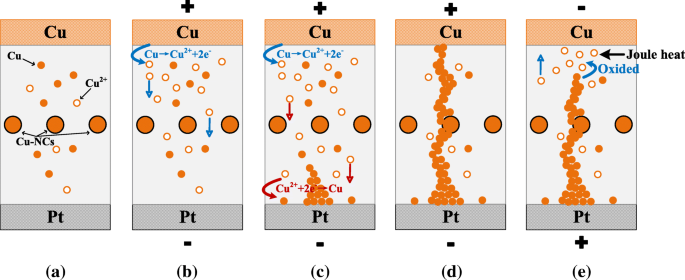
Принципиальные схемы RS-механизма устройств Cu / LaAlO3:Cu-NC / Pt в a начальное состояние; б , c установить процесс; г Состояние ВКЛ; и е процесс сброса
Заключение
Таким образом, предлагается метод легирования металлов для улучшения характеристик устройств RRAM на основе La. Очевидные улучшения характеристик резистивного переключения, включая более низкое напряжение формования, более высокое соотношение включения / выключения, лучшую электрическую однородность и превосходный выход устройства, подтверждаются I - V результаты измерений отожженного и легированного медью образца. Результаты анализа XPS и TEM подтвердили, что улучшение характеристик переключения может быть связано с диффузией атомов Cu и образованием нанокристаллов Cu (Cu-NC) после процесса отжига. Дальнейшие исследования показывают, что резистивный механизм переключения Cu \ LaAlO 3 :Устройства Cu-NC \ Pt можно отнести к образованию и разрыву Cu-проводящих нитей, что тесно связано с механизмом SCLC и эффектом джоулева нагрева. Это исследование демонстрирует возможный метод управления резистивным переключением RRAM за счет встраивания нанокристаллов Cu, и необходимо провести дополнительные работы для понимания физического механизма и внутренних законов RRAM на основе La.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой рукописи, включены в рукопись.
Сокращения
- ALD:
-
осаждение атомного слоя; RRAM
резистивная оперативная память; НК
нанокристаллы; М-И-М
металл-изолятор-металл; RS
резистивное переключение; Высокий- k
высокая диэлектрическая проницаемость; RS
резистивное переключение; БЫТЬ
нижний электрод; RTA
быстрый термический отжиг; TE
верхний электрод; XPS
Рентгеновская фотоэлектронная спектроскопия; Округ Колумбия
постоянный ток; CFs
токопроводящие нити; HRS
состояние высокого сопротивления; LRS
состояние низкого сопротивления; SCLC
ограниченный ток пространственного заряда
Наноматериалы
- 5 влияний IoT на производство
- Сверхмалые устройства SAW от Murata удовлетворяют потребности 5G
- Растущая угроза Интернета вещей с поддержкой Wi-Fi
- Подключение к Интернету вещей - узкополосные возможности
- Роль Интернета вещей в здравоохранении во время Covid-19
- Выявление слепой зоны Интернета вещей в постпандемическом мире
- Как правильный роботизированный конечный эффект влияет на производительность робота
- Проблемы тестирования программного обеспечения устройств Интернета вещей
- Эффективная производительность быстрого литья под давлением
- Кайдзен, управление операционной эффективностью?



