Сравнительное исследование полевых транзисторов с отрицательной емкостью и разной емкостью МОП
Аннотация
Мы демонстрируем эффект отрицательной емкости (NC) HfZrO x полевые транзисторы (FET) в экспериментах. Улучшенный I DS , SS и G м NCFET были достигнуты по сравнению с контрольным полевым транзистором из оксида металла и полупроводника (MOS). В этом эксперименте нижние МДП-транзисторы с разным временем пассивации эквивалентны устройствам с ЧПУ с разной емкостью МОП. Между тем, электрические свойства NCFET с 40-минутной пассивацией лучше, чем у NCFET с 60-минутной пассивацией, благодаря хорошему согласованию между C FE и C MOS . Хотя SS ниже 60 мВ / декаду не достигается, получены негистерезисные характеристики передачи, полезные для логических приложений.
Введение
По мере уменьшения размера транзистора уровень интеграции интегральной схемы (ИС) постоянно растет. Необходимо срочно решить сопутствующую проблему рассеивания мощности. Чтобы обойти эту проблему, рабочее напряжение транзистора должно быть уменьшено [1]. Допороговое колебание (SS) MOSFET не может быть ниже 60 мВ / декаду при комнатной температуре, что ограничивает снижение порогового напряжения V TH и напряжение питания В DD [2]. Много усилий было направлено на исследования и разработку устройств с новыми механизмами переноса и переключения, позволяющих преодолеть предел Больцмана, включая полевой транзистор с отрицательной емкостью (NCEFT) [3, 4], полевые транзисторы с резистивным затвором [5], нано- электромеханический полевой транзистор (NEMFET) [6, 7], ударная ионизация металл-оксид-полупроводник (I-MOS) [8, 9] и туннельный полевой транзистор [10, 11]. Среди них NCFET привлек большое внимание, потому что он может достичь крутой SS без потери управляющего тока [12,13,14,15]. Допированный HfO 2 (например, HfZrO x (HZO) и HfSiO x ) широко используется в NCFET [4, 16, 17]; он совместим с процессом CMOS [18]. Теоретическое исследование показало, что нежелательный гистерезис возникает из-за несогласованной сегнетоэлектрической емкости C FE к базовой емкости MOS C MOS в NCFET [19]. Однако эффект соответствия между C FE и C MOS электрические характеристики NCFET все еще вызывают озабоченность в ходе экспериментов.
В этой работе изучаются электрические характеристики полевых транзисторов NC Ge с различными МОП-емкостями на основе различного согласования между C FE и C MOS . Хотя SS менее 60 мВ / декада не проявляется, достигаются безгистерезисные характеристики передачи и лучшие электрические свойства. Видимые пики C FE по сравнению с V FE кривые демонстрируют NC-эффект NCFET на основе HZO. Лучшее соответствие C FE и C MOS способствует более крутому SS и более высокому току, что выгодно для логических приложений.
Методы
Основной процесс изготовления Ge NCFET показан на рис. 1а. В качестве исходных подложек использовались четырехдюймовые пластины n-Ge (001) с удельным сопротивлением 0,088–0,14 Ом · см. После очистки перед затвором пластины Ge загружали в камеру сверхвысокого вакуума для пассивации поверхности с использованием Si 2 H 6 . Использовали две продолжительности пассивации:40 и 60 мин. Тогда TaN / HZO / TaN / HfO 2 стек был депонирован. Толщина HfO 2 толщина диэлектрического слоя и слоя HZO FE составляет 4,35 и 4,5 нм соответственно. После формирования рисунка затвора и травления области истока / стока (S / D) были имплантированы с использованием ионов бора (B + ) при энергии 30 кэВ и дозе 1 × 10 15 см −2 . Металлический S / D-металл Никель был получен методом отрыва. Наконец, был проведен быстрый термический отжиг при 450 ° C в течение 30 с. Управляющий MOSFET с TaN / HfO 2 стек также был изготовлен. На рисунках 1b и c показаны схемы изготовленных NCFET и управляющих MOSFET соответственно. Внутренний металлический затвор в изготовленном NCFET уравновешивает потенциал на поверхности канала, который называется структурой MFMIS.

а Основные этапы процесса изготовления изготовленных устройств с ЧПУ. Схема изготовленного б NCFET и c управление MOSFET
Результаты и обсуждение
На рис. 2а показаны измеренные значения I DS - V GS кривые пары NCFET и контрольного MOSFET с пассивацией поверхности 40 мин. Оба устройства имеют длину затвора L . G 3,5 мкм. Устройство ЧПУ с 40-минутной пассивацией имеет значительно улучшенный I DS чем управляющий полевой МОП-транзистор. Передаточные кривые NCFET не имеют гистерезиса. Точка SS против I DS Кривые на рис. 2b показывают, что транзистор с NC имеет улучшенную SS по сравнению с устройством управления, хотя SS ниже 60 мВ / декада не появляется. На рисунке 2с показано, что транзистор с ЧПУ имеет значительно увеличенную линейную крутизну G . м над устройством управления на V DS - 0,05 В. На рис. 3 сравниваются электрические характеристики NCFET и управляющего MOSFET с пассивацией поверхности в течение 60 мин. Точно так же I DS , точка SS и G м NCFET превосходит управляющий MOSFET.

а Измеренный I DS - V GS кривые NCFET и контрольного MOSFET с 40-минутной пассивацией. Сравнение b точка SS против I DS и c G м характеристики между NC FET и управляющим MOSFET
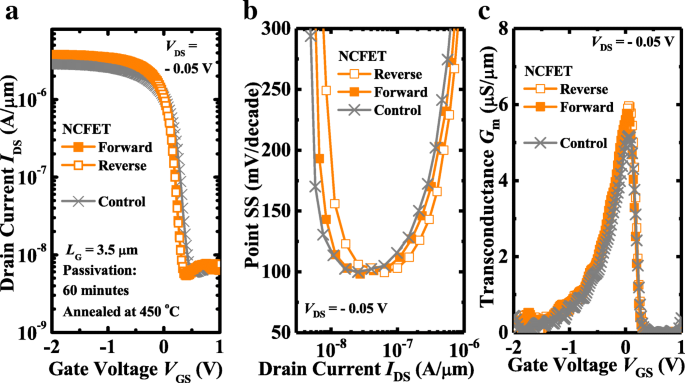
а Измеренный I DS - V GS кривые NCFET и контрольного MOSFET с 60-минутной пассивацией. Сравнение b точка SS против I DS и c G м характеристики между NCFET и управляющим MOSFET
На рисунке 4a показаны статистические результаты тока возбуждения NCFET и управляющих MOSFET при V . DS от - 0,05 В и В GS - V TH =- 1,0 В. NCFET демонстрируют улучшение I на 18,7% и 35,6% DS для пассивации поверхности 60 мин и 40 мин соответственно по сравнению с контрольными приборами. Предполагается, что NCFET, пассивированные в течение 40 минут, имеют лучшее соответствие между C MOS и C FE через устройства ЧПУ с 60 мин. На рис. 4b показано, что NCFET дает улучшение максимальной крутизны на 26,4% и 51,3% G . м, не более для пассивации поверхности 60 мин и 40 мин соответственно по сравнению с контрольными приборами. Видно, что контрольные МОП-транзисторы с пассивацией поверхности в течение 40 мин имеют более высокое значение I DS и G м, не более чем устройства, пассивированные в течение 60 мин, что связано с большей C MOS вызвано меньшей эквивалентной толщиной оксида ( E ОТ ). Внутренний металлический затвор обеспечивает плоскость уравнивания потенциалов; устройство можно эквивалентно смоделировать как емкостной делитель напряжения. Общая емкость C G представляет собой серию C FE и C MOS . Напряжение внутреннего затвора усиливается за счет NC-эффекта. Коэффициент усиления внутреннего напряжения β =∣ C ИП ∣ / ∣ C ИП ∣ - C MOS получает максимум, когда | C MOS | =| C FE | [20, 21]. Достижение оптимального соответствия C FE и C MOS является предпосылкой улучшения текущего состояния.

Статистический a Я DS и b G м результаты NCFET и управляющих MOSFET с продолжительностью пассивации 40 и 60 минут
Извлеченный V int от напряжения затвора В GS кривые показаны на рис. 5а. V int транзистора с ЧПУ можно извлечь из гипотезы, что I DS - V int кривая NC-транзистора точно такая же, как у I DS - V GS кривая устройства управления. Коэффициент усиления внутреннего напряжения dV int / dV GS показан на рис. 5б. d V int / d V GS > 1 достигается в широком диапазоне развертки V GS для NCFET с 40-минутной пассивацией поверхности, что способствует более крутой SS, чем устройство управления во время процесса измерения, что связано с локальным переключением поляризации [22]. Это согласуется с вышеупомянутыми результатами на рис. 2b. Для NCFET с 60-минутной пассивацией коэффициент усиления внутреннего напряжения d V int / d V GS > 1 достигается в диапазоне V GS <0 В для двойной развертки V GS , что согласуется с приподнятым СС на рис. 3б.
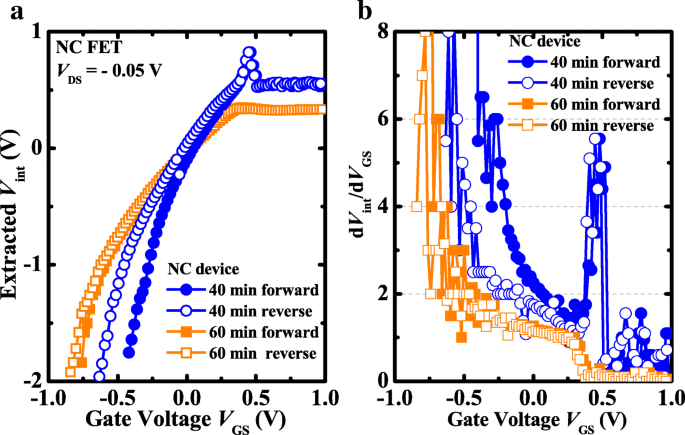
а Извлечено V int как функция от V GS кривые. б Коэффициент усиления внутреннего напряжения в зависимости от В GS кривые
На рисунке 6а показан извлеченный C MOS по сравнению с V GS кривые для NC транзистора, который полагается на V int - V GS на рис. 5a и C G - V GS кривые управляющих полевых МОП-транзисторов. Извлеченный C MOS хорошо согласуется с измеренными C Г. Таким образом, демонстрируется справедливость метода расчета. C FE и C MOS по сравнению с V FE кривые изображены на рис. 6б. С момента запуска NC-эффекта абсолютное отрицательное значение C FE транзистора превышает C MOS для двойного подметания V GS все время на рис. 6б. | C FE |> C MOS и C FE <0 может вызвать характеристики без гистерезиса, и совпадение C MOS и C FE полезен для логических приложений [23, 24]. Безгистерезисные характеристики на рис. 2a и 3a наблюдаются за счет согласования всех доменов и подавления захвата заряда [25]. Устойчивое переключение поляризации отвечает за негистерезисные характеристики [26]. Кроме того, большое внутреннее усиление затвора d V int / d V G > 1 объясняется небольшим расхождением между | C FE | и C MOS в подпороговой области, что приводит к крутому SS устройства NC. Между тем, существует лучшее соответствие между C FE и C MOS для NCFET с 40-минутной пассивацией, чем для NCFET с 60-минутной пассивацией. Таким образом, это является прямым доказательством того, что NCFET с 40-минутной пассивацией обладает лучшими электрическими характеристиками, чем NCFET с 60-минутной пассивацией. Поляризация FE изменяет V FE ; следовательно, заряд FE варьируется. Суммарный заряд увеличивается в несколько раз, что связано с поляризацией FE помимо увеличения V . GS . Другими словами, для данного V GS , заряд в канале увеличивается, поэтому I DS улучшается. Как следствие, в экспериментах появляется крутой СС передаточной характеристики.
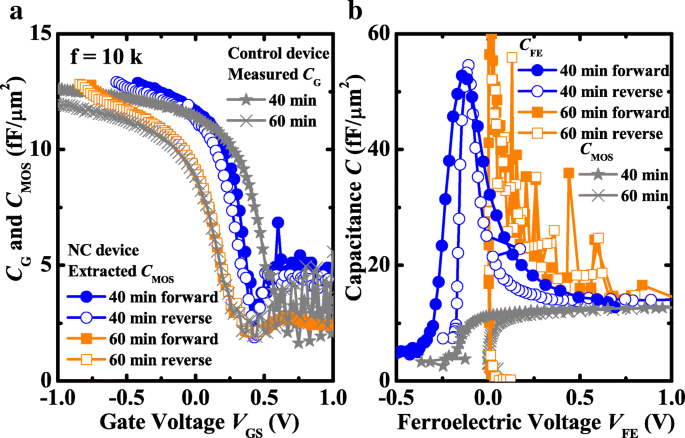
а Измерено C G и извлекли C MOS как функция от V GS . б C FE и C MOS по сравнению с V FE кривые
Выводы
Характеристики передачи без гистерезиса получены для полевых транзисторов NCFET с пассивацией в течение 40 и 60 минут. NC Ge pFET с 40-минутной пассивацией имеют лучшие электрические характеристики, чем NC-устройство с 60-минутной пассивацией в экспериментах. Мы также демонстрируем NC-эффект NCFET на основе HZO. Для NCFET крутые SS и d V int / d V GS > 1 получается. NCFET с 40-минутной пассивацией показал хорошее соответствие между C FE и C MOS , что способствует негистерезисным характеристикам. Считается, что различное поведение НК связано с переключением микроскопических доменных стенок в тонких пленках СЭ.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- B + :
-
Ионы бора
- E ОТ :
-
Эквивалентная толщина оксида
- полевые транзисторы:
-
Полевые транзисторы
- HZO:
-
HfZrO x
- IC:
-
Интегральная схема
- I-MOS:
-
Ударная ионизация металл-оксид-полупроводник
- MOS:
-
Металлооксидный полупроводник
- NC:
-
Отрицательная емкость
- NCFET:
-
Полевой транзистор с отрицательной емкостью
- NEMFET:
-
Наноэлектромеханический полевой транзистор
- S / D:
-
Источник / сток
- SS:
-
Подпороговое колебание
Наноматериалы
- Транзисторы, переходный полевой транзистор (JFET)
- Транзисторы, полевой эффект с изолированным затвором (IGFET или MOSFET)
- Переходные полевые транзисторы
- Полевые транзисторы с изолированным затвором (MOSFET)
- Введение в полевые транзисторы (JFET)
- Введение в полевые транзисторы с изолированным затвором
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Исследование влияния направления удара на абразивный нанометрический процесс резания с помощью молекулярно…
- Изготовление, характеристика и биологическая активность систем нано-доставки авермектина с различными разм…



