Гетероструктура ReS2 / GaAs насыщающийся поглотитель Nd:YVO4-лазер с пассивной модуляцией добротности
Аннотация
Гетероструктура ReS 2 / GaAs был изготовлен на пластине GaAs размером 110 мкм (111) методом химического осаждения из газовой фазы. Nd:YVO 4 с пассивной коммутацией добротности лазер был продемонстрирован с использованием гетероструктуры ReS 2 / GaAs как насыщающийся поглотитель (НА). Была получена самая короткая длительность импульса 51,3 нс с частотой следования 452 кГц, что соответствует энергии импульса 465 нДж и пиковой мощности 9,1 Вт. По сравнению с ReS 2 Лазер с модуляцией добротности и лазер с модуляцией добротности на GaAs, гетероструктор ReS 2 / GaAs-лазер с модуляцией добротности может генерировать более короткие импульсы и более высокую энергию.
Введение
Технологии пассивной модуляции добротности широко применяются в промышленности, медицине и научных исследованиях благодаря своим заметным преимуществам в отношении простой конструкции и значительной эффективности [1,2,3,4]. В качестве насыщающихся поглотителей использовались различные материалы, наиболее распространенным из которых является полупроводниковый насыщающийся поглотитель [5,6,7]. По сравнению с SESAM, двумерные (2D) материалы демонстрируют большой потенциал благодаря широкой полосе пропускания, низкой стоимости и простоте изготовления. В последние годы 2D-материалы, такие как черный фосфор, графен и переходные ментальные дихалькогениды (TMD), получили широкое распространение в качестве SA в лазерах с пассивной модуляцией добротности [8,9,10,11,12]. Среди этих заявленных TMD, таких как MoS 2 , MoSe 2 , и WS 2 , одной из характеристик является то, что при переходе от объема к монослою происходит прямое изменение ширины запрещенной зоны [13, 14].
В отличие от вышеупомянутых TMD, ReS 2 имеет прямую запрещенную зону, значение которой остается ~ 1.5 эВ как в объемной, так и в монослойной формах [15]. Кроме того, фотоэлектрические свойства ReS 2 подобны от объема к монослою [16]. Как полупроводник ReS 2 демонстрирует сильное нелинейное поглощение, так что ReS 2 as SA был экспериментально использован в твердотельных лазерах с длинами волн 1,5, 2,8 и 3 мкм [17,18,19]. Недавно ReS 2 на основе сапфировой подложки был заявлен в качестве насыщающегося поглотителя в лазере с длиной волны 1 мкм [20]. Однако ReS 2 насыщаемый поглотитель приклеивался к сапфировой подложке за счет слабых ван-дер-ваальсовых сил, который легко отщеплялся от подложки [20]. На сегодняшний день GaAs обычно применяется в твердотельных лазерах, легированных неодимом, для модуляции добротности на длине волны 1 мкм [21]. Однако GaAs также может быть объединен с другими полупроводниками в гетероструктуры, такие как MoS 2 / GaAs, MoSe 2 / GaAs и PtSe 2 / GaAs [22]. Пока что гетероструктура полупроводник MoS 2 / GaAs SA использовался для получения более коротких импульсов [23], что убедило нас в том, что подобная гетероструктура может быть привлекательной для импульсного режима. Технология химического осаждения из паровой фазы (CVD) может точно контролировать толщину осаждения и создавать поверхность с чисто согласованной решеткой. По сравнению с ReS 2 на сапфировой подложке, полупроводник ReS 2 Гетероструктуры / GaAs в качестве квантовой ямы могут ограничивать носитель и значительно улучшать инверсию населенностей. Характеристики гетероструктуры ReS 2 / Можно ожидать насыщающегося поглотителя из GaAs.
В данной статье гетероструктурный полупроводник ReS 2 / GaAs сначала изготавливается. В качестве насыщающегося поглотителя используется Nd:YVO 4 с пассивной модуляцией добротности. продемонстрирован твердотельный лазер с гетероструктурой ReS 2 / GaAs. По сравнению с ReS 2 с насыщающимся поглотителем или полупроводниковым насыщающимся поглотителем из GaAs, характеристики лазера были значительно улучшены с помощью гетероструктуры ReS 2 / Насыщающийся поглотитель из GaAs. Результаты экспериментов показывают, что ReS 2 / Насыщающийся поглотитель из GaAs может представлять большой интерес для операций с пассивной модуляцией добротности.
Методы / экспериментальные
Недавно ReS 2 насыщаемый абсорбер получают методом жидкофазного отшелушивания (ЖФЭ) из-за низкой стоимости. Однако ReS 2 монослой в нашем эксперименте был синтезирован методом CVD, потому что мы можем точно контролировать толщину ReS 2 . Здесь порошок серы и перренат аммония (NH 4 РеО 4 ) использовались в качестве предшественников для роста. ReS 2 монослой выращивали на чистой сапфировой пластине. В процессе осаждения в качестве газа-носителя для серы использовался аргон. Затем мы перенесли выращенный CVD ReS 2 монослой на пластину GaAs толщиной 110 мкм и размером 10 × 10 мм 2 для создания гетероструктуры. Полная процедура показана на рис. 1.
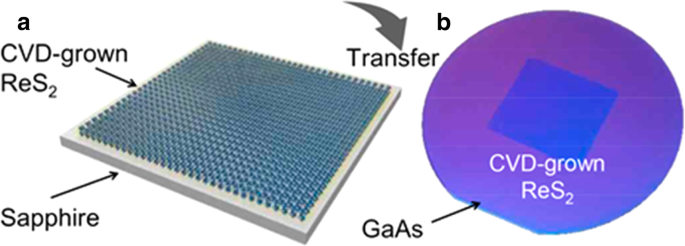
а , b Процедура изготовления ReS 2 / Гетероструктура GaAs
Убедиться, что номер слоя приготовленного ReS 2 / GaAs исследовали рамановский сдвиг приготовленного образца (рис. 2). A г моды, расположенные на 134 и 141 см −1 , а E г моды, расположенные на 150,7, 160,6, 210,7 и 233 см −1 . Разница пиков III-I составила 16,7 см -1 . , который рассматривался как монослой [24].

Рамановская спектроскопия гетероструктуры ReS 2 / GaAs
На рисунке 3 показана схема лазера с пассивной модуляцией добротности с ReS 2 . Насыщающийся поглотитель на гетероструктуре GaAs. Nd:YVO 4 , легированный 0,1% -ным Nd. В качестве лазерного кристалла использовался кристалл размером 3 × 3 × 10 мм 3 . Лазер с пассивной модуляцией добротности накачивался с торца диодным лазером с волоконной связью на длине волны 808 нм. Затем пучок накачки фокусировался в кристалл модулем рефокусировки с пятном на усиливающей среде диаметром 400 мкм. В качестве входного зеркала использовалось вогнутое зеркало M1, которое имело просветляющее (AR) покрытие на 808 нм с двух сторон и высокоотражающее (HR) покрытие на 1064 нм внутри резонатора. Радиус кривизны M1 составлял 200 мм. Плоское зеркало M2 работало как выходной ответвитель (OC) с пропусканием на 1064 нм 10%. Образовалась короткая линейная полость длиной около 30 мм. ReS 2 / GaAs (или GaAs) затем был вставлен в резонатор, работающий как насыщающийся поглотитель, и помещен рядом с выходным ответвителем.
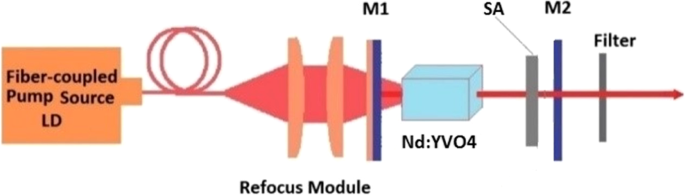
Схема резонатора лазера с модуляцией добротности
Результаты и обсуждение
Длительность и частота следования импульсов регистрировались цифровым люминофорным осциллографом (DPO 7104C) через быстрый фотодиод InGaAs. Как показано на рис. 4 и 5, при увеличении входной мощности с 0,5 до 2,26 Вт длительность импульса от ReS 2 Лазер с пассивной модуляцией добротности / GaAs уменьшился с 322 до 51,3 нс, а частота следования увеличилась с 139 до 452 кГц. Для сравнения мы также установили GaAs-лазер с модуляцией добротности. Как видно из рис. 4 и 5, что ReS 2 / Гетероструктура GaAs способствует сокращению ширины импульса и снижению частоты следования импульсов.

Зависимость длительности импульса лазера с модуляцией добротности от падающей мощности накачки

Частота следования лазера с пассивной модуляцией добротности в зависимости от мощности падающей накачки
На рис. 6 показаны профили импульсов модуляции добротности при мощности накачки 2,26 Вт с различными полупроводниковыми насыщающимися поглотителями. Выходные импульсы с длительностью 51,3 нс и энергией 465 нДж могут быть получены с помощью ReS 2 Насыщающийся поглотитель на гетероструктуре GaAs. Напротив, длительность выходного импульса GaAs-лазера с модуляцией добротности составляла 63,2 нс при энергии импульса 435 нДж, что показано на вставке. Рисунок 6 также подразумевает, что симметрия ReS 2 / GaAs-импульс с модуляцией добротности сравнительно лучше.

Профиль лазера с модуляцией добротности на основе ReS 2 / GaAs или GaAs при падающей мощности накачки 2,26 Вт
Энергия импульса и пиковая мощность в зависимости от мощности падающей накачки показаны на рис. 7. С увеличением мощности накачки наблюдалось быстрое увеличение пиковой мощности. Кроме того, пиковая мощность и энергия импульса ReS 2 / GaAs-лазеры с модуляцией добротности выше, чем лазеры на основе GaAs с модуляцией добротности при тех же условиях. А для ReS 2 / GaAs-лазер с модуляцией добротности, максимальная пиковая мощность 9,1 Вт и максимальная энергия импульса 465 нДж могут быть достигнуты при мощности накачки 2,26 Вт.

Энергия импульса ( a ) и пиковая мощность ( b ) лазера с модуляцией добротности
Мы также сравнили наши экспериментальные результаты с предыдущей работой [20] с ReS 2 насыщающийся поглотитель на сапфировой подложке. Самая короткая длительность импульса у ReS 2 Лазер 1 мкм с модуляцией добротности давал 139 нс при частоте следования 644 кГц, что соответствует пиковой мощности 1,3 Вт. Как следствие, гетероструктура ReS 2 Насыщающийся поглотитель / GaAs, очевидно, может улучшить характеристики лазера, особенно с точки зрения длительности импульса, энергии импульса и пиковой мощности, по сравнению с ReS 2 Лазеры с модуляцией добротности или лазеры с модуляцией добротности на GaAs.
Выводы
Таким образом, гетероструктура ReS 2 / Впервые изготовлен насыщающийся поглотитель из GaAs. На основе ReS 2 / GaAs гетероструктура насыщающийся поглотитель, Nd:YVO 4 с пассивной модуляцией добротности был продемонстрирован лазер. При мощности накачки 2,26 Вт была достигнута минимальная длительность импульса 51,3 нс с частотой следования 452 кГц, что соответствует максимальной энергии импульса 465 нДж и пиковой мощности 9,1 Вт. Наши результаты подтверждают, что гетероструктура ReS 2 / GaAs полезен для улучшения характеристик модуляции добротности по сравнению с полупроводниковым ReS 2 или насыщающиеся поглотители из GaAs.
Сокращения
- 2D:
-
Двумерный
- AR:
-
Антиотражение
- CVD:
-
Химическое осаждение из паровой фазы
- HR:
-
Высокое отражение
- LPE:
-
Жидкофазное отшелушивание
- OC:
-
Выходной соединитель
- SESAM:
-
Зеркало полупроводникового насыщающегося поглотителя
- TMD:
-
Переходный психодихалькогенид
Наноматериалы
- Плазмонно-усиленное поглощение света в (p-i-n) переходных GaAs-нанопроводных солнечных элементах:исследование ме…
- Матрицы нанополосов на основе GaAs с золотым покрытием, изготовленные методом химического травления с примене…
- Большой боковой фотоэлектрический эффект в гетеропереходе MoS2 / GaAs
- Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и кон…
- Устранение бимодального размера в квантовых точках InAs / GaAs для изготовления лазеров на квантовых точках 1,3 мк…
- Оптимизация солнечных элементов с решеткой с нановолоконным GaAs с использованием гетеропереходов AlGaAs / GaAs
- Электрические свойства средневолновых и длинноволновых сверхрешеток InAs / GaSb, выращенных на подложках GaAs мето…
- InAs / GaAs квантовый двухрежимный лазер с распределенной обратной связью для применения в терагерцовом диапазон…
- Наблюдение внешнего фотоиндуцированного обратного спинового эффекта Холла в двумерном электронном газе GaAs …
- Устройства фотоники на основе графена для дистанционного зондирования



