Высоковольтный диод Шоттки β-Ga2O3 с граничной нагрузкой, имплантированной аргоном
Аннотация
Торцевой Au / Ni / β-Ga 2 О 3 Диоды с барьером Шоттки были изготовлены с использованием имплантации аргона для формирования высокоомных слоев на периферии анодных контактов. При энергии имплантации 50 кэВ и дозе 5 × 10 14 см −2 и 1 × 10 16 см −2 напряжение обратного пробоя увеличивается с 209 до 252 и 451 В (максимум до 550 В) и добротность Балиги (V BR 2 / R на ) также увеличивается с 25,7 до 30,2 и 61,6 МВт · см −2 , примерно на 17,5% и 140%, соответственно. Согласно 2D-моделированию, электрические поля в углу соединения сглаживаются после имплантации аргона, а положение максимального электрического поля пробоя, 5,05 МВ / см, изменяется от угла анода на границе раздела к углу перекрытия непосредственно под имплантацией. область. Также была исследована температурная зависимость прямых характеристик.
Фон
Разработка мощных устройств с использованием полупроводниковых материалов со сверхширокой запрещенной зоной, таких как Ga 2 О 3 , AlN, алмаз и т. Д. В последние годы ускоряется. Ширина запрещенной зоны β-Ga 2 О 3 достигает 4,8–4,9 эВ, а поле пробоя β-Ga 2 О 3 оценивается в 8 МВ / см, что примерно в три раза больше, чем у 4H-SiC и GaN. Показатель качества Baliga, 3400, по крайней мере в десять раз больше, чем у 4H-SiC, и в четыре раза больше, чем у GaN [1]. Кроме того, большой монокристалл и недорогой β-Ga 2 О 3 субстрат может быть изготовлен с помощью методов выращивания из расплава, таких как плавающая зона (FZ) [2] и рост по краям с подачей из пленки (EFG) [3, 4]. Электронной плотностью можно управлять в широком диапазоне от 10 16 до 10 19 см −3 легированием Sn, Si или Ge [5,6,7]. Эти превосходные свойства делают β-Ga 2 О 3 идеально подходит для коммутации высокого напряжения и высокой мощности с низкими потерями, включая диод с барьером Шоттки (SBD) с высоким напряжением пробоя и полевой транзистор металл-оксид-полупроводник (MOSFET) [8,9,10,11,12] . Диоды с барьером Шоттки обладают преимуществами быстрой скорости переключения и низкого прямого падения напряжения по сравнению с диодами с p-n переходом, что может снизить потери мощности и повысить эффективность источников питания.
Хотя в β-Ga 2 были получены большие пробивные напряжения 1016 В, 2300 В и 1600 В О 3 Диоды с барьером Шоттки без торцевой заделки, все они составляют около 34%, 8% и 10% от идеального значения [10, 13, 14]. Чтобы уменьшить эффект сгущения электрического поля и полностью реализовать потенциал напряжения β-Ga 2 О 3 , должны быть разработаны подходящие краевые заделки. Существует ряд методов торцевого заделывания для увеличения пробивного напряжения устройства, таких как полевые пластины, плавающие металлические кольца, желобковая МОП-структура, имплантированные защитные кольца и удлинители для заделки переходов (JTE) [12, 15, 16, 17]. Однако имплантированные защитные кольца и структура JTE не применимы к Ga 2 О 3 Диод Шоттки из-за отсутствия легирования p-типа. Х. Мацунами и Б.Дж. Балига предложили краевую оконечную структуру, использующую имплантацию аргона для формирования высокоомного аморфного слоя на краях анода, чтобы уменьшить скопление электрического поля [18,19,20,21,22], что является это простой метод, не требующий многофотолитографии или глубокого травления канавок, и он широко используется в выпрямителях SiC и GaN для сглаживания распределения электрического поля по периферии выпрямляющего контакта [15, 23, 24].
В этой статье вертикальный β-Ga 2 с торцевым окончанием О 3 Диоды Шоттки изготавливались с имплантацией аргона по краям контактов Шоттки. Характеристики емкости-напряжения (C – V) и зависимости плотности тока от температуры (J-V) были записаны с использованием системы определения характеристик полупроводников Keithley 4200, а также проанализировано распределение электрического поля.
Методы / экспериментальные
Дрейфовый слой толщиной 10 мкм был получен из высококачественного легированного оловом (100) -ориентированного β-Ga 2 О 3 объемный субстрат путем механического отшелушивания. Β-Ga 2 О 3 объем был выращен методом EFG с использованием 4 N чистого Ga 2 О 3 порошок в качестве исходного материала. Превосходное качество кристаллов и гладкая поверхность были подтверждены измерениями дифракции рентгеновских лучей высокого разрешения (HRXRD) и атомно-силового микроскопа (АСМ), как показано на рис. 1a, b. Полная ширина на полувысоте (FWHM) и среднеквадратичное значение (RMS) были оценены в 37,4 угловых секунды и 0,203 нм, соответственно. На рисунке 1c показано распределение β-Ga 2 . О 3 сопротивление листа подложки толщиной 10 мкм с помощью измерения четырехточечным зондом. При концентрации носителя (1,3 ± 0,04) × 10 17 см −3 и поверхностное сопротивление (563 ± 18,5) Ом / □, подвижность электронов рассчитана как 85,3 ~ 95,2 см 2 / Vs от μ n =1 / (R Лист × n × q × т ), где μ n, R Лист, нет , q , и t - подвижность электронов, сопротивление слоя, концентрация электронов, заряд электронов и толщина β-Ga 2 О 3 субстрата, аналогично опубликованным результатам [25]. Имплантация ионов аргона с энергией 50 кэВ, доза 2,5 × 10 14 см −2 , и высокотемпературный отжиг при 950 ° C в течение 60 мин в N 2 сначала выполнялись на обратной стороне атмосферы, после чего следовало испарение электронным пучком омической металлической стопки Ti / Au (20 нм / 100 нм) и быстрый термический отжиг при 600 ° C в течение 60 с в N 2 окружающий. Затем фоторезист толщиной 2 мкм использовался в качестве маски для имплантации аргона при комнатной температуре с энергией 50 кэВ и дозой 5 × 10 14 см −2 (образец B) и 1 × 10 16 см −2 (образец C) соответственно. Для устранения повреждений имплантации и уменьшения тока утечки при обратном смещении имплантированные образцы подвергали быстрому термическому отжигу при 400 ° C в течение 60 с в атмосфере N 2 . амбиент [13, 26]. Наконец, на лицевой стороне были изготовлены круглые анодные электроды Шоттки диаметром 100 мкм с помощью стандартного фотолитографического нанесения рисунка, испарения пакета Ni / Au (30 нм / 200 нм) и подъема. Также был изготовлен эталонный прибор без имплантации аргона (образец А). На рисунке 2а показано поперечное сечение ПЭМ изготовленного Ga 2 . О 3 Диод Шоттки с краевым окончанием, имплантированным аргоном. Практически поверхностный аморфный β-Ga 2 О 3 слой был создан в области имплантации. Фактическая фотография прекращенного β-Ga 2 О 3 Диод Шоттки показан на рис. 2б. На рисунке 2c представлена схема измерения прямого тока – напряжения ( I - V ) характеристики β-Ga 2 О 3 SBD, при этом измеряемое напряжение колеблется от 0 до 3 В с шагом 10 мВ. На рисунке 2d изображена установка для измерения обратного тока – напряжения ( I - V ) характеристики β-Ga 2 О 3 Выпрямители Шоттки для получения напряжения пробоя, при этом измеряемое напряжение находится в диапазоне от 0 до - 500 В, а шаг составляет - 1 В.

а Кривая качания XRD и b АСМ изображение β-Ga 2 О 3 дрейфовый слой, механически отслоившийся от (100) β-Ga 2 О 3 субстрат c измеренное сопротивление листа 10 мм × 10 мм β-Ga 2 О 3 субстрат
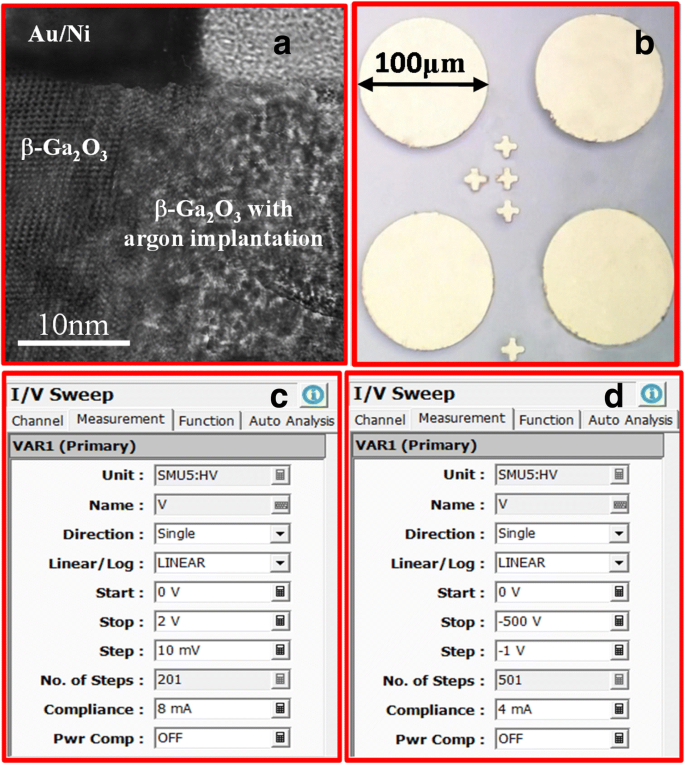
а ПЭМ-изображение образца C и b фотография прекращенного β-Ga 2 О 3 Диод Шоттки c установка измерения прямого тока и d обратные вольт-амперные характеристики (ВАХ) β-Ga 2 О 3 SBD для получения напряжения пробоя
Результаты и обсуждение
На рисунке 3 показан экспериментальный 1 / C 2 по сравнению с V характеристики трех образцов SBD при комнатной температуре. Эффективная концентрация носителей N d - N а β-Ga 2 О 3 дрейфовый слой и встроенный потенциал ( эВ би ) извлекаются как (1,3 ± 0,04) × 10 17 см −3 и (1.30 ± 0.08) эВ соответственно. Согласно следующим уравнениям высота барьера Шоттки φ b_CV рассчитывается как (1,32 ± 0,08) эВ.
$$ \ frac {1} {C ^ 2} =\ frac {2} {q \ varepsilon {A} ^ 2 \ left ({N} _d- {N} _ {\ mathrm {a}} \ right)} \ left ({V} _ {bi} -V \ right) $$ (1) $$ e {\ varphi} _b ={eV} _ {bi} + \ left ({E} _c- {E} _f \ right) -e \ Delta \ varphi $$ (2) $$ {E} _c- {E} _f =kT \ ln \ left (\ frac {N_c} {N_d- {N} _a} \ right) $$ ( 3) $$ e \ Delta \ varphi ={\ left \ {\ frac {e} {4 \ pi \ varepsilon} {\ left [\ frac {2 {eV} _ {bi} \ left ({N} _d- {N} _a \ right)} {\ varepsilon} \ right]} ^ {1/2} \ right \}} ^ {1/2} $$ (4)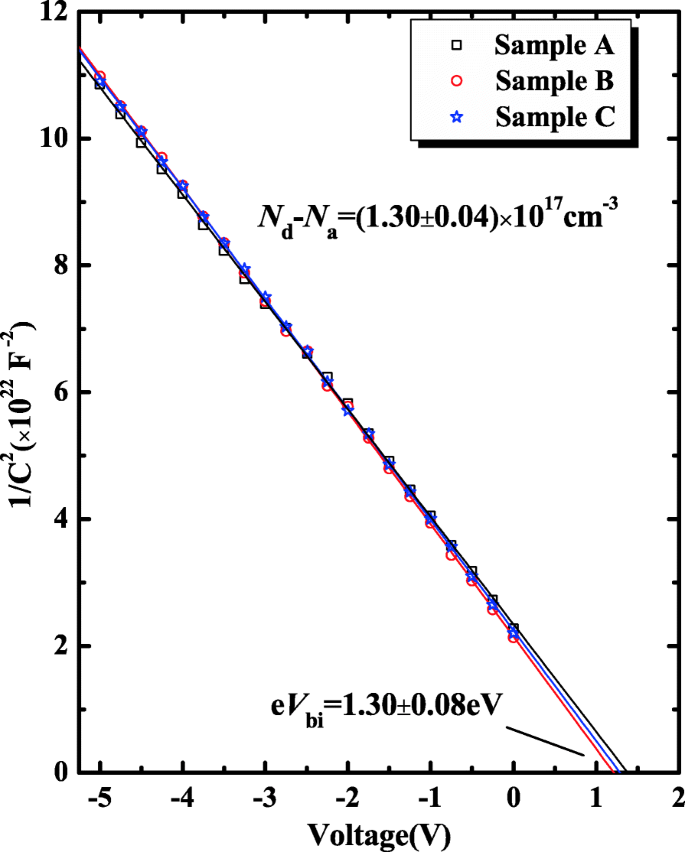
1 / C 2 - V графики трех β-Ga 2 О 3 Образцы SBD
где A , q , и ε - площадь контакта Шоттки, заряд электрона и диэлектрическая проницаемость β-Ga 2 О 3 . E c , E f , eΔφ , k , Т , и N c - минимум зоны проводимости, уровень Ферми, снижение потенциального барьера, вызванное силой изображения, постоянная Больцмана, абсолютная температура в K и эффективная плотность состояний зоны проводимости соответственно.
На рис. 4а представлена плотность-напряжение прямого тока ( Дж - V ) характеристики β-Ga 2 О 3 SBD. При прямом смещении имплантация аргона не оказывает существенного влияния на электрические характеристики. Пороговое напряжение составляет 0,91 В, 0,92 В и 0,95 В для трех образцов: I на / Я выкл все коэффициенты больше 10 9 при комнатной температуре и подбирая линейную область, удельные сопротивления в открытом состоянии ( R на ) составляют 1,7, 2,1 и 3,3 мОм см 2 , а плотности прямого тока при 2 В составляют 857, 699 и 621 А / см 2 для трех образцов соответственно, как показано на вставке к рис. 4а. Плотности тока выше, а удельное сопротивление в открытом состоянии ниже или сопоставимо с заявленными значениями для более высокой проводимости и плотности носителей в дрейфовом слое [12, 13, 26,27,28,29,30].
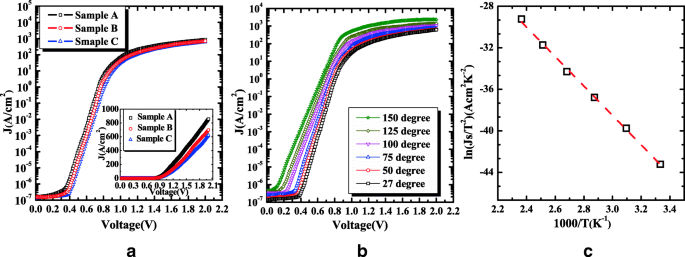
а Нападающий J - V характеристики терминированного и незавершенного β-Ga 2 О 3 при комнатной температуре и b температурно-зависимый передний Дж - V характеристики образца C от 300 до 423 К. c График Ричардсона ln ( J s / T 2 ) против 1000 / T образца C
Чтобы исследовать влияние имплантации аргона на температурную зависимость прямых характеристик, прямые J - V измерения образца C проводятся от 300 до 423 K, как показано на рис. 4b. Идеальный коэффициент n и высота барьера Шоттки φ b_JV определены равными 1,06 и 1,22 эВ при комнатной температуре, что ниже φ b_CV (1,32 ± 0,08) эВ согласно термоэлектронной эмиссионной (ТЭ) модели [31, 32]. При повышении температуры n уменьшается с 1,06 до 1,02, а высота барьера немного уменьшается, но остается почти постоянной на уровне 1,21 ± 0,01 эВ во всем диапазоне температур, что противоречит уменьшению высоты барьера идеального диода Шоттки с повышением температуры, но наблюдалось в изготовленном β-Ga 2 О 3 SBD [26]. Используя уравнение ln ( J s / T 2 ) =Ln (A *) - q ϕ b / кТ , высота барьера ϕ b и эффективная постоянная Ричардсона A * определены равными 1,22 эВ и 48,5 А / см 2 К 2 для образца C с наклона и y - пересечение оси линейного участка графика, как показано на рис. 4c. Кроме того, извлеченные значения A * для десятков устройств на трех образцах составляют от 24 до 58 А / см 2 . К 2 , что соответствует результатам предыдущего эксперимента и теоретическому значению, 24–58 А / см 2 К 2 , с эффективной массой электрона m * =0,23–0,34 м 0 β-Ga 2 О 3 [33,34,35,36,37].
На рисунке 5а изображено обратное J - V характеристики образцов. После имплантации аргона напряжение пробоя увеличивается с 209 до 252 и 451 В, а добротность по Балиге (V BR 2 / R на ) для трех образцов составляют примерно 25,7, 30,2 и 61,6 МВт · см −2 , соответственно. Во время имплантации могут появиться некоторые дефекты, которые могут привести к значительному и нежелательному увеличению тока утечки, о чем также сообщалось в устройствах с диодами Шоттки из SiC и GaN [18,19,20]. Несмотря на то, что термический отжиг проводился после имплантации аргона, для образцов B и C по-прежнему наблюдаются несколько более высокие токи утечки. Поэтому в следующей статье следует рассмотреть детали исследования температуры и продолжительности прямого и обратного отжига электрических характеристик после отжига.

а Обратный J - V характеристики β-Ga 2 О 3 образцы при комнатной температуре. б и c Распределение пробивных напряжений β-Ga 2 О 3 SBD с имплантацией аргона и без нее
На рис. 5б, в представлено распределение пробивных напряжений β-Ga 2 . О 3 Выпрямители Шоттки с имплантацией аргона и без нее. Идеальные плоскопараллельные напряжения пробоя этих устройств определены как 553 ~ 598 В с использованием критического электрического поля 5,1 ~ 5,3 МВ / см [11, 39]. Напряжение пробоя без имплантации аргона составляет примерно 110 ~ 310 В, что составляет около 50% от идеальных значений. Однако при дозе имплантации аргона 5 × 10 14 см −2 , напряжение пробоя увеличивается до 150 ~ 350 В, что не намного больше, чем у эталонного устройства, в то время как при дозе 1 × 10 16 см −2 , напряжение пробоя приближается к идеальным значениям. В этой работе может быть получено максимальное напряжение пробоя 550 В. Кроме того, моделировалось распределение электрического поля при напряжении пробоя. Для упрощения был добавлен один уровень акцептора средней запрещенной зоны с глубиной имплантации 50 нм, определенной с помощью моделирования TRIM, а также была рассмотрена модель неполной ионизации [38], как показано на рис. 6. Очевидно, что слой с высоким сопротивлением эффективно сглаживает электрическое поле в углах перехода и значительно увеличивает напряжение пробоя по сравнению с эталонным образцом. Максимальные электрические поля при напряжении пробоя составляют около 5,05 МВ / см, аналогично опубликованным результатам [11, 39], в то время как положение изменяется от угла анода на границе раздела к углу перекрытия непосредственно под областью имплантации, как показано на Рис. 6г, д.
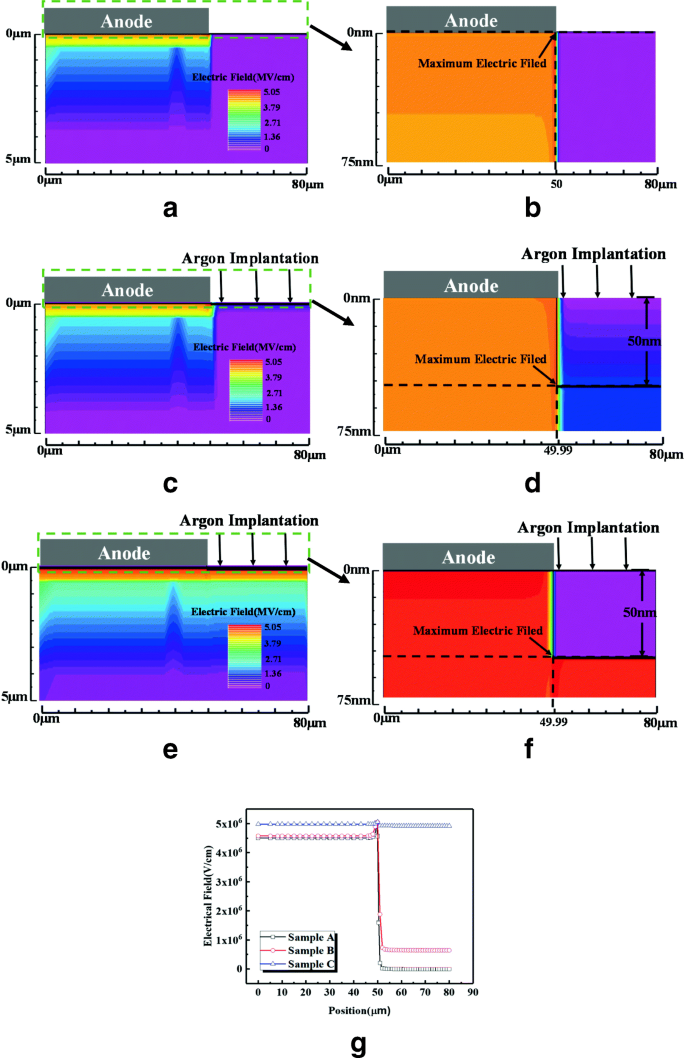
Моделирование распределения электрического поля при напряжении пробоя образцов A – C ( a , c , e ), увеличенное изображение выбранных областей в пунктирной рамке ( b , d , f , г ) смоделированное электрическое поле в зависимости от положения вдоль пунктирной линии в ( b , d , f ) для трех образцов Au / Ni / β-Ga 2 О 3 граница раздела для образца A, на 50 нм ниже границы раздела для образцов B и C, соответственно. Максимальное поле 5,05 МВ / см
Выводы
Вертикальный Au / Ni / β-Ga 2 О 3 Диоды с барьером Шоттки с торцевым окончанием, образованным имплантацией аргона, были изготовлены на β-Ga 2 О 3 дрейфовый слой, механически отслоившийся от высококачественного (100) -ориентированного β-Ga 2 О 3 насыпной субстрат. По сравнению с устройством управления, удельные сопротивления в открытом состоянии ( R на ) увеличивается с 1,7 до 2,1 и 3,3 мОм см 2 а напряжение пробоя увеличивается с 209 до 252 и 451 В для дозы имплантации 5 × 10 14 см −2 и 1 × 10 16 см −2 соответственно с большим обратным током утечки. Максимальное электрическое поле при напряжении пробоя составляет около 5,05 МВ / см, что намного больше, чем у SiC и GaN.
Сокращения
- AFM:
-
Атомно-силовой микроскоп
- EFG:
-
Рост по краю с пленочной подачей
- FWHM:
-
Полная ширина на полувысоте
- FZ:
-
Плавающая зона
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- JTE:
-
Удлинитель оконечной нагрузки соединения
- MOSFET:
-
Полевой транзистор металл-оксид-полупроводник
- RMS:
-
Среднеквадратичное значение
- SBD:
-
Диод с барьером Шоттки
- TE:
-
Термоэмиссия
Наноматериалы
- ST управляет ИИ для граничных и узловых встроенных устройств с помощью набора инструментов разработчика нейр…
- ept:HighSpeed SMT Edge Card Connector с шагом 0,8 мм
- Future Electronics:микрофон MEMS от CUI с улучшенным качеством звука
- Advantech переносит ускоренные вычисления из облака на периферию с NVIDIA
- ADLINK:развертывание ИИ из периферии в облако с помощью решений Edge AI и платформы NVIDIA EGX
- ADLINK:более быстрая и точная логистика с Edge IoT Smart Pallet Experience
- Cisco объединяет предприятия и промышленные предприятия с помощью новых маршрутизаторов
- Обновление Индустрии 4.0 с помощью пограничной аналитики
- Развитие пограничных вычислений, IIC объединяется с OpenFog
- Умные патрульные роботы 5G, оснащенные периферийным компьютером Advantech, используются для борьбы с коронавирусо…



