RTN и отжиг, связанный с напряжением и температурой, в массиве FIND RRAM
Аннотация
В этой работе представлено наблюдение за сигналом случайного телеграфного шума (RTN) в токе чтения диэлектрического устройства RRAM FinFET (FIND RRAM). Было обнаружено, что сигнал RTN ячейки FIND RRAM изменяется после того, как устройство подвергается циклической нагрузке. После циклического стресса клетки RRAM имеют более сильную тенденцию показывать более частые и интенсивные сигналы RTN. Повышение уровня шума в ячейках FIND RRAM можно в целом уменьшить за счет высокотемпературного отжига, и с этой концепцией предлагается и демонстрируется схема отжига на кристалле.
Введение
Непрерывное масштабирование технологии CMOS значительно улучшило характеристики и производительность интегральных схем за последнее десятилетие. Однако по мере того, как технологический узел уменьшается ниже 20 нм, вариации из-за одного атома / электрона в характеристиках устройства увеличиваются, например, случайные флуктуации примеси (RDF), и, таким образом, порождают фундаментальные проблемы, за которыми нельзя наблюдать [1]. Например, любые вариации в количестве несущих или структурные дефекты имеют гораздо большее влияние на выход и производительность масштабируемого устройства, а также влияние масштабирования устройства на изменчивость из-за RDF и шероховатости линии затвора (LER). сообщалось [2,3,4]. Случайный телеграфный шум (RTN) считается еще одной серьезной проблемой для устройств с небольшой площадью, таких как NAND Flash и RRAM [5,6,7,8,9,10,11]. В этой работе мы исследуем шум RTN в n-канальной ячейке FIND RRAM на основе FinFET, которая уже была успешно реализована в стандартном логическом процессе в массивах 1 кбит [12]. Наблюдаются изменения RTN в ответ на циклические напряжения и высокотемпературную сушку. В этой работе изучается влияние напряжения и температуры на шум RTN в ячейках FIND RRAM, а также предлагается схема отжига на кристалле для уменьшения зависящего от времени шума тока чтения после цикла.
Предпосылки и методы
FIND RRAM состоит из двух транзисторов FinFET. Один действует как транзистор выбора WL последовательно с узлом RRAM. Диэлектрик затвора с высоким k между SiP и SL другого транзистора служит узлом хранения, как показано на рис. 1a. Устройства FIND состоят из диэлектрической пленки затвора в стандартных полевых транзисторах FinFET, где электродом затвора является W для верхнего электрода и TaN для нижнего. Оксид стопки затвора состоит из HfO 2 / SiO 2 Слои стопки / TiN [12]. Состояние чтения ячейки FIND RRAM проиллюстрировано на рис. 1b, где WL дается 0,8 В для включения транзистора выбора, а 0,8 В добавляется к SL для обеспечения достаточного тока чтения для считывания данных. Резистивное переключение между состояниями высокого сопротивления (HRS) и состояниями низкого сопротивления (LRS) достигается путем выполнения установки / сброса в ячейке FIND RRAM [13]. FIND RRAM демонстрирует довольно стабильные характеристики резистивного переключения при развертке по постоянному току, см. Рис. 2a, а его характеристики времени до установки и времени до сброса суммированы на рис. 2b. Условия эксплуатации, перечисленные на рис. 2а, показывают, что возможны операции с низким напряжением. Ячейки проходят несколько циклов импульсов как для установки, так и для сброса, чтобы достичь целевых уровней тока считывания. Ширина импульса будет увеличиваться, если устройству не удается установить или сбросить после подачи нескольких импульсов, как показано на рис. 3a. Отличительный сигнал RTN можно найти как в ячейках LRS, так и в HRS FIND RRAM, как показано на рис. 3b. Сигналы RTN, вызванные захватом и отключением заряда в токопроводящем тракте, могут привести к значительным колебаниям тока [14,15,16,17].
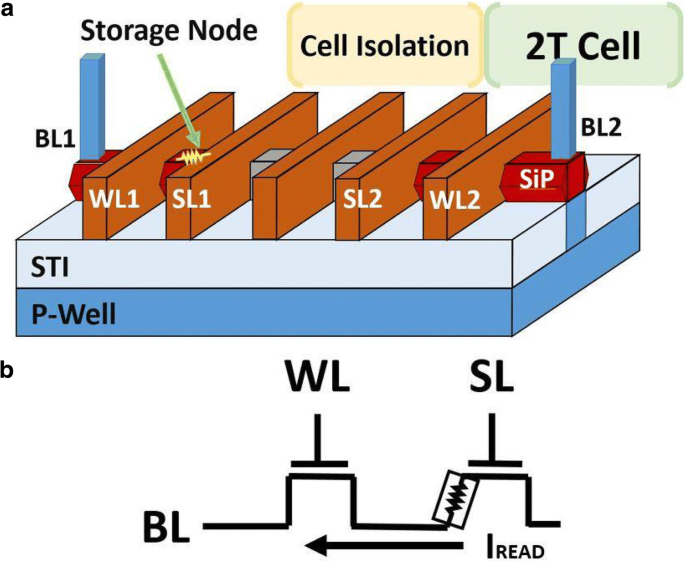
а Трехмерное изображение 2 T ячеек FIND RRAM, реализованных с помощью технологий CMOS FinFET и b показана принципиальная схема элементарной ячейки для НАЙТИ RRAM в условиях чтения, где VSL =VWL =0,8 В, а BL смещен на ноль
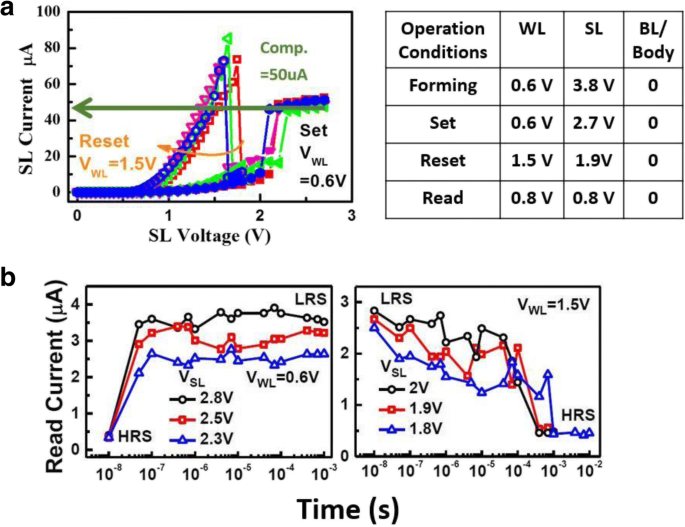
Функции резистивного переключения постоянного тока FIND RRAM и условия его работы показаны на ( a ). Его время установки и время восстановления кратко описаны в ( b )

а Иллюстрация увеличения ширины импульса, используемого для выполнения операции установки / сброса. После первого импульса длительностью 1 мкс выполняется операция чтения, чтобы оценить, достигает ли ток считывания целевых уровней 3 мкА для LRS и менее 1 мкА для HRS. Если требуемое состояние не достигается, выдается следующий импульс. Ширина импульса увеличивается на порядок каждые десять импульсов. б Сравнение тока считывания при комнатной температуре, измеренного при VSL =VWL =0,8 В и VBL =0, с частотой дискретизации 500 Гц, до и после 100-кратного цикла
Хорошо известно, что многократное циклирование, то есть переключение между двумя состояниями, может вызвать нагрузку на диэлектрический слой затвора FinFET [18]. Напряженный слой оксида переходного металла (TMO) в ячейках FIND RRAM имеет более сильную тенденцию показывать шумы RTN, что приводит к изменяющемуся во времени току чтения, что может вызвать ошибки чтения и проблемы со стабильностью во время считывания данных. В этом эксперименте мы выбрали токи считывания массива в свежем состоянии, после 10 × циклов и после 100 × циклов, чтобы наблюдать влияние напряжения на RTN в FIND RRAM.
Чтобы исследовать влияние температуры на напряженные клетки FIND RRAM, образцы с отчетливыми сигналами RTN в LRS сначала охлаждают до 0 ° C, а затем постепенно нагревают до 50 ° C. Во время этого процесса токи считывания при этих температурах непрерывно измеряются в течение 20 с с частотой 500 Гц. Это дает нам некоторое представление о том, как RTN ведет себя при изменении температуры.
Результаты и обсуждение
Посредством обширных измерений было обнаружено, что RTN является более стабильным и легко наблюдаемым в ячейке FIND RRAM в его LRS. Таким образом, при изучении влияния циклирования и отжига на RTN клеток FIND RRAM следующий раздел посвящен исследованию клеток в LRS. Как показано на рис. 4a, шумы RTN приводят к изменяющемуся во времени току чтения, который вызывает ошибку чтения. Этот эффект можно наблюдать в массиве ячеек размером 1 Кбит. В массиве, прошедшем 10 циклов, обнаруживаются значительные колебания тока чтения при измерении тока чтения в течение 20-секундного интервала. Карта нормализованного битового тока в массиве представлена на рис. 4b, где колебания тока в LRS могут достигать + 5%, что сопоставимо с RTN, наблюдаемым в токе утечки затвора после напряжения [19]. Чтобы исследовать влияние стресса, мы отслеживали текущие уровни колебаний 50 клеток до и после стресса от езды на велосипеде. Данные на рис. 5а показывают, что более 90% клеток демонстрируют увеличение ΔI / I после цикла. А именно, показано, что изменяющийся во времени шум в FIND RRAM постепенно ухудшается по мере того, как ячейки испытывают больше циклических нагрузок. Когда мы сравниваем нормализованное распределение тока чтения свежих клеток и циклических клеток, было обнаружено, что клетки, которые прошли больше циклов, демонстрируют более значимые сигналы RTN и показывают два или более распределения пикового тока в определенных состояниях. С другой стороны, свежие клетки имеют стандартное распределение тока, что указывает на отсутствие шумов RTN, связанных с флуктуацией, как показано на рис. 5b [20, 21]. Это говорит о том, что если FIND RRAM подвергается длительной циклической нагрузке, ток ее битовой ячейки может подвергаться более резким колебаниям из-за добавления RTN.

а Нормализованный ток чтения при 25 ° C, измеренный с частотой 500 Гц в ячейке RRAM, прошедшей 10 циклов. Это показывает, что RTN вызывает изменяющийся во времени ток чтения. б Показывает график нормализованного тока в массиве 1 кбит, который прошел через 10 циклов, выбранных одновременно при t1 =3, t2 =7,5, t3 =14 и t4 =17,5 с, последовательно. Сравнивая снимок в разное время, ток чтения колеблется в одних и тех же условиях чтения

а Сравнивая распределение | ΔI / I | 50 образцов до и после стресса. Можно видеть, что клетки демонстрируют в целом больший ΔI / I после стресса. Значения процентилей прямоугольной диаграммы снизу вверх представляют 25, 50 и 75 точек процентиля, соответственно, в то время как усы указывают максимальное и минимальное значения. б Гистограмма нормализованного распределения тока считывания ячейки, измеренная в свежем состоянии и после 10 и 100 циклов. Это показывает, что как только FIND RRAM подвергается длительной циклической нагрузке, ток его битовой ячейки может подвергаться более резким колебаниям из-за добавления RTN
Нормализованные результаты образца считываемого тока на различных этапах температуры сравниваются на рис. 6. Время захвата и время излучения ловушек RTN были изучены и, как известно, изменяются с температурой, причем оба значения уменьшаются с увеличением температуры [22, 23 ]. Как и ожидалось, частота шума RTN увеличивается с ростом температуры, а именно, колебания тока считывания при 0 ° C происходят реже, чем при 25 ° C. Однако при измерении при 50 ° C колебания тока между двумя состояниями становятся менее заметными. Это может быть дополнительно показано на рис. 7a, где представлена гистограмма нормированных токов считывания, измеренных при 0 ° C, 50 ° C и комнатной температуре. Распределения тока 0 ° C и 25 ° C действительно имеют два пика распределения, предполагая, что одиночные состояния захвата RTN доминируют на проводящем пути [19], в то время как дискретные состояния на токе выборки при 50 ° C становятся менее заметными. Это говорит о том, что при более высокой температуре ловушки, которые вызывают сигнал RTN, могут быть нестабильными, например, эффектом отжига или рекомбинацией дефектов, что, в свою очередь, влияет на вероятность захвата электронов и, таким образом, ослабляет эффект RTN [27].

Сравнение нормализованных токов чтения ячейки RRAM (в состоянии LRS), прошедшей 100 циклов, с шумом RTN, измеренным при 0, 25 и 50 ° C, с частотой дискретизации 500 Гц

а Сравнение гистограмм нормализованного распределения тока чтения ячейки в состоянии LRS, измеренных при 0, 25 и 50 ° C. б Сравнение кумулятивной вероятности | ΔI / I | 30 образцов до напряжения, после напряжения и после отжига соответственно. Обнаружено, что большая часть ячеек возвращается к исходному ΔI / I после процесса отжига
При дальнейшем исследовании образцы нагревают до 75 ° C. Эти ячейки охлаждались до комнатной температуры через 30 мин, после чего отбирались образцы. Выбираются тридцать ячеек, и их совокупные уровни флуктуаций тока в свежем, напряженном состоянии и после отжига сравниваются на рис. 7b. Это показывает, что большинство ячеек возвращаются к исходному значению ΔI / I после процесса отжига. Нормализованные токи чтения из ячейки в ее свежем состоянии, напряженном состоянии и после запекания сравниваются на рис. 8. Ток после запекания похож на ток свежего, предполагая, что высокотемпературное запекание отжигает ловушки, которые вызывают сигналы RTN. На рис. 9а представлен график нормализованного тока чтения для массива свежих ячеек размером 1 Кбит, ячеек с небольшим стрессом, ячеек с высоким уровнем стресса и ячеек после запекания, соответственно. Из графика видно, что колебания тока становятся более интенсивными, когда RRAM сильно нагружается, и резко уменьшается после высокотемпературной запекания. Этот эффект можно наблюдать во всем массиве, что подтверждает, что высокотемпературная выпечка действительно обеспечивает эффект отжига ловушек, которые вызывают шум RTN [24,25,26,27,28,29]. На рисунке 9b дополнительно сравниваются распределения ΔI / I в массиве ячеек, полученные путем последовательной выборки из десяти различных выборок. Обнаружено, что один и тот же массив демонстрирует разные распределения ΔI / I в свежем, напряженном и после отожженном состояниях. Данные предполагают, что отжиг действительно помогает массиву ячеек показать меньшие колебания тока, аналогичные уровню массива в его свежем состоянии. Этот результат можно использовать для исправления и продления срока службы ячеек FIND RRAM, которые показали сигналы RTN после циклического стресса.

Считайте токи свежих и напряженных ячеек, отобранных при 25 ° C, 500 Гц, по сравнению с током ячейки после высокотемпературной запекания и охлаждения в течение 30 минут до комнатной температуры. Это показывает, что после запекания напряжение снимается и ячейка ведет себя как свежая

а Нормализованные токи чтения массива 1 Кбит, снятые в определенное время, нанесенные на график при свежем, слегка нагруженном, сильно нагруженном состоянии и после отжига. Можно видеть, что количество ячеек с сильными колебаниями в массиве значительно увеличивается по мере того, как массив подвергается большему напряжению и умирает после отжига. б Сравнение кумулятивных вероятностей | ΔI / I | распределения 50 образцов из одного массива в свежем, напряженном и после отожженном состояниях в разные моменты времени с интервалом 1 с. Общий ΔI / I на образцах после напряжения выше, и он возвращается к норме после отжига
Следует отметить, что некоторые клетки, застрявшие в среднем состоянии при циклировании, восстанавливаются после высокотемпературной обработки. Поскольку ячейка FinFET RRAM циклически проходит через LRS и HRS, проводящая нить в некоторых ячейках может образовывать канал, который не может быть легко сброшен. Процесс запекания обеспечивает этим клеткам путь для перераспределения кислородных вакансий, что позволяет эффективно вернуться к HRS [30]. На рис. 10 показана ячейка, которая не смогла переключиться на HRS, восстанавливаемая после 125 ° C, 15 мин запекания. Имея это в виду, предлагается механизм отжига на кристалле, включающий локальный нагрев ячейки FIND RRAM. Постоянный ток 1,5 мА с периодом 10 с подается на ячейку через прямое смещение на дренажном переходе выбранного FinFET, как показано на рис. 11a. Этот большой ток нагревает ограниченную область около RRAM TMO и обеспечивает аналогичный эффект отжига. Ток считывания до и после отжига тестируемого устройства (DUT) измеряется и анализируется на рис. 11b. Кумулятивные распределения непрерывно измеряемого тока считывания демонстрируют удаление RTN на ячейке после этапа отжига на кристалле. Здесь отжиг на кристалле FIND RRAM был выполнен на отдельных ячейках в последовательных этапах, чтобы понять номинальный ответ на типичную ячейку RRAM после нагрузки. Для эксперимента на уровне массива необходимо разработать новую процедуру отжига на кристалле.

Применяя запекание при 125 ° C к ячейкам, застрявшим в среднем состоянии, и обеспечивая процесс отжига, мы переводим эти ячейки обратно в функциональное состояние, тем самым продлевая срок их службы

Схема отжига на кристалле, которую мы предложили, включает приложение -1 В на BL, что приводит к прямому смещению, и измеренный ток 1,5 мА, который нагревает и отжигает напряженную ячейку. На графике, сравнивая совокупный процент нормализованного тока ячейки до и после процесса, мы видим, что колебания тока, вызванные RTN, значительно уменьшаются
Заключение
В этой статье обсуждается влияние напряжения и температуры на RTN в массиве ячеек FIND RRAM. Наблюдается увеличение RTN, вызванное циклическим стрессом. Наблюдается влияние высокотемпературной обработки на уменьшение RTN и снятие напряжения TMO в FIND RRAM. Наконец, предлагается и демонстрируется схема отжига на кристалле.
Сокращения
- НАЙТИ RRAM:
-
Резистивная диэлектрическая резистивная память на полевых транзисторах Fin
- HRS:
-
Состояние высокого сопротивления
- LER:
-
Шероховатость кромки линии
- LRS:
-
Состояние низкого сопротивления
- RTN:
-
Случайный телеграфный шум
- TMO:
-
Оксид переходного металла
Наноматериалы
- [Объяснение] Что такое отслеживание активов и связанные вопросы
- Контроль доступа с помощью QR, RFID и проверки температуры
- Датчик температуры Python и Raspberry Pi
- Простая температура и влажность на Raspberry Pi
- Сделай сам:мониторинг и регулирование температуры для домашнего пивоварения
- Датчик температуры и освещенности Raspberry Pi
- Материалы:советы по отжигу аморфных полимеров, часть 2
- Измерение температуры внутри композитов и клеевых линий
- Что такое отжиг? - определение, процесс и этапы
- Лабораторный датчик расхода и температуры



