Характеристики восстановления легированных германием вертикальных GaN-диодов с барьером Шоттки
Аннотация
Вертикальные GaN-диоды с барьером Шоттки (SBD) были изготовлены на свободно стоящих подложках GaN, легированных Ge. Кристаллическое качество SBD было охарактеризовано измерением катодолюминесценции, и плотность дислокаций была определена как ~ 1,3 × 10 6 см - 2 . После проведенных измерений электрических характеристик SBD показывают низкое напряжение включения В . на (0,70 ~ 0,78 В) и большой ток I на / Я выкл соотношение (9,9 × 10 7 ~ 1,3 × 10 10 ). Исследованы характеристики обратного восстановления. Время обратного восстановления составило 15,8, 16,2, 18,1, 21,22 и 24,5 нс для SBD диаметром 100, 200, 300, 400 и 500 мкм соответственно. Между тем, время обратного восстановления и заряд обратного восстановления показывают значительную положительную корреляцию с площадью электрода.
Введение
В последнее время широкозонный полупроводник, такой как GaN, с присущими ему преимуществами, привлек огромное внимание исследователей для электронных устройств следующего поколения, особенно в области высоких частот, высокой мощности и высоких характеристик [1,2,3 , 4,5,6]. Между тем, благодаря развитию гидридной парофазной эпитаксии (HVPE), низкая плотность дислокаций (≤ 10 6 см - 2 ) Подложки из GaN в настоящее время коммерчески доступны [7,8,9,10]. По сравнению с боковыми устройствами устройства вертикального типа, изготовленные на этих подложках, считаются более совершенной структурой, которая способствует достижению большего тока, меньшего пути утечки и большей надежности системы [11, 12]. Среди них диод с барьером Шоттки (SBD) на основе GaN является жизненно важным компонентом переключающих устройств. В отличие от биполярного диода, SBD с его униполярной природой значительно снижает эффект накопления неосновных носителей и, соответственно, обеспечивает высокую скорость переключения с низкими потерями при обратном восстановлении. Однако несколько групп провели систематическое исследование характеристик обратного восстановления для вертикальных GaN SBD [13,14,15,16,17], из которых исследования были сосредоточены больше на сравнении времени переключения в устройствах с различными структурами. Таким образом, по-прежнему существует острая необходимость в глубоком исследовании механизма восстановления характеристик GaN SBD, особенно вертикальных.
Между тем, поскольку во многих опубликованных статьях [18] метод омического контакта постоянно исследуется для улучшения характеристик устройства, сильно легированный GaN n-типа является ключевым звеном при изготовлении нитридных устройств. В последнее время Ge предлагается в качестве альтернативы примеси Si в GaN, потому что оба они имеют схожие характеристики примесей на мелких уровнях (энергия активации, как сообщается, составляет 20 и 17 мэВ для Ge и Si соответственно), а также искажение решетки, вызванное за счет замещения атомов Ge в узлы Ga будет меньше из-за их более близких ионных радиусов [19, 20]. Считается, что легирование Ge формирует более гладкую поверхность с меньшим количеством дефектов [21, 22]. Более того, с меньшим искажением решетки и напряжением пленки это легирование также является перспективным для высокотемпературных электронных устройств, в которых больше внимания уделяется термической стабильности. Хотя GaN, легированный Ge, был изучен теоретически, важно исследовать реальное влияние на соответствующее устройство. В данной статье предлагаются новые вертикальные SBD из GaN, изготовленные на свободно стоящей (FS) подложке GaN, легированной Ge. Вертикальные GaN SBD демонстрируют превосходное качество кристаллов и электронные свойства. Между тем, эффективность восстановления вертикальных SBD систематически исследуется. Время обратного восстановления и заряд обратного восстановления, наконец, показывают значительную положительную корреляцию с площадью электрода.
Методы и эксперименты
Схема структурных устройств изготовленных SBD представлена на рис. 1a, который в основном состоит из FS n + с размером частиц 390 мкм. -GaN и 9 мкм n - -GaN дрейфовый слой. В данной работе (0001) -ориентированный слой подложки GaN с концентрацией Ge 1 × 10 18 см - 3 и плотность дислокаций 1 × 10 6 см - 2 был выращен HVPE. И нелегированный эпитаксиальный слой на этой подложке был выращен методом химического осаждения из газовой фазы, со скоростью роста ~ 2 мкм / ч. Для изготовления SBD на тыльной поверхности подложки GaN формировались омические контакты Ti / Al / Ni / Au. Ni / Au электроды Шоттки были сформированы на передней поверхности эпитаксиального слоя пяти различных диаметров (100, 200, 300, 400 и 500 мкм), как показано на рис. 1b. Более подробную информацию о процессе изготовления можно найти в нашем предыдущем отчете [23, 24].
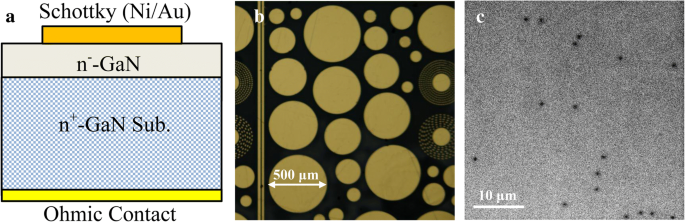
а Схематический разрез изготовленного вертикального SBD. б Оптическая микроскопия изображения различных электродов. c Панхроматическое КЛ изображение эпитаксиального слоя
Изображения катодолюминесценции (КЛ) были получены с использованием сканирующего электронного микроскопа (СЭМ) Quanta 400 FEG с ускоряющим напряжением 10 кВ для изучения пространственного распределения плотности дислокаций для эпитаксиального слоя. Емкость-напряжение ( C-V ) и ток-напряжение ( I-V ) измерения были выполнены с использованием анализатора параметров полупроводников Keithley 4200 для оценки электронных свойств SBD. Температурно-зависимые измерения проводились в диапазоне от 300 до 500 К с индивидуальной экспериментальной установкой.
Результаты и обсуждение
Результат КЛ эпитаксиального слоя представлен на рис. 1в. Поскольку дислокация считается центром безызлучательной рекомбинации, она появляется на КЛ-изображении в виде темного пятна. Поскольку заметной разницы в пространственном распределении не наблюдается, среднее значение плотности дислокаций составило ~ 1,3 × 10 6 . см - 2 , при этом измерения КЛ проводились в нескольких различных регионах. Этот результат указывает на то, что для вертикальных SBD был получен высококачественный эпитаксиальный слой.
Поскольку вертикальные SBD были охарактеризованы в параллельном режиме, C-V и GV кривые получены с частотой 1 МГц. Результаты SBD показаны на рис. 2a и b, соответственно, где ( 1 / C 2 ) от приложенного напряжения В нанесен на врезку. Здесь концентрация носителей N d можно оценить с помощью выражения:\ ({N} _d =\ frac {-2} {A ^ 2 q \ varepsilon \ left [d \ left (1 / {C} ^ 2 \ right) / dV \ right]} \), где A - площадь электродов Шоттки, q - заряд электрона (1,602 × 10 - 19 C) и ε - диэлектрическая проницаемость GaN (8,854 × 10 - 11 Ф / м). Следовательно, N d эпитаксиального слоя составила ~ 6,2 × 10 15 см - 3 . И фазовый угол θ также может быть вычислено по следующему уравнению:\ (\ theta ={\ tan} ^ {- 1} \ left (\ frac {2 \ pi fC} {G} \ right) \), где f - применяемая частота, C - емкость, а G - измеренная проводимость (утечка затвора). Поскольку результаты для разных диаметров аналогичны, рассчитанный угол θ от приложенного напряжения В SBD диаметром 300 мкм показан на вставке рис. 2b в качестве примера. Обратите внимание, что θ очень близка к 90 °, это подтверждает, что в этом исследовании был получен превосходный вентиль Шоттки с малым путем утечки. J-V характеристики также представлены на рис. 2в. Хорошо видно, что I на / Я выкл соотношение составляет 3,8 × 10 9 , 5,9 × 10 8 , 1,3 × 10 10 , 6,5 × 10 8 , и 9,9 × 10 7 для SBD диаметром 100, 200, 300, 400 и 500 мкм соответственно, из которых I на и я выкл определяются как ток при напряжении затвора 1,6 и - 2 В соответственно. После линейной подгонки напряжение включения В на вертикальных SBD составляет 0,70, 0,76, 0,72, 0,70 и 0,78 В, соответственно, при увеличении диаметра электродов от 100 до 500 мкм. Эти результаты показывают, что для вертикальных SBD были получены хорошие электронные характеристики.
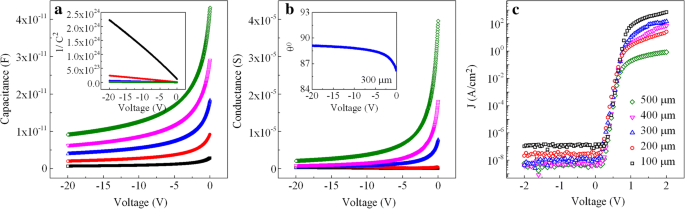
а Комнатная температура C-V кривая вертикальных SBD для каждого отдельного электрода на частоте 1 МГц. На вставке график ( 1 / C 2 ) от напряжения В . б GV кривая вертикальных SBD для каждого отдельного электрода. На вставке график фазового угла θ в зависимости от напряжения В для SBD диаметром 300 мкм. c JV кривая вертикальных SBD для каждого отдельного электрода
Типичная испытательная схема использовалась для измерения характеристик обратного восстановления вертикальных SBD, как показано на рис. 3a. Периодические прямоугольные сигналы напряжения (от +20 до -20 В) последовательно подавались на тестируемое устройство (DUT), где паразитный индуктор накапливал магнитную энергию и влиял на ток. Когда сигнал напряжения изменяется, в течение периода может иметь место колебательный ток. Быстродействующий токовый пробник с осциллографом Tektronix MDO 4104-3 был предназначен для обнаружения переходных изменений тока в вертикальных SBD. Поскольку схематическая форма сигнала тока обратного восстановления показана на рис. 3b, в этом исследовании t а определяется как время хранения, в то время как t б определяется как время задержки обратного тока. И обратное время восстановления T rr определяется как время, когда обратный ток восстанавливается до 10% от максимального обратного тока восстановления I RM , который является суммой t а и t б . И обратный заряд восстановления Q rr получается интегрированием обратного тока до T rr что соответствует накопленному в диоде заряде.

а Испытательная схема, используемая для измерения характеристик обратного восстановления вертикальных SBD. б Схематическое изображение характеристики обратного восстановления вертикальных SBD
На рисунке 4 показана кривая обратного восстановления вертикальных SBD для каждого диаметра электрода при изменении приложенного напряжения с +20 до -20 В. Здесь для SBD диаметром 100, 200, 300 и 500 мкм. , T rr были получены значения 15,8, 16,2, 18,1, 21,22 и 24,5 нс, в то время как Q rr значения были интегрированы и составили 0,0127, 0,0536, 0,150, 0,280 и 0,405 нКл соответственно. Все эти вертикальные устройства показали быстрое время переключения (менее 25 нс). Значительно низкий обратный ток также наблюдается в результатах, что может быть связано с меньшим количеством накопленного заряда в SBD [13]. Между тем также ясно видно, что значение T rr и Q rr оба увеличиваются вместе с увеличением диаметра электродов, и самый маленький показывает самое быстрое T rr 15,8 нс.
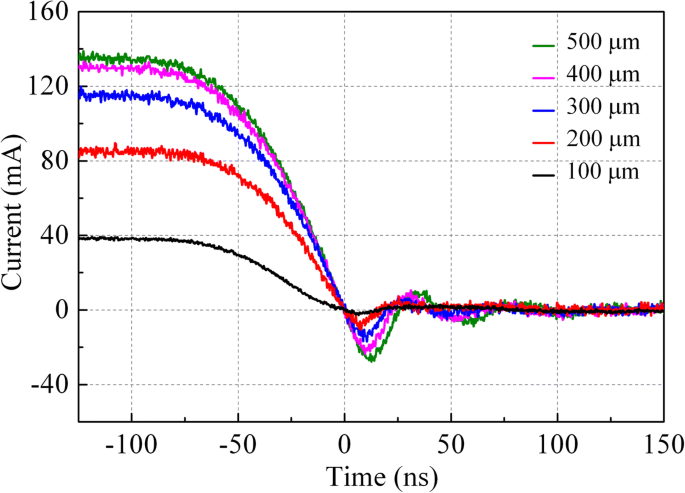
Ток обратного восстановления вертикальных SBD для каждого отдельного электрода
Для дальнейшего изучения механизма, лежащего в основе этих изменений, вертикальные SBD также были измерены при переключении напряжения с +10 на - 10 В. В качестве времени обратного восстановления T rr от диаметра диода d 5 показано значение T rr для каждого диода не было заметно переделано. Заряд обратного восстановления Q rr по сравнению с d отображается на рис. 6 одновременно, где данные двух кривых указывают на одну и ту же тенденцию. Между тем, примечательно, что Q rr обоих тестов показывают значительную положительную корреляцию с d 2 , то есть площадь электродов.
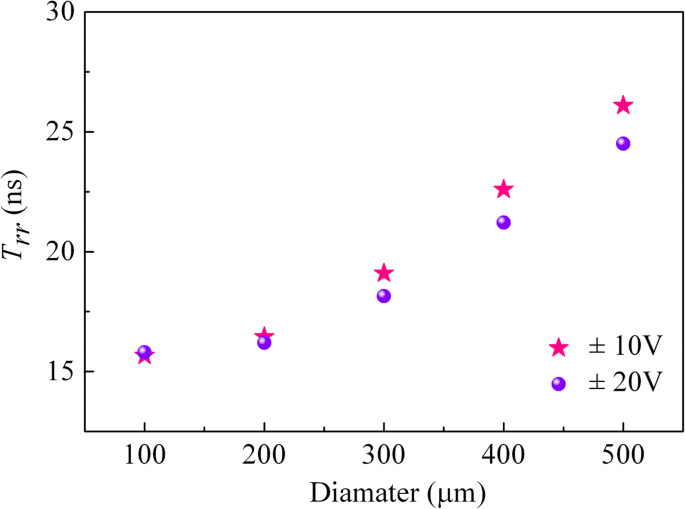
Время обратного восстановления T rr от диаметра электрода d
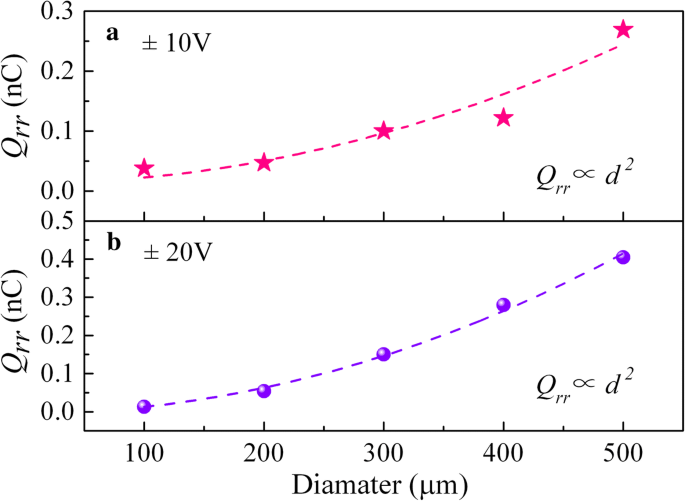
Плата за обратное восстановление Q rr от диаметра электрода d
Фактически, сообщается, что эффект обратного восстановления должен происходить в основном из-за паразитной индуктивности и захвата интерфейса SBD [25, 26]. Учитывая, что вклад паразитной индуктивности характеризуется в виде колебательного тока, который явно не наблюдается на этих кривых обратного восстановления, то изменение времени обратного восстановления и заряда обратного восстановления должно было происходить из-за ловушек [27, 28]. Поскольку концентрация ловушек в вертикальных SBD одинакова, Q rr будет зависеть от площади контакта устройства и, наконец, увеличиваться с площадью электрода, как показано на рис. 6. Таким образом, ловушки действуют как ограничители электрического поля на границе раздела. В течение t а период задержки сильно зависит от захвата носителей в переходе Шоттки, в то время как в t б В течение периода, скорость обратного восстановления также замедляется на время выметания накопленного заряда из перехода. Эти результаты согласуются с нашим предыдущим отчетом [29], в котором предлагалось RC постоянная времени увеличивается с увеличением диаметра устройства и хорошо зависит от времени обратного восстановления. И дальнейшего улучшения характеристик обратного восстановления можно ожидать от меньшего электрода или более тонкого дрейфового слоя в этих устройствах.
Более того, характеристики восстановления вертикальных SBD дополнительно исследуются при более высоких температурах. На рисунке 7 показан ток обратного восстановления для GaN SBD диаметром 500 мкм, измеренный при 300, 400 и 500 K соответственно. При повышении температуры не наблюдается изменения ни времени обратного восстановления, ни заряда обратного восстановления. Эти результаты согласуются с приведенным выше анализом, поскольку концентрация ловушки не очень чувствительна к температуре. Напротив, сообщается, что время обратного восстановления SBD на основе Si увеличится на 191% при повышении температуры с 300 до 425 K [17]. Здесь показано, что с коротким сроком службы носителей и более широкой запрещенной зоной, GaN SBD обеспечивают существенное улучшение способности выдерживать ток, обратного восстановления и потерь энергии. Поскольку термостабильность SBD на основе GaN выше, чем у традиционных узкозонных полупроводников [30], можно сделать вывод, что GaN также является подходящим материалом для коммутационных устройств, применяемых в высокотемпературной среде.
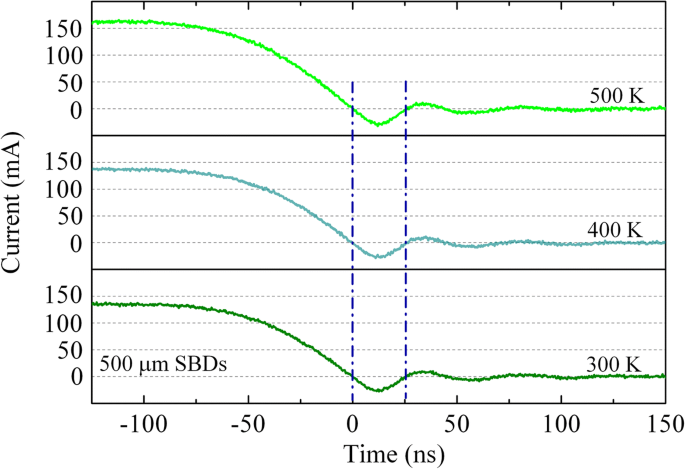
Характеристики обратного восстановления для SBD диаметром 500 мкм, измеренные при 300, 400 и 500 K соответственно
Выводы
Таким образом, мы изготовили вертикальные SBD из GaN на подложках FS GaN, легированных Ge, выращенных методом HVPE. Проведенные измерения характеристик материала и вольт-амперные измерения показывают, что для вертикальных SBD были получены превосходное качество кристалла и электронные свойства. Систематически исследовались характеристики обратного восстановления. Время обратного восстановления составило 15,8, 16,2, 18,1, 21,22 и 24,5 нс для диодов диаметром 100, 200, 300, 400 и 500 мкм соответственно. Между тем, время обратного восстановления и заряд обратного восстановления показывают значительную положительную корреляцию с площадью электрода. Наши результаты могут служить ориентиром для дальнейшего улучшения характеристик восстановления SBD на основе GaN.
Сокращения
- CL:
-
Катодолюминесценция
- C – V :
-
Емкость-напряжение
- DUT:
-
Тестируемое устройство
- FS:
-
Отдельно стоящий
- GaN:
-
Нитрид галлия
- HVPE:
-
Эпитаксия из паровой фазы гидрида
- I-V :
-
Ток-напряжение
- SBD:
-
Диоды с барьером Шоттки
- SEM:
-
Сканирующий электронный микроскоп
Наноматериалы
- Диоды
- Квантовые устройства
- Диоды специального назначения
- Navistar:сверхмощные характеристики
- Технология HDPE с барьером высокой влажности для многослойной гибкой упаковки
- Влияние ультрафиолетового излучения на характеристики 4H-SiC PiN диодов
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Нацеливание на эндотелиальные клетки с помощью многофункциональных наночастиц GaN / Fe
- Видимые световые фотокаталитические характеристики нанокомпозитов ZnO / g-C3N4, легированных азотом
- 3 способа повысить производительность вашего вертикального насоса



