Удобный и эффективный метод нанесения тонкой пленки nc-Si:H с низкой плотностью дефектов от PECVD
Аннотация
Тонкая пленка гидрогенизированного нанокристаллического кремния (nc-Si:H) привлекла большое внимание как многообещающий материал для транзисторов плоских дисплеев, солнечных элементов и т. Д. Однако многофазная структура nc-Si:H приводит ко многим дефектам. Одна из основных задач - как удобно уменьшить количество дефектов. В данной работе мы разработали простой и эффективный метод нанесения тонкой пленки nc-Si:H с низкой плотностью дефектов. Этот метод заключается в простой настройке давления осаждения в диапазоне высокого давления в процессе химического осаждения из паровой фазы (PECVD), усиленного плазмой. Микроструктуры nc-Si:H охарактеризованы методами комбинационного рассеяния света, АСМ и СЭМ. Кроме того, мы сосредоточились на плотности дефектов, которая была ключевой характеристикой фотоэлектрических материалов, и достигли плотности дефектов 3,766 × 10 16 см −3 . Эта плотность дефектов ниже, чем в предыдущих исследованиях изготовления nc-Si:H с низкой плотностью дефектов другими сложными методами в процессе PECVD. Таким образом, время жизни неосновных носителей nc-Si:H значительно увеличивается. Кроме того, мы продемонстрировали механизм влияния давления осаждения на ионную бомбардировку и доказали, что плотность дефектов является ключевой характеристикой фотоэлектрического материала nc-Si:H.
Фон
Важной вехой в развитии технологии тонкопленочного кремния является разработка высококачественного гидрогенизированного нанокристаллического кремния (nc-Si:H). По сравнению с гидрированным аморфным кремнием (a-Si:H), nc-Si:H имеет гораздо более высокую подвижность, гораздо лучший отклик на длинах волн более 800 нм и гораздо менее подвержен деградации по Штаблеру-Вронски [1, 2]. Тонкая пленка nc-Si:H может быть нанесена с использованием плазменного химического осаждения из паровой фазы (PECVD), что делает ее совместимой с хорошо развитой промышленностью интегральных схем. Поэтому тонкая пленка nc-Si:H находит широкое применение в различных устройствах, таких как тонкопленочные транзисторы [3], фотодетекторы [4] и солнечные элементы [5].
Однако как многофазный материал тонкая пленка nc-Si:H имеет свои собственные дефекты, такие как пустоты и оборванные связи на границах раздела кристалл / аморфная фаза и между кристаллами. Известно, что атомарный водород является ключом к осаждению высококачественного nc-Si:H с меньшим количеством дефектов [6]. Атомарный водород может насыщать оборванные связи, и было указано [7], что атомарный водород на растущей поверхности вызывает рост кристаллов при температуре намного ниже температуры плавления. Таким образом, большее количество атомарного водорода выгодно для осаждения высококачественного nc-Si:H. Чтобы увеличить поток атомарного водорода на растущей поверхности, для роста nc-Si:H необходимо большое разбавление водородом или истощение силана.
Истощение силана в PECVD должно повысить мощность радиочастоты (RF) [7]. Но простое увеличение мощности резко увеличит ионную бомбардировку растущей поверхности, что, вероятно, приведет к большему количеству дефектов. Таким образом, для подавления ионной бомбардировки следует использовать смещение постоянного тока (DC). Однако, если мощность ВЧ увеличивается для получения большего количества атомарного водорода, смещение постоянного тока также должно быть изменено. В противном случае смещение постоянного тока не сможет эффективно уменьшить ионную бомбардировку. И подходящее смещение постоянного тока при определенной мощности ВЧ невозможно найти без обширных экспериментов. Другой метод увеличения содержания атомарного водорода - повышение давления осаждения. Частота столкновений электронов с молекулами увеличивается с увеличением давления осаждения. Это делает скорость диссоциации SiH 4 и H 2 поднимается. Диссоциация SiH 4 и H 2 генерирует атомарный водород [8]. В результате повышение давления осаждения может привести к увеличению содержания атомарного водорода.
Таким образом, в этой статье мы предлагаем настроить давление осаждения в диапазоне высоких давлений, чтобы получить больше атомарного водорода (обычное давление осаждения составляет 50–100 Па). Это удобный и эффективный метод в процессе PECVD. При использовании этого метода пленка, осажденная под определенным давлением, имеет более низкую плотность дефектов по сравнению с предыдущими исследованиями по изготовлению nc-Si:H с низкой плотностью дефектов [5, 9, 10]. И был достигнут высокий срок службы неосновных носителей заряда. Кроме того, по сравнению с предыдущими сообщениями о влиянии различных давлений осаждения на макроскопические или общие свойства образцов [11, 12], мы значительно расширили диапазон давления осаждения и сосредоточились на его влиянии не только на общие свойства. (например, кристалличность), но также от плотности дефектов и срока службы неосновных носителей, которые являются ключевыми характеристиками для высококачественного фотоэлектрического материала. Кроме того, мы продемонстрировали механизм влияния давления осаждения на ионную бомбардировку, в то время как в предыдущих отчетах приводились только общие обсуждения. Кроме того, мы доказали, что ионная бомбардировка не тем слабее, тем лучше для роста пленки (степень ионной бомбардировки должна быть соответствующей). В конце концов, мы доказали, что плотность дефектов является ключевой характеристикой фотоэлектрического материала nc-Si:H.
Методы / экспериментальные
Тонкие пленки nc-Si:H были выращены на стекле Corning с помощью емкостной системы PECVD (принципиальная схема реактора показана на рис. 1а) при различном давлении осаждения. Давление осаждения было увеличено со 150 до 1050 Па с шагом 150 Па. Все образцы были нанесены с использованием ВЧ 13,56 МГц и плотности мощности 0,32 Вт / см 2 , с общим количеством газа (SiH 4 и H 2 ) расход 110 куб.см (SiH 4 концентрация составила 0,727%). Температура подложки поддерживалась на уровне 250 ° C, а время осаждения составляло 2 часа.
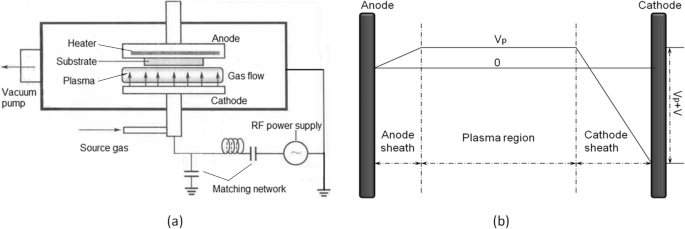
Принципиальная схема а реактор PECVD и b распределение потенциала между электродами ( V p , потенциал плазмы; V , среднеквадратичный потенциал RF)
Кристалличность X c рассчитывали из спектров комбинационного рассеяния, измеренных с помощью УФ-микро-рамановского спектрометра (Jobin Yvon LabRam, HR800) в режиме обратного рассеяния с использованием лазера на ионах Ar на длине волны 514,5 нм. Плотность мощности лазера поддерживалась на уровне 1 мВт / мм 2 . чтобы избежать кристаллизации, вызванной пучком. Плотность дефектов в образцах характеризовалась спиновой плотностью Ns, которую рассчитывали на основе результатов, измеренных спектрометром электронного парамагнитного резонанса (ЭПР) (Bruker, EMX-8X-диапазон) при 9,8 ГГц и 5 мВт. Эффективное время жизни неосновных носителей заряда τ измеряли с помощью Semilab WT-1200A. Морфология поверхности этих пленок наблюдалась с помощью атомно-силового микроскопа (AFM, SII Nanonavi E-Sweep), а микроморфология наблюдалась с помощью сканирующего электронного микроскопа (SEM, Sirion 200).
Результаты и обсуждение
Структурное исследование с помощью рамановского анализа
Для исследования структуры тонкой пленки nc-Si:H, осажденной при различном давлении, были проведены измерения с помощью микро-комбинационного рассеяния света. На рис. 2 были выбраны четыре репрезентативных образца, чтобы показать спектры комбинационного рассеяния. Они откладываются при 300 Па, 450 Па, 750 Па и 1050 Па соответственно. Каждый спектр (белые кружки) под определенным давлением можно деконволюционировать на три гауссовых пика:(1) широкое гауссово распределение около 480 см −1 , который относят к поперечному оптическому (ТО 1 ) мода аморфного кремния; (2) пик около 520 см −1 , принадлежащий асимметричному ТО 2 колебательная мода кристаллического кремния [13, 14]; и (3) пик около 506 см −1 которое относят к промежуточному порядку [1, 15]. Кристалличность ( X c ) в nc-Si:H можно рассчитать по [16, 17]:
$$ {X} _c =\ left ({I} _ {520} + {I} _ {506} \ right) / \ left ({I} _ {520} + {I} _ {506} + \ gamma {I} _ {480} \ right) $$ (1)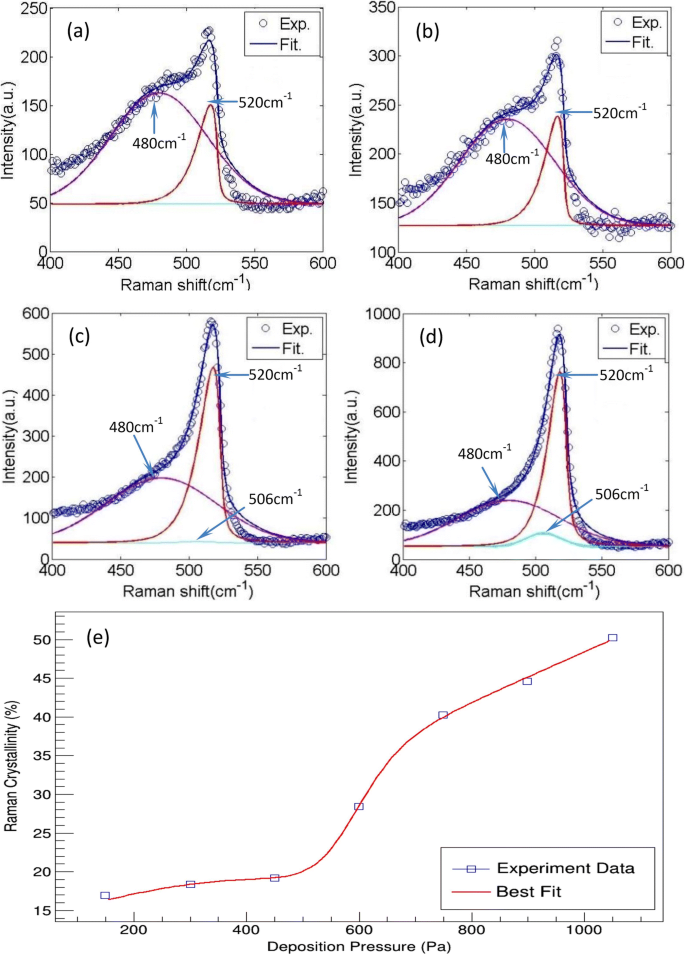
Рамановские спектры и их деконволюция типичных образцов, осажденных под давлением 300 Па ( a ), 450 Па ( b ), 750 Па ( c ) и 1050 Па ( d ) и расчетная кристалличность тонких пленок nc-Si:H, осажденных при различных давлениях ( e )
где γ представляет собой отношение интегрального поперечного сечения комбинационного рассеяния для c-Si к a-Si ( γ =1 [17, 18]) и I 520 , Я 506 , Я 480 представляют собой интегральную интенсивность пиков, наблюдаемых при 520, 506, 480 см −1 , соответственно. Кристалличность как функция различных давлений осаждения показана на рис. 2e.
Известно, что атомарный водород (H), в основном, образуется в результате следующих двух столкновений в разбавленной водородом силановой плазме [8]:
- а.
Первичная электрон-силановая реакция
- б.
Электронно-водородная реакция
Согласно формулам S (1) и S (2) в Дополнительном файле 1, мы можем получить \ ({n} _e =\ frac {P} {RT} \ bullet \ mu \) ( P , давление осаждения; R , постоянная идеального газа; Т , абсолютная температура газа перед разрядом; μ , скорость ионизации; и н e , электронная плотность). μ постоянна из-за неизменной мощности РЧ, и T также является постоянным. Электронная плотность n e таким образом, увеличивается с давлением осаждения P . Согласно химическим уравнениям. Согласно (2) и (3) плотность H, образующегося в плазме, увеличивается с n e . Это теоретический анализ в идеальном состоянии. Процесс разряда настолько сложен, что анализ процесса разряда (т.е. диагностика плазмы) становится самостоятельной дисциплиной. Изменение H с давлением осаждения в реальных условиях следует измерять с помощью диагностики плазмы. Ян и др. измерил интенсивность \ ({H} _ {\ alpha} ^ {\ ast} \) (\ ({I} _ {H _ {\ alpha} ^ {\ ast}} \)) по спектрам оптического излучения (OES) и продемонстрируем, что \ ({I} _ {H _ {\ alpha} ^ {\ ast}} \) сначала увеличивается, а затем уменьшается [19]. Согласно предыдущим отчетам о диагностике плазмы, интенсивность \ ({H} _ {\ alpha} ^ {\ ast} \) указывает на количество атомарного водорода [20, 21]. Таким образом, плотность H в плазме сначала увеличивается, а затем уменьшается, когда давление осаждения продолжает увеличиваться. Эта тенденция немного отличается от нашего теоретического анализа. Разница связана с вторичной реакцией H:
$$ \ mathrm {H} + {\ mathrm {SiH}} _ 4 \ to {\ mathrm {H}} _ 2 + {\ mathrm {SiH}} _ 3 $$ (4)где SiH 4 это тот, который не разложился, т.е. оставшиеся SiH 4 . В нашем эксперименте давление осаждения увеличивается за счет уменьшения выхода газов, включая SiH 4 . Другими словами, это эквивалентно увеличению добавки SiH 4 Когда давление наплавки повышается до определенного уровня, скорость SiH 4 добавка превышает скорость разложения. Таким образом, количество SiH 4 больше левый. Для H существует расстояние от выхода из плазмы до выхода на поверхность, на которой растет пленка. H будет реагировать с оставшимся SiH 4 на этом расстоянии, как показано во вторичной химической формуле. (4). Таким образом, плотность H уменьшается. В результате плотность атомарного водорода сначала увеличивается, а затем уменьшается, когда давление осаждения продолжает увеличиваться. Известно, что большее количество H выгодно для осаждения nc-Si:H с низкой плотностью дефектов. Следовательно, плотность дефектов nc-Si:H, осажденного в нашем эксперименте, демонстрирует ту же тенденцию, что и плотность атомарного водорода, т.е. плотность дефектов сначала уменьшается, а затем увеличивается. Подробное обсуждение тенденции плотности дефектов показано в последнем разделе.
На рис. 2e ясно видно, что кристалличность nc-Si:H, X c , увеличивается с увеличением давления осаждения. Это означает, что увеличение давления может привести к увеличению X c . На кристалличность влияет не только атомарный водород, но и содержание прекурсора роста SiH n ( нет =1,2,3, в основном n =3), который может обозначаться SiH * в измерении ОЭС [21, 22]. Hsieh et al. продемонстрировали, что \ ({I} _ {H _ {\ alpha} ^ {\ ast}} \) / I SiH ∗ (отношение интенсивностей \ ({H} _ {\ alpha} ^ {\ ast} \) / SiH * ) увеличивается с увеличением давления осаждения [20]. Принято считать, что \ ({I} _ {H _ {\ alpha} ^ {\ ast}} \) / I SiH ∗ это индекс для X c , т.е. X c увеличивается с увеличением \ ({I} _ {H _ {\ alpha} ^ {\ ast}} \) / I SiH ∗ [21, 23]. Следовательно, \ ({I} _ {H _ {\ alpha} ^ {\ ast}} \) / I SiH ∗ тенденция решительно поддерживает наш результат о тенденции X c .
Средний размер зерна d также можно вывести из рамановского спектра по формуле [24, 25]:
$$ d =2 \ pi \ sqrt {B / \ Delta \ upnu} $$ (5)где ∆ν - частота в см −1 сдвиг, который определялся как разница между наблюдаемым значением пиковой частоты и значением частоты объемного Si. Используя обычное значение B 2,0 см −1 нм 2 [25], d =4,07 ~ 4,50 нм.
Морфология поверхности и механизм влияния давления осаждения на ионную бомбардировку
Помимо структурного анализа с помощью спектроскопии комбинационного рассеяния света, морфология образцов также была охарактеризована с помощью АСМ, как показано на рис. 3. Для обнаружения эволюции шероховатости поверхности пленки использовали среднеквадратичное значение (RMS) как функцию давления осаждения. изображено на рис. 3h (среднеквадратичное значение было усреднено по нескольким различным местоположениям в каждой пленке). На рис. 3h среднеквадратичное значение уменьшается с увеличением давления осаждения. Повышение давления вызывает обострение столкновения между частицами и последующую потерю кинетической энергии, когда эти частицы достигают поверхности роста пленки. Ионы с более низкой энергией, попадающие на поверхность для роста пленки, приводят к более слабой ионной бомбардировке. Это говорит о том, что повышение давления способствует подавлению ионной бомбардировки, о которой также упоминалось в предыдущем отчете [7]. Однако механизм влияния давления осаждения на ионную бомбардировку не был продемонстрирован. Это будет рассмотрено следующим образом.

АСМ-изображения тонких пленок nc-Si:H, показывающие изменение морфологии поверхности при различных давлениях осаждения. а 150 Па, b 300 Па, c 450 Па, д 600 Па, эл. 750 Па, f 900 Па и г 1050 Па. Кратеры в а и b отмечены пунктирными кружками, а среднеквадратичная (RMS) шероховатость поверхности пленки при различных давлениях осаждения обозначена как h
Распределение потенциала между двумя электродами можно разделить на три области:область плазмы в центре, анодная оболочка и катодная оболочка (см. Рис. 1b). Ионы, которые приводят к ионной бомбардировке, должны диффундировать из области плазмы и проходить через анодную оболочку. Потенциал плазмы выше, чем у любой другой секции реактора, потому что электроны диффундируют быстрее, чем ионы. Поскольку стенка нашего реактора заземлена, потенциал плазмы положительный (см. Рис. 1). Таким образом, анионы захватываются в плазменной области; только нейтральные частицы и катионы могут диффундировать к анодной оболочке и, наконец, достичь поверхности роста пленки. Другими словами, ионная бомбардировка в нашем эксперименте вызывается только катионами. Катионы проходят через анодную оболочку без столкновений, поскольку ширина оболочки очень мала (подробное свидетельство показано в Дополнительном файле 1). В результате катионы ускоряются электрическим полем анодной оболочки только тогда, когда они входят в нее. Следовательно, сила ионной бомбардировки зависит только от начальной скорости катионов, когда они только входят в анодную оболочку ( v 0 ) и степень ускорения электрическим полем анодной оболочки впоследствии.
Во-первых, соотношение v 0 с давлением осаждения будет проанализировано. Частицы, включая катионы, теряют свою кинетическую энергию в области плазмы из-за обостряющегося столкновения при увеличении давления осаждения. Итак, v 0 снижается по мере увеличения давления. Затем будет продемонстрировано изменение степени ускорения электрическим полем оболочки в зависимости от давления осаждения. Известно, что [22]:
$$ {V} _p- {V} _f =\ frac {k {T} _e} {2e} \ left (\ frac {m_i {T} _e} {m_e {T} _i} \ right) $$где м e - масса электрона; м я - масса иона; Т e и T я - температура электрона и иона соответственно; V p - потенциал плазмы; и V f - плавающий потенциал. Поскольку подложка подвешена в нашем реакторе, напряжение анодной оболочки В оболочка равно V p - V f , то имеем:
$$ {V} _ {\ mathrm {sheath}} =\ frac {k {T} _e} {2e} \ left (\ frac {m_i {T} _e} {m_e {T} _i} \ right) $$ (6)В области плазмы T e уменьшается, поскольку увеличение давления осаждения усугубляет столкновение между частицами (включая электроны и ионы). Hsieh et al. продемонстрировали, что T e уменьшается с увеличением давления осаждения по измерениям OES [20]. Это говорит о том, что тенденция T e по нашему теоретическому анализу это абсолютно верно. По сравнению с T e , Т я уменьшается настолько мало, что его можно считать неизменным. В результате V оболочка снижается при увеличении давления в соответствии с Формулой (6). Это снижает степень ускорения анодной оболочки. Вместе с падением v 0 , можно сделать вывод, что кинетическая энергия катионов, достигающих поверхности роста пленки, становится намного меньше при увеличении давления. Другими словами, увеличение давления осаждения ослабляет эффект ионной бомбардировки. Таким образом, RMS поверхности пленки продолжает снижаться от 150 до 1050 Па. Согласно предыдущему отчету, чем ниже энергия ионов, тем лучше кристалличность [7]. Это также подтверждает вывод о корреляции между кристалличностью и давлением осаждения, который мы уже сделали. Более того, поверхности пленки, которые осаждаются при гораздо более низких давлениях (150 Па и 300 Па), более шероховатые, и мы также можем видеть, что эти поверхности содержат множество кратеров, как показано на рис. 4a, b. Это следствие сильной ионной бомбардировки. Согласно рис. 3, можно, по-видимому, сделать вывод, что пленка, осажденная при давлении 450 Па, является наиболее компактной (особенно показанной на рис. 5c и 6d) и однородной.
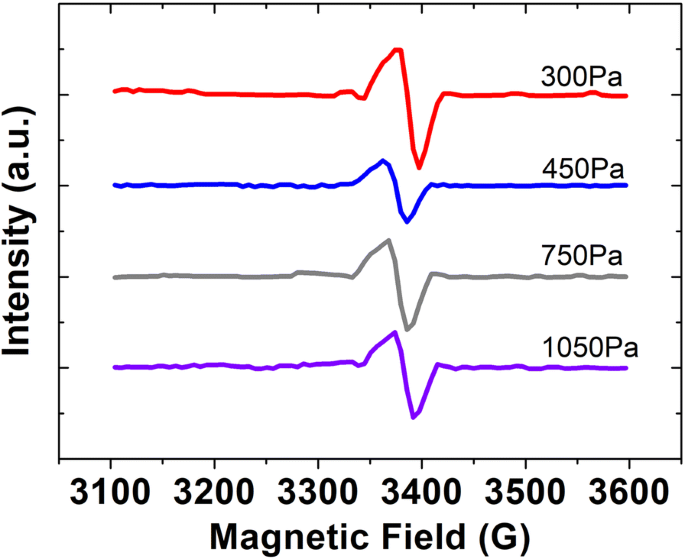
Спектры ЭПР типичных образцов, осажденных при давлении 300 Па, 450 Па, 750 Па, 1050 Па
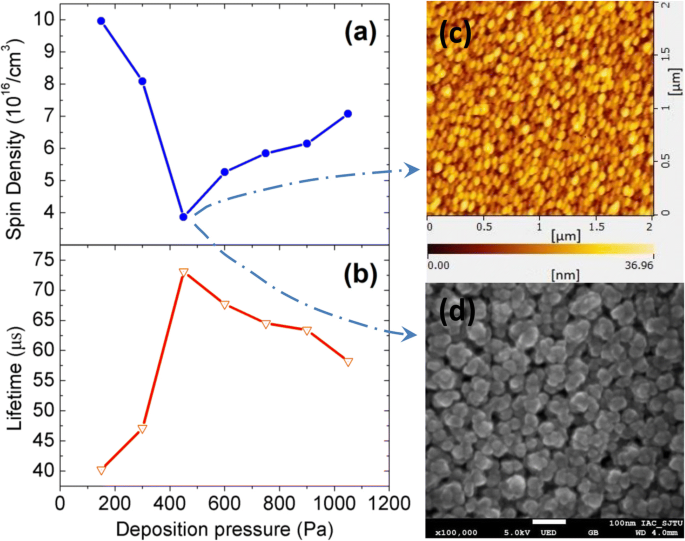
Зависимость спиновой плотности ( a ) и эффективный срок службы неосновных носителей ( b ) при различных давлениях осаждения. Изображение АСМ высокого разрешения ( c ) и изображение SEM ( d ) тонкой пленки nc-Si:H, осажденной под давлением 450 Па

Принципиальная схема диффузии частиц на растущей поверхности
Плотность дефектов и электрические свойства
Влияние давления осаждения на плотность дефектов тонкой пленки nc-Si:H было исследовано методом ЭПР. На рис. 4 показаны четыре спектра ЭПР типичных образцов, осажденных при давлении 300 Па, 450 Па, 750 Па, 1050 Па соответственно. Данные рис. 5а рассчитаны по спектру ЭПР каждого образца. Как показано на фиг. 5а, когда давление увеличивается, сначала уменьшается спиновая плотность, а затем увеличивается. Минимум составляет 450 Па. Согласно принципу ESR, количество неспаренных спинов прямо пропорционально плотности нейтральных оборванных связей. Эти связи в основном находятся на поверхности роста пленки и составляют стационарный дефект на поверхности роста пленки, в то время как плотность дефектов в полученной пленке в основном определяется этими плотностями стационарных дефектов [26]. Следовательно, результаты, рассчитанные по спектрам ЭПР, действительно представляют собой плотность дефектов полученной пленки. Эти результаты на рис. 5a показывают, что плотность дефектов в nc-Si:H достигает минимума при 450 Па, что составляет 3,766 × 10 16 . см −3 . Чоудхури и др. изучал, как изготовить nc-Si:H с низкой плотностью дефектов. Когда они использовали источник ВЧ 13,56 МГц, они сделали все возможное, чтобы добиться низкой плотности дефектов. Значения были 1,1 × 10 17 . и 7,0 × 10 16 см −3 . Когда они использовали источник возбуждения с очень высокой частотой (УКВ) (54,24 МГц), они достигли самой низкой плотности дефектов 4,3 × 10 16 см −3 [10]. Известно, что энергия ионов в плазме УКВ мала, а плотность потока ионов высока. Благодаря этим двум факторам тонкая пленка, осажденная методом VHF-PECVD, имеет низкую плотность дефектов и, следовательно, имеет высокое качество [27]. Однако плотность дефектов выше, чем у нас, а источник возбуждения 54,24 МГц намного дороже своего аналога на 13,56 МГц. Чтобы добиться низкой плотности дефектов, Wen et al. дополнительно приложено смещение постоянного тока. Однако минимум 4,0 × 10 16 см −3 [9]. Найти подходящую ВЧ-мощность непросто, не говоря уже о подходящем смещении постоянного тока. Причина в том, что смещение постоянного тока необходимо настраивать после изменения мощности ВЧ. В противном случае смещение постоянного тока не сможет эффективно уменьшить ионную бомбардировку. Напротив, наш метод прост. Недавно Jadhavar et al. нанесли высококачественный nc-Si:H с помощью PECVD, который имеет низкую плотность дефектов. Плотность дефектов составляет около 8,75 × 10 16 см −3 [5]. Таким образом, наш метод получения тонкой пленки с низкой плотностью дефектов удобен и эффективен. Учитывая, что чем меньше плотность дефектов, тем больше должно быть время жизни неосновных носителей, мы непосредственно провели измерение времени жизни неосновных носителей. Как показано на рис. 5b, эффективное время жизни неосновных носителей достигает максимума при 450 Па. Тенденция времени жизни неосновных носителей заряда синхронизируется с тенденцией плотности дефектов, рассчитанной по спектрам ЭПР. Это показывает, что плотность дефектов пленок может быть абсолютно измерена с помощью ЭПР.
Взаимосвязь ионной бомбардировки и плотности дефектов
Повышение давления может подавить ионную бомбардировку. В некотором смысле плотность дефектов должна непрерывно снижаться от 150 до 1050 Па. Фактически, она уменьшается, а затем увеличивается. Есть еще один фактор, который нельзя игнорировать - диффузия H и SiH 3 (в плазме основным предшественником пленки является SiH 3 [26]). Принципиальная схема диффузии частиц на растущей поверхности представлена на рис. 6. От 150 до 1050 Па кинетическая энергия частиц уменьшается. Эффект ионной бомбардировки все меньше и меньше. Однако кинетическая энергия частиц значительно уменьшается с 450 до 1050 Па из-за увеличения частоты столкновений частиц. Атомарный водород, который является ключом к осаждению высококачественного nc-Si:H, теряет свою кинетическую энергию настолько, что не может диффундировать дальше для насыщения более оборванных связей, не говоря уже о том, что его плотность начинает уменьшаться, что показано на рисунке «Структурное исследование с помощью рамановского анализа». С другой стороны, частицы, включая атомарный водород, резко теряют свою кинетическую энергию, поэтому они не могут передавать больше энергии растущей поверхности. Таким образом, диффузионная длина SiH 3 предшественник не может быть улучшен. Известно, что если SiH 3 поглощенный на поверхности может найти энергетически выгодные места роста, образуется атомно более упорядоченная структура. Но теперь SiH 3 не имеет достаточной длины распространения, чтобы найти свои энергетически благоприятные места для роста. Следовательно, упорядоченная структура не может быть сформирована. Другими словами, в наплавленной пленке больше дефектов. В результате спиновая плотность на рис. 5а, наоборот, начинает расти с 450 Па. Однако стоит отметить, что спиновые плотности от 600 до 1050 Па все же ниже, чем от 150 до 300 Па. Это результат более слабой ионной бомбардировки. Кроме того, в результате уменьшенной диффузионной длины SiH 3 прекурсор имеет тенденцию накапливаться с образованием агрегатов. Как показано на рис. 3, агрегаты начали появляться при 750 Па, и они постепенно интенсивно агломерировались, когда давление осаждения продолжало увеличиваться. Согласно вышеизложенному, ионная бомбардировка не тем слабее, тем лучше для роста пленки. Степень ионной бомбардировки должна быть соответствующей.
Плотность дефектов:ключевая характеристика фотоэлектрического материала nc-Si:H
Кристалличность и плотность дефектов являются характеристиками материалов солнечных элементов nc-Si:H. Первое увеличивается с увеличением давления осаждения. В некотором смысле, последнее должно продолжать снижаться. Однако это не так. Согласно характеристикам комбинационного рассеяния, хотя кристалличность увеличивается, изменение размера зерна очень мало (4,07 ~ 4,50 нм). Это указывает на то, что увеличивается только количество зерен, а не размер зерен. В этих условиях объем границ зерен увеличивается. Известно, что границы зерен являются объемными дефектами и центрами рекомбинации. Большее количество границ зерен увеличит плотность дефектов. Когда кристалличность повышается до определенного уровня, отрицательное влияние увеличения объема границ зерен на плотность дефектов преодолевает положительный эффект увеличения числа зерен. Следовательно, плотность дефектов не уменьшается с ростом кристалличности; напротив, она повышается после того, как кристалличность достигает определенного уровня. Этот результат предполагает, что тонкие пленки nc-Si:H с более высокой степенью кристалличности не обязательно имеют лучшее качество, что подтверждается другой исследовательской группой. В последние годы сообщалось, что оптимальный слой nc-Si:H для солнечных элементов получается вблизи границы фазового перехода, т. Е. Оптимум достигается сразу после перехода от a-Si:H к nc-Si:H переход. Кристалличность оптимальных слоев nc-Si:H невысока [28,29,30]. Mukhopadhyay et al. дополнительно продемонстрировали, что слои nc-Si:H с высокой степенью кристалличности и, следовательно, с низкой световой деградацией не позволяют производить высококачественные солнечные элементы. Стабилизированная эффективность ячеек, осажденных сразу после перехода из a-Si:H-в-nc-Si:H, выше, чем у ячеек, в которых i-слой имеет высокую кристалличность, хотя первый деградирует больше, чем второй перед стабилизацией. [31]. Han et al. дополнительно доказали, что индуцированная светом деградация слоя nc-Si:H происходит за счет образования метастабильных оборванных связей. В то время как структурные изменения, вызванные светом, являются предвестником образования метастабильных оборванных связей [30]. Метастабильная оборванная связь является одним из дефектов [32]. Следовательно, ключевой характеристикой высококачественных фотоэлектрических материалов nc-Si:H является плотность дефектов, а не кристалличность, светостойкость или другие характеристики.
Выводы
Тонкие пленки nc-Si:H осаждались путем изменения давления от 150 до 1050 Па. Диапазон давления осаждения выше, чем при обычном осаждении в процессе PECVD. Установлено, что кристалличность увеличивается, а шероховатость поверхности пленки уменьшается с увеличением давления осаждения. Средний размер зерна d =4,07 ~ 4,50 нм. Кроме того, мы сосредоточили внимание на влиянии давления осаждения не только на макроскопические или обычные свойства образцов, но также на плотность дефектов и время жизни неосновных носителей, которые являются более важными характеристиками. Обнаружено, что плотность дефектов образцов сначала уменьшается, а затем увеличивается при повышении давления осаждения. Плотность дефектов достигает минимума (3,766 × 10 16 см −3 ) при 450 Па. Это ниже, чем в предыдущих исследованиях по созданию тонких пленок nc-Si:H с низкой плотностью дефектов. Эта работа обеспечивает удобный и эффективный способ осаждения nc-Si:H с низкой плотностью дефектов с помощью PECVD. И мы продемонстрировали механизм влияния давления осаждения на ионную бомбардировку. Более того, доказано, что ионная бомбардировка не тем слабее, тем лучше для роста пленки. Степень ионной бомбардировки должна быть соответствующей.
Сокращения
- AFM:
-
Атомно-силовой микроскоп
- DC:
-
Постоянный ток
- H:
-
Атомарный водород
- NC-Si:H:
-
Гидрированный нанокристаллический кремний
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- SEM:
-
Сканирующая электронная микроскопия
- VHF:
-
Очень высокая частота
Наноматериалы
- Текущий метод и анализ сетки
- Абстрактный класс и метод С#
- Частичный класс C# и частичный метод
- Запечатанный класс и метод С#
- Противотуманная пленка для ПК для козырьков, линз и очков
- Java String replace(), replaceAll() и replaceFirst()
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Эффективный и действенный дизайн нанопроволок InP для максимального сбора солнечной энергии
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Служба Rapid Tooling и ее эффективное применение



