Обзор полупроводникового диода Шоттки со сверхширокой запрещенной зоной на основе Ga2O3 для применения в силовой электронике
Аннотация
Оксид галлия (Ga 2 О 3 ) представляет собой новый полупроводниковый материал, который обладает преимуществом сверхширокой запрещенной зоны, высокого электрического поля пробоя и большой добротности Балиги (BFOM), поэтому он является многообещающим кандидатом для мощных устройств следующего поколения, включая диод с барьером Шоттки (SBD). ). В этой статье основные физические свойства Ga 2 О 3 полупроводники. И недавние исследования Ga 2 О 3 SBD на основе. Между тем, были обобщены и сопоставлены различные методы улучшения характеристик, включая напряжение пробоя и сопротивление в открытом состоянии. Наконец, перспектива Ga 2 О 3 на основе SBD для применения в силовой электронике.
Фон
С быстрым развитием электроэнергетики, промышленного управления, автомобильной электроники и бытовой электроники существует огромный спрос на высокопроизводительные силовые полупроводниковые устройства. Полупроводниковые материалы с широкой и сверхширокой запрещенной зоной могут удовлетворить это требование [1, 2]. Среди пяти структур Ga 2 О 3 монокристалл, моноклинный β -Ga 2 О 3 является наиболее стабильным и имеет сверхширокую запрещенную зону ( E g ~ 4.8 эВ) и очень сильное электрическое поле пробоя ( E br ~ 8 МВ см −1 ) по сравнению с традиционным Si, а затем разработанным материалом SiC и GaN. Следовательно, β -Ga 2 О 3 показывает очень большую добродетель Балиги (BFOM =\ (\ varepsilon \ mu {E} _ {\ mathrm {b}} ^ 3 \); ε - относительная диэлектрическая проницаемость, а μ - подвижность электронов). BFOM - важный критерий оценки пригодности материала для применения в силовых устройствах [3,4,5,6,7,8,9,10,11]. В таблице 1 сравниваются основные физические свойства Si, широкой запрещенной зоны (GaN, SiC) и сверхширокой запрещенной зоны ( β -Ga 2 О 3 ) полупроводниковый материал. Кроме того, для выращивания монокристалла β -Ga 2 О 3 подложки, существуют простые, недорогие и производимые в массовом масштабе методы выращивания из расплава при атмосферном давлении, такие как плавающая зона (FZ) [12, 13] и рост по краям с пленочной подачей (EFG) [14,15 , 16,17]. Это еще одно превосходство Ga 2 О 3 в аспекте качественного роста монокристаллов по сравнению с SiC и GaN. Следовательно, β -Ga 2 О 3 является многообещающим кандидатом для мощных полупроводниковых устройств следующего поколения, таких как диод с барьером Шоттки (SBD) [18,19,20,21,22,23,24] и полевой транзистор металл-оксид-полупроводник (MOSFET) [ 25,26,27,28,29]. Стоит отметить, что большое количество исследований Ga 2 О 3 рост материала, изготовление и определение характеристик силовых устройств были выполнены в течение последних нескольких лет, поэтому в этой статье мы рассмотрели свойства материала сверхширокой запрещенной зоны Ga 2 О 3 полупроводник и исследования Ga 2 О 3 SBD на основе силовой электроники. В SBD наиболее важными параметрами производительности являются напряжение пробоя ( В br ) и сопротивление во включенном состоянии ( R на ), поэтому путем обобщения и сравнения различных методов улучшения V br и R на выступления, мы желаем, чтобы наша работа по анализу была полезна для разработки Ga 2 О 3 на базе силовых устройств.
Физические свойства полупроводника из оксида галлия
Оксид галлия (Ga 2 О 3 ) представляет собой новый оксидно-полупроводниковый материал, но он имеет долгую историю исследований. Исследование фазовых равновесий в Al 2 О 3 -Ga 2 О 3 -H 2 Система O восходит к 1952 году, и R. Roy et al. определили существование полиморфов Ga 2 О 3 и их отношения стабильности [30]. В 1965 г. H. H. Tippins et al. исследовали оптическое поглощение и фотопроводимость на краю полосы β -Ga 2 О 3 и подтвердил его ширину запрещенной зоны 4,7 эВ [6]. В 1990-х годах был разработан ряд методов увеличения плавления Ga 2 О 3 объемный монокристалл и эпитаксиальный рост Ga 2 О 3 фильм был проявлен. За последние 5 лет благодаря своим особым свойствам и успешному выращиванию качественной и крупногабаритной монокристаллической подложки Ga 2 О 3 материал вызвал большой исследовательский интерес.
К настоящему времени люди обнаружили пять кристаллических фаз Ga 2 О 3 , т.е. α , β , γ , δ , и ε фазы. Отношения трансформации между этими пятью фазами показаны на рис. 1 [30]. Моноклинная фаза β- Ga 2 О 3 имеет лучшую термическую стабильность, в то время как другие четыре фазы являются метастабильными и склонны превращаться в β- Ga 2 О 3 при высоких температурах. Поэтому в настоящее время большинство исследований сосредоточено на β- Ga 2 О 3 . Некоторые недавние исследования также показали, что другие фазы обладают некоторыми особыми свойствами материала, которые β фазы не было. Например, α- Ga 2 О 3 имеет кристаллическую структуру корунда, аналогичную структуре сапфира (Al 2 О 3 ), поэтому сравнительно легко эпитаксиально выращивать высококачественные α- Ga 2 О 3 монокристаллическая пленка на существующем в настоящее время Al 2 О 3 монокристаллическая подложка. Гексагональная фаза ε- Ga 2 О 3 является второй стабильной фазой и представляет собой сильный эффект спонтанной поляризации, который способствует формированию двумерного электронного газа высокой плотности на границе гетероперехода [31], как и в случае перехода AlGaN / GaN. В последние годы благодаря успешному росту крупногабаритных β- Ga 2 О 3 монокристаллическая подложка и ее лучшая стабильность, до сих пор, исследования по β- Ga 2 О 3 намного больше, чем на других четырех этапах. Итак, в этой статье мы в основном рассматриваем исследования по β- Ga 2 О 3 .
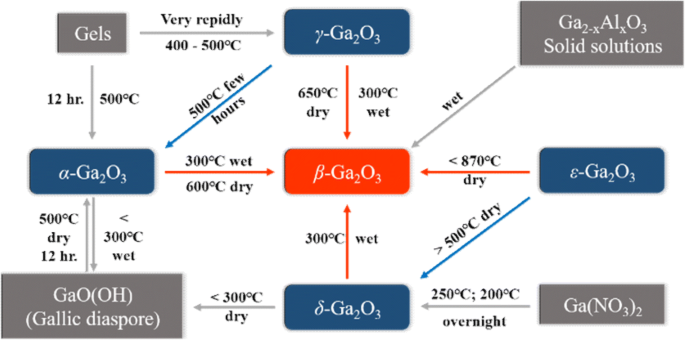
Отношения трансформации между кристаллическими фазами Ga2O3 и их гидратами [30]
β- Ga 2 О 3 относится к моноклинной системе и термически устойчив. Его постоянные решетки равны a =1,22 нм, b =0,30 нм и c =0,58 нм, как показано на рис. 2. Кристаллическая структура β- Ga 2 О 3 определяет, что он имеет определенную проводимость, но ограниченную его сверхширокой запрещенной зоной (4,7–4,9 эВ), самой широкой из всех известных прозрачных полупроводниковых материалов. Только если в запрещенной зоне существуют некоторые дефектные уровни энергии и генерируются свободные электроны, материал имеет сравнительно высокую проводимость. Для большинства полупроводников с широкой запрещенной зоной проводимость формируется именно из-за наличия дефектных уровней в запрещенной зоне, таких как полупроводник ZnO [32]. Собственная электрическая проводимость β- Ga 2 О 3 происходит от свободных электронов, ведомых точечными дефектами, образовавшимися в объеме кристалла. Большинство исследований показали, что кислородные вакансии являются ключевыми дефектами для электропроводности [33,34,35].

Структура решетки β-Ga 2 О 3 кристалл. Печатается по исх. [5]
Интересно, что из-за наличия большого количества кислородных вакансий в поликристаллических β- Ga 2 О 3 , легко поглотить какой-то газ, чтобы изменить удельное сопротивление, поэтому было много сообщений об использовании β- Ga 2 О 3 изготовить газовые сенсоры для обнаружения H 2 , Канал 4 , CO и O 2 [36,37,38,39]. Кроме того, поскольку постоянная решетки β- Ga 2 О 3 в направлении [100] намного больше, чем в направлениях [001] и [010], ультратонкую пленку легко отслаивать вдоль направления [100] для изготовления устройства [27, 40, 41, 42, 43]. В то же время, благодаря этой характеристике кристаллической структуры, при изготовлении β- Ga 2 О 3 пластины, разрезая основную часть по направлению [100], могут получить плоскую поверхность с очень низкой шероховатостью.
По сравнению с SiC и GaN, β- Ga 2 О 3 обладает особыми электрическими характеристиками, среди которых наиболее заметна сверхширокая запрещенная зона (4,7–4,9 эВ). Это обеспечивает очень высокое критическое электрическое поле пробоя ( E br ≈8 МВ / см), что примерно вдвое больше, чем у SiC и GaN. Электрическое поле пробоя материала - очень важный параметр для униполярных силовых устройств. Если у материала выше E br в материале единичной толщины может поддерживаться более высокое электрическое поле, что является преимуществом для уменьшения размера устройства и повышения уровня интеграции силовых модулей. На рисунке 3 показаны основные пределы сопротивления в открытом состоянии ( R на ) как функция напряжения пробоя ( В br ) для нескольких важных полупроводников, включая Si, GaAs, SiC, GaN, Ga 2 О 3 , и алмаз [5]. Из этого рисунка видно, что потери проводимости Ga 2 О 3 устройств на порядок ниже, чем у устройств SiC и GaN при том же V br . Таким образом, Ga 2 О 3 показывает свой большой потенциал в униполярных устройствах. Поскольку подвижность электронов насыщения β- Ga 2 О 3 сравнительно невысокий (~ 200 см 2 V - 1 s - 1 ), β- Ga 2 О 3 не подходит для высокочастотных устройств по сравнению с GaN. Однако его широкая запрещенная зона может компенсировать этот недостаток, поскольку более тонкий дрейфовый слой имеет меньшую ширину истощения; таким образом, паразитная емкость может быть уменьшена для удовлетворения требований высокочастотных приложений. Кроме того, ширина запрещенной зоны около 4,8 эВ делает Ga 2 О 3 обладают специальной полосой поглощения волны (250–280 нм), которая находится как раз в диапазоне солнечных слепых ультрафиолетовых (УФ) лучей, поэтому Ga 2 О 3 является естественным хорошим материалом для изготовления УФ-детекторов [44,45,46,47].
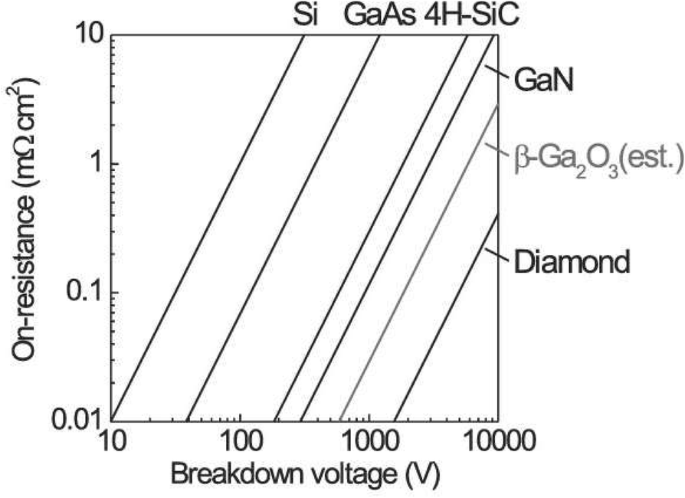
Теоретические пределы сопротивления во включенном состоянии ( R на ) как функция напряжения пробоя ( В br ) для β-Ga 2 О 3 и типичные полупроводники. Печатается по исх. [26]
В последние годы легирование n-типа β- Ga 2 О 3 в основном реализовано. Элементы Si и Sn как его донорные примеси с мелким энергетическим уровнем имеют низкую энергию активации. Концентрация допинга может быть хорошо отрегулирована до 10 15 . –10 19 см −3 [47] с максимальным значением 10 20 см −3 достиг. В то же время с изменением концентрации легирования изменятся и оптические и электрические свойства. Например, удельное сопротивление n-типа β- Ga 2 О 3 изменяется в диапазоне 10 −3 - 10 12 Ом см с изменяющейся концентрацией легирования [48, 49]. Ширина запрещенной зоны также изменяется при разной концентрации легирования, поэтому характеристики поглощения света Ga 2 О 3 находятся под влиянием [50].
Из разработки Ga 2 О 3 , этот материал по-прежнему имеет следующие недостатки. (1) Легирование P-типа - большая проблема для Ga 2 . О 3 материал. Поскольку акцепторные уровни далеки от валентной зоны β- Ga 2 О 3 , энергия активации акцепторных примесей очень высока. Между тем фоновые примеси n-типа в Ga 2 О 3 кристалл также будет производить эффект самокомпенсации акцепторных примесей, что приводит к самоизоляции материала. Следовательно, до сих пор не было эффективных действий p-типа. (2) Теплопроводность Ga 2 О 3 слишком низко. Экспериментальные и теоретические исследования доказали, что теплопроводность β- Ga 2 О 3 всего 0,1–0,3 Вт / см −1 К -1 [51,52,53]. Это неблагоприятно для силового устройства, используемого в условиях высокого напряжения и тока. Чрезмерное накопление тепла серьезно скажется на работоспособности и надежности устройства. (3) Низкая мобильность оператора связи. Теоретическая подвижность Ga 2 О 3 ограничивается примерно 200 см 2 / V s из-за влияния рассеяния [54]. Малая подвижность отрицательно сказывается на частотных и токовых характеристиках.
Основная концепция диода с барьером Шоттки
Контакт Шоттки, омический контакт и распределение электрического поля являются ключевыми факторами в SBD для достижения высоких характеристик, включая сопротивление в открытом состоянии ( R на ) и напряжения пробоя ( В br ), поэтому различные методы их улучшения особенно важны.
Согласно концепции барьера Шоттки, высота барьера связана с работой выхода металла Шоттки и сродством к электрону полупроводника. Работа выхода различных металлов периодически изменяется, и металл должен иметь большую работу выхода, чем полупроводник, чтобы сформировать барьер Шоттки. Никель (Ni) и платина (Pt) - обычные металлы Шоттки для β- Ga 2 О 3 , а их высота барьера определяется различными методами [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 , 75,76,77]. Область обеднения под поверхностью полупроводника должна иметь необходимую толщину, чтобы предотвратить туннелирование носителей, а это требует ограниченной концентрации легирования полупроводника. Обычные значения концентрации легирования 10 16 –10 17 см −3 в β- Ga 2 О 3 подложка или слой эпитаксии [56,57,58,59,60,61,62]. Высота барьера фактически зависит от состояний интерфейса и отличается от простой связи с работой выхода. Предварительная обработка поверхности направлена на уменьшение интерфейсных состояний, включая приповерхностные кислородные вакансии и оборванные связи [78].
Омический контакт является основным связующим звеном между металлом и полупроводником. Низкое удельное сопротивление омического контакта помогает устройствам уменьшить контактное сопротивление ( R s ) и сопротивление во включенном состоянии ( R на ). Традиционные методы достижения низкого контактного сопротивления - это выбор металла с низкой работой выхода и сильного легирования. Фактически работа выхода контактного металла всегда не влияет на формирование омического контакта из-за закрепления интерфейсных состояний. Сильное легирование полупроводника становится основным методом омического контакта. Основные цели - повышение концентрации носителей и снижение межфазного барьера. RTA (быстрый термический отжиг) улучшает межфазные характеристики и способствует снижению контактного сопротивления. Y. Yao et al. испытал девять металлов в качестве омических контактных металлов на β- Ga 2 О 3 и обнаружили, что титан (Ti) и индий (In) демонстрируют хорошее омическое поведение в определенных условиях [79]. После отжига при высоких температурах только титан может сохранять непрерывную морфологию. Подобно этому, в большинстве исследований титан применялся в качестве металла омического контакта с β- Ga 2 О 3 и получили хорошие характеристики устройства [60,61,62,63,64,65,66,67,68,69,70].
Поведение пробоя связано с распределением электрического поля внутри устройств, а цилиндрический переход и сферический переход имеют большее электрическое поле, чем переход в параллельной плоскости в тех же условиях [1]. Следовательно, необходимы некоторые методы защиты концевых заделок, такие как полевая пластина для повышения напряжения пробоя [19, 23, 68]. Состояния интерфейса, называемые интерфейсными зарядами, обычно воздействуют на электрическое поле вблизи поверхности полупроводника и вызывают преждевременный пробой. Ток утечки является индикатором поведения пробоя и обычно зависит от внутренних дефектов полупроводника, включая дислокации. Обе ситуации вызывают нестабильность устройств и могут снизить напряжение пробоя, чего следует избегать. Обычной практикой для уменьшения влияния состояний интерфейса является пассивация поверхности, и для увеличения напряжения пробоя также требуется высококачественная подложка.
Диод с барьером Шоттки на основе β- Ga 2 О 3
Трудности с выращиванием высококачественных и недорогих монокристаллических подложек повлияли на коммерциализацию устройств SiC и GaN. Пока Ga 2 О 3 монокристаллические подложки могут быть выращены методом малозатратной плавки, силовые устройства на основе Ga 2 О 3 Монокристалл привлекает большое внимание в последние годы. В настоящее время технология легирования n-типа Ga 2 О 3 достаточно зрелый, но отсутствие легирования p-типа делает Ga 2 О 3 не может применяться в биполярных устройствах. Сверхбольшая запрещенная зона дает большое преимущество при использовании униполярных устройств. Поэтому разработка Ga 2 О 3 В силовых устройствах преобладают два типа униполярных устройств:диод с барьером Шоттки (SBD) и полевой транзистор металл-оксид-полупроводник (MOSFET) [23, 55, 56].
С развитием технологии полупроводниковых материалов с широкой запрещенной зоной (WBG) устройство SBD на основе полупроводника WBG начинает заменять диод с p-n-переходом для применения в силовой электронной системе, поскольку в SBD отсутствует эффект накопления неосновных носителей, а его потери при переключении довольно низки. Теоретически, по сравнению с SiC и GaN SBD, Ga 2 О 3 SBD может достичь того же напряжения пробоя с гораздо более тонким дрейфовым слоем. В то же время более тонкий дрейфовый слой снижает паразитную емкость, сокращая время обратного восстановления устройства. Основной прогресс в разработке Ga 2 О 3 SBD показан на рис. 4. С развитием технологии эпитаксии структура SBD превратилась из первоначальной простой структуры на основе подложки в подложку и сложную структуру на основе эпитаксиальной пленки. Впоследствии, благодаря постепенному исследованию процессов изготовления устройств, появились усовершенствованные конструкции терминалов, включая полую плиту и траншею, что еще больше повысило характеристики устройства. Ga 2 О 3 SBD начинает раскрывать свой потенциал в приложениях силовой электроники.
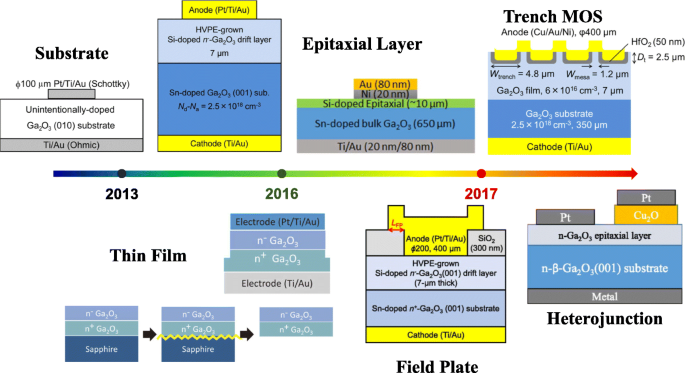
Разработка Ga 2 О 3 SBD в последние годы [16, 18, 62, 68–71]
В качестве нового полупроводникового материала с широкой запрещенной зоной люди столкнулись с множеством основных проблем на начальной стадии разработки Ga 2 О 3 , так что прогресс разработки Ga 2 О 3 SBD очень хорошо отражает эволюцию силы SBD. Самая важная часть SBD - это соединение Шоттки, поэтому в ранних исследованиях Ga 2 О 3 SBD, существует значительное количество исследований, посвященных изучению перехода Шоттки, в основном включая контакт между Ga 2 О 3 и различные электроды Шоттки (Ni 、 Cu 、 Au 、 Pt 、 TiN) [57,58,59], механизм переноса электронов в переходе Шоттки, проблемы интерфейсных состояний, неоднородность барьера и сила изображения, существующая в контакте Шоттки, и методы достижения идеального омического контакта на границе раздела катода [60, 61].
По мере того, как физические свойства становятся все более очевидными, а технологические процессы все более совершенствуются, характеристики устройства постоянно улучшаются. Ниже приведены некоторые типичные работы при разработке Ga 2 О 3 SBD.
В 2013 г. К. Сасаки и соавт. в Tamura Corporation изготовили SBD на основе высококачественного (010) β –Ga 2 О 3 монокристаллическая подложка, выращенная методом плавающих зон [62]. Они исследовали влияние различной концентрации легирования в подложке на характеристики устройства и обнаружили, что более высокая концентрация легирования вызывает меньшее сопротивление в открытом состоянии, но меньшее напряжение обратного пробоя и больший ток обратной утечки. На рисунке 5 показаны характеристики обратного пробоя двух SBD, изготовленных с использованием (010) β –Ga 2 О 3 подложки с разной концентрацией легирования. Напряжение пробоя достигает 150 В. Фактор идеальности обоих устройств близок к 1. А высота барьера Шоттки Pt / β –Ga 2 О 3 граница раздела оценивается в 1,3–1,5 эВ.
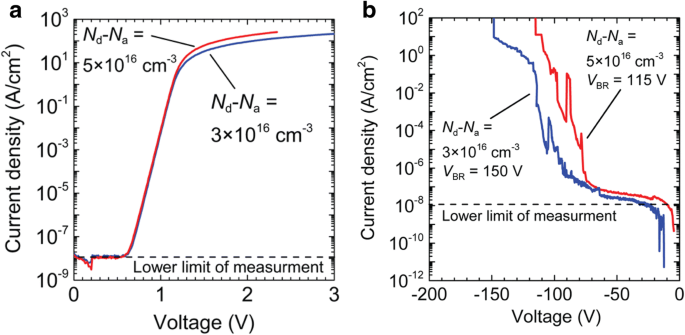
а , b Прямые и обратные электрические характеристики SBD на основе (010) β -Ga 2 О 3 подложки с разной концентрацией легирования. Нижний предел измерения плотности тока 10 -8 А / см 2 . Печатается по исх. [62]
Исследователи из Института микроэлектроники Китайской академии наук (IMECAS) и Шаньдунского университета совместно исследовали SBD на основе (100) -ориентированного β –Ga 2 О 3 насыпной субстрат. В 2017 году они сообщили о Pt / β –Ga 2 О 3 SBD и его электрические характеристики, зависящие от температуры. Анализ дифракции рентгеновских лучей (XRD) и просвечивающей электронной микроскопии высокого разрешения (HRTEM) показал, что β –Ga 2 О 3 Объемный монокристалл, выращенный методом выращивания с заданной кромкой с подачей пленки (EFG), имел хорошую ориентацию (100) и хорошее качество кристаллов (рис. 6a, b). Благодаря измерениям ВАХ и моделированию термоэлектронной эмиссии изготовленная Pt / β –Ga 2 О 3 Устройство SBD показало хорошие характеристики, включая коэффициент выпрямления 10 10 , коэффициент идеальности ( n ) 1,1, высота барьера Шоттки ( Φ B ) 1,39 эВ, пороговое напряжение ( В би ) 1,07 В, сопротивление в открытом состоянии ( R на ) 12,5 мОм см 2 , плотность прямого тока при 2 В ( Дж @ 2V ) 56 А / см 2 , и эффективная концентрация доноров ( N d - N а ) 2,3 × 10 14 см −3 (Рис. 6в, г). В устройстве также были обнаружены хорошие температурно-зависимые характеристики (рис. 6e, f). При повышении температуры R на и Дж @ 2V стало лучше, демонстрируя, что устройство хорошо работает при высоких температурах. В своей следующей работе они дополнительно исследовали температурную зависимость фактора идеальности и высоты барьера Шоттки и обнаружили, что такого рода температурные характеристики могут быть объяснены гауссовым распределением неоднородности высоты барьера [61]. В 2018 году они дополнительно оптимизировали параметры роста кристаллов и улучшили концентрацию легирования Sn ( N d - N а =2,3 × 10 14 см −3 ). Новый Pt / β –Ga 2 О 3 Устройство SBD демонстрирует заметно улучшенные характеристики, включая плотность прямого тока ( Дж @ 2V =421 А / см 2 ), Сопротивление в открытом состоянии ( R на =2,9 мОм см 2 ), короткое время обратного восстановления (20 нс) и напряжение обратного пробоя более 200 В [63]. Их работа показывает, что EFG выращивают β –Ga 2 О 3 Монокристалл перспективен для применения в силовых устройствах.

а Кривая дифракции рентгеновских лучей (XRD) для (100) β -Ga 2 О 3 монокристаллическая подложка, на которой четко видны пики плоскостей (400), (600) и (800). б Изображение Pt / β в поперечном сечении с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM) -Ga 2 О 3 Контакт Шоттки и микрофотография с быстрым преобразованием Фурье (БПФ) β -Ga 2 О 3 кристалл. c Прямая и обратная J – V-кривая Pt / β -Ga 2 О 3 SBD и схема SBD (врезка). г Прямая J – V-кривая на линейном и полулогарифмическом графике. е Температурно-зависимые кривые J – V и график Ричардсона (вставка). е Зависимость сопротивления включения и плотности прямого тока от температуры. Печатается по исх. [60]
Q. Feng et al. из Xidian University изучили процессы подготовки импульсного лазерного осаждения (PLD) и основные физические свойства легированных алюминием β –Ga 2 О 3 фильм [64,65,66]. Допинг Al может настроить запрещенную зону β –Ga 2 О 3 за счет включения различных соотношений атомов Al. На основе этой пленки, легированной алюминием, Ni / β - (AlGa) 2 О 3 Изготовлено и охарактеризовано устройство SBD. Высота барьера Шоттки составляет 1,33 эВ. Текущее соотношение включения и выключения и сопротивление в открытом состоянии достигают 10 11 . и 2,1 мОм см 2 соответственно [65]. Они также изучили влияние температуры на коэффициент идеальности и высоту барьера Шоттки, а также пришли к выводу, что эти характеристики температурной зависимости n и Φ B были отнесены к неоднородностям барьера Шоттки в предположении существования гауссова распределения высоты барьера [66].
С развитием технологии пленочной эпитаксии, парофазная эпитаксия галогенидов (HVPE) была использована для выращивания Ga 2 О 3 фильм. Благодаря преимуществам высокой скорости эпитаксии и высокого качества пленки, Ga 2 , выращенный HVPE О 3 очень подходит для изготовления дрейфового слоя высоковольтного SBD. В 2015 г. M. Higashiwaki et al. в Национальном институте информационных и коммуникационных технологий (NICT) выросли легированные легированные частицы толщиной 7 мкм (~ 1 × 10 16 см −3 ) эпитаксиальный слой на сильно легированном ( N d - N а =2,5 × 10 18 см −3 ) (001) β- Ga 2 О 3 субстрат методом HVPE и дополнительно изготовленное устройство SBD. Исследованы ВАХ и ВАХ прибора при различных температурах. Отмечена тенденция изменения высоты барьера Шоттки, порогового напряжения, ВАХ и ВАХ с температурой. На рис. 7 показана конструкция устройства, а также прямые и обратные кривые J – V – T [16]. Было обнаружено, что при 21–200 ° C высота барьера остается практически постоянной. Прямой и обратный ток хорошо согласуются с моделями термоэлектронной эмиссии (TE) и термоэлектронной полевой эмиссии (TFE) соответственно. Их результаты продемонстрировали потенциал применения Ga 2 О 3 SBD в силовых устройствах нового поколения.
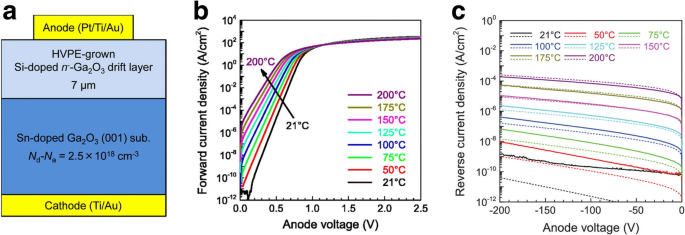
а Структура SBD-устройства на основе выращенного HVPE n толщиной 7 мкм - - Ga 2 О 3 гомоэпитаксиальный дрейфовый слой на n + - Ga 2 О 3 монокристаллическая подложка. б Прямые ВАХ прибора, измеренные при 21–200 ° C. c Обратный J – V при 21–200 ° C (сплошные и пунктирные линии представляют экспериментальные и смоделированные результаты соответственно). Печатается по исх. [16]
В 2016 г. M. Oda et al. в FLOSFIA Inc. опубликовали работу о α -Ga 2 О 3 SBD [18]. Посредством технологии химического осаждения из паровой фазы (CVD), то есть MIST EPITAXY®, они последовательно росли сильно (3–4 мкм) и слегка легированными α -Ga 2 О 3 пленки на сапфире (Al 2 О 3 ) подложки. После снятия α -Ga 2 О 3 слои подложек, катода и анода были нанесены на нижнюю и верхнюю поверхность n - - Ga 2 О 3 / n + - Ga 2 О 3 слоев соответственно (рис. 8). Устройство с n - толщиной 2580 нм - Ga 2 О 3 слой показал высокое напряжение пробоя 855 В и сопротивление в открытом состоянии 0,4 мОм см 2 . Пока аппарат с более тонким (430 нм) н - - Ga 2 О 3 слойные SBD показали очень низкое сопротивление в открытом состоянии 0,1 мОм · см 2 и напряжение пробоя 531 В. В 2018 году они также сообщили об этом виде устройства, выполненном с корпусом TO220 [67]. Была получена емкость перехода 130 пФ, поэтому устройство показало лучшую характеристику обратного восстановления по сравнению с SiC SBD и Si SBD. В то же время после упаковки устройство показало тепловое сопротивление 13,9 ° C / Вт, сравнимое с сопротивлением SiC SBD с тем же корпусом (12,5 ° C / Вт), демонстрируя, что использование тонкого дрейфового слоя может эффективно компенсировать недостаток - плохая теплопроводность Ga 2 О 3 материал. В этом отчете авторы также отметили, что α - (Rh, Ga) 2 О 3 может действовать как эффективный канальный слой p-типа α -Ga 2 О 3 устройств.

Процессы изготовления α -Ga 2 О 3 SBD, предложенный FLOSFIA Inc. Перепечатано из исх. [18, 67]
В 2017 г. К. Кониши и соавт. в NICT сообщили о Pt / HVPE-n - - Ga 2 О 3 / (001) n + - Ga 2 О 3 Устройство SBD с напряжением пробоя 1076 В и сопротивлением в открытом состоянии 5,1 мОм см 2 (Рис. 9) [68]. Технология полевых пластин (FP), разновидность технологии заделки кромок, была впервые использована в Ga 2 О 3 SBD. Добавив анод, связанный SiO 2 FP, максимальное электрическое поле во всей структуре устройства поддерживалось ниже критического поля, особенно электрическое поле вокруг анода, очевидно, может быть уменьшено. Используя этот метод, можно достичь как высокого напряжения пробоя, так и низкого сопротивления в открытом состоянии. В том же году J. Yang и др. Сообщили о более высоком пробивном напряжении (1600 В). из Университета Флориды в их устройстве SBD с Ni / MOCVD-n - - Ga 2 О 3 / (- 201) п + - Ga 2 О 3 [69], но сопротивление в открытом состоянии очень велико (25 мОм см 2 ). Ограничение по краю не использовалось. Их исследование показало, что размер электрода Шоттки влияет на напряжение пробоя и сопротивление в открытом состоянии, поскольку электрод большего размера будет иметь больше дефектов и приведет к более легкому пробою.
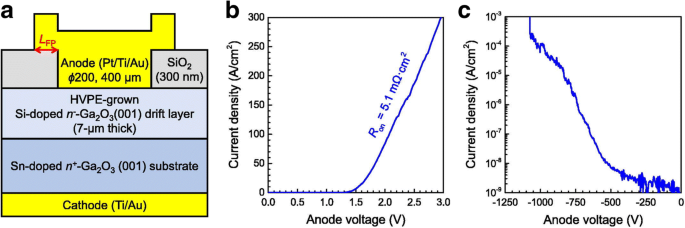
а Конструкция SBD с полевой пластиной. б , c Прямые и обратные электрические характеристики ( V br =1076 В). Печатается по исх. [68]
In 2017, K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 О 3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 О 3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 О 3 SBD exhibited superiority in switching loss.
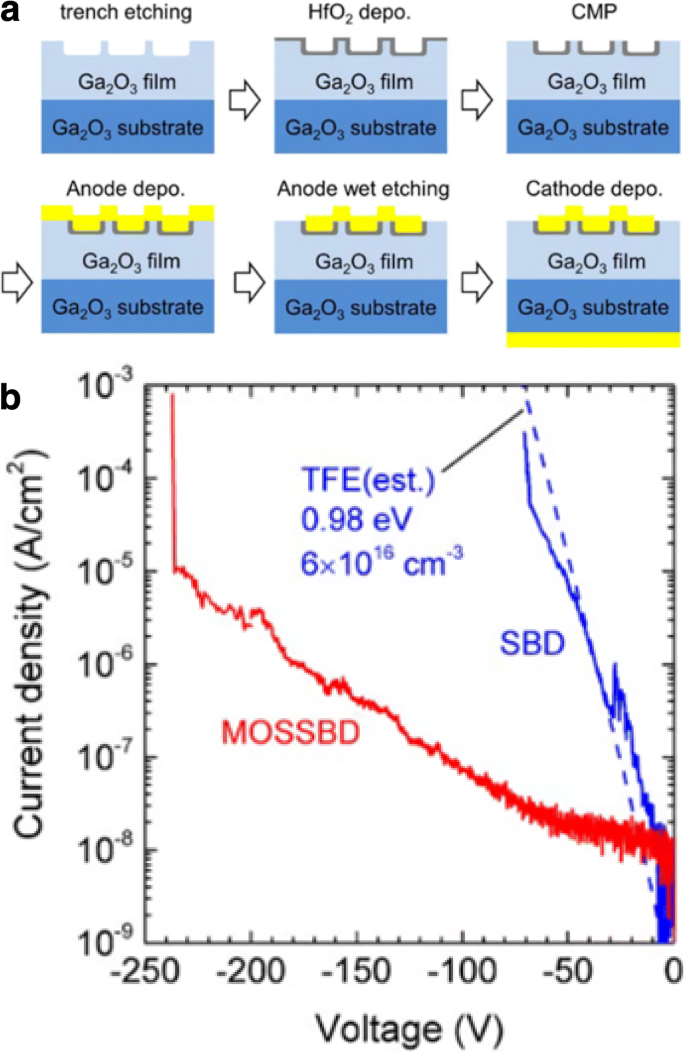
а Fabrication processes of the MOS-type Ga2 О 3 SBD with trench termination structure. б Comparison of the reverse characteristics of the Ga2 О 3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 О 3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 О 3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 О 3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 О 3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 О 3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 О 3 device before the successful preparation of p-type Ga2 О 3 .
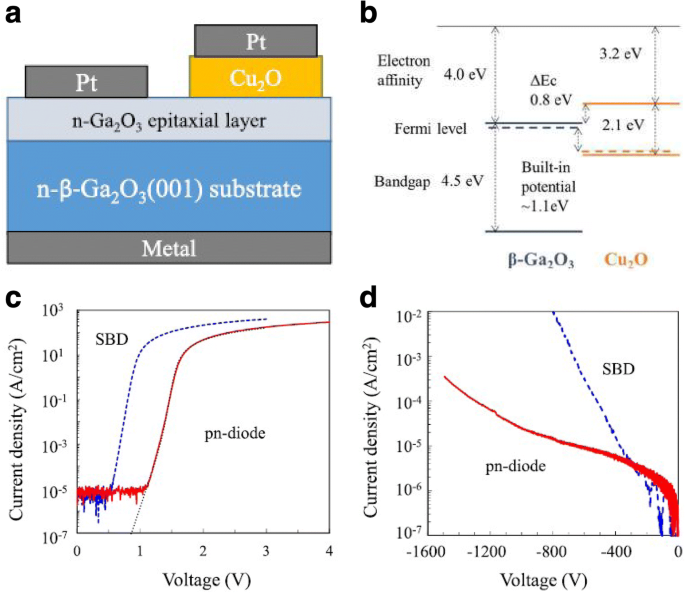
а Schematic of the cross-sectional Pt/Ga2 О 3 SBD and p-Cu2 O/n-Ga2 О 3 diode. б Band diagram of the p-Cu2 O/n-Ga2 О 3 интерфейс. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 О 3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 О 3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 О 3 SBD single device.

а Rectification circuit. б - е Rectifying effect of Pt/Ga2 О 3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 О 3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Выводы
Currently, Ga2 О 3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 О 3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 О 3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 О 3 will better display its unique application value, which requires the joint efforts of the researchers.
Сокращения
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- CVD:
-
Химическое осаждение из паровой фазы
- EFG:
-
Edge-defined film-fed growth
- БПФ:
-
Быстрое преобразование Фурье
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
Metal-organic chemical vapor deposition
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
Импульсное лазерное напыление
- SBD:
-
Schottky barrier diode
- TE:
-
Thermionic emission
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Выбор красок-растворителей наилучшего качества для идеального нанесения
- 10 факторов для поиска идеального переключателя для вашего приложения
- Использование мощи умных городов для светлого будущего
- В области электроники Индия стремится стать «мировой фабрикой»
- Поиск запасного генератора:4 жизненно важных вопроса
- Лучшие варианты изготовления корпусов для электроники
- Краткий обзор перспектив рынка кранов на ближайшие годы
- Выбор правильного генератора электроэнергии для вашего бизнеса
- Правильный электродный материал для сварки сопротивлением
- Как правильно выбрать фильтр для вашего приложения



