Исследование сплавов GaAs1-xBix с атомным разрешением EDX, HAADF и EELS
Аннотация
Распределение легированных атомов в полупроводниках часто отклоняется от случайного распределения, что может существенно повлиять на свойства материалов. В этом исследовании методы сканирующей просвечивающей электронной микроскопии используются для анализа распределения Bi в нескольких отчетливо выращенных методом МПЭ GaAs 1 − x Би x сплавы. Статистическая количественная оценка изображений HAADF с атомным разрешением, а также численное моделирование используются для интерпретации контраста от Bi-содержащих столбцов на атомно-резкой границе раздела (001) GaAs-GaAsBi и начала упорядочения типа CuPt. Используя монохроматическое отображение EELS, исследуются объемные красные смещения энергии плазмонов в образце, демонстрирующем разделенные по фазе домены. Это предлагает простой метод исследования локального расширения объема элементарной ячейки GaAsBi и дополнение стандартных измерений деформации решетки с помощью рентгеновских лучей. Кроме того, одновариантный образец GaAsBi с упорядоченным CuPt, выращенный на обрезной подложке, характеризуется составными отображениями EDX атомного масштаба и оценен параметр порядка. Наконец, сплав GaAsBi с вертикальной модуляцией состава Bi синтезируется с использованием низкой скорости вращения подложки. Атомно-разрешенная EDX- и HAADF-визуализация показывает, что обычное упорядочение типа CuPt дополнительно модулируется вдоль оси роста [001] с периодом, равным трем постоянным решетки. Эти отдельные образцы GaAsBi иллюстрируют разнообразие распределений Bi, которые могут быть достигнуты в этом сплаве, проливая свет на механизмы включения атомов Bi и способы дальнейшей разработки Bi-содержащих полупроводников AIIIBV.
Введение
Бисмид GaAs 1 − x Би x Сплав прошел обширные исследования и представляет собой формирующийся класс висмутсодержащих полупроводников III – V групп [1]. Висмут - самый крупный стабильный и нетоксичный элемент, который при введении приводит к значительному уменьшению ширины запрещенной зоны GaAs. Замена Bi в подрешетке группы V позволяет достичь изгиба запрещенной зоны до 90 мэВ / Bi% в GaAsBi с умеренной деформацией решетки [1,2,3]. Большое расщепление спин-орбитальных зон - еще один заметный эффект включения Bi в решетку. Это может позволить подавить межвалентную полосу поглощения и оже-мейтнеровскую рекомбинацию в GaAs 1 − x Би x с концентрациями x > 10% [4]. В сочетании с пониженной чувствительностью запрещенной зоны эти свойства делают бисмид привлекательным кандидатом для применения в длинноволновых инфракрасных лазерах, фотодетекторах и многопереходных солнечных элементах, среди прочего [1, 5,6,7].
Включение Bi в матрицу GaAs требует нетрадиционных условий роста, поскольку атомы Bi имеют тенденцию десорбироваться при типичных температурах роста GaAs [8,9,10]. Обычно требуются температуры основания ниже 400 ° C, а также почти стехиометрические соотношения групп III / V. Необходимо соблюдать осторожность, чтобы избежать образования поверхностных капель Ga или Bi, которые могут легко возникнуть вблизи этих условий и связаны с неоднородностями толщины растущего слоя и его состава [11,12,13,14]. Низкие температуры, необходимые для включения больших концентраций Bi, делают молекулярно-лучевую эпитаксию (МБЭ) предпочтительным методом синтеза, хотя прогресс был достигнут с использованием парофазной эпитаксии из металлорганических соединений [15,16,17]. Сплавы GaAsBi все еще демонстрируют удивительно высокую интенсивность фотолюминесценции (ФЛ) для этих низких температур роста, что объясняется эффектом поверхностно-активного вещества Bi и пониженной плотностью связанных с As точечных дефектов, которые обычно образуются в низкотемпературном GaAs [18,19]. В картине антипересечения валентной зоны (VB) внедренные отдельные атомы Bi создают резонансное состояние ниже протяженной VB GaAs, вызывая уменьшение оптической ширины запрещенной зоны [2, 20, 21]. Расчеты из первых принципов также показывают, что кластеры, состоящие из соседних взаимодействующих атомов Bi, могут приводить к значительному сужению запрещенной зоны, чем изолированные атомы Bi [22]. Эти различные конфигурации Bi создают сильные возмущения VB и могут вводить локализованные электронные дефектные состояния. Исследования показывают, что деформация решетки, создаваемая крупными атомами Bi, будет вызывать более высокую вероятность связывания кластеров с вакансиями V Ga и V As [23]. Условия роста, богатые As, должны способствовать образованию Bi Ga гетеро-антиструктурные дефекты, которые, по прогнозам, вызывают ловушки с глубокими дырками в GaAsBi [23, 24]. Ярко выраженные эффекты локализации экситонов обычно наблюдаются при температурно-зависимой ФЛ сплавов GaAsBi и связаны с такими связанными с Bi кластерами и комплексами дефектов [25, 26].
Как и многие другие тройные полупроводниковые сплавы AIIIBV, GaAsBi проявляет тенденцию к спонтанному упорядочению [27]. Так называемый CuPt B Упорядочение по типу, при котором концентрация атомов Bi модулируется на каждой второй плоскости {111} B-типа, наблюдалось с помощью просвечивающей электронной микроскопии высокого разрешения (STEM / TEM) [13, 17, 28]. Широко признано, что CuPt B Модуляция -типа в сплавах AIIIBV обусловлена динамикой реконструкции поверхности и сопровождается реконструкцией (2 × 1), состоящей из рядов поверхностных димеров [27, 29,30,31,32,33]. При осаждении на плоские подложки (001) GaAs упорядочение происходит на двух из четырех различных наборов плоскостей {111}. Единственный подвариант упорядочения B-типа может быть дополнительно выбран с использованием вицинальных субстратов. Действительно, недавняя работа показала, что это применимо и к GaAsBi, в результате чего большие CuPt B -типа были получены на единственном наборе плоскостей {111} B с использованием малоугловых пластин с обрезками [34]. Порядок типа CuPt в GaInP 2 является, вероятно, наиболее изученным, поскольку в этом сплаве можно получить кристаллы высокого качества с большим параметром порядка. Дальний порядок изменяет симметрию точечной группы цинковой обманки с тетраэдрической T d в тригональный C 3v [35, 36] . Заметные эффекты из-за снижения симметрии включают сужение запрещенной зоны, поляризацию фотолюминесценции, двойное лучепреломление и анизотропную деформацию [37,38,39]. Величина этих эффектов зависит от параметра дальнего порядка η , который показывает степень распределения элементов по упорядоченным плоскостям решетки. В CuPt B -упорядоченный AB 1 − x С x сплав (для x <=0.5) решетка чередуется в B, богатом элементами AB 1− ( x − η / 2) С x − η / 2 и C-богатые AB 1- ( x + η / 2) С x + η / 2 монослои вдоль направления <111> B. Параметр порядка η =0 в случайном сплаве, а в полностью упорядоченном с концентрацией x таким образом, η =2 x .
Ясно, что распределение Bi в таких упорядоченных сплавах отличается от случайного сплава, и это следует учитывать при дальнейшем выводе свойств сплава [17, 40]. Понимание эффектов упорядочения CuPt в разбавленных сплавах GaAsBi все еще находится на начальной стадии и требует более систематических исследований. В этой статье передовые методы STEM с коррекцией аберраций используются для анализа режимов распределения Bi в нескольких отчетливо выращенных сплавах GaAsBi. Анализ выполняется с использованием статистической обработки изображений Z-контраста STEM и моделирования изображений, а также рентгеновской энергодисперсионной спектроскопии с атомарным разрешением (EDX). Монохроматическая электронная спектроскопия потери энергии (EELS) используется для исследования локальных изменений объема элементарной ячейки в GaAsBi с использованием объемных сдвигов энергии плазмонов.
Результаты и обсуждение
Первый GaAs 1 − x Би x Представленный здесь образец S1 представляет собой p-i-n-гетеродиод с легированными слоями GaAs и собственным бисмидом 420 нм. Концентрация висмута в образце составила 4,5% Bi с использованием дифракции рентгеновских лучей (здесь не показана) и PL при комнатной температуре, что указывает на ширину запрещенной зоны 1,10 эВ (SI рис. S1). Измерения границ полосы ФЛ переводятся в Bi% с использованием ссылок [1, 2, 4]. Изображение HAADF STEM с атомным разрешением в поперечном сечении вдоль оси зоны [110] вблизи границы раздела GaAs-GaAsBi показано на рис. 1а. Ось роста [001] и другие соответствующие кристаллографические направления отмечены на фиг. 1b и также применимы к фиг. 1a. Поскольку тяжелые атомы Bi рассеивают зондирующие электроны на большие углы намного сильнее, чем атомы Ga или As, детектор HAADF с большим внутренним углом сбора (здесь 90 мрад) выгодно подчеркивает распределение Bi в тонких образцах. Кристалл, рассматриваемый в направлении <110>, выглядит как набор атомных «гантелей», которые ориентированы параллельно оси роста [001]. Из-за их близких атомных номеров (Z) Ga (31) и As (33) не могут быть легко различимы простым просмотром изображений HAADF. Однако столбцы группы V, содержащие Bi, показывают заметно более высокий контраст. Как видно на рис. 1а и в увеличенной области рядом с границей раздела, столбцы группы V расположены в верхней половине гантелей над столбцами Ga. Это ожидается при визуализации GaAsBi вдоль оси зоны [110]. Обратите внимание, что полярность гантелей групп V / III меняется на противоположную, когда образец рассматривается в ортогональном направлении [\ (\ overline {1} \) 10]. Эти ортогональные направления в плоскости также можно различить, поскольку упорядочение типа CuPt происходит на плоскостях типа {111} B и, таким образом, его можно увидеть только при построении изображения вдоль оси зоны [110]. На рис. 1b показано изображение HAADF с меньшим увеличением, глубже в пленке, с ярко выраженным CuPt B . -тип заказа. Упорядоченные области чередуются случайным образом между двумя наборами плоскостей {111} B, то есть (\ (\ overline {1} \) 11) и (1 \ (\ overline {1} \) 1). Их называют B + . и B - подварианты условно. Преобразование Фурье изображения показано на вставке слева вверху. Четыре основных пятна Брэгга относятся к типу [111] *, а четыре пятна сверхрешетки типа 1/2 [111] * указывают на CuPt B упорядочение с одинаковой величиной на двух наборах плоскостей {111} B. Фазово-разделенная область GaAsBi видна на рис. 1b в виде более темной полосы в нижней части изображения. Этот домен кажется более темным, чем висмид, поскольку он подобен Bi с дефицитом GaAs. Из-за метастабильности сплавов GaAsBi спинодальный распад и разделение фаз описаны во многих статьях [11,12,13,14, 41, 42]. Для более четкого изображения B + и B - субвариантное упорядочение, рис. 1c, d представлены путем формирования изображений с использованием пар отражений сверхрешетки 1/2 [111] *. Маска применяется к каждой паре сверхрешеток в обратном пространстве, и обратное преобразование Фурье обратно в реальное пространство. Более яркие области плоскостей (111) на этих изображениях указывают на более выраженное упорядочение или, другими словами, на то, что параметр порядка изменяется локально. Также возможны вариации толщины поверхности образца ПЭМ из-за подготовки образца сфокусированным ионным пучком. При приготовлении образца на поверхности могут оставаться аморфные поверхностные слои и расплавленные атомные агломераты Ga, что может вызвать слабую модуляцию интенсивности изображения. Однако Ga рассеивается в большие углы намного слабее, чем атомы Bi, и не должен существенно влиять на анализ распределения Bi. Стрелкой на рис. 1г показана область с упорядочивающимися противофазными границами. Через такую границу B + (B - ) изменяет свою фазу, переводя все плоскости с высоким содержанием Bi в плоскости с высоким содержанием As. Упорядоченные противофазные границы могут образовываться за счет скольжения дислокаций или случайного чередования B + и B - домены во время роста [43]. Последнее, похоже, имеет место здесь.
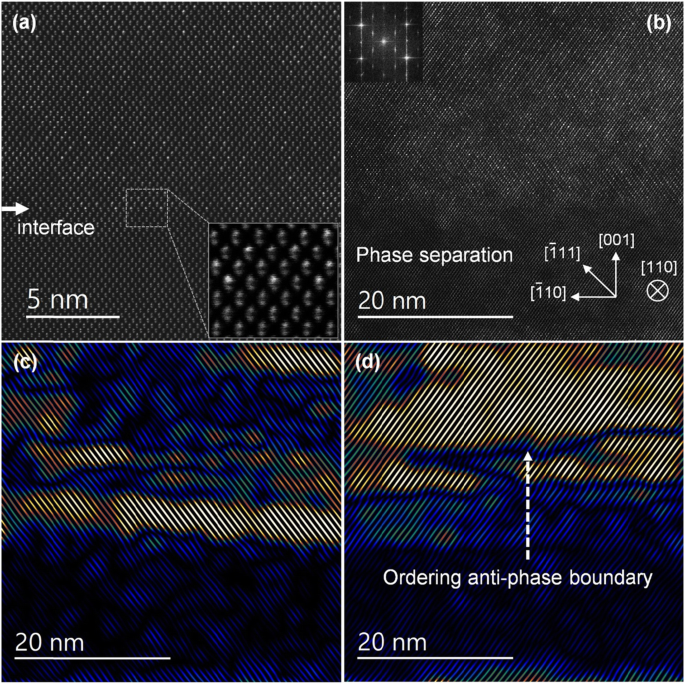
а Изображение поперечного сечения HAADF области интерфейса GaAs-GaAsBi образца S1. Увеличенная вставка интерфейса показана в правом нижнем углу. Кристаллографические направления такие же, как на рис. 1б. б Изображение образца HAADF вдали от интерфейса. В центре виден удлиненный GaAs-подобный домен со спонтанным разделением фаз. На вставке показано преобразование Фурье изображения. c Изображение, сформированное из ( b ) с использованием пары 1/2 [\ (\ overline {1} \) 11] * сверхрешеточных отражений. Более яркие цвета указывают на более выраженный порядок. г Изображение, сформированное из ( b ) с использованием пары ½ [1 \ (\ overline {1} \) 1] * отражений
Количественная оценка изображения HAADF, показанного на рис. 1а, проводится следующим образом с учетом пространственного распределения поперечных сечений рассеяния атомных столбцов (SCS) (см. Методы). Алгоритм StatSTEM используется для подгонки столбцов с двумерными гауссианами, а SCS данного столбца определяется как объем по этому гауссиану [44, 45]. Это количественная оценка на основе параметрической модели, в отличие от прямого интегрирования интенсивности столбцов в экспериментальном изображении. Подход параметрической модели может быть более надежным, если интенсивности столбцов имеют тенденцию перекрываться, например, в <110> GaAsBi. Распределение SCS на количественно определенном рис. 1a представлено в виде гистограммы на рис. 2b, которая предварительно соответствует пяти гауссианам. Затем на рис. 2а строятся пространственные распределения SCS на модельной структуре, состоящей из суперпозиции гауссиан, с использованием одинаковых квадратов цветовой схемы, размещенных в каждом столбце. Столбцы SCS Ga и As сильно перекрываются и дают основной пик на гистограмме. Это связано с похожими Z-числами этих атомов, а также с дополнительным экспериментально введенным уширением (см. Методы). Построение нижнего гауссова компонента (темно-синий цвет) или верхнего (светло-синий) в этом основном пике показывает, что ~ 60%, например, столбцов As в буферном слое GaAs идентифицированы правильно, что можно проверить по полярности гантели. . Для сравнения, количественная оценка SCS только нижнего буферного слоя GaAs представлена на дополнительном рисунке S2. Это предполагает, что в настоящее время необходимо более двух гауссиан, чтобы лучше различать столбцы Ga и As в поле зрения, и указывает, что их среднее значение SCS отличается на целых 10%. Это различие согласуется с нашим моделированием, показанным ниже, а также с результатами, полученными Beyer et al. [17], где были разрешены интегральные распределения интенсивности колонок Ga и As в [010] GaAsBi. Наличие сильно рассеивающих атомов Bi увеличивает SCS до значений выше ~ 5.5 × 10 5 e - Å 2 (см. SI Рис. S2), что дает начало правому плечу на Рис. 2b. Он снабжен тремя гауссианами для предварительного выделения столбцов с более высоким содержанием Bi. Атомарно резкая граница раздела GaAs-GaAsBi видна на рис. 2а. При более внимательном рассмотрении видно, что первый слой столбцов группы V (001), содержащий значительное количество атомов Bi, расположен на каждой второй гантели вдоль границы раздела. Это указывает на начало упорядочения типа CuPt на ранней стадии эпитаксиального роста. Изображение атомной конфигурации интерфейса показано на вставке к рис. 2b. Он воссоздает расположение атомов вдоль границы раздела с атомами Bi (оранжевый) в каждом втором столбце вдоль плоскости первой группы-V (001). Первые ~ 4–5 (001) атомных плоскостей на рис. 2а не показывают предрасположенности к CuPt B + или B - подварианты. Более выраженное одновариантное упорядочение возникает из ~ 6-го (001) атомного слоя V группы, а затем переключается на другой субвариант. Отсутствие антиструктурных дефектов Bi Ga обозначаются распределением SCS на интерфейсе, которое будет отображаться в виде квадратов в столбцах группы III с цветами, связанными с Bi. Вероятность нескольких Bi Ga Однако антисайты находятся в правом верхнем углу рисунка. Столбцы группы III и группы V показывают Bi-подобные SCS на отдельных гантелях в этой области, что также может указывать на наличие пар дефектов Bi Ga -Bi Как . Чтобы получить лучшее представление о количестве атомов Bi, участвующих в определении SCS, обратите внимание, что в образце номинальной толщиной 20–25 нм имеется 50–60 атомов в столбце <110>. Таким образом, 2–3 атома Bi наиболее вероятно будут обнаружены в столбце группы V для случайного сплава с в настоящее время 4,5% Bi. Это число будет выше в упорядоченных плоскостях, богатых Bi, и, вероятно, достигнет 6–7 в столбцах с наибольшим SCS [40]. В дополнение к анализу StatSTEM, далее представлено моделирование многосрезового изображения HAADF на модели сверхъячейки GaAsBi <110> (подробности см. В разделе "Методы").

а Распределение СКС на рис. 1а. Цветные квадраты на каждом атомном столбце соответствуют цветовой схеме SCS на рис. 2b. б Гистограмма SCS на рис. 1а, снабженная 5 гауссианами. На вставке показано изображение области интерфейса. Столбцы с атомом Ga выделены темно-синим цветом, As - светло-синим, а столбцы, содержащие Bi, - оранжевым. c Моделирование HAADF-изображения структуры GaAsBi показано на рис. 2d. Количество атомов Bi в столбце показано в круглых скобках оранжевым цветом справа от каждого столбца группы V. Соответствующие значения SCS показаны слева от каждого столбца и нормализованы к наибольшему значению SCS в суперячейке. г Модельная структура GaAsBi <110> повернута в сторону, чтобы выделить позиции Bi (оранжевый), голубые атомы As, синие атомы Ga. Стрелка показывает направление падающего луча
Вклад в интенсивность изображения HAADF от атомов Bi на разной глубине образца может быть нелинейным из-за того, что в общих чертах называется каналированием [46,47,48,49]. Количественная оценка примесей в атомном масштабе, следовательно, требует рассмотрения при различении истинных изменений в составе от изменений в конфигурациях примесей [50, 51]. Чтобы проиллюстрировать поведение каналов, среднее изменение интенсивности зонда с глубиной образца при размещении над столбцом As в <110> GaAs численно моделируется и показано на дополнительном рисунке S3 (см. «Методы»). Модельная структура GaAsBi толщиной 17 нм, используемая для моделирования HAADF, показана на рис. 2d повернутой в сторону, чтобы выделить положения атомов Bi (оранжевый) в столбцах As (As - голубой, Ga - темно-синий). Стрелка указывает направление падающего луча. Смоделированное изображение, показанное на рис. 2c, подогнано с использованием алгоритма StatSTEM для сравнения с экспериментом. Полученные значения SCS были нормализованы к значению SCS столбца с наибольшим SCS (6 атомов Bi) и округлены до двух значащих цифр. Эти нормализованные значения показаны слева от каждого столбца. Количество атомов Bi в каждом столбце группы V показано в скобках справа от столбца. В разумном согласии с предыдущими данными разница между значениями SCS As и Ga составляет ~ 8%. Разница в SCS между колонкой с чистым As и колонками с одним атомом Bi составляет 2–4% для атомов Bi, расположенных по-разному. Можно ясно видеть, что разные конфигурации Bi могут быть неверно интерпретированы для разных составов, например, 4 и 5 атомов или 5 и 6 атомов, которые дают почти одинаковые значения SCS. Атомы Bi в колонке по направлению к нижней поверхности вносят все меньший вклад в SCS. Несколько рассмотренных здесь конфигураций с двумя атомами Bi один за другим, по-видимому, вносят большой вклад в значения SCS. Можно ожидать, что конфигурация из 2 атомов Bi вдоль столбца [110] будет найдена на практике, если CuPt B упорядочение сплавов GaAsBi действительно дает структурные единицы с C 3v точечная групповая симметрия, т.е. атом Ga с ближайшими соседями 1 As и 3 атома Bi. Обратите внимание, что идентичные столбцы Ga также демонстрируют изменение SCS на величину до ~ 0,02. Это говорит о том, что их ближайшее окружение, например, близлежащие сильно рассеивающие столбцы, вносят дополнительную интенсивность из-за многократного рассеяния или связи с ними через протяженные хвосты зонда [52]. Недавно представленные улучшенные алгоритмы масштабирования открывают возможность ускорить квантово-механические многосрезовые вычисления и, таким образом, более подробно изучить вышеупомянутые эффекты [53, 54].
Чтобы завершить STEM-анализ образца S1, используется спектроскопия потерь энергии электронов (EELS) для картирования энергий объемных плазмонов. Сдвиги энергии плазмонов будут связаны с изменениями объема элементарной ячейки и, следовательно, с деформацией сплава, как обсуждается далее. GaAs имеет один основной плазмонный пик при ~ 16 эВ и, в отличие, например, от CdTe, он не показывает сложных интерферирующих особенностей от межзонных переходов [55]. В качестве первого приближения для интерпретации измеренных изменений энергии плазмонов мы используем модель Друде-Лоренца для газа свободных электронов, где свободные электроны теперь являются валентными электронами в полупроводнике [56]. Энергия объемного плазмона в этой модели задается как \ ({E} _p =\ hslash {\ left (N {e} ^ 2 / Vm {\ epsilon} _0 \ right)} ^ {1/2} \), где N - количество валентных электронов в элементарной ячейке, e - заряд электрона, V - объем элементарной ячейки, м - масса электрона, а ε 0 - диэлектрическая проницаемость свободного пространства. Простая модель Друде-Лоренца обычно предсказывает энергию плазмона в полупроводниках с точностью до нескольких процентов и должна быть скорректирована с учетом эффектов зонной структуры, если требуется лучшее соответствие [56]. Как показано в InGaAs и нитридных полупроводниковых сплавах III группы, изменение объема элементарной ячейки является ведущей величиной, определяющей сдвиги энергии плазмонов [57, 58]. Точно так же замещение изоэлектронных атомов Bi в матрице GaAs в основном приводит к увеличению объема элементарной ячейки, V , и, таким образом, вызывает красное смещение энергии плазмона. Далее мы используем измеренные энергии пиков GaAs и GaAsBi, чтобы сделать вывод о локальном изменении состояния деформации в слое GaAsBi через соотношение объемов их элементарных ячеек.
Выбирается область, которая содержит разделенные по фазе домены GaAsBi, показанные на изображении HAADF, рис. 3. Спектры EELS были собраны для каждого пикселя, сопровождающего одновременно полученное изображение HAADF (необработанный спектр см. В разделе «Методы и SI на рис. S4»). Пунктирные линии на изображении HAADF указывают границы раздела между собственным GaAsBi и слоями GaAs p-типа (внизу) и n-типа (вверху). Демаркационные линии интерфейса были определены из изображений STEM с меньшим увеличением (здесь не показаны). Защитный слой Pt виден как более контрастный материал над верхним слоем n-GaAs. Слои GaAs, а также домены с фазовым разделением внутри GaAsBi кажутся более темными на изображении HAADF. Профиль вертикальной линии на правой стороне рисунка EELS был получен путем объединения всех точек данных EELS по горизонтали. Он показывает относительный сдвиг энергии пика объемного плазмона, E GaAsBi -E GaAs , относительно энергии плазмона GaAs (измеренная как 16,23 эВ) в нижнем буферном слое p-GaAs. Видно, что в слое GaAsBi плазмонный пик смещается в среднем на 0,08 эВ в сторону меньших энергий. Небольшие вариации в пределах ~ 0,01 эВ относятся к уровням шума количественного определения. Домены с фазовым разделением около верхнего (тонкий слой) и нижнего (два пересекающихся домена) GaAs возвращаются к значению энергии плазмона GaAs, что позволяет предположить, что они содержат пренебрежимо малые концентрации Bi. Концентрация примеси в слоях GaAs (порядок 10 17 см −3 ) незначительны по сравнению с N / V и не должен влиять на энергию плазмона. Теперь рассмотрим два предельных случая для GaAs 1 − x Би x объем элементарной ячейки V ; в одном решетка полностью релаксирована, а в другом - полностью напряжена относительно подложки GaAs. В полностью релаксированном случае элементарная ячейка является кубической с постоянной решетки a ≈ 5,684 Å при x =4,5% Bi [1]. Используя указанное выше соотношение квадратного корня между энергией плазмона и V , сдвиг энергии относительно GaAs должен быть \ (\ Delta {E} _p ^ {GaAs Bi} =16.23 \ left ({\ left ({V} _ {GaAs} / {V} _ {GaAs Bi} \ right) } ^ {1/2} -1 \ right) =- 0.132 \ mathrm {eV} \), что явно больше измеренного. Основываясь на тенденциях релаксации сплавов GaAsBi, мы оцениваем, что ~ 30% решетки релаксировано в этой пленке толщиной 420 нм, учитывая, что она также претерпела короткий термический отжиг при выращивании верхнего слоя n-GaAs. Следовательно, средняя элементарная ячейка GaAsBi будет завышена в полностью релаксированном сценарии и объясняет большую \ (\ Delta {E} _p ^ {GaAsBi} \), полученную выше. В другом пределе решетка бисмида считается полностью деформированной с постоянной решетки в плоскости, равной постоянной решетки GaAs ( a =5,653 Å). Затем находится постоянная решетки вне плоскости, необходимая для получения сдвига энергии -0,080 эВ a z =5,709 Å. Это разумный a z значение и может быть сравнено с измерениями XRD-RSM GaAsBi, напряженного сжатием на подложку GaAs [1, 34, 59]. Ожидается, что из-за релаксации фактические постоянные решетки будут находиться между этими двумя предельными случаями. Это демонстрирует многообещающий метод определения характеристик, который может предоставить информацию о деформации решетки, дополняющую рентгеновские методы в таких метастабильных сплавах.

Изображение поперечного сечения HAADF (слева) p-i-n образца S1 с отмеченными слоями GaAs и GaAsBi. Более темные области внутри GaAsBi - это домены с разделенными фазами. Профиль линии (справа) показывает сдвиг энергии пика объемного плазмона EELS, E GaAsBi - E GaAs относительно буферного слоя GaAs. Профиль точно совпадает с одновременно полученным изображением HAADF слева. Пиксели данных EELS полностью разделены по горизонтали и, таким образом, указывают пространственно усредненные значения. Масштабная линейка составляет 100 нм, и она также применяется к вертикальной оси профиля EELS
Второй образец GaAsBi, S2, был выращен на буферном слое GaAs, нанесенном на обрезанную подложку Ge (см. Методы). Гетероэпитаксия Ge-GaAsBi была проанализирована в нашей предыдущей работе, в которой также был продемонстрирован одновариантный CuPt B с большими доменами. упорядочение в GaAsBi [34]. Дополнительные данные представлены в этой работе и используются для полноты обсуждения атомного упорядочения Bi. Общая концентрация висмута в этом образце составляет ~ 5,8% по измерениям PL (SI Fig. S1) [34]. Обрезка в сочетании с буферным слоем GaAs, используемым в этой эпитаксии, помогает избежать образования противофазных доменов в GaAsBi, которые все еще сложно устранить при его выращивании непосредственно на неполярном Ge [60,61,62]. На рис. 4а показана заметно более яркая область интерфейса GaAs-GaAsBi со слоем GaAsBi на изображении HAADF. В отличие от предыдущей пленки GaAsBi, нанесенной на плоскую подложку из GaAs, здесь одна пленка CuPt B Подвариант заказа выбирается по обрезке. Это можно увидеть на изображении HAADF и на вставке его преобразования Фурье в правом верхнем углу, показывающей пару 1/2 [\ (\ overline {1} \) 11] * пятен сверхрешетки. Рисунок 4b был сформирован путем наложения маски на пару рефлексов сверхрешетки, аналогично рисунку 1c, d. Это показывает гораздо более единообразный и крупный порядок в фильме. EDX-изображения с атомным разрешением были получены из этого образца для оценки параметра порядка η на основе композиционного анализа. Химическое картирование EDX часто превосходит альтернативную количественную оценку потерь в сердечнике EELS, которая имеет тенденцию иметь худшее отношение сигнал / шум при количественной оценке фронтов высокоэнергетической и отложенной ионизации [56, 63, 64, 65]. Направление сканирования STEM было изменено для выравнивания упорядоченных (\ (\ overline {1} \) 11) плоскостей по горизонтали. На рис. 4c – e показаны рентгеновские элементные карты с фильтром Винера. Порядок атомов Bi на каждой второй (\ (\ overline {1} \) 11) плоскости ясен, и это следует из положений атомов As. Для количественной оценки состава EDX были получены два набора данных размером 512 × 512 пикселей каждый из разных областей образца с использованием идентичных экспериментальных условий. Субрегионы были выровнены, и необработанные сигналы суммировались, в результате получилось 10 кадров. Профили вертикальных линий As-K и Bi-M с суммированными по горизонтали исходными данными показаны на рис. 4f. Для количественной оценки состава висмута в Bi-богатой и Bi-дефицитной (111) плоскостях использовалось окно интегрирования шириной 3 Å с центром на атомных плоскостях. После вычитания фона и усреднения по всем плоскостям (111) это показывает, что количество рентгеновских лучей Bi в ~ 3 раза выше в плоскостях, богатых Bi. Общая концентрация 5,8% Bi в образце, полученная с помощью измерений PL и XRD-RSM, затем используется для линейного масштабирования количества рентгеновских лучей Bi до состава, что показывает, что Bi достигает 9% в плоскостях, богатых Bi. Таким образом, параметр порядка можно оценить (см. Введение) как η =0,07. Отметим, что полностью упорядоченный бисмид с такой полной концентрацией Bi имел бы параметр порядка η =0,116. Подобно анализу HAADF, количественное определение EDX отдельных столбцов страдает от эффектов каналирования, поскольку потенциал ионизации остовных электронов сильно локализован. Как показано другими авторами в Al x Ga 1-x В случае сплава это может привести к стандартному отклонению рентгеновских лучей до ~ 5% из-за различных конфигураций примеси [50]. Учитывая отклонение, обнаружено, что количество рентгеновских лучей линейно масштабируется в зависимости от количества примесей в не слишком толстых образцах. Конфигурационная ошибка в настоящем исследовании минимизирована путем эффективного усреднения по ~ 11 атомным столбцам в каждой плоскости (111), всего ~ 130 столбцов. Кроме того, хвосты электронного зонда и многократное рассеяние могут вызывать делокализацию сигнала на EDX-изображениях [52]. Моделирование изображения HAADF в предыдущем разделе, показывающее изменение значений Ga SCS, намекает на ожидаемую величину этих эффектов при количественной оценке EDX. Дробовой шум, по-видимому, в настоящее время является основным ограничивающим фактором точности из-за изначально низкого количества рентгеновских лучей Bi в таких разбавленных сплавах.

а Изображение HAADF образца S2 GaAsBi вблизи границы с буферным слоем GaAs, выращенного на обрезке (001) Ge. Преобразование Фурье в правом верхнем углу показывает пару пиков, указывающих порядок на единственном наборе плоскостей (\ (\ overline {1} \) 11). б Изображение, сформированное из ( a ) с использованием пары сверхрешеток 1/2 [\ (\ overline {1} \) 11] * пятен Брэгга. c - е Винер отфильтровал EDX-изображения образца GaAsBi с рентгеновским излучением Bi-M, As-K и Ga-K, как указано. Обратите внимание, что в данных EDX кристаллографические направления поворачиваются для выравнивания упорядоченных (\ (\ overline {1} \) 11) плоскостей по горизонтали. е Горизонтально суммированный вертикальный профиль рентгеновских лучей необработанного сигнала As-K и Bi-M. Два выровненных набора данных объединяются для получения профиля
The final GaAsBi sample, S3, that we wish to explore here was synthesized under conditions to create so-called vertical composition modulations (VCM) (see Methods) [66]. In contrast to samples S1 and S2, the VCM is achieved in S3 by utilizing a slower substrate rotation rate (RPM), which is coupled to intrinsically inhomogeneous elemental flux profiles reaching the substrate in a typical MBE chamber. The III/V elemental ratio within a sample region can be oscillated by controlling the RPM and the film growth rate to obtain the desired VCM period. A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens и другие. [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

а HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. б A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. c Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
Выводы
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB -type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordering. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
Методы
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 см −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 Торр. The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
Доступность данных и материалов
Наборы данных, использованные и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- BEP:
-
Beam equivalent pressure ratio
- EELS:
-
Electron energy-loss spectroscopy
- БПФ:
-
Fast Fourier transform
- HAADF:
-
High-angle annular dark-field
- MBE:
-
Молекулярно-лучевая эпитаксия
- PL:
-
Фотолюминесценция
- STEM:
-
Сканирующая просвечивающая электронная микроскопия
- SCS:
-
Scattering cross-section
- VCM:
-
Vertical composition modulations
- EDX:
-
X-ray energy dispersive spectroscopy
Наноматериалы
- Применение металлического молибдена и его сплавов
- 4 использования гафния | Применение гафния и сплавов гафния.
- Применение молибдена и молибденовых сплавов
- Свойства и применение медно-никелевых сплавов
- Руководство по надежной меди и ее сплавам
- Виды и характеристики:Алюминиевые бронзовые сплавы
- Знакомство с металлическими сплавами и пределом текучести
- 5 важных промышленных металлических сплавов и их применение
- Термическая обработка алюминия и алюминиевых сплавов
- Термическая обработка меди и медных сплавов



