Анализ распределения Bi в эпитаксиальном GaAsBi с помощью HAADF-STEM с коррекцией аберраций
Аннотация
Содержание Bi в GaAs / GaAs 1 - x Би x / GaAs-гетероструктуры, выращенные методом молекулярно-лучевой эпитаксии при температуре подложки, близкой к 340 ° C, исследованы методами высокоуглового кольцевого темного поля с коррекцией аберраций. Анализ изображений, полученных с помощью широкоугольной кольцевой сканирующей электронной микроскопии в темном поле при малом увеличении, подтвержденный EDX-анализом, выявил плоские бездефектные слои и неоднородное распределение Bi на границах раздела и внутри слоя GaAsBi. При большом увеличении анализ qHAADF подтвердил неоднородное распределение и сегрегацию Bi на границе раздела GaAsBi / GaAs при низком потоке Bi и искаженную форму гантели в областях с более высоким содержанием Bi. При более высоком потоке Bi размер скопления Bi увеличивается, что приводит к примерно равноосным частицам с высоким содержанием Bi, ограненным вдоль цинковой обманки {111} и равномерно диспергированным вокруг матрицы и границ раздела. Анализ БПФ проверяет сосуществование двух фаз в некоторых кластерах:ромбоэдрической чистой Bi (rh-Bi) фазы, окруженной цинковой обманкой GaAs 1 - x Би x матрица. Кластеры могут влиять на локальную релаксацию решетки и приводить к частично релаксированной системе GaAsBi / GaAs, что хорошо согласуется с данными рентгеноструктурного анализа.
Фон
В настоящее время полупроводники на основе GaAsBi вызывают интерес как термостабильные устройства и устройства среднего инфракрасного диапазона [1]. Добавление небольшого количества Bi в решетку GaAs приводит к значительному уменьшению ширины запрещенной зоны, что является одним из наиболее интересных оптоэлектронных эффектов [2, 3]. Однако включение даже небольшого количества Bi в GaAs является сложной задачей из-за слабой энергии связи Ga – Bi, большой щели смешиваемости и большой разницы в постоянной решетки между GaBi и GaAs. Следовательно, GaAsBi должен расти в неравновесном динамическом процессе для эффективного включения Bi. Хотя даже если он синтезирован успешно, распределение Bi иногда бывает неоднородным, что увеличивает плотность центров безызлучательной рекомбинации и, следовательно, влияет на их эффективность при генерации. Большой размер и низкая электроотрицательность Bi имеют тенденцию вызывать разделение фаз [4], поверхностные капли [5, 6], атомное упорядочение [7,8,9], наноразмерные жидкие капли [10] или кластеры Bi во время эпитаксиального роста. Присутствие кластеров Bi было ранее обнаружено Ciatto et al. с помощью комбинации методов рентгеновской абсорбционной спектроскопии (XAS), атомно-силовой микроскопии и рентгеновской дифракции (XRD) [11]. Затем несколько авторов сообщили о наличии кластеров Bi в отожженных образцах GaAsBi, используя различные методы просвечивающей электронной микроскопии [4, 12, 13]. Кроме того, Kunzer et al. [14] с помощью обычного электронного спинового резонанса (ЭПР) подтвердили, что около 10% внедренного Bi заняли позиции Ga в слоях GaAsBi. Следовательно, понимание и контроль включения Bi и образования дефектов имеет решающее значение для успешного применения GaAsBi в устройствах. Стоит отметить, что разработка новых материалов на основе Bi связана с усовершенствованием инструментов определения характеристик. В этом смысле методы высокоугловой кольцевой сканирующей электронной микроскопии в темном поле (HAADF-STEM) в микроскопах с коррекцией аберраций играют важную роль в получении информации на уровне суб-ангстрема [15, 16]. В этом методе интенсивность изображений примерно пропорциональна среднему атомному номеру ( Z ) в проецируемом атомном столбце, поэтому его можно успешно применять в гетероструктурах разбавленного Ga (AsBi) из-за большой разницы в атомном номере Bi по отношению к As и Ga. Кроме того, яркие детали на изображениях HAADF, в отличие от Просвечивающая электронная микроскопия высокого разрешения (HRTEM) может быть связана с атомными столбцами в выровненном кристалле из-за отсутствия инверсии контраста и делокализации. Кроме того, HAADF-изображения образцов GaAsBi с коррекцией аберраций показывают слабую зависимость от толщины образца и почти линейную зависимость от состава As / Bi [12]. Более того, применяя алгоритм количественного анализа изображений HAADF (qHAADF), разработанный Molina et al. [17], можно эффективно коррелировать интенсивность HAADF и атомный столбчатый состав в тройных полупроводниковых материалах AIIIBV [12,16,18] и, следовательно, в соединениях GaAsBi. Кроме того, изображения HAADF-STEM с высоким разрешением предлагают информацию о качестве кристаллов [19,20,21,22].
В этой работе мы исследуем с помощью HAADF-STEM-визуализации с коррекцией аберраций и дополнительного энергодисперсионного рентгеновского излучения (EDX) распределение Bi в GaAs / GaAs 1 - x Би x / GaAs-гетероструктуры, выращенные методом молекулярно-лучевой эпитаксии (МЛЭ) при температуре подложки, близкой к 340 ° C. Мы также изучили эффект сбора Bi в нано- и микромасштабах. Для этой цели мы использовали подход qHAADF, анализ быстрого преобразования Фурье (БПФ) изображений с высоким разрешением и методы XRD.
Методы
Мы исследуем серию из двух образцов, состоящих из GaAs / GaAs 1 - x Би x / GaAs-гетероструктуры, выращенные методом МЛЭ с твердым источником на 2 ″ n + Пластины GaAs:Si (001) с различным потоком Bi, определяемым температурами ячейки Bi S1 (460 ° C) и S2 (505 ° C). В качестве системы использовалась машина VG V80 MBE со средним фоновым давлением покоя ~ 5 × 10 - 10 мбар. Структуры номинально состоят из буфера GaAs 130 нм, слоя GaAsBi 130 нм, разделительного слоя GaAs 5 нм и затем крышки из GaAs 130 нм. Перед выращиванием подложку дегазировали при 400 ° C в течение 20 мин, а затем удалили поверхностный оксид при 600 ° C. Буфер и колпачок GaAs выращивали при ~ 580 ° C в As 2 потока, в то время как слой GaAsBi и спейсерный слой GaAs выращивались при ~ 340 ° C в почти стехиометрическом As 4 поток. Поэтому слой GaAsBi отжигался in situ при ~ 580 ° C в течение ~ 20 мин во время роста крышки GaAs. В этих условиях роста металлических капель на поверхности не наблюдалось. Температуры подложки были оценены с помощью оптической термометрии, при этом результаты были откалиброваны по переходам реконструкции поверхности при известных температурах. Перед выращиванием GaAsBi поверхность образца подвергалась воздействию потока Bi в течение 20 с; Целью этого шага было создание поверхностного слоя Bi и усиление включения Bi в начале роста GaAsBi.
Образцы для HAADF-STEM были приготовлены в поперечном сечении механическим шлифованием и Ar + ионное измельчение с использованием прецизионной системы ионной полировки (PIPS) с углом наклона луча от -3 ° до + 4 ° и энергией луча от 2,8 до 3,0 кВ. На заключительном этапе измельчения энергия ионов была снижена до 1,5 кВ для улучшения качества поверхности. Образцы перед исследованием подвергались плазменной очистке для уменьшения влияния электронно-лучевого осаждения на поверхность образцов [23]. Изображения HAADF-STEM, спектр потерь энергии электронов с нулевыми потерями (EELS) и линейное сканирование энергодисперсионных рентгеновских спектров были выполнены при 200 кВ с использованием Titan 3 Фемида на 60–300 кВ. Титан 3 Themis оснащена холодным автоэмиссионным пистолетом (FEG), корректором зонда Cs и электронным монохроматором, что обеспечивает атомное разрешение при визуализации HAADF. Этот микроскоп также включает в себя детектор Super-X quad EDX для элементного анализа, одновременно предоставляющий информацию о положении и составе атомов. Изображения вторичных электронов (SE) для исследования топографии образца ПЭМ были выполнены с использованием микроскопа FEI NOVA NANOSEM 450 при 2 кВ.
Линию Bi-M при 2,42 кэВ использовали для количественного определения состава Bi с помощью программного обеспечения Bruker Espirit. Толщина образца определялась на основе анализа пространственно разрешенного сигнала EELS с нулевыми потерями с использованием программного обеспечения Digital Micrograph (GATAN ™) [23]. Распределение Bi по столбцам изучали с помощью программного обеспечения qHAADF, доступного для работы на цифровой микрофотографии. Это программное обеспечение позволяет измерять и отображать интегральную интенсивность выбранных областей вокруг атомных столбцов путем обнаружения пиков интенсивности на изображении HAADF-STEM [17]. Спектры ω-2θ (0 0 4) XRD были измерены с помощью рентгеновского дифрактометра Bruker D8 Discover с использованием Cu-Kα 1 радиация. Сканы были смоделированы с помощью программного обеспечения Bede Rads Mercury.
Результаты и обсуждение
На рисунке 1 показаны изображения HAADF-STEM с малым увеличением, полученные на оси зоны [110] образцов S1 (a) и S2 (b), вместе с профилями интенсивности с поправкой на градиент толщины, взятыми вдоль направления [001] из областей, отмеченных значком изображения HAADF-STEM (зеленые прямоугольники). Проходных дислокаций и дефектов упаковки в исследованных областях обоих образцов не обнаружено. В HAADF полученная интенсивность пропорциональна среднему атомному номеру. Таким образом, для постоянной толщины образца более яркий контраст изображения связан с более высоким содержанием Bi ( Z Би =83, Z Ga =31 и Z Как =33). Это делает возможным изучение распределения Bi в гетероструктурах GaAsBi / GaAs. Как можно видеть на рис. 1а, в слое GaAsBi в образце S1 не обнаружено явных изменений контраста - с более низким содержанием Bi - не показывая четких доказательств кластеризации, даже в других областях с большей толщиной образца. Однако кластеры Bi и As описаны в литературе даже для образцов GaAsBi с содержанием Bi всего 1,44%, хотя и выращенных при более низких температурах [11]. Что касается образца S2, с более высоким содержанием Bi, на рис. 1b показаны некоторые области с более ярким контрастом в слое с относительно однородным размером и распределением. Эти области, регулярно распределенные вдоль слоя GaAsBi и границ раздела, могут быть напрямую интерпретированы как Bi-содержащие кластеры из-за их более высокой интенсивности HAADF. Для лучшей визуализации соответствующее изображение с фильтром нижних частот показано в виде вставки на том же изображении, где желтый цвет соответствует областям с более высоким содержанием Bi, а черный - областям с более низким содержанием (температурная шкала). Об образовании кластеров Bi в GaAsBi без возникновения структурных дефектов сообщалось ранее другими авторами [7, 24, 25]. Интеграция Bi (в 1,6 раза больше атомного объема As) в матрицу GaAs может вызвать увеличение энергии замещения из-за деформации, уменьшая растворимость атомов As и позволяя собирать атомы Bi. Исследование образца с использованием сканирующего электронного микроскопа с автоэлектронной эмиссией (FEG-SEM) было выполнено, чтобы убедиться, что кластеры Bi встроены в слой. Для этого изображения топографии вторичных электронов, полученные при низком напряжении (здесь не показаны), сравнивались с изображениями STEM, полученными в той же области.

а Изображение поперечного сечения HAADF-STEM образца S1, показывающее границы раздела GaAs / GaAsBi / GaAs. б На изображении поперечного сечения HAADF-STEM образца S2 в слое GaAsBi наблюдаются яркие пятна, распределенные вдоль слоя GaAsBi, связанные с областями, богатыми Bi. Детализация с использованием температурной цветовой шкалы области после применения фильтра нижних частот включена в качестве вставки в то же изображение для лучшей визуализации. c Профили интенсивности с коррекцией градиента толщины, снятые вдоль направления [001] из областей, отмеченных зелеными прямоугольниками на изображениях HAADF-STEM, синей линией для образца S1 и черной линией для образца S2, демонстрируя несколько иное поведение на границах раздела.
Чтобы получить дополнительную информацию о распределении Bi в образцах, профили интенсивности вдоль направления роста с скорректированным градиентом толщины показаны на рис. 1c. Профили, взятые из изображений HAADF-STEM на рис. 1а, б, указывают на схожее поведение в обоих образцах:грубо резкие границы раздела, слои GaAsBi одинаковой длины (~ 140 нм). Что касается границы раздела GaAsBi / GaAs, интенсивность HAADF падает от максимального значения до ~ 0 примерно через 10 нм (см. Серый пунктирный прямоугольник на профиле), что свидетельствует о некотором включении Bi по всему покровному слою GaAs даже без потока Bi. Профили также отображают информацию о времени уравновешивания. Как видно из профилей, в образце с более низким содержанием Bi (S1) граница раздела GaAs / GaAsBi более резкая, чем в образце с более высоким содержанием Bi (S2). Это можно объяснить разными коэффициентами включения Bi в двух образцах. S1, выращенный при той же температуре, что и S2, имеет гораздо меньшее содержание Bi. Следовательно, S1, вероятно, выращивается в кинетически ограниченных условиях с почти единичным включением Bi [26], что означает, что поверхностный слой Bi будет уравновешиваться в течение периода времени, меньшего, чем время жизни на поверхности атома Bi при этой температуре. С другой стороны, S2, вероятно, имеет более низкий коэффициент включения Bi [27]. Поверхностному слою Bi в этом случае потребуется больше времени, чем время жизни на поверхности атома Bi, чтобы уравновеситься, что приведет к более медленной стабилизации включения Bi.
Чтобы подтвердить корреляцию между профилями интенсивности HAADF-STEM и распределением Bi в гетероструктуре, одновременно были взяты составные карты образцов STEM-EDX Bi. Они показаны на рис. 2 для образца при низком (а) и высоком (б) потоках Bi. Соответствующие профили состава Bi вдоль направления роста, определенные путем интегрирования точечных EDX-спектров области около 130 нм, показаны на рис. 2c синими и черными линиями соответственно. Эти композиционные профили демонстрируют ту же тенденцию, обнаруженную на границах раздела GaAs / GaAsBi / GaAs с помощью HAADF-анализа при малом увеличении. Средняя атомная доля Bi в слоях GaAsBi была определена количественно из соответствующих EDX-спектров и составила 1,2 ± 0,4% и 5,3 ± 0,4% в образцах S1 и S2 соответственно, что свидетельствует о неоднородном распределении Bi в слое GaAsBi в обоих образцах. .

Карты элементов STEM / EDX, представляющие распределение Bi в образцах S1 ( a ) и S2 ( b ). Детали элементных карт Bi, Ga и As, соответствующих кластеру, отмеченному белым прямоугольником на рис. 1b, показывают падение сигналов As и Ga там, где есть область с высоким содержанием Bi. c Профили содержания Bi вдоль направления [001], извлеченные после интегрирования области около 130 нм из карты EDX образцов S1 (синяя линия) и S2 (черная линия). Подобные особенности наблюдались на профилях интенсивности при малом увеличении, показанных на рис. 1c
Присутствие кластеров Bi может быть связано с эффектом стерических затруднений. В этом случае поверхностное натяжение может увеличиваться из-за большего атомного размера атомов Bi, поэтому для уменьшения напряжения в структуре атомы Bi могут блокировать включение Ga и, следовательно, вызывать вакансии Ga в сетке. Составные карты Ga и As кластера, окруженные белым квадратом на рис. 2b, включены, чтобы показать, как оба сигнала падают там, где есть высокий сигнал Bi. Это предполагает, что в этом конкретном кластере Bi может занимать подрешетки как группы III, так и группы V. Это также свидетельствует о том, что кластеры не являются поверхностными, образовавшимися при пробоподготовке ПЭМ.
Чтобы провести глубокое исследование распределения Bi на атомном уровне, в проекции [110] были получены изображения HAADF-STEM с коррекцией аберраций при большом увеличении. В этом полупроводниковом сплаве III – V два максимальных пика интенсивности гантели соответствуют атомным столбцам группы III и группы V. Чтобы правильно соотнести интенсивность атомных столбцов с их составом, фоновый уровень был удален из экспериментальных изображений HAADF-STEM. Затем было выполнено автоматическое определение местоположения пиков интенсивности и тщательно выбраны области интегрирования вокруг атомных столбцов группы V. Интегрированная интенсивность измеряется и отображается для каждой гантели с использованием подхода qHAADF. Процедура количественного определения содержания Bi была аналогична процедуре, опубликованной в [5]. [28]. В этой работе интегральные коэффициенты интенсивности каждой гантели ( R ) рассчитывали как отношение интегрированной интенсивности в столбцах группы V ( I As - Bi ) на всем изображении и средняя интегральная интенсивность в столбцах группы V в слое GaAs ( I Как ), как R =( Я (As - Bi) ) / Я Как .
На рисунке 3а показано изображение границы раздела GaAs / GaAsBi с большим увеличением, полученное методом HAADF-STEM, для образца с низким содержанием Bi (S1). Цветная нормализованная интегральная карта интенсивности изображения HAADF показана на рис. 3b. Цветные точки в диапазоне от 1 (темно-синий) до 1,27 (красный) показывают содержание Bi в столбцах группы V. Как можно заметить, небольшие колебания R значения от среднего значения находятся в обоих слоях. Чтобы сравнить разброс полученных результатов, мы рассчитали коэффициент корреляции Cv (определяется как соотношение между стандартным отклонением и средним значением R значение) в GaAs (подложка), слое GaAsBi и покровном слое GaAs. Cv значения составили 1,3, 2,6 и 2,6% соответственно, поскольку флуктуации, наблюдаемые на границе раздела GaAsBi / GaAs, выше, чем флуктуации, обнаруженные в подложке GaAs, взятой за эталон; мы можем считать, что эти вариации в R значения связаны с изменениями в составе столбца Bi. Причина ненулевого Cv Фактор в подложке может быть вызван локальными колебаниями толщины, шумом детектора (измеренным в области без материала как 0,6%) или отложением углеводородов на поверхности образца во время исследования под микроскопом.

а Поперечное сечение [110] HAADF-STEM-изображение границы раздела GaAsBi / GaAs образца S1. Детали неискаженной области в слое GaAs и искаженные анион-катионные гантели в богатой Bi области при большем увеличении включены в качестве вставки в то же изображение. б Цветная карта, представляющая R значения вокруг столбцов группы V изображения HAADF на рис. 3a. Зеленый цвет соответствует среднему составу Bi в слое GaAsBi, измеренному методом EDX. Несмотря на однородное распределение Bi на изображении HAADF-STEM, на карте интенсивности показаны области с высокой вероятностью нанокластеризации (красные точки) и столбцы с относительно низким содержанием Bi (синие точки) в слое GaAsBi. c Профиль по направлению роста всего R карта интенсивности, показывающая размытую границу раздела GaAsBi / GaAs примерно через 10 нм
Этот анализ qHAADF подтверждает отсутствие резких скачков верхней границы раздела GaAsBi / GaAs размером более 10 нм, воспринимаемое при малом увеличении, в основном из-за сегрегации поверхности Bi во время роста, что можно наблюдать по профилю, взятому вдоль направления роста во всей интенсивности R карта, показанная на рис. 3в. Кроме того, с помощью этого программного обеспечения также обнаруживаются диспергированные столбцы с высоким содержанием Bi в слое GaAsBi (красные точки), а также области с низким содержанием Bi (синие точки) в слое GaAsBi, что подтверждает колебания содержания Bi в слое GaAsBi. . Присутствие колонок с высоким содержанием Bi, по-видимому, вызывает явное искажение формы гантели, что можно увидеть на вставке при большем увеличении на рис. 3a. Замена более крупных атомов Bi на атомы As во время эпитаксиального роста привела бы к локальному расширению решетки матрицы, вызывая искажение формы гантели при сохранении структуры.
Методы HAADF-STEM также позволяют проводить структурный и композиционный анализ кластеров, обнаруженных при малом увеличении в образце S2. Эти кластеры, почти однородно распределенные, занимают около 20–30% поверхности слоя GaAsBi. Чтобы узнать состав Bi, форму и размер обнаруженных кластеров, были сделаны изображения HAADF-STEM с исправленными аберрациями в проекции [110] и составлены карты элементов EDX и соотношения карт интенсивности вокруг столбцов группы V. Чтобы идентифицировать различные кристаллические фазы, было проведено исследование с быстрым преобразованием Фурье (БПФ) на изображениях с высоким разрешением в различных областях внутри и рядом с кластерами.
На рис. 4а показано изображение [110] HAADF-STEM с высоким разрешением границы раздела GaAsBi / GaAs с чистым кластером Bi диаметром около 12 нм. Красные прямоугольники на изображении представляют области, где проводилось исследование БПФ. Хорошо известно, что фильтрация нижних частот не только уменьшает количество шума в данных, но также удаляет периодические особенности, наблюдаемые в необработанном изображении, подчеркивая края кластера Bi. Отфильтрованное изображение HAADF-STEM в соответствии с процедурой, описанной Werner et al. [29], показан на рис. 4б. Как можно понять, четко видны грани {111} и (001) в самой яркой области. Однако распределение интенсивности предполагает наличие в частице двух различных композиционных объемов:объемного, богатого биом и имеющего трапециевидную форму, окруженного менее богатым биом участком. Подобная форма кластера наблюдалась у Wood et al. в пятипериодном GaAs 1 - x Би x / GaAs 1 - y Би y структура [10].
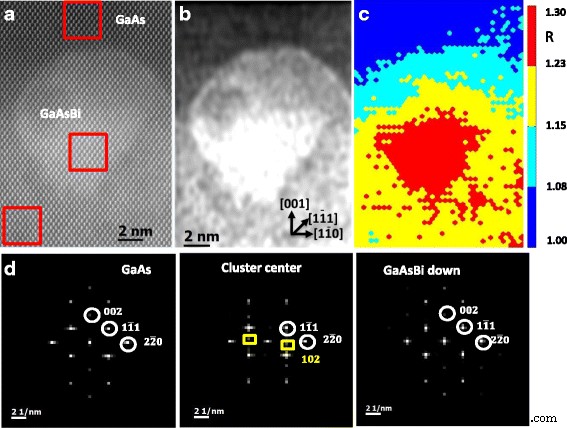
а Поперечное сечение [110] HAADF-STEM-изображение границы раздела GaAsBi / GaAs образца S2, захватывающее кластер Bi размером около 12 нм, рядом с границей раздела GaAsBi / GaAs. б Изображение с низкой фильтрацией изображения HAADF-STEM показывает две области с разным контрастом в слое GaAsBi:зона, богатая Bi, огранена вдоль плоскостей {111} и (001), окруженная более низкой зоной, богатой Bi. c Цветная карта, представляющая R значения вокруг столбцов группы V, изображающие градуированное распределение Bi вокруг кластера. г Соответствующее преобразование Фурье из выделенных областей, отмеченных красными прямоугольниками на рис. 1а. Дополнительные пятна, соответствующие плоскостям {102}, относящимся к фазе rh-Bi, обнаруживаются в наиболее контрастной области кластера
Анализ qHAADF через интенсивность R карта, показанная на рис. 4c, показывает примерно равноосную форму частицы и градиент концентрации Bi с максимумом в центре кластера.
Wu et al. [4] сообщили о наличии различных кристаллографических структур в слоях GaAsBi, изучая микрофотографии ПЭМВР и моделируя образование и фазовое превращение от Bi-богатого цинка к ромбоэдрическому Bi (rh-Bi), зародившемуся в плоскостях {111} цинковой обманки. В этом смысле стоит упомянуть, что яркие пятна в БПФ из изображений HAADF-STEM с высоким разрешением можно интерпретировать как дифракционные пятна от кристаллографических плоскостей. Тогда дополнительные пятна в традиционной структуре структуры цинковой обманки GaAs следует интерпретировать как дополнительные фазы. Для изучения наличия различных кристаллических структур в кластере на рис. 4d показаны БПФ, соответствующие трем различным областям, отмеченным красными квадратами на рис. 1а. Справа налево показаны однородная область в покровном слое GaAs, самая яркая зона в слое GaAsBi и еще одна область с более низким контрастом в том же слое GaAsBi. Белые кружки обозначают положение дифракционного пика с индексами Миллера 002, \ (1 \ overline {1} 1 \) и \ (2 \ overline {2} 0 \). Как можно заметить, только в центре кластера появляются четкие пятна, отмеченные желтым квадратом, относящиеся к плоскостям {102}, примерно параллельным плоскостям цинковой обманки {220}, что свидетельствует о зарождении новой фазы rh-Bi в слой цинковой обманки GaAsBi. БПФ также показывают уширение дифракционных пиков, относящихся к плоскостям {111}. Этот наблюдаемый асимметричный пик может быть вызван причинами микродеформации из-за смещения плоскостей {111} между фазами rh-Bi и цинковой обманки в кластере.
Для более глубокого изучения кластерного состава стоит упомянуть, что, проходя через электронно-прозрачный образец с внедренными кластерами, электроны несут информацию не только о кластере, но и от матрицы. Итак, чтобы оценить реальный состав кластера, мы следуем той же процедуре, которая описана в [5]. [25]. Результаты также показали, что кластеры, расположенные вблизи границы раздела GaAsBi / GaAs, имеют тенденцию к меньшему размеру (12 нм) с более высоким содержанием Bi (≈ 30%), вероятно, из-за присутствия Bi на поверхности, когда верхний слой начинает оседать. расти. Однако большинство кластеров, расположенных внутри слоев GaAsBi, имеют больший размер (16 нм), но содержание в них Bi меньше (≈ 22%). Кроме того, в слое GaAsBi были обнаружены кластеры с превосходным содержанием Bi (35%) и большим размером (23 нм). Кроме того, как упоминалось ранее, ядро некоторых кластеров состоит из чистого rh-Bi.
Для исследования деформированного состояния эпитаксиальной пленки были записаны рентгеновские кривые ω-2θ высокого разрешения. На рисунке 5 показаны (004) XRD-сканирования слоев GaAsBi / GaAs синим цветом и смоделированные аппроксимации оранжевым цветом для образцов S1 (a) и S2 (b). В обоих образцах самый резкий и самый высокий пик интенсивности, расположенный при 0 ° угловых секундах, соответствует подложке GaAs, в то время как широкий более низкий пик интенсивности, расположенный на отрицательной угловой секунде, соответствует напряженному слою GaAsBi. Угол между пиками относится к величине рассогласования решеток между обоими слоями. Плечо справа от пика GaAs в спектре S2 указывает на слой GaAs при растяжении; это означает релаксацию деформации в слое S2 GaAsBi. Спектр XRD образца S1 был хорошо подогнан с использованием фракции Bi и толщин, полученных с помощью измерений EDX и HAADF. В спектре XRD образца S1 нет признаков релаксации деформации. Спектр XRD образца S2 подобрать было сложнее. На рис. 5b показаны данные, смоделированные однородным слоем GaAsBi с 5,8%, как определено анализом HAADF-STEM, без учета кластеров, богатых Bi, и релаксации слоя GaAsBi на 6%, как определено путем аппроксимации кривой XRD; это было бы разумно, если бы кластеры не были когерентными с остальной частью матрицы GaAsBi. Эта модель не точно отображает слой; в то время как расщепления подложка-GaAsBi достаточно для объяснения данных, пика растяжения GaAs при ~ 250 ° угловых секунд не видно. Пик растяжения GaAs указывает на то, что релаксация произошла внутри слоя. Релаксация сжимающегося слоя приведет к уменьшению постоянной решетки вне плоскости, что означает, что смоделированное среднее содержание Bi в 5,8% является заниженной оценкой реального среднего значения; это согласуется с наблюдением кластеров с высоким содержанием Bi в слое. Никаких пиков, соответствующих ~ 22–35% GaAsBi, не наблюдалось при отображении обратного пространства (не показано), что предполагает, что кластеры могут не быть когерентными с матрицей GaAsBi. Дальнейшего моделирования спектра S2 XRD не предпринималось.

Данные дифракции рентгеновских лучей (синие линии) и моделирование (оранжевые линии) образца S1 ( a ) и образец S2 ( b ). Вертикальные пунктирные линии выделяют пик GaAs при 0 ° угловых секундах и пик пленки GaAsBi, расположенный при отрицательной угловой секунде. Плечо на правом пике GaAs на рис. 5b указывает на покрывающий слой GaAs под действием деформации растяжения
Выводы
Анализ ac-HAADF-STEM дает полезную информацию о структуре и составе гетероструктур GaAs / GaAsBi / GaAs, результаты хорошо согласуются с исследованиями EDX, FFT и XRD. Анализ изображений HAADF-STEM с малым увеличением позволил выявить неоднородное распределение Bi и нерезкие границы раздела GaAsBi / GaAs. При большом увеличении анализ qHAADF выявил четкую сегрегацию Bi на границе раздела GaAsBi / GaAs при низком потоке Bi (S1) и искаженную форму гантели в областях с более высокой долей Bi из-за замещающих позиций As атомов Bi в подсети V группы. . При более высоком потоке Bi (S2) размер скопления Bi увеличивается, что приводит к примерно равноосным кластерам, равномерно распределенным по всей матрице и границам раздела. Исследование показало сосуществование двух различных кристаллических фаз в исследуемых кластерах rh-Bi и плоскостях сдвига {111} цинковой обманки, влияющих на локальную релаксацию решетки и приводящих к частично релаксированной системе GaAsBi / GaAs, что хорошо согласуется с данными рентгеноструктурного анализа.
Сокращения
- Ac-HAADF-STEM:
-
Сканирующая электронная микроскопия в кольцевом темном поле с коррекцией аберраций
- EDX:
-
Энергодисперсионный рентгеновский снимок
- EELS:
-
Спектр потерь энергии электронов
- ESR:
-
Обычный электронный спиновой резонанс
- FEG:
-
Холодная автоэмиссионная пушка
- БПФ:
-
Быстрое преобразование Фурье
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- IMEYMAT:
-
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE:
-
Молекулярно-лучевая эпитаксия
- qHAADF:
-
Алгоритм количественного анализа изображений HAADF
- SEM:
-
Сканирующий электронный микроскоп
- XAS:
-
Рентгеновская абсорбционная спектроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Анализ формы волны
- Параметры анализа
- Анализ отказов компонентов
- Анализ отказов компонентов (продолжение)
- Что такое сетевой анализ?
- Подробнее о спектральном анализе
- Распределительный центр Промышленное обслуживание
- РАСПРОСТРАНЕНИЕ ИЗДЕЛИЙ
- Что такое распределение питания?
- Что такое планирование распространения?



